為什么現(xiàn)在越來越多的客戶一看到SiC碳化硅MOSFET功率器件供應商聊的第一個話題就是碳化硅MOSFET的柵氧可靠性,碳化硅(SiC)MOSFET的柵氧可靠性成為電力電子客戶應用中的核心關(guān)切點,其背后涉及材料特性、工藝挑戰(zhàn)、應用場景的嚴苛性以及產(chǎn)業(yè)鏈成熟度的多重博弈。
客戶的電力電子研發(fā)工程師在與國產(chǎn)SiC MOSFET供應商交流時首先聚焦于柵氧可靠性問題,這一現(xiàn)象也確實反映了對國產(chǎn)碳化硅功率器件市場亂象魚龍混雜現(xiàn)狀的深層次擔憂。
應用場景的嚴苛要求
電動汽車/充電樁:頻繁啟停和溫度循環(huán)下,柵氧可靠性影響逆變器壽命。
可再生能源逆變器:需在野外惡劣環(huán)境下穩(wěn)定運行數(shù)十年,柵氧退化可能導致發(fā)電效率下降。
工業(yè)電源:高功率密度設計下,局部過熱可能加速柵氧失效。
電力電子研發(fā)工程師關(guān)注SiC MOSFET的柵氧可靠性,本質(zhì)上是因為柵氧化層(SiO?)的缺陷直接影響器件的長期穩(wěn)定性和壽命。而通過TDDB(Time-Dependent Dielectric Breakdown,時間相關(guān)介電擊穿)實驗是評估柵氧可靠性的核心方法,能夠量化柵氧化層的失效風險。
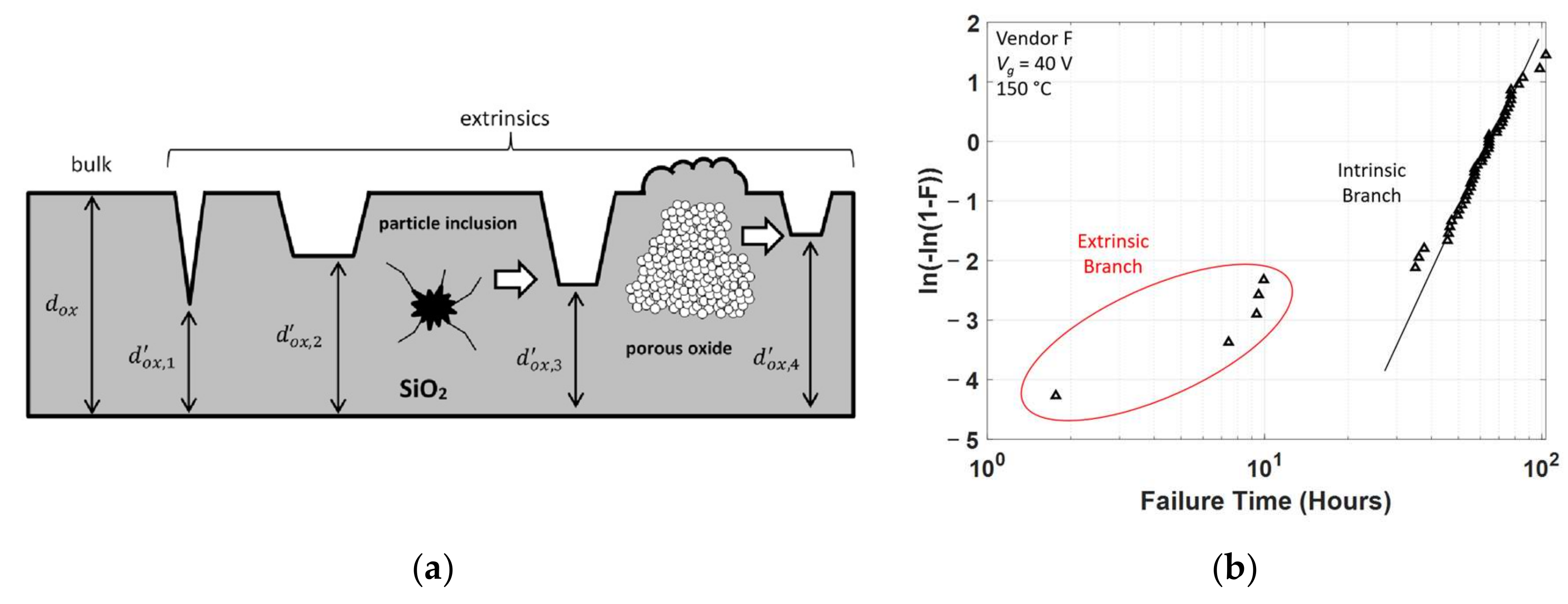
TDDB實驗的核心流程與參數(shù)解析
實驗設計
加速應力條件
電場加速:施加高于額定值的柵極電壓(如額定18V,測試+40V)。
溫度加速:通常在125℃~175℃下測試,模擬高溫環(huán)境對柵氧的退化效應。
樣本數(shù)量:需測試足夠樣本(如30~50顆芯片)以覆蓋工藝波動。
測試模式
恒定電壓法(CVS):保持恒定柵壓直至擊穿,記錄擊穿時間(TBD)。
斜坡電壓法(RVS):逐步升高柵壓直至擊穿,記錄擊穿電壓(VBD)。
關(guān)鍵參數(shù)分析
擊穿時間分布(Weibull分布)
TDDB數(shù)據(jù)通常符合Weibull統(tǒng)計模型:
F(t)=1?exp[?(ηt)β]
形狀參數(shù)(β):反映失效分布的離散程度。β>1表示早期失效風險高(工藝缺陷多)。
特征壽命(η):63.2%樣本失效的時間,直接表征柵氧壽命。
國產(chǎn)器件常見問題:β值偏低(如β<2),表明工藝一致性差;η值可能僅為國際產(chǎn)品的1/5~1/10。
電場加速因子(EAF)
通過不同電場下的TDDB數(shù)據(jù),擬合電場加速模型(如E-model):
TTF∝exp(?γEox)
γ值:反映柵氧對電場的敏感度。γ值越高,柵氧在高電場下退化越快。
國產(chǎn)器件風險:γ值偏高,說明柵氧質(zhì)量不足(如界面態(tài)密度高)。
如何通過TDDB數(shù)據(jù)評估供應商能力?
1. 數(shù)據(jù)可信度驗證
測試標準:要求供應商提供符合JEDEC JEP001、AEC-Q101等標準的TDDB報告。
數(shù)據(jù)完整性:需包含Weibull分布圖、電場加速模型、溫度相關(guān)性分析。
案例對比:對比國際大廠數(shù)據(jù),評估國產(chǎn)器件的差距。
2. 關(guān)鍵指標解讀
β值>3:工藝一致性較好(國產(chǎn)器件常β≈1.5~2.5)。
η值@額定電壓:若η值對應的實際壽命小于應用需求(如光伏儲能>25年),則不可接受。
失效機理分析:要求供應商提供擊穿點定位(如SEM/TEM分析),確認失效是否源自柵氧缺陷(而非封裝問題)。
3. 國產(chǎn)供應商的典型問題
早期失效集中:Weibull曲線左移,β值低,反映襯底缺陷或氧化工藝波動。
電場敏感性高:γ值>4(國際水平γ≈3~3.5),表明界面鈍化不足。
數(shù)據(jù)缺失或模糊:部分廠商僅提供“通過/未通過”結(jié)論,缺乏原始數(shù)據(jù)支撐。
成本與可靠性的平衡
高質(zhì)量的柵氧工藝可能增加制造成本,但客戶研發(fā)工程師需權(quán)衡:犧牲可靠性可能導致更高的售后維護成本或品牌聲譽損失,尤其在關(guān)鍵基礎設施領域。
以下是系統(tǒng)性分析:
一、材料特性與柵氧失效的根源
SiC與SiO?的界面缺陷
SiC材料的晶體結(jié)構(gòu)(如4H-SiC的六方密堆積)與氧化生成的SiO?之間存在晶格失配和熱膨脹系數(shù)差異,導致界面處產(chǎn)生高密度缺陷(如碳空位(VC)、氧空位(VO))。這些缺陷形成電荷陷阱,引發(fā)以下問題:
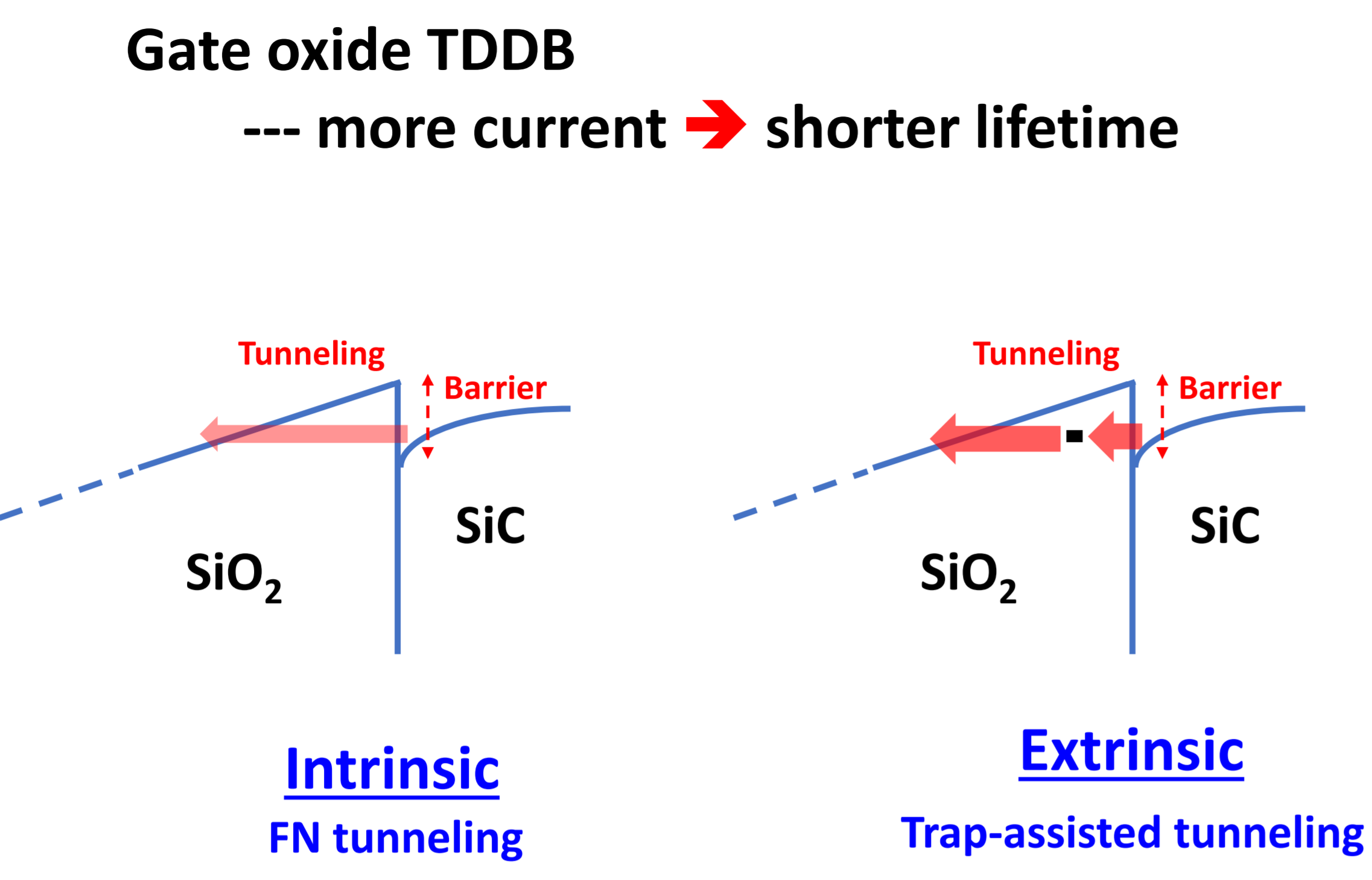
閾值電壓(Vth)漂移:電荷陷阱充放電導致Vth不穩(wěn)定,影響開關(guān)特性。
柵漏電流增加:缺陷成為導電通道,加速柵氧退化。
局部電場畸變:缺陷集中區(qū)域電場強度驟增,誘發(fā)提前擊穿。
高電場與高溫下的可靠性風險
高壓應用場景:SiC器件柵氧層承受的電場強度遠高于硅器件,氧化層缺陷易引發(fā)局部擊穿或長期退化。
高溫穩(wěn)定性:SiC適用于高溫環(huán)境(如175℃以上),但高溫會加劇界面態(tài)密度上升,導致柵氧壽命下降。
高臨界擊穿電場的雙刃劍
更薄的柵氧層(如50 nm以下)給碳化硅MOSFET帶來性能優(yōu)勢,但實際應用中:
電場強度極高:相同電壓下,SiC MOSFET柵氧層承受的電場強度遠高于硅器件(如1200V器件中電場達4-5 MV/cm)。
工藝容差小:氧化層厚度或均勻性的微小偏差(如±2 nm)即可導致局部電場超出耐受極限。
對系統(tǒng)可靠性的直接影響
閾值電壓漂移:柵氧缺陷可能導致閾值電壓(Vth)不穩(wěn)定,影響開關(guān)特性,甚至引發(fā)誤觸發(fā)或熱失控。
長期失效風險:柵氧層失效是器件壽命的主要限制因素之一,尤其在新能源、軌道交通等對可靠性要求極高的領域,微小的失效率可能引發(fā)嚴重系統(tǒng)故障。
二、工藝挑戰(zhàn)與國產(chǎn)化痛點
氧化工藝的成熟度差距
熱氧化條件苛刻:SiC需在1200℃以上高溫氧化生成SiO?,但高溫加劇碳原子析出,形成界面碳團簇(如SiOxCy),降低柵氧質(zhì)量。
工藝技術(shù)不足:廠商采用氮退火、氫退火等技術(shù)修復界面缺陷,而國產(chǎn)工藝多依賴傳統(tǒng)氧化,界面態(tài)密度(Dit)高。
供應商技術(shù)能力的核心指標
工藝差異化:柵氧質(zhì)量直接反映供應商的核心技術(shù)水平(如氧化工藝優(yōu)化、氮化界面鈍化技術(shù)等),工程師需評估不同供應商的解決方案。
數(shù)據(jù)驗證需求:客戶研發(fā)工程師會要求供應商提供柵氧可靠性測試數(shù)據(jù)(如HTGB高溫柵偏測試、TDDB時間相關(guān)介電擊穿數(shù)據(jù)),以量化器件壽命。

三、應用場景的嚴苛需求
高壓與高溫的協(xié)同應力
新能源汽車主驅(qū)逆變器:SiC MOSFET工作電壓達較高,結(jié)溫超過150℃,柵氧需在10年內(nèi)承受>1e8次開關(guān)循環(huán)。若柵氧失效導致Vth漂移超過±1V,可能引發(fā)誤觸發(fā)或熱失控。
光伏逆變器:戶外25年壽命要求下,碳化硅MOSFET柵氧壽命需被關(guān)注。
動態(tài)工況下的可靠性風險
短路耐受能力:SiC MOSFET短路時間僅2μs左右,短路時柵氧承受的瞬時功率密度極高,劣質(zhì)柵氧可能直接擊穿。
雪崩能量沖擊:部分國產(chǎn)碳化硅MOSFET器件因柵氧局部缺陷,雪崩能量耐受值(EAS)較低。
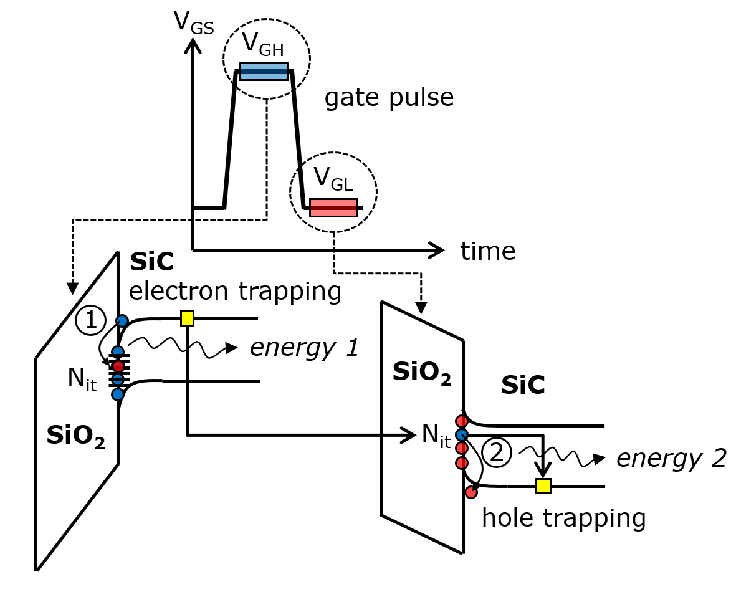
四、國產(chǎn)SiC MOSFET的信任危機
數(shù)據(jù)透明度不足
部分國產(chǎn)廠商僅提供“通過/未通過”的定性結(jié)論,缺乏關(guān)鍵數(shù)據(jù)(如TDDB的Weibull分布參數(shù)、HTGB閾值電壓漂移曲線),客戶難以量化風險。
早期失效案例頻發(fā)
某國產(chǎn)SiC MOSFET在車載充電樁應用中,因柵氧缺陷導致15個月內(nèi)批量失效,失效分析顯示界面態(tài)密度超標。
成本與可靠性的失衡
國產(chǎn)廠商為降低成本,可能簡化工藝(如縮短氧化時間、減少鈍化步驟),犧牲柵氧可靠性。
五、解決方案與技術(shù)演進方向
工藝端
界面優(yōu)化:采用氮等離子體處理降低Dit。
柵介質(zhì)創(chuàng)新:引入高k介質(zhì)(如Al?O?/SiO?疊層)或非熱氧化工藝(如等離子體氧化),減少碳殘留。
設計端
場板結(jié)構(gòu)(Field Plate):在柵極邊緣集成場板,分散電場峰值。
集成監(jiān)測電路:內(nèi)置柵氧健康狀態(tài)傳感器,實時預警退化風險。
驗證端
加速老化模型標準化:推動國產(chǎn)SiC MOSFET的TDDB、HTGB測試標準與JEDEC/JEP001接軌。
開放失效分析:向客戶提供TEM/SEM圖像、二次離子質(zhì)譜(SIMS)數(shù)據(jù),證明缺陷控制能力。

工程師的應對策略
要求供應商提供完整TDDB報告
包括不同電壓/溫度組合下的壽命預測曲線、失效分布統(tǒng)計、工藝改進措施(如氮化退火工藝優(yōu)化)。
自主驗證測試
對關(guān)鍵應用場景(如新能源汽車主驅(qū)),可抽樣進行TDDB測試,重點關(guān)注早期失效比例。
結(jié)合其他可靠性測試
HTGB(高溫柵偏測試):驗證閾值電壓穩(wěn)定性。
HTRB(高溫反向偏置測試):評估體二極管退化。
功率循環(huán)測試:模擬實際開關(guān)工況下的綜合應力。
結(jié)論
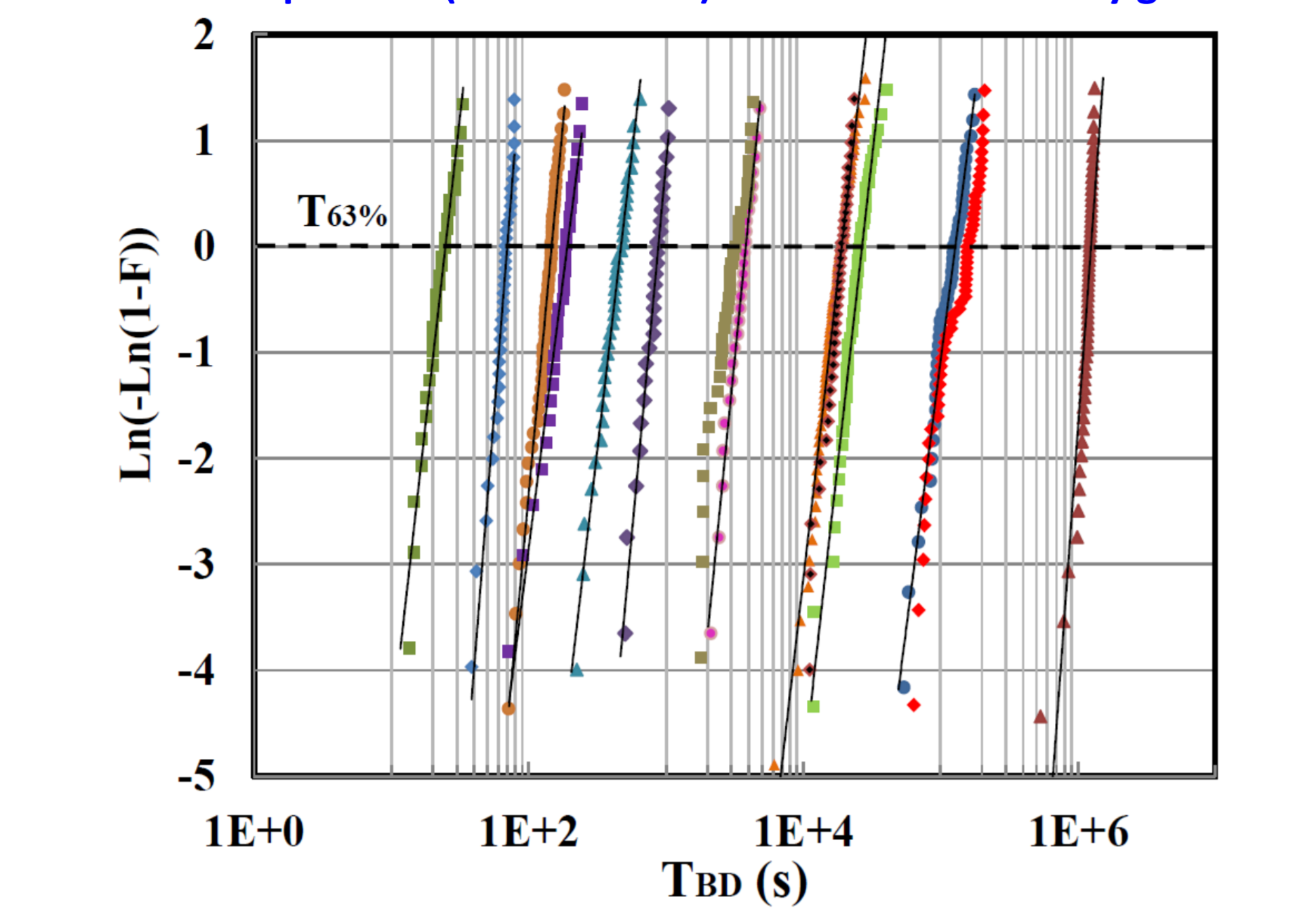
TDDB實驗是檢驗SiC MOSFET柵氧可靠性的“試金石”。工程師通過分析TDDB的Weibull分布、電場加速因子等數(shù)據(jù),可直接評估供應商的工藝水平和產(chǎn)品可靠性。對國產(chǎn)碳化硅MOSFET供應商而言,唯有攻克襯底缺陷控制、柵氧工藝優(yōu)化等關(guān)鍵技術(shù),并主動提供嚴謹?shù)腡DDB驗證數(shù)據(jù),才能打破“國產(chǎn)不可靠”的固有印象,真正實現(xiàn)高端市場替代。
柵氧可靠性是SiC MOSFET能否大規(guī)模商用的“阿喀琉斯之踵”。客戶研發(fā)工程師首要關(guān)注此問題,既是對技術(shù)本質(zhì)的深刻理解,也是對供應商技術(shù)實力和產(chǎn)品長期穩(wěn)定性的關(guān)鍵考察。只有通過材料和工藝創(chuàng)新(如新型柵介質(zhì)、界面優(yōu)化技術(shù)),才能推動SiC MOSFET在高端電力電子應用中真正替代硅基器件。
柵氧可靠性是SiC MOSFET能否從“實驗室性能優(yōu)越”邁向“工業(yè)級可靠應用”的核心門檻。客戶的深度關(guān)切源于材料本質(zhì)缺陷、工藝代際差距與嚴苛應用需求的矛盾。對于國產(chǎn)供應鏈而言,唯有通過全產(chǎn)業(yè)鏈協(xié)同(從襯底缺陷控制到終端失效分析)、數(shù)據(jù)透明化(公開TDDB/HTGB原始數(shù)據(jù))和正向設計創(chuàng)新(突破專利封鎖),才能將柵氧可靠性從“痛點”轉(zhuǎn)化為“競爭力”,真正贏得高端市場信任。
審核編輯 黃宇
-
MOSFET
+關(guān)注
關(guān)注
148文章
7716瀏覽量
216442 -
SiC
+關(guān)注
關(guān)注
30文章
3040瀏覽量
63827 -
碳化硅
+關(guān)注
關(guān)注
25文章
2930瀏覽量
49744
發(fā)布評論請先 登錄
相關(guān)推薦
國產(chǎn)SiC碳化硅MOSFET廠商絕口不提柵氧可靠性的根本原因是什么
如何測試SiC MOSFET柵氧可靠性

長期工作的充電樁電源模塊中碳化硅MOSFET失效率越來越高的罪魁禍首:柵氧可靠性埋了大雷
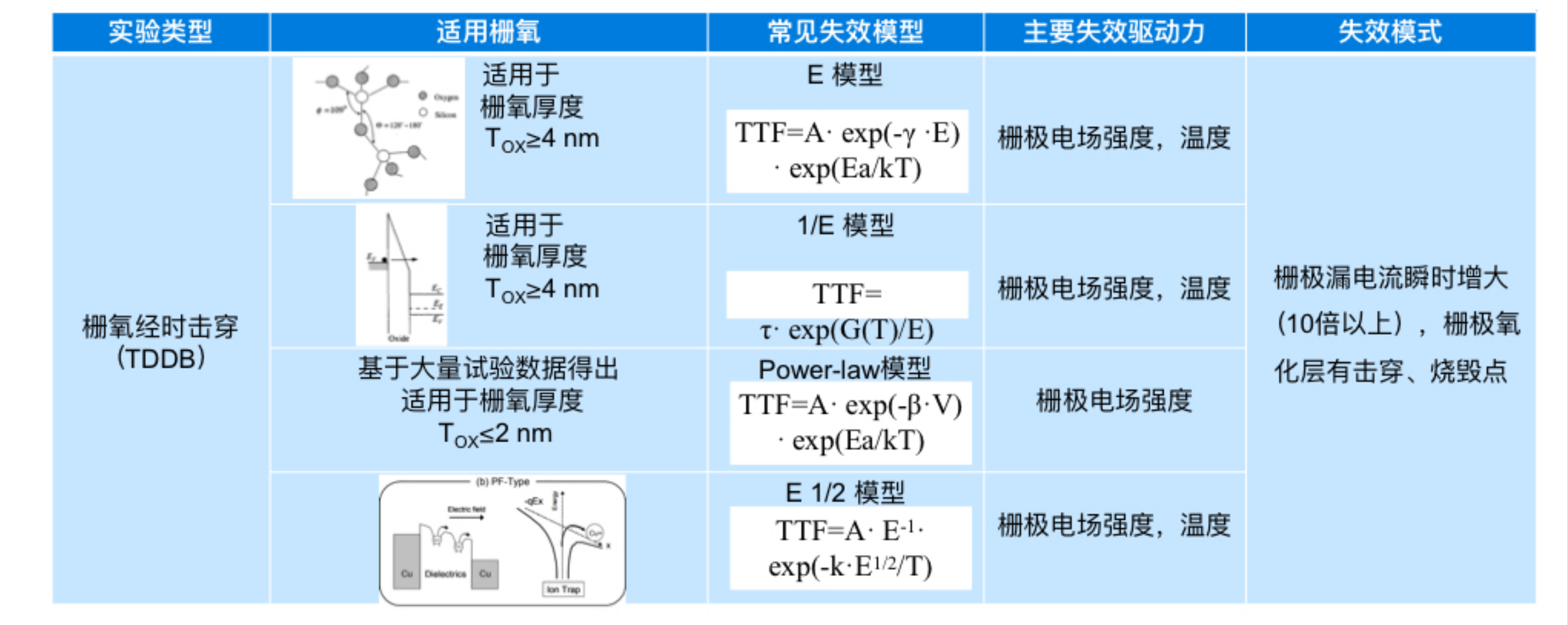
國產(chǎn)碳化硅MOSFET“最低比導通電阻”宣傳噱頭背后隱藏的真相

40mR/650V SiC 碳化硅MOSFET,替代30mR 超結(jié)MOSFET或者20-30mR的GaN!
產(chǎn)SiC碳化硅MOSFET功率模塊在工商業(yè)儲能變流器PCS中的應用
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
碳化硅SiC在電子器件中的應用
瞻芯電子交付碳化硅(SiC)MOSFET逾千萬顆 產(chǎn)品長期可靠性得到驗證

英飛凌科技推出新一代碳化硅(SiC)MOSFET溝槽柵技術(shù)








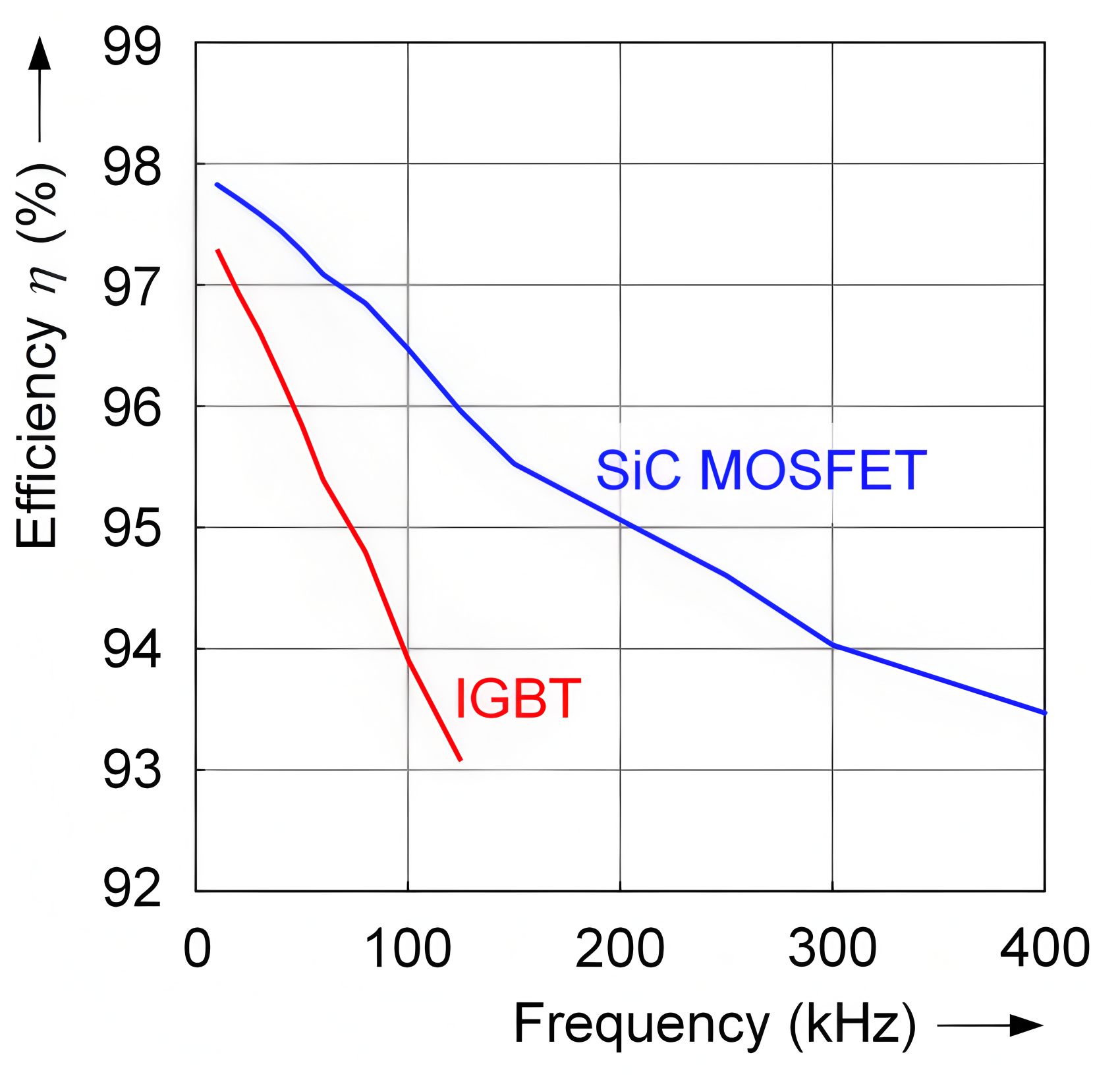
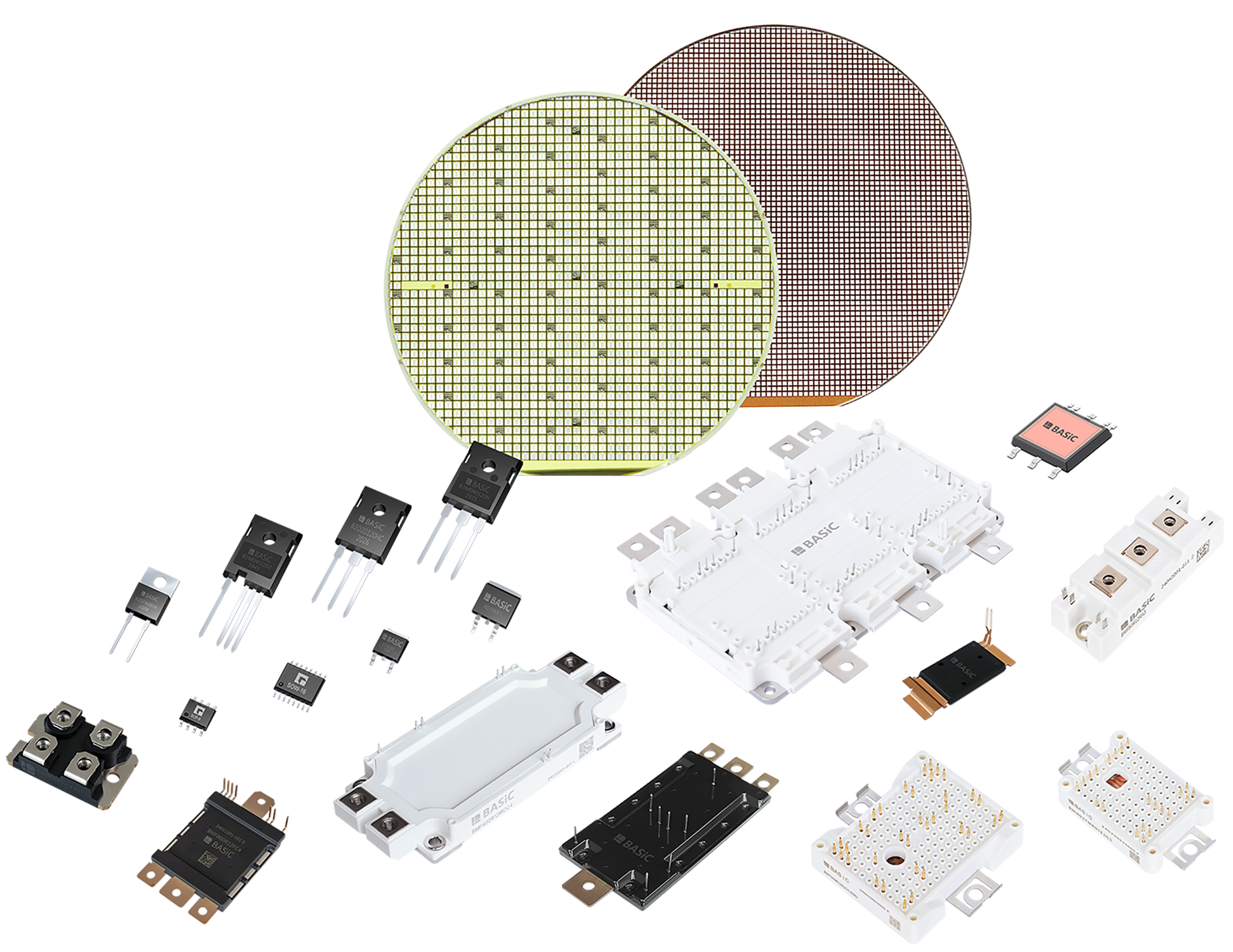
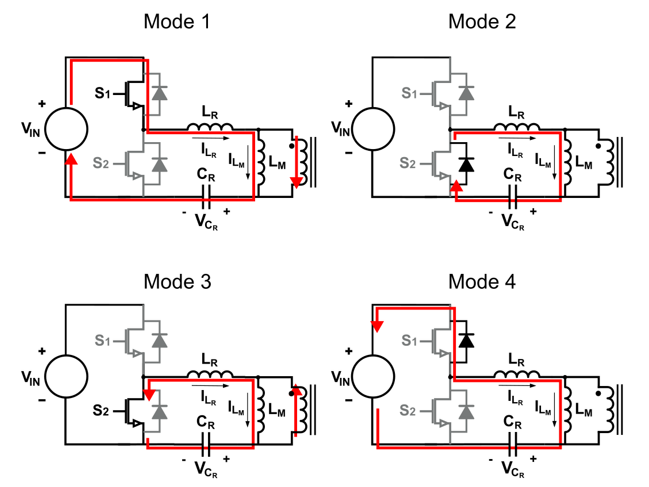
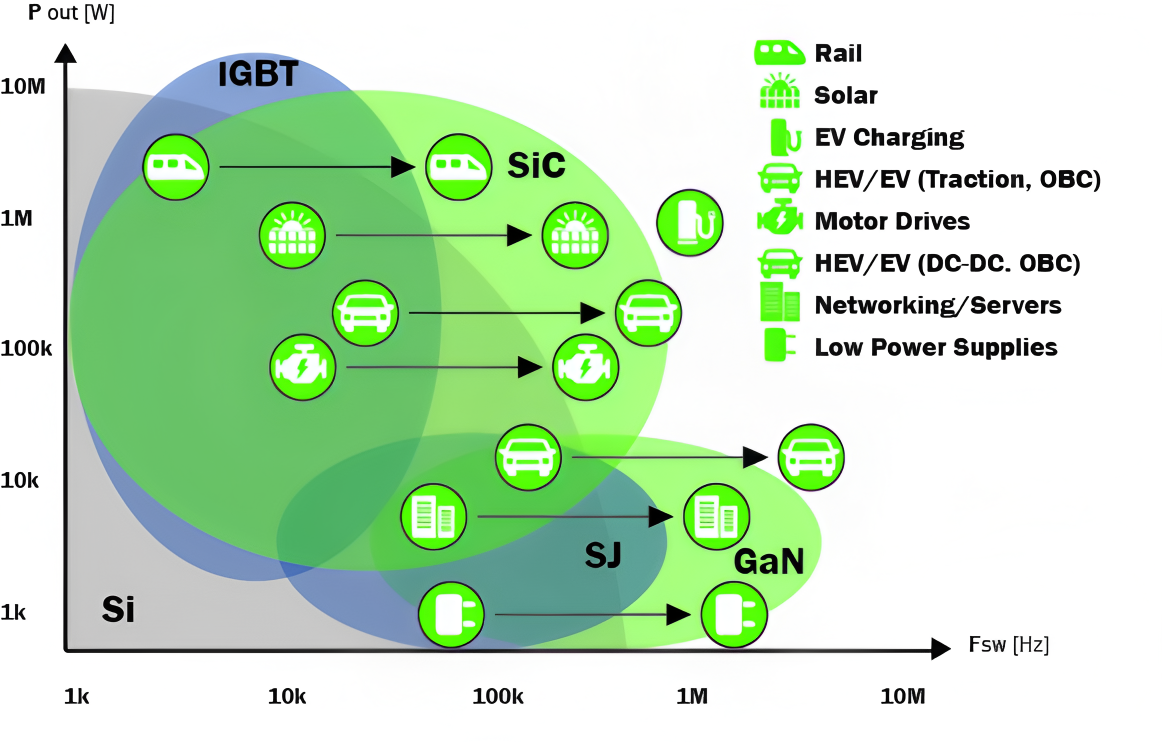












評論