隨著電力電子技術的飛速發展,碳化硅(SiC)金屬氧化物半導體場效應晶體管(MOSFET)因其優異的性能,如高開關速度、低導通電阻和高工作溫度,逐漸成為高頻、高效功率轉換應用的理想選擇。然而,SiC MOSFET的柵氧可靠性問題一直是制約其廣泛應用的關鍵因素之一。柵氧層的可靠性直接影響到器件的長期穩定性和使用壽命,因此,如何有效驗證SiC MOSFET柵氧可靠性成為了業界關注的焦點。
本文將詳細介紹一種常用的柵氧可靠性驗證方法——經時介電擊穿(TDDB)測試,并通過實驗數據和壽命預測模型,評估SiC MOSFET柵氧層的可靠性。
TDDB失效機理
經時介電擊穿(TDDB)是一種用于評估柵氧層可靠性的重要測試方法。其基本原理是通過在柵氧層上施加恒定的電壓應力,觀察柵氧層在長時間應力作用下的擊穿行為。TDDB失效機理主要包括以下幾個步驟:
1.缺陷生成:在電場應力的作用下,柵氧層中的缺陷逐漸生成。這些缺陷可能是由于制造過程中的雜質、界面態或晶格不匹配引起的。
2.電荷捕獲:電場應力會導致電荷在柵氧層中捕獲,形成局部高電場區域,進一步加速缺陷的生成。
3.導電通道形成:隨著缺陷的積累,柵氧層中會形成導電通道,導致局部電流密度增加。
4.擊穿發生:當導電通道的密度達到一定程度時,柵氧層會發生擊穿,導致器件失效。

圖一 SiO2體內形成滲流路徑簡化二維模型
柵氧內部產生缺陷的物理機理并沒有一個準確的結論,廣泛認同的模型有基于電場的熱化學 E 模型、基于電流的陽極空穴注入1/E模型、基于缺陷自身位置與能量的幸運缺陷模型以及不涉及真實物理機理但有助于早期失效篩選的局部柵氧變薄模型,下表列出了不同模型的特點及其壽命推算公式。

TDDB實驗流程
了解TDDB的失效機理后,我們可以知道器件的柵氧可靠性測試是可以通過改變施加在器件上的應力加速的,加速因子為柵極電壓VG與環境溫度Ta,圖2是TDDB測試的實驗流程,旨在確定擊穿電壓并在不同溫度和電壓條件下評估柵氧可靠性。

圖2TDDB實驗流程
(1)器件初篩:每組實驗選用20顆SiC MOSFET器件,初篩選取電學特性符合規范的器件,以獲取更加準確的失效分布;
(2)TZDB測試:確定器件的擊穿電壓(VBD),為TDDB測試提供參考電壓,如果知道器件的柵氧層厚度,可以計算器件失效時的臨界擊穿場強;
(3)設置TDDB加速應力:在升溫完成后施加柵極電壓應力,并實時監測每顆器件的柵極泄漏電流IGSS,根據不同的測試溫度和柵極應力可以將器件分為不同的測試組;
(4)器件失效判據:TDDB測試老化板需要在器件的柵極串聯一顆保險絲,其作用是限制器件的柵極的電流,一旦器件出現失效,保險絲可以及時熔斷,電流歸零,記錄此時的總應力時間,即為該器件的失效時間;
(5)實驗停止判據:一般情況下,TDDB實驗為完全壽命實驗,即需要所有器件出現失效;為了縮短TDDB實驗時間,也可以采用80%器件失效作為實驗結束判據。
以上為TDDB實驗的流程,通過控制加速因子,可以得出器件在不同溫度、不同應力下的失效時間,而器件柵氧失效的數據處理常常使用威布爾分布(Weibull distribution)進行分析,在實驗中可以使用以下公式計算第i個器件在n個樣本中的累計失效率F(i):

同時,累計失效率與失效時間也滿足以下關系:

因此只需要計算出ln(-ln(1-F))的值和ln(t)的值,通過線性回歸獲得的斜率與截距,經過計算后就可以得到形狀參數β及本征壽命t63.2,同時可以獲得柵氧壽命的威布爾分布圖:

圖3柵氧失效威布爾分布圖[4]
從圖中可以看到對于不同的測試條件,器件的失效時間是不同的,這對應了不同的應力下的失效分布,四條曲線的形狀參數β存在區別,一般來說,隨著應力的減小,β也會提高,測試獲得的壽命也約接近真實值。同時,也可以注意到每組器件都會有幾個點與擬合曲線的距離較遠,這說明器件出現了早期失效,這些器件的預估壽命也會遠小于正常壽命,對應了浴盆曲線的早期高失效率階段。

圖4浴盆曲線風險函數
E模型壽命預測
通過TDDB實驗獲取器件的失效分布后,結合器件柵氧失效的機理,也就是之前提到的E模型、1/E模型等,我們可以通過這些模型合理地預測SiC MOSFET器件的柵氧可靠性。
這里以E模型為例進行簡單介紹,E模型的器件本征失效壽命tBD滿足:

其中Eox為器件的柵氧電場強度,從公式可知,器件的本征壽命的對數與柵氧電場強度呈現線性關系,因此可以通過多個電壓點的本征壽命擬合,外推正常工作電壓條件下的失效率63.2%的本征壽命,同時也可以計算1ppm、10ppm以及100ppm失效率下的器件本征壽命,這里也為大家解答一個疑問,為什么工業上常常使用E模型進行壽命外推?
我們來看圖5,這是使用E模型、1/E模型以及冪律模型進行壽命外推獲得的曲線,可以看到,E模型的推算壽命是最為保守的,盡管E模型主要是作用于高電場強度下的模型,在低壓下,1/E模型和冪律模型擬合度更高,但獲得的壽命也更加高,因此為了保證器件柵氧長期使用的可靠性,E模型成為了工業上柵氧壽命外推的首選公式。
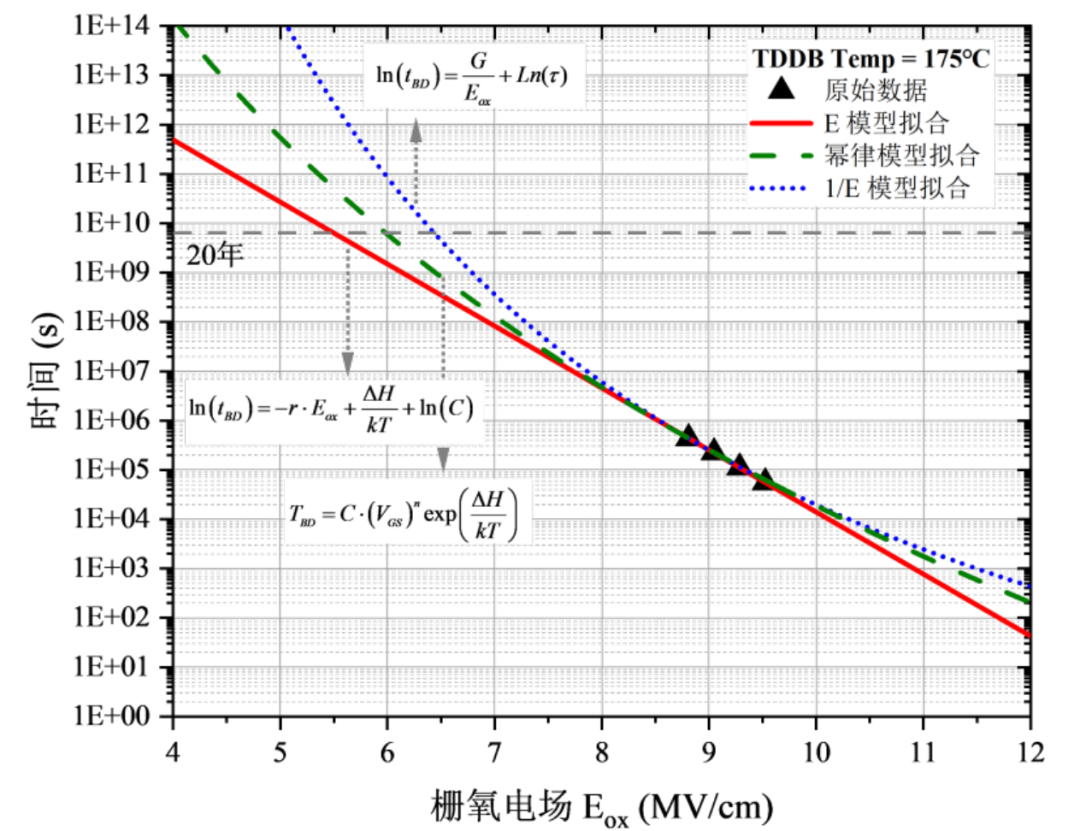
圖5 不同模型壽命外推的擬合曲線[5]
小結:通過TDDB測試和壽命預測模型,我們可以有效評估SiC MOSFET柵氧的可靠性。實驗結果表明,柵氧層的擊穿時間與電場強度密切相關,且在不同應力條件下表現出不同的失效分布特性。基于E模型和1/E模型的壽命預測,可以為SiC MOSFET的設計和應用提供重要的可靠性參考。
然而,需要注意的是,TDDB測試僅能模擬柵氧層在恒定應力下的失效行為,實際應用中,器件可能會經歷復雜的動態應力條件。因此,未來的研究可以進一步探索動態應力下的柵氧可靠性評估方法,以更全面地反映SiC MOSFET在實際工作環境中的可靠性表現。
關于揚杰
揚州揚杰電子科技股份有限公司是國內少數集半導體分立器件芯片設計制造、器件封裝測試、終端銷售與服務等產業鏈垂直一體化(IDM)的杰出廠商。產品線含蓋分立器件芯片、MOSFET、IGBT&功率模塊、SiC、整流器件、保護器件、小信號等,為客戶提供一攬子產品解決方案。
公司產品廣泛應用于汽車電子、清潔能源、工控、5G通訊、安防、AI、消費電子等諸多領域。
公司于2014年1月23日在深交所上市,證券代碼300373,相信在您的關懷支持下,我們一定能夠成為世界信賴的功率半導體伙伴。
-
MOSFET
+關注
關注
148文章
7674瀏覽量
215951 -
晶體管
+關注
關注
77文章
9869瀏覽量
139682 -
SiC
+關注
關注
30文章
3024瀏覽量
63632 -
碳化硅
+關注
關注
25文章
2923瀏覽量
49631
原文標題:如何驗證SiC MOSFET柵氧可靠性——TDDB測試及柵氧壽命評估
文章出處:【微信號:yangjie-300373,微信公眾號:揚杰科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
SiC-SBD關于可靠性試驗
SiC-MOSFET的可靠性
SiC MOSFET:經濟高效且可靠的高功率解決方案
從硅過渡到碳化硅,MOSFET的結構及性能優劣勢對比
SiC MOSFET FIT率和柵極氧化物可靠性的關系
碳化硅SiC MOSFET:低導通電阻和高可靠性的肖特基勢壘二極管
ROHM SiC-MOSFET的可靠性試驗
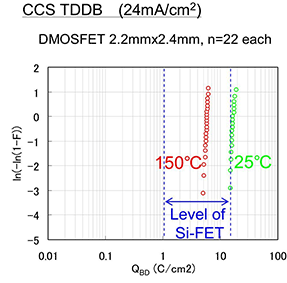
AEC---SiC MOSFET 高溫柵氧可靠性研究

瞻芯電子參與編制SiC MOSFET可靠性和動態開關測試標準







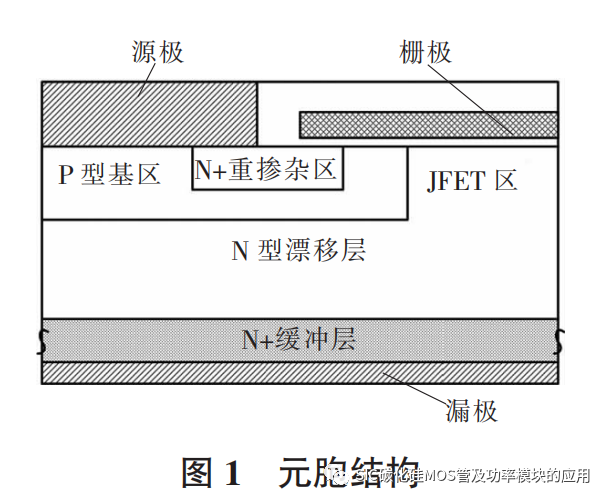

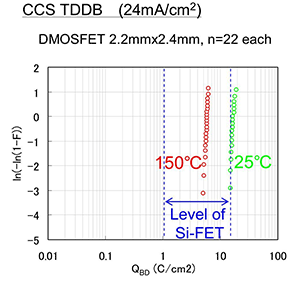













評論