本文介紹了什么是原子層沉積(ALD, Atomic Layer Deposition)。
1.原理:基于分子層級的逐層沉積
ALD 是一種精確的薄膜沉積技術,其核心原理是利用化學反應的“自限性”,以原子或分子層為單位逐層生長薄膜。
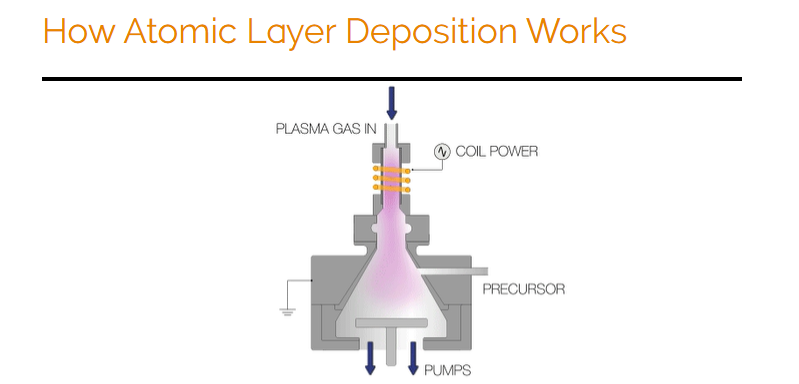
具體過程包括:
前體吸附:將化學前體(Precursor)引入反應室,前體分子在襯底表面發生吸附,形成單分子層。
吹掃:用惰性氣體(如氮氣或氬氣)將未吸附的前體和副產物清除,確保僅剩化學吸附的分子。
反應:引入第二種前體,與已吸附分子發生化學反應,生成所需的薄膜層,同時釋放出氣相副產物。
循環重復:每次循環僅沉積一個原子層,通過重復循環,逐漸形成所需厚度的均勻薄膜。
這種“自限性反應”確保每個循環的沉積厚度恒定,無論基材表面是平坦還是復雜的三維結構。
2. 優勢分析
2.1 無針孔薄膜
特點:ALD 沉積薄膜致密,無微小孔洞,確保膜層具備優異的密封性和隔離性。
原因:由于每個周期只沉積一個原子層,沉積過程可以填補薄膜中的微小缺陷,保證膜層完整性。
應用:這種無缺陷薄膜廣泛應用于高性能電子器件(如柵氧化層)、防腐涂層和氣體屏障等場景。
2.2 階梯覆蓋能力
特點:ALD 在高深寬比結構中實現 100% 階梯覆蓋,無論是復雜凹槽、孔隙還是微納結構。
原因:由于 ALD 依賴于化學吸附,每個層面都能均勻吸附前體,并逐層沉積,無厚薄不均現象。
應用:適用于半導體器件、納米線、光學傳感器等復雜三維結構的涂覆。
2.3 低溫沉積
特點:適合溫度敏感的基材,常見溫度范圍為 50-350°C。
原因:ALD 的前體吸附和化學反應是熱驅動過程,但在適當溫度內不需要高溫,因此可避免高溫對材料的破壞。
應用:對熱敏基材(如柔性電子、聚合物基材)的涂覆。
3. ALD 與傳統沉積技術的對比
薄膜均勻性:傳統方法如 PECVD(等離子體增強化學氣相沉積)或 PVD(物理氣相沉積)在高深寬比結構中沉積不均勻,ALD 能在微納米尺度結構中實現均勻沉積。
刻蝕精度:ALD 的對標工藝 ALE(原子層刻蝕)同樣依賴自限性反應,具備更高的刻蝕均勻性和精度。
成本與效率:雖然 ALD 的循環沉積速度較慢,但其薄膜質量和均勻性使其成為高精度領域的首選。
4. 材料與應用
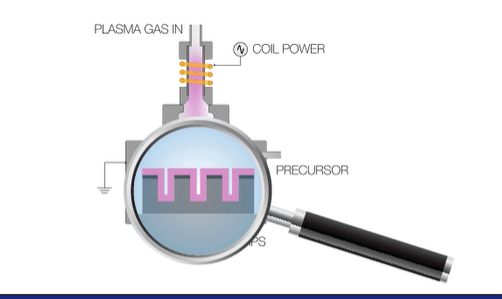
ALD 可沉積多種無機和有機材料:
金屬氧化物:如 TiO?(高折射率薄膜)、ZrO?(電介質層)。 氮化物:如 TiN(導電屏蔽層)。 碳化物:用于高溫穩定性涂層。
無機材料:
有機涂層:如聚酰胺(納米級防腐薄膜)。
典型應用領域
半導體制造:制備柵極氧化層、導電屏蔽層、鈍化層。
光學與光子學:制備抗反射涂層、高折射率鏡片。
綠色能源:用于太陽能電池的鈍化和催化劑涂層。
5. ALD 的未來趨勢
與 ALE 的聯動:結合原子層沉積和刻蝕技術,推動極高深寬比結構制造。
前體開發:開發更高反應活性、環保型前體,擴展可沉積材料種類。
大面積制造:研究提高 ALD 沉積速率的方案(如 Spatial ALD),實現高效量產。
通過逐層沉積和精確控制,ALD技術已成為微納米制造的基石之一,在半導體、光學、能源等多個領域發揮著不可替代的作用。 END 轉載內容僅代表作者觀點 不代表中國科學院半導體所立場
-
半導體
+關注
關注
334文章
27693瀏覽量
222216 -
微納米
+關注
關注
0文章
20瀏覽量
7579
原文標題:原子層沉積(ALD, Atomic Layer Deposition)詳解
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
半導體薄膜沉積技術的優勢和應用
探索物質極限:原子級制造的崛起與未來
原子層沉積ALD技術實現邊緣鈍化,TOPCon電池效率提高0.123%

選擇性沉積技術介紹
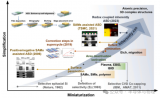
詳解金屬互連中介質層
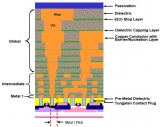
最新Science:原子層沉積技術在鈣鈦礦太陽能電池中沉積錫氧化物(SnOx)以提高其長期穩定性的研究

周星工程研發ALD新技術,引領半導體工藝革新
中微推出自研的12英寸原子層金屬鎢沉積設備Preforma Uniflex AW
蘋果測試新抗反射涂層技術,提升iPhone相機成像水平
流量控制器在半導體加工工藝化學氣相沉積(CVD)的應用





 原子層沉積(ALD, Atomic Layer Deposition)詳解
原子層沉積(ALD, Atomic Layer Deposition)詳解
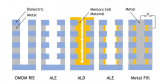

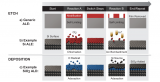
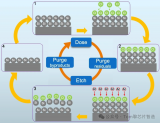
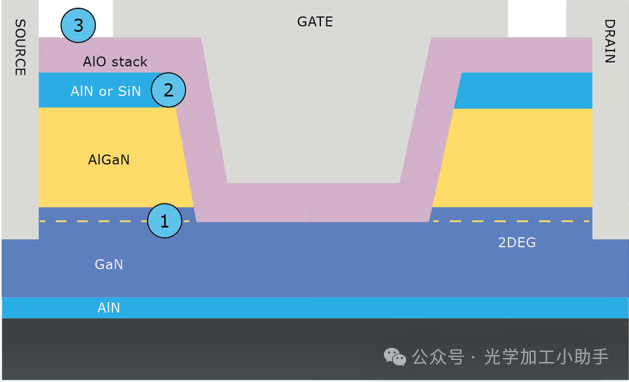










評論