在AI高性能芯片需求的推動下,玻璃基板封裝被寄予厚望。據Prismark統計,預計2026年全球IC封裝基板行業規模將達到214億美元,而隨著英特爾等廠商的入局,玻璃基板對硅基板的替代將加速,預計3年內玻璃基板滲透率將達到30%,5年內滲透率將達到50%以上。
與有機基板相比,玻璃基板憑借其卓越的平整度、絕緣性、熱性能和光學性質,為需要密集、高性能互連的新興應用提供了傳統基板的有吸引力的替代方案,開始在先進封裝領域受到關注。
先進封裝中2.5D和3D IC集成方案是實現下一代性能要求和適用于商業產品的關鍵組成部分,超高密度的I/O連接可利用中介層實現,最突出和最廣泛使用的中介層類型之一是硅通孔——TSV中介層。而在玻璃基板中,同樣通過高密度的通孔來提供垂直電連接,它們被稱為玻璃通孔(TGV) ,形成高質量、高密度的TGV通孔對于中介層至關重要。

不同類型基板性能對比
玻璃基板來襲,TGV成核心
在先進封裝浪潮中,隨著對更強大計算的需求增加,半導體電路變得越來越復雜,信號傳輸速度、功率傳輸、設計規則和封裝基板穩定性的改進將至關重要。
玻璃基板的出現,可以降低互連之間的電容,從而實現更快的信號傳輸并提高整體性能。在數據中心、電信和高性能計算等速度至關重要的應用中,使用玻璃基板可以顯著提高系統效率和數據吞吐量。
玻璃是一種可能替代硅基轉接板的材料,與硅通孔(TSV)相比,TGV具有低成本、大尺寸超薄玻璃襯底易獲取、高頻電學性能優異等特點。玻璃基板可進行大尺寸生產,具有超薄加工的可能性,基于玻璃通孔(TGV)的轉接板工藝在微波系統集成領域中的應用越來越為人們所關注。多年以來,業界及學界許多研究工作都致力于研發低成本、快速可規模化量產的成孔技術。
TGV成孔與填孔技術
TGV技術能夠實現三維垂直互聯,顯著提高集成密度。目前,制約TGV技術發展的主要困難包括其成孔及填孔技術。
TGV通孔需要滿足高速、高精度、窄節距、側壁光滑、垂直度好以及低成本等一系列要求。多年來,許多研究工作都在致力于開發低成本、快速可規模化量產的成孔技術,其中包括噴砂法、光敏玻璃法、聚焦放電法、等離子體刻蝕法、激光燒蝕法、電化學放電加工法、激光誘導刻蝕法等。激光誘導刻蝕法因其諸多優點,如成孔質量均勻,一致性好,無裂紋,成孔速率快且可通過調節激光參數控制通孔的垂直度和形貌,成為目前最可能大規模應用的工藝技術。

不同TGV成孔技術優缺點
與硅通孔不同的是TGV孔徑通常較大且多為通孔,常規的電鍍填孔耗時長且成本高。此外,玻璃表面粗糙度很低,與線路材料(如銅)的結合力較差,容易發生分層、卷曲,甚至剝落。目前,TGV填孔常用的方法包括金屬實孔填充技術和孔內電鍍薄層技術兩種。金屬實孔填充技術可以采用先通過物理氣相沉積的方法在孔內沉積種子層,再電鍍填實。也可以采用金屬導電膠進行孔內填實。孔內電鍍薄層技術同樣需要先在孔內沉積金屬粘附層(如鈦、鉻),再進行電鍍。
TGV技術的應用
如今,隨著摩爾定律接近盡頭,2.5D/3D先進封裝已成主流,其中轉接板發揮著重要作用。目前,硅通孔技術(TSV)已相對比較成熟,在實際生產中也已經廣泛應用,但硅是一種半導體材料,在電場或磁場的作用下,其周圍的載流子可以自由移動,可能會對鄰近的電路或信號產生干擾,從而影響芯片的性能。
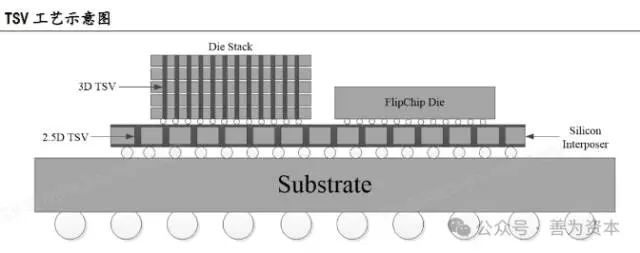
以TGV技術為基礎的玻璃基板因其具有比硅基板更為優良的材料及電學特性,應用前景更加廣泛。在電子封裝領域,基于玻璃基板的無源器件集成生產成本更低,翹曲可以控制在1mm以內;基于玻璃基板的射頻MEMS封裝器件具有低插入損耗和高返回損耗;基于多層玻璃堆疊基板的2.5D和3D封裝翹曲低于使用傳統有機基板,在實現高密度布線的同時具有更高的可靠性。此外,玻璃基板在光電領域也有廣泛的應用,如在玻璃基板上集成的光發電模塊,傳輸速度快且功耗低。
國內外TGV相關技術研究進展
國外以TGV技術為基礎的玻璃基板封裝產業鏈發展勢頭尤為迅速。此前,英特爾便宣布在用于下一代先進封裝的玻璃基板開發方面取得重大突破。此外,三星、AMD、蘋果、康寧等多家廠商也在布局玻璃基板相關的研發線或供應鏈,其中部分已處于量產階段。

國外玻璃基板研發/生產進度
國內TGV及其基板技術研發雖然起步較晚,但已有部分企業開始嶄露頭角。華天科技早在2020年就開始著眼于TGV技術的研發,現已掌握玻璃盲孔/通孔制備、孔內金屬化、頂部重布線等關鍵技術。科技創新是企業發展永恒的目標,自主研發更是發展的不竭動力。依托華天集團在晶圓級先進封裝行業多年的技術積累,未來,華天科技在發展硅基轉接板技術的同時也將大力發展TGV及其轉接板技術,助力我國先進封裝技術長足發展。
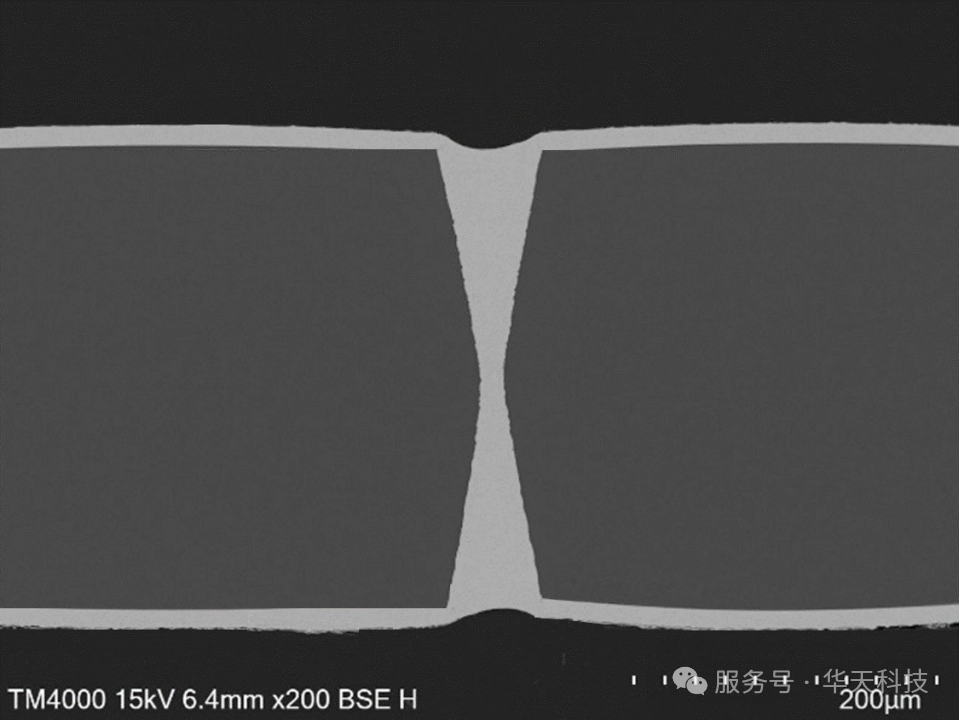
華天科技TGV掃描圖片
SEMI-e2025是覆蓋半導體全產業鏈的多維度科技盛會,涵蓋芯片及芯片設計、半導體設備、半導體材料、先進封裝、半導體核心零部件、寬禁帶半導體及功率器件等領域。其中先進封裝展區,集中展示倒裝芯片封裝、晶圓級封裝、2.5D封裝、3D封裝、凸塊封裝、扇出型晶圓級封裝等設計、材料、測試、設備,聚焦新型封裝技術在高性能計算、人工智能、汽車電子等前沿領域的應用,為半導體產業鏈聯動協同注入新的活力。
針對先進封裝技術與材料,以及玻璃通孔(TGV)工藝技術在先進封裝的應用及發展趨勢,SEMI-e 2025將同期舉辦先進封裝與材料高峰論壇及TGV技術論壇,圍繞先進封裝在芯片領域中的應用、最新一代TGV技術及應用等議題,聚焦當下熱點,破解產業難題。
-
玻璃基板
+關注
關注
1文章
96瀏覽量
10642 -
先進封裝
+關注
關注
2文章
445瀏覽量
467
原文標題:行業資訊 | 玻璃基板時代到來,TGV技術助力下一代先進封裝
文章出處:【微信號:Smart6500781,微信公眾號:SEMIEXPO半導體】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
芯和半導體將參加2025年玻璃基板TGV產業鏈高峰論壇
2025年TGV玻璃基板市場規模預計將達到1.7411億美元

玻璃通孔(TGV)技術原理、應用優勢及對芯片封裝未來走向的影響

韓國JNTC為三家芯片封裝企業供應新型TGV玻璃基板
京東方披露玻璃基板及先進封裝技術新進展
特種玻璃巨頭肖特發力半導體業務,新材料基板成為下一代芯片突破口
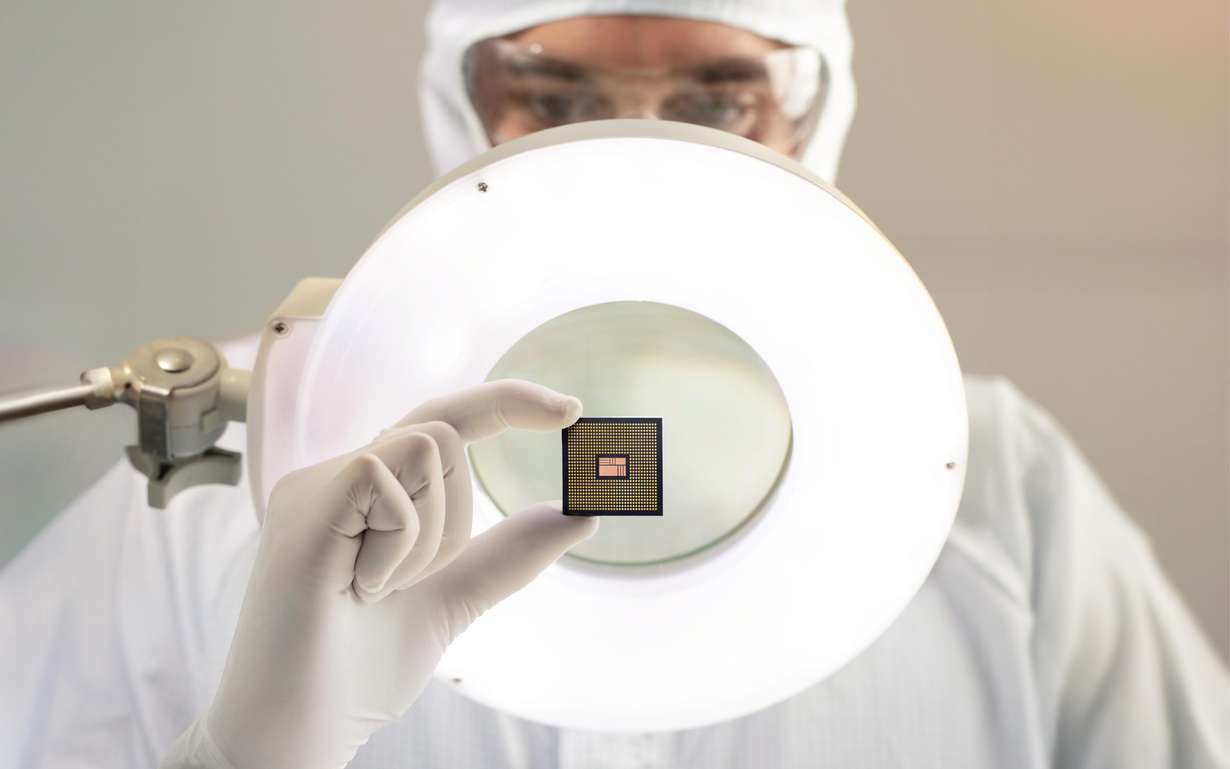







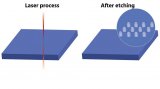













評論