聚焦離子束掃描電鏡雙束系統(FIB-SEM)作為一種前沿的微納加工與成像技術,憑借其強大的功能和多面性,在材料科學研究中占據著舉足輕重的地位。它能夠深入微觀世界,揭示材料內部的結構與特性,為材料科學的發展提供了強有力的支撐。
定點剖面形貌與成分分析
FIB-SEM系統具備精準的定點切割與分析能力,能夠深入材料內部,揭示其微觀結構與成分。以CdS微米線為例,光學顯微鏡雖能觀察到微米線節點處可能存在其他物質,但無法確定其具體成分與內部形貌。而FIB-SEM技術則可在此節點進行定點切割,制備截面樣品,并通過掃描電鏡成像與能量色散譜(EDS)mapping,直觀呈現內部含有Sn球的結構。這種分析方法為材料微觀結構研究開辟了新的視角,使研究人員能夠更深入地理解材料的內在特性。
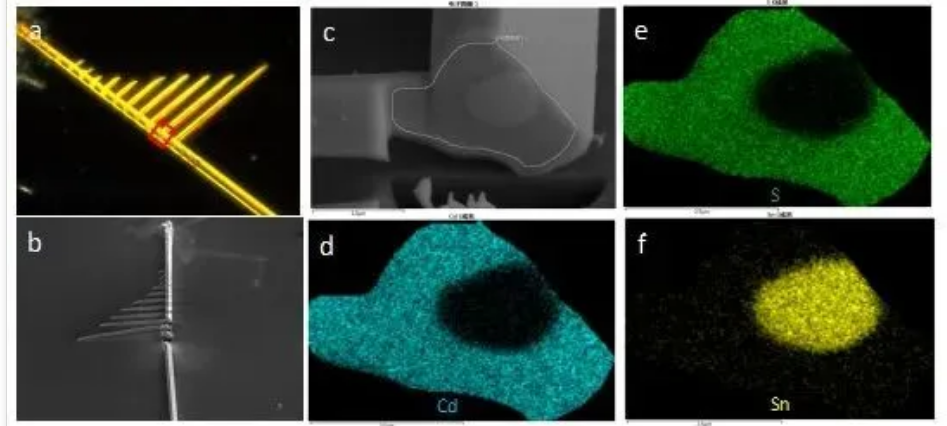
TEM樣品制備
透射電子顯微鏡(TEM)是材料研究中常用的高分辨率成像工具,而FIB-SEM系統在制備TEM樣品方面具有獨特優勢。為了方便大家對材料進行深入的失效分析及研究,以MoS?場效應管的研究為例,FIB-SEM技術可精準制備截面透射樣品,使研究人員在TEM下清晰觀察到MoS?的層數以及Ag納米線與MoS?之間的間距,為深入研究材料的微觀結構與性能提供了有力支持。

微納加工
FIB - SEM 系統在微納加工領域展現出卓越的性能,這些圖形包括光柵、切侖科夫輻射源針尖、三維對稱結構等,廣泛應用于光學、電子學和材料科學等領域。
例如,在Au/SiO?上制備的光柵,其周期和開口尺寸均達到納米級別,充分展示了FIB-SEM在微納加工方面的高精度與高分辨率。這種高精度的微納加工能力為新材料的研發與應用提供了廣闊的空間。

切片式三維重構
FIB-SEM系統能夠實現材料的切片式形貌與成分三維重構,為研究材料內部結構提供了新的維度。通過切下一定厚度的試樣進行SEM拍照,反復操作數百次拍攝切片圖片,再進行三維形貌重建,即可清晰呈現材料內部的三維結構。
材料轉移
FIB-SEM系統配備的納米機械手和離子束沉積技術,使得微米級別的材料轉移成為可能。通過精確的定位與固定,可將材料從一個襯底轉移到另一個指定位置。例如,將氧化鋅微米線從硅片轉移到兩電極溝道間,可制得專用器件。這種材料轉移技術在微電子器件的制備與研究中具有重要意義,為微納器件的創新與開發提供了新的途徑。

未來發展
FIB-SEM雙束系統憑借其獨特的微納加工與成像能力,在材料研究領域展現出巨大的潛力與價值。從定點剖面形貌與成分分析到TEM樣品制備、微納加工、切片式三維重構以及材料轉移,FIB-SEM技術的應用范圍廣泛,為材料科學家提供了強大的工具。隨著技術的不斷發展與創新,FIB-SEM系統將在更多領域發揮重要作用,助力材料科學的進一步發展。
-
fib
+關注
關注
1文章
74瀏覽量
11223 -
離子束
+關注
關注
0文章
70瀏覽量
7572 -
掃描電鏡
+關注
關注
0文章
101瀏覽量
9119
發布評論請先 登錄
相關推薦
聚焦離子束一電子束(FIB-SEM)雙束系統原理

聚焦離子束掃描電鏡(FIB-SEM)技術原理、樣品制備要點及常見問題解答







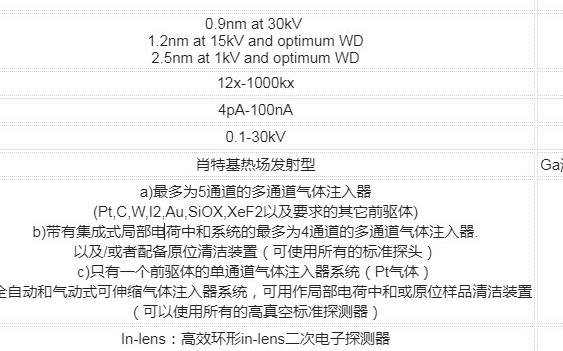


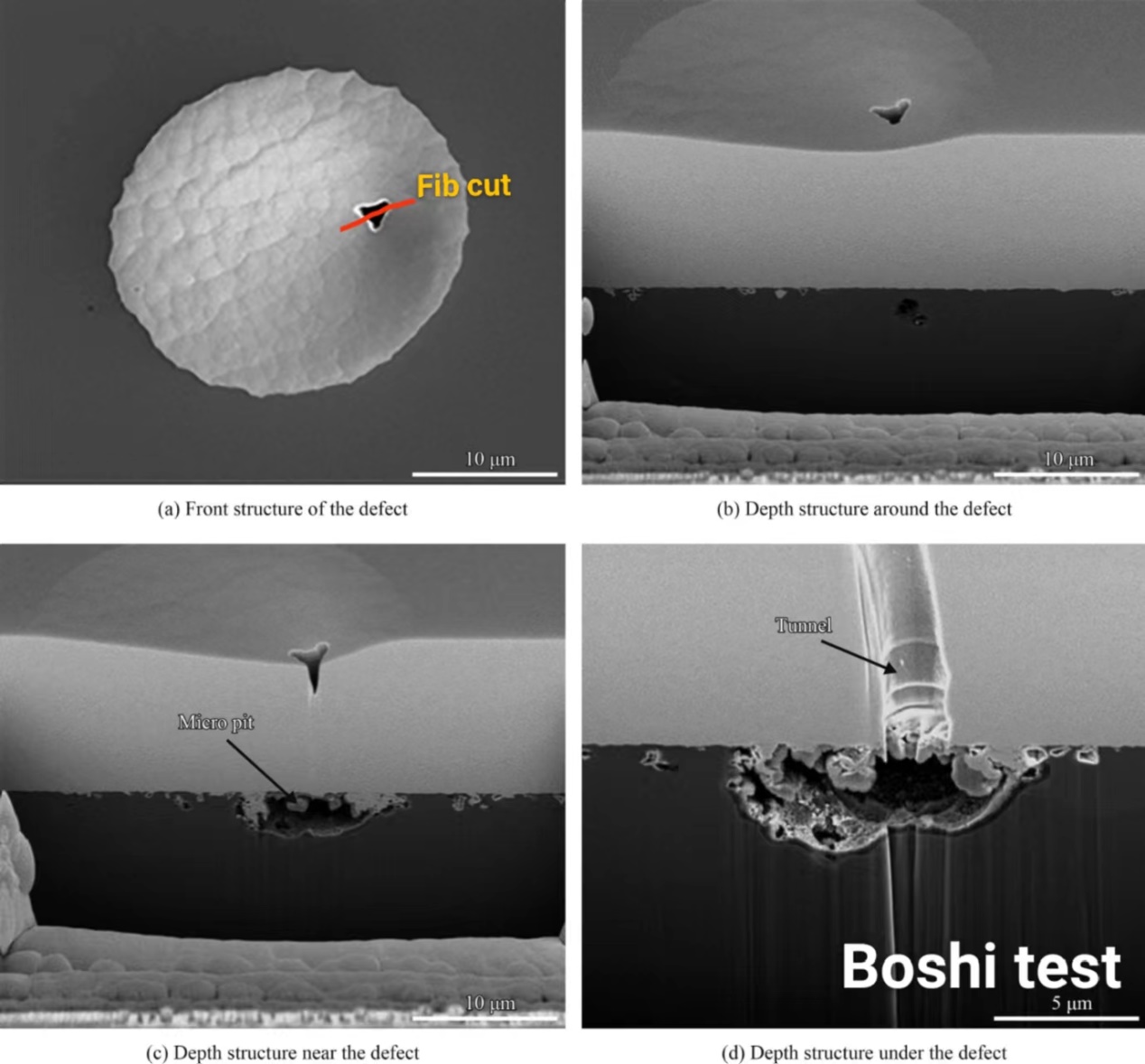
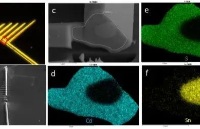
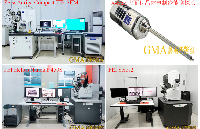
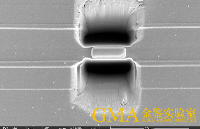
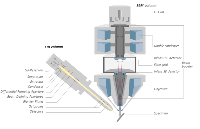












評論