華林科納半導(dǎo)體高選擇性蝕刻是指在半導(dǎo)體制造等精密加工中,通過化學(xué)或物理手段實現(xiàn)目標(biāo)材料與非目標(biāo)材料刻蝕速率的顯著差異,從而精準(zhǔn)去除指定材料并保護(hù)其他結(jié)構(gòu)的工藝技術(shù)?。其核心在于通過工藝優(yōu)化控制不同材料的刻蝕速率比,達(dá)到?>5:1?甚至更高的選擇比標(biāo)準(zhǔn)?。
一、核心價值與定義
l?精準(zhǔn)材料去除?
高選擇性蝕刻通過調(diào)整反應(yīng)條件,使目標(biāo)材料(如多晶硅、氮化硅)的刻蝕速率遠(yuǎn)高于掩膜或底層材料(如氧化硅、光刻膠),實現(xiàn)納米級結(jié)構(gòu)的精確成型?。
l?保護(hù)關(guān)鍵結(jié)構(gòu)?
在多層材料體系(如光刻膠/薄膜/襯底)中,高選擇性可避免非目標(biāo)層被意外刻蝕,防止器件性能受損?。
二、實現(xiàn)方法
l?氣體化學(xué)調(diào)控?
使用?CHF?/O?混合氣體?進(jìn)行干法蝕刻,通過氧氣增加氧化硅的刻蝕選擇性?;
在氮化硅刻蝕中采用?Cl?/HBr/O?混合氣體?,實現(xiàn)氮化硅與氧化硅的高選擇比?。
l?工藝參數(shù)優(yōu)化?
調(diào)整射頻功率、腔室壓力和溫度等參數(shù),平衡物理轟擊與化學(xué)反應(yīng)。例如,降低功率可減少物理濺射,增強(qiáng)化學(xué)選擇性?。
l?自由基選擇性反應(yīng)?
利用等離子體產(chǎn)生的自由基與特定材料發(fā)生化學(xué)反應(yīng),例如自由基優(yōu)先與氮化硅反應(yīng)生成揮發(fā)性產(chǎn)物,而對氧化硅幾乎無影響。
三、典型應(yīng)用場景
l?先進(jìn)邏輯器件?
?環(huán)柵晶體管(GAA)?制造中,需對各向同性蝕刻提出更高選擇性要求,以形成納米線或納米片結(jié)構(gòu)?;
?柵極刻蝕?需保證多晶硅對光刻膠的高選擇性,防止掩膜過早損耗?。
l?存儲器件制造?
在?3D NAND?和?3D DRAM?中,高選擇性蝕刻用于垂直孔洞或溝槽的成型,避免損傷多層堆疊結(jié)構(gòu)?。
l?MEMS與光學(xué)器件?
通過選擇性去除犧牲層(如氧化硅),釋放微機(jī)械結(jié)構(gòu)或制備光學(xué)波導(dǎo)?6。
四、影響因素
l?材料特性?
化學(xué)鍵能(如Si-N鍵比Si-O鍵更易被特定氣體刻蝕)、抗蝕性(如金屬掩膜比光刻膠更耐蝕)直接影響固有選擇比?。
l?工藝條件?
氣體類型與比例(如氟碳?xì)怏w增強(qiáng)化學(xué)刻蝕,惰性氣體提高物理濺射)?;
物理與化學(xué)作用的平衡:過度依賴物理濺射會降低選擇性?。
五、挑戰(zhàn)與趨勢
l?技術(shù)瓶頸?
現(xiàn)有蝕刻工具在?2nm以下節(jié)點(diǎn)?面臨選擇性不足的問題,需開發(fā)新型氣體化學(xué)(如原子層蝕刻)和腔室設(shè)計?。
l?材料創(chuàng)新?
引入新型掩膜材料(如金屬硬掩膜)或低損傷蝕刻氣體,進(jìn)一步提升選擇比。
審核編輯 黃宇
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28029瀏覽量
225626 -
刻蝕
+關(guān)注
關(guān)注
2文章
193瀏覽量
13236
發(fā)布評論請先 登錄
相關(guān)推薦
選擇性激光蝕刻中蝕刻劑對玻璃通孔錐角和選擇性有什么影響

芯片濕法蝕刻工藝
選擇高容電容的關(guān)鍵因素

SiGe與Si選擇性刻蝕技術(shù)
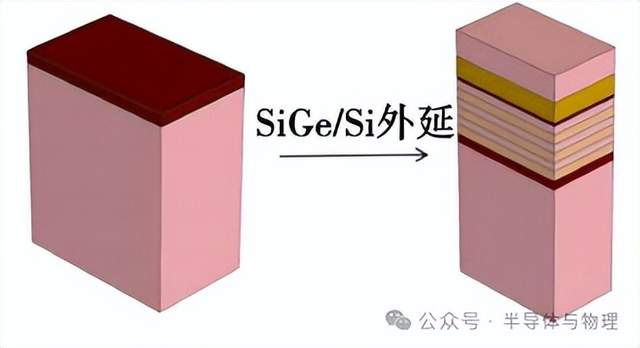
選擇性沉積技術(shù)介紹
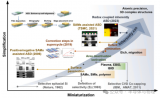
礦井電網(wǎng)選擇性絕緣在線監(jiān)測
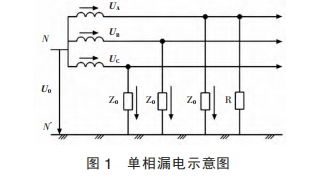
過電流保護(hù)的選擇性是靠什么來實現(xiàn)的
選擇性喚醒如何實現(xiàn)局部聯(lián)網(wǎng)

簡化ECU中具有選擇性喚醒功能的隔離式CAN設(shè)計

交流二元繼電器如何具有相位選擇性和頻率選擇性
在smt貼片加工廠中選擇性波峰焊存在的作用和意義
利用貝塞爾光束、超短雙脈沖激光和選擇性化學(xué)蝕刻研究玻璃通孔(TGV)
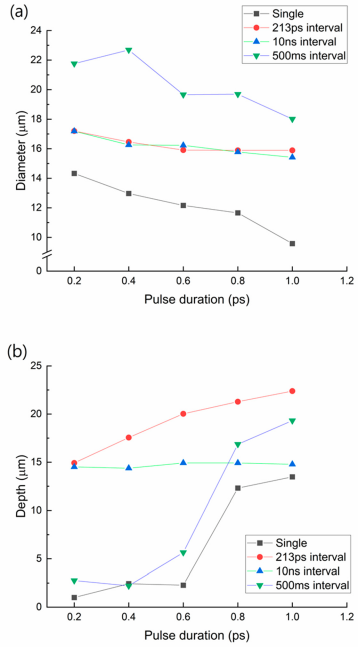
通信——通過表面電荷操縱控制鍺的蝕刻

淺談礦井電網(wǎng)選擇性絕緣在線監(jiān)測技術(shù)研究
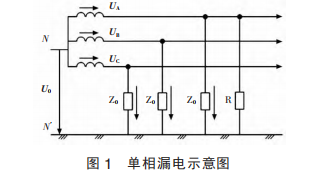

















評論