氮化鋁(AlN)具有優良的物理化學特性以及與標準CMOS晶硅技術的兼容性,且在多方面性能上優于氧化鋅(ZnO)和鋯鈦酸鉛(PZT),因此成為最受關注的壓電材料之一。AlN壓電薄膜表現出合適的機電耦合系數、高縱波聲速、大楊氏模量和高熱導率等特點,隨著制備工藝和材料微結構調控技術的快速發展,使其成為5G時代聲波諧振器中的關鍵電子材料。
AlN壓電薄膜的成膜質量直接決定器件的工作頻率、Q值和可靠性。制備AlN薄膜的方法很多,包括磁控濺射、脈沖激光沉積、分子束外延、化學氣相沉積等。近些年來,人們在磁控濺射法制備AlN薄膜及其微結構調控方面取得重要進展,該制備方法具有成膜質量好、沉積速率高以及成本低等優點,已成為這類薄膜的首選制備方法。AlN薄膜定向生長受濺射功率、工作氣壓和N2/Ar流量比等多重因素影響,因此提高薄膜取向性相對復雜。降低薄膜應力一般通過簡單地調節Ar氣流量來實現,這是因為薄膜應力對Ar氣流量變化極為敏感。而表面粗糙度和膜厚均勻性等主要受到濺射功率和工作氣壓影響。除了反應磁控濺射基本參數外,基底放置方向、基底材料、基底清潔度、退火溫度和氣氛等對薄膜的結晶及擇優取向的影響也十分顯著。
據麥姆斯咨詢報道,多年來,國內外學者在AlN壓電薄膜的新工藝開發、設備優化、器件應用和性能檢測等方面開展了大量的研究,針對相關研究內容,湖北工業大學芯片產業學院馬國新教授等研究人員進行了綜述分析,在《材料導報》期刊發表了題為“適用聲波諧振器的磁控濺射制備AIN薄膜優化技術”的綜述文章,圍繞影響AlN壓電薄膜在聲波諧振器應用的主要物理指標進行了說明,并系統分析了反應磁控濺射法中的濺射功率、氣體分壓、基底溫度等關鍵工藝參數對其影響的規律;最后,對AlN薄膜研究中亟待解決的問題以及未來發展方向進行了展望。
AlN薄膜質量的提升
為了有效提高聲波諧振器的機電耦合系數和品質因數等,當前除了對AlN薄膜進行摻雜改性之外,通過濺射功率、氣體分壓等關鍵工藝參數優化,可以獲得高c軸結晶取向性、小薄膜應力、低表面粗糙度等物理性能的壓電薄膜。圖1顯示了其腔內的反應濺射生成AlN薄膜的過程(以工作氣體Ar氣為例)。可以看出,腔內磁場分布對反應濺射過程有重要影響。
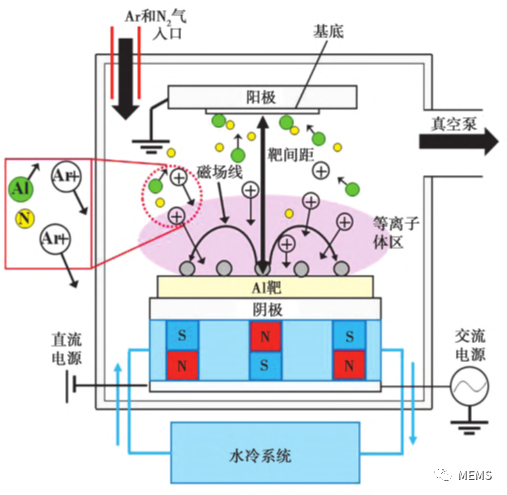
圖1 腔內的反應濺射生成AlN薄膜的一般過程
大量的研究數據表明,控制通入的氣體流量是實現AlN晶面擇優取向的又一種有效途徑。除了反應磁控濺射基本參數外,研究人員還發現基底放置方向、基底材料種類、基底清潔度、退火溫度和氣氛等對薄膜的結晶及擇優取向的影響也十分顯著。例如,Kamohara等人在硅基底上引入了一層AlN的種子層,可以提高鉬(Mo)電極的成膜質量,從而改善了AlN(002)柱狀晶的形貌,如圖2所示。
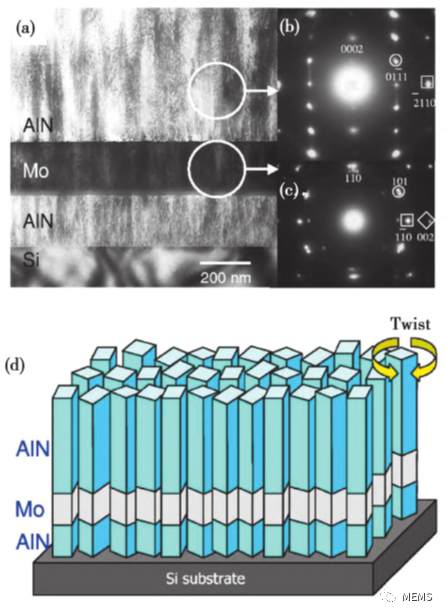
圖2 (a)沉積在Mo/AlN/Si基底上的AlN薄膜TEM圖;(b)選擇AlN薄膜區域的電子衍射圖樣;(c)選擇Mo薄膜區域的電子衍射圖樣;(d)AlN/Mo/AlN的纖維織構原理
薄膜應力是制備薄膜過程中普遍存在的現象,其大小不僅會影響薄膜附著力和力學性能,而且直接決定了聲波諧振器的加工性,以及影響器件的機電耦合系數kt2。較小的薄膜應力有利于提高器件的良率、穩定性和可靠性。因此,在保證AlN薄膜具有較好壓電性能的同時,還需要盡量減小薄膜的應力,提高器件加工性和可靠性。例如,杜波克等人研究了Ar氣流量變化對Sc0.2AI0.8N薄膜應力的影響,其薄膜應力很容易控制在± 200 MPa以內,可以滿足器件的高一致性要求。
壓電薄膜的厚度直接決定器件的工作頻率。降低壓電薄膜的表面粗糙度和提高厚度均勻性是獲得高質量薄膜的重要途徑。影響薄膜表面粗糙度的因素很多,包括濺射功率、工作氣壓、襯底溫度以及后處理工藝等。例如,Iriarte等人測量了Si(111)基底上生長的AlN薄膜表面粗糙度,發現電鏡探針的掃描面積越大,粗糙度就越大,甚至產生數倍的誤差。測量精度的提升和測量方式的標準化仍然是未來需要重點關注的問題。
AlN薄膜沉積速率的控制
在聲波諧振器產線上,對于工程師而言,提高薄膜的沉積速率是大規模制備薄膜過程中需要重點考慮的一個因素。在保證薄膜結晶質量的前提下,較大的沉積速率可以提高生產效率,降低生產成本。
目前國內磁控濺射法制備AlN薄膜的性能指標與國外并沒有明顯的差距,只是在薄膜后加工以及應用層面上還存在不足。此外,由于工藝條件、厚度和測量方法的不同,壓電系數的測量值也有所不同。目前采用的方法包括電容量法和干涉儀法。一般而言,壓電系數的有效測量值會隨著薄膜厚度的增加而增加。對于電容法,由于電極與壓電薄膜之間產生了界面電容,導致其測量值明顯偏大。而采用干涉儀法獲得的薄膜壓電系數在3.00 ~ 5.15 pm/v,相對可靠。
研究展望
由于知識產權保護完成度不充分帶來的技術機會,以及5G新頻段大幅增加帶來的商業機會,薄膜體聲波諧振器(FBAR)成為各方爭奪的重點。當前,面向5G應用的C波段FBAR技術逐漸成熟,達到量產條件,然而對于未來更高頻率的X波段FBAR開發(8 ~ 12 GHz),還處于研發的初期階段。這是因為X波段FBAR需要更薄的薄膜、更好的壓電性能和更高的質量(薄膜應力更小、取向性更好、表面更光滑等)。這勢必導致薄膜的制備和光刻工藝要求更高,提升FBAR良品率更為困難。磁控濺射法比其他的薄膜沉積方法所需的沉積溫度要低,薄膜的沉積速率適中,可以有效控制AlN薄膜的質量等,使其成為產業界大面積薄膜制備和改性的主要手段之一。
目前FBAR中的AlN基壓電薄膜更多采用磁控濺射等低成本工藝,面對FBAR高頻化和集成化的發展趨勢,AlN壓電薄膜的研究進展并不能完全適應未來發展的需要。針對上述問題,后續可以開展三個方面的工作:
(1)克服AlN等薄膜向更薄方向發展所帶來的取向性和表面平整性等問題,可以從離子到達基底動能以及在基底表面運動的生長過程出發,建立薄膜表面/界面結構的物理模型,采用分子動力學或第一性原理方法深入研究微結構與性能之間的關系,為實驗研究提供理論依據。
(2)基于AlN薄膜制備的成熟工藝,對其進行摻雜改性,提高壓電性能,滿足更高頻應用場景的需要。對AlN薄膜進行高濃度的Sc或者Er摻雜等,提高其壓電系數及聲波諧振器的機電耦合系數。但是薄膜的結晶性能仍然較差,由此制作的FBAR可靠性仍然有待提升。此外,高濃度Sc或者Er摻雜的微觀機理,目前尚存在爭論,有待后期深入研究。
(3)深入開展AlN薄膜的表征技術研究。從目前的文獻來看,涉及AlN薄膜的表征技術很多,包括XRD、SEM、AFM、XPS、膜厚儀、應力測試儀和壓反應力顯微鏡等,但是對測量結果可靠性的探討卻很少。進一步加強AlN薄膜的表征技術研究,可以促進薄膜制備工藝技術的發展,對獲得高質量AlN薄膜具有重要意義。總體而言,除通過控制濺射功率、氮分壓和基底溫度等磁控濺射工藝參數外,還需要從理論仿真、材料改性和表征技術等方向上進一步推進壓電薄膜制備工藝的發展,滿足后5G時代通信技術的需要。
審核編輯:劉清
-
耦合器
+關注
關注
8文章
731瀏覽量
60235 -
SEM
+關注
關注
0文章
253瀏覽量
14658 -
CMOS技術
+關注
關注
0文章
68瀏覽量
10410 -
壓電薄膜傳感器
+關注
關注
4文章
17瀏覽量
3597 -
聲波諧振器
+關注
關注
0文章
4瀏覽量
2789
原文標題:適用聲波諧振器的磁控濺射制備AIN薄膜優化技術
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
濺射薄膜性能的表征與優化
磁控濺射鍍膜工藝參數對薄膜有什么影響
深圳鴻合智遠 DT-38,DT-381/DT-26,DT-261:音叉型晶體諧振器與kHz帶晶體諧振器
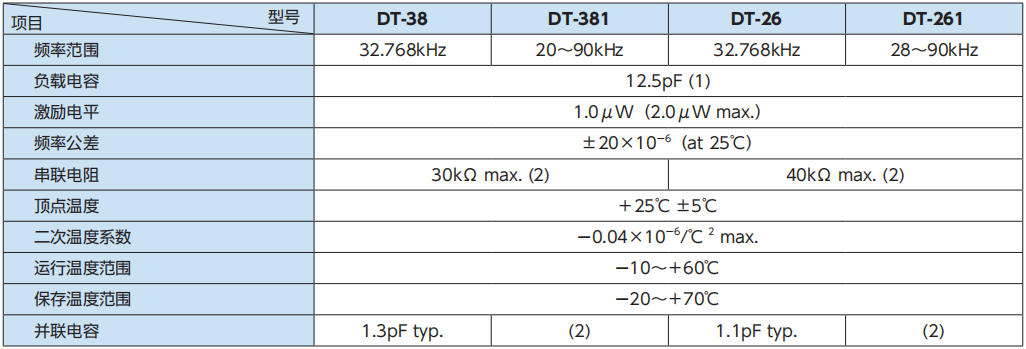







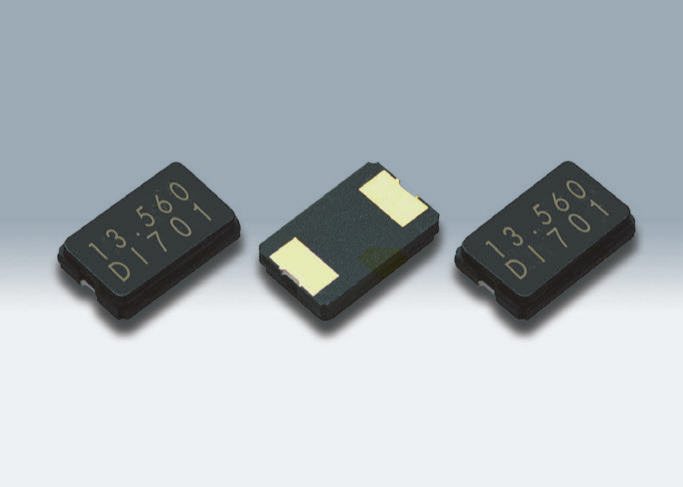
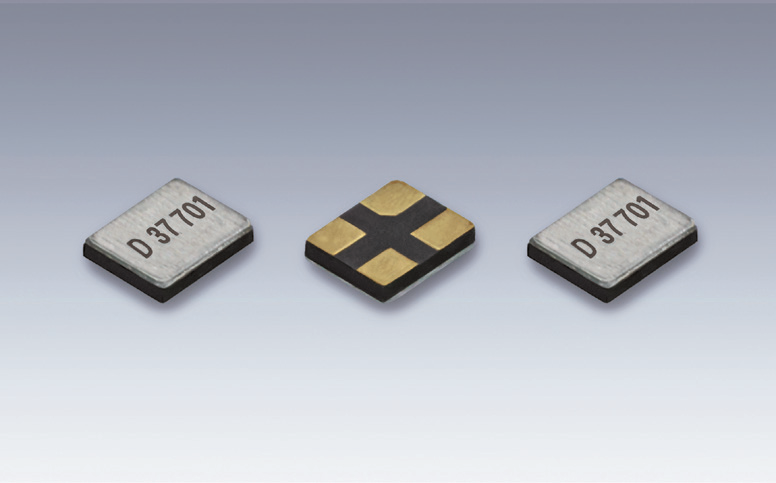
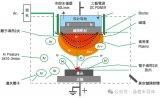

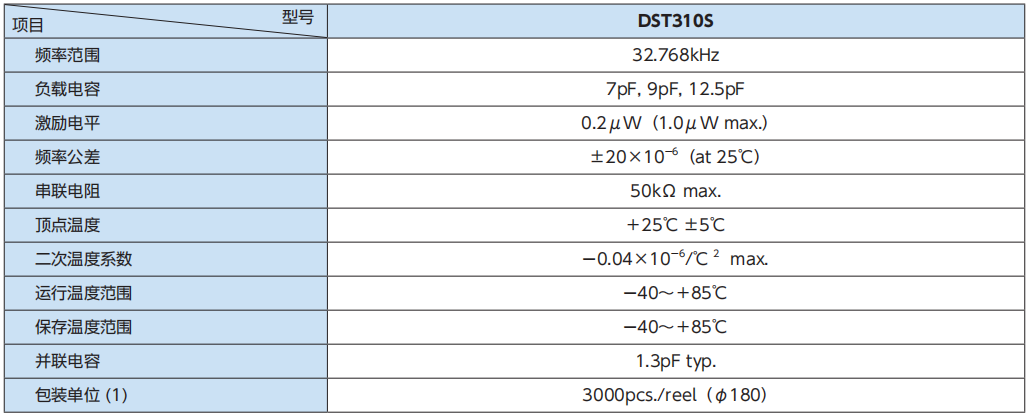
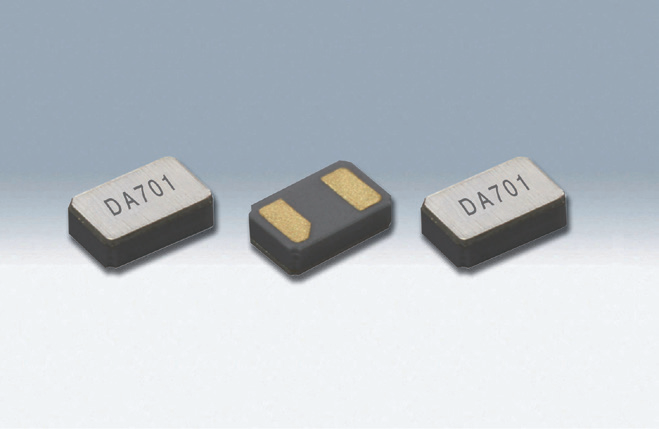
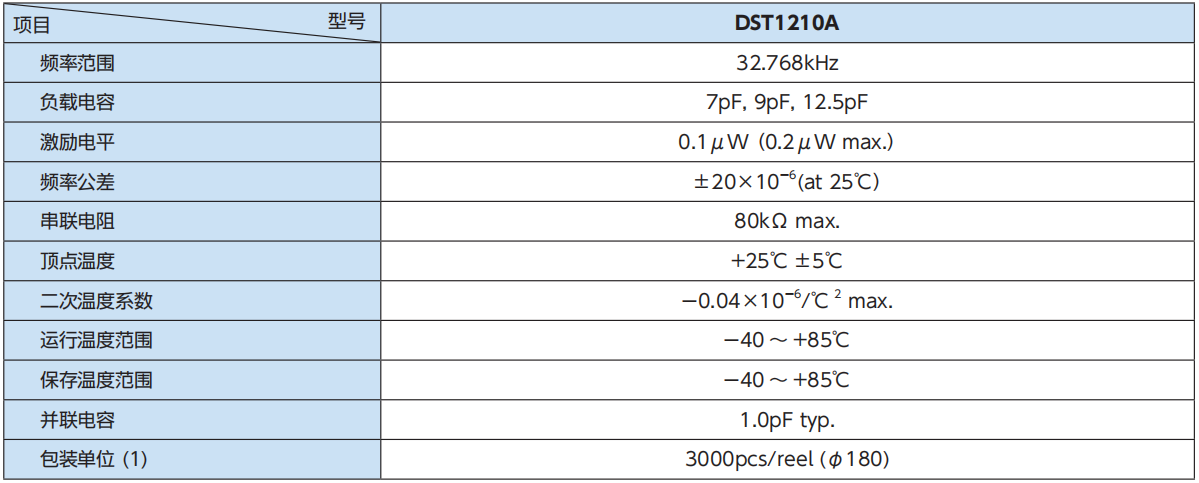
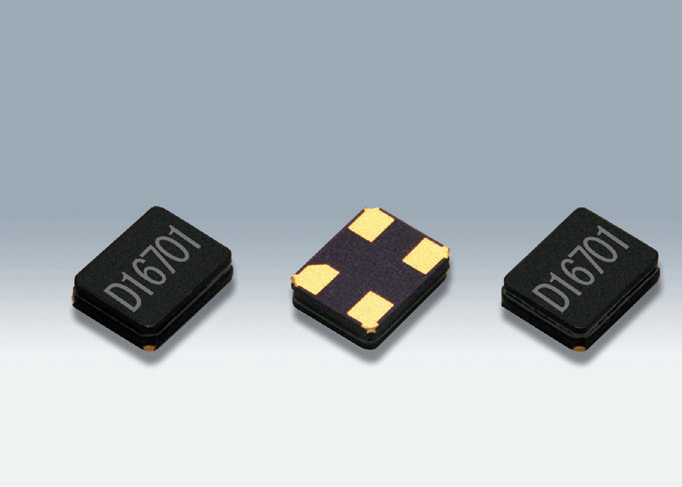
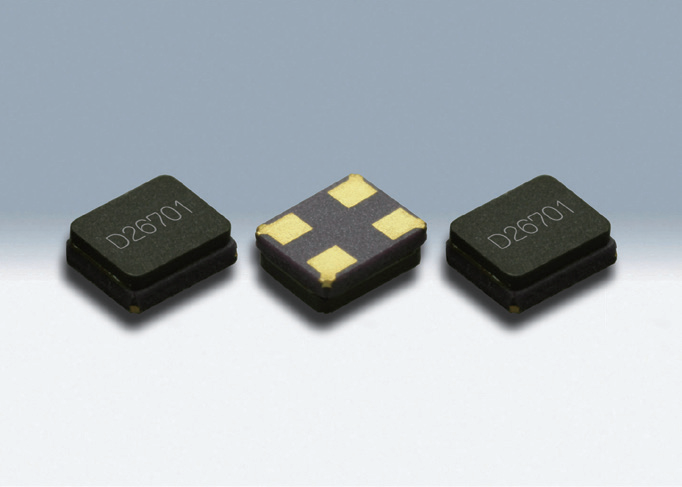
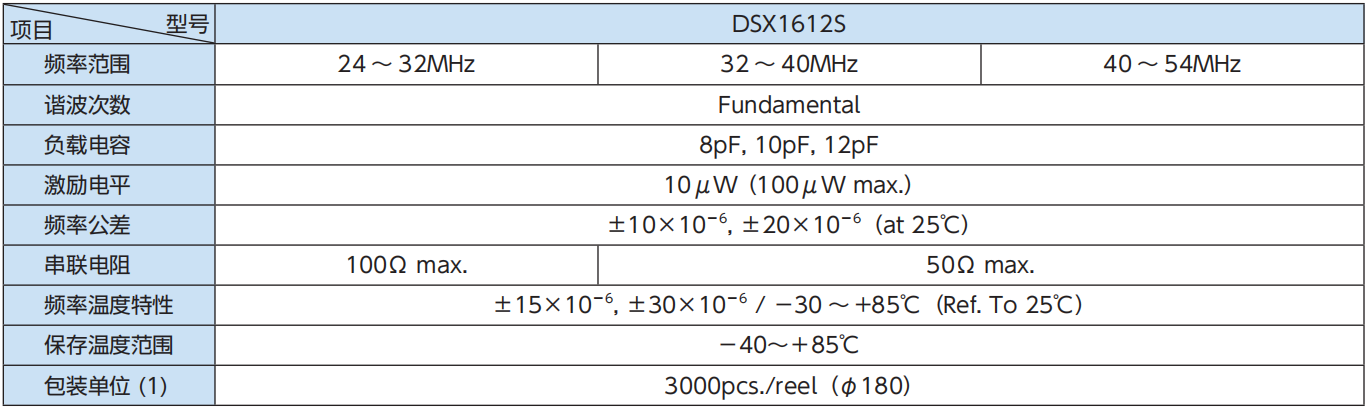
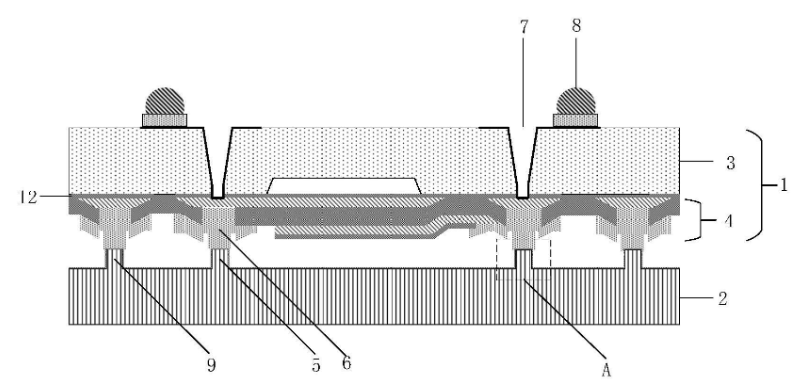











評論