LED正裝芯片
正裝結(jié)構(gòu),上面通常涂敷一層環(huán)氧樹脂,下面采用藍寶石為襯底,電極在上方,從上至下材料為:P-GaN、發(fā)光層、N-GaN、襯底。
正裝結(jié)構(gòu)有源區(qū)發(fā)出的光經(jīng)由P型GaN區(qū)和透明電極出射,采用的方法是在P型GaN上制備金屬透明電極,使電流穩(wěn)定擴散,達到均勻發(fā)光的目的。
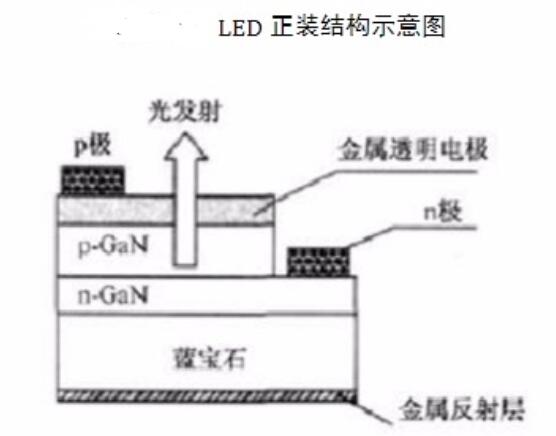
LED倒裝芯片
倒裝芯片(filp chip)技術(shù),是在芯片的P極和N極下方用金線焊線機制作兩個金絲球焊點,作為電極的引出機構(gòu),用金線來連接芯片外側(cè)和Si底板。LED芯片通過凸點倒裝連接到硅基上。這樣大功率LED產(chǎn)生的熱量不必經(jīng)由芯片的藍寶石襯底,而是直接傳到熱導(dǎo)率更高的硅或陶瓷襯底,再傳到金屬底座。
制作方式:制備具有適合共晶焊接的大尺寸LED芯片,同時制備相應(yīng)尺寸的硅底板,并在其上制作共晶焊接電極的金導(dǎo)電層和引出導(dǎo)電層(超聲波金絲球焊點)。然后,利用共晶焊接設(shè)備將大尺寸LED芯片與硅底板焊在一起。
LED正裝與倒裝區(qū)別
(1)固晶:正裝小芯片采取在直插式支架反射杯內(nèi)點上絕緣導(dǎo)熱膠來固定芯片,而倒裝芯片多采用導(dǎo)熱系數(shù)更高的銀膠或共晶的工藝與支架基座相連,且本身支架基座通常為導(dǎo)熱系數(shù)較高的銅材;
(2)焊線:正裝小芯片通常封裝后驅(qū)動電流較小且發(fā)熱量也相對較小,因此采用正負電極各自焊接一根φ0.8~φ0.9mil金線與支架正負極相連即可;而倒裝功率芯片驅(qū)動電流一般在350mA以上,芯片尺寸較大,因此為了保證電流注入芯片過程中的均勻性及穩(wěn)定性,通常在芯片正負級與支架正負極間各自焊接兩根φ1.0~φ1.25mil的金線;
(3)熒光粉選擇:正裝小芯片一般驅(qū)動電流在20mA左右,而倒裝功率芯片一般在350mA左右,因此二者在使用過程中各自的發(fā)熱量相差甚大,而現(xiàn)在市場通用的熒光粉主要為YAG, YAG自身耐高溫為127℃左右,而芯片點亮后,結(jié)溫(Tj)會遠遠高于此溫度,因此在散熱處理不好的情況下,熒光粉長時間老化衰減嚴重,因此在倒裝芯片封裝過程中建議使用耐高溫性能更好的硅酸鹽熒光粉;
(4)膠體的選擇:正裝小芯片發(fā)熱量較小,因此傳統(tǒng)的環(huán)氧樹脂就可以滿足封裝的需要;而倒裝功率芯片發(fā)熱量較大,需要采用硅膠來進行封裝;硅膠的選擇過程中為了匹配藍寶石襯底的折射率,建議選擇折射率較高的硅膠(》1.51),防止折射率較低導(dǎo)致全反射臨界角增大而使大部分的光在封裝膠體內(nèi)部被全反射而損失掉;同時,硅膠彈性較大,與環(huán)氧樹脂相比熱應(yīng)力比環(huán)氧樹脂小很多,在使用過程中可以對芯片及金線起到良好的保護作用,有利于提高整個產(chǎn)品的可靠性;
(5)點膠:正裝小芯片的封裝通常采用傳統(tǒng)的點滿整個反射杯覆蓋芯片的方式來封裝,而倒裝功率芯片封裝過程中,由于多采用平頭支架,因此為了保證整個熒光粉涂敷的均勻性提高出光率而建議采用保型封裝(Conformal-Coating)的工藝;
(6)灌膠成型:正裝芯片通常采用在模粒中先灌滿環(huán)氧樹脂然后將支架插入高溫固化的方式;而倒裝功率芯片則需要采用從透鏡其中一個進氣孔中慢慢灌入硅膠的方式來填充,填充的過程中應(yīng)提高操作避免烘烤后出現(xiàn)氣泡和裂紋、分層等現(xiàn)象影響成品率;
(7)散熱設(shè)計:正裝小芯片通常無額外的散熱設(shè)計;而倒裝功率芯片通常需要在支架下加散熱基板,特殊情況下在散熱基板后添加風(fēng)扇等方式來散熱;在焊接支架到鋁基板的過程中 建議使用功率《30W的恒溫電烙鐵溫度低于230℃,停留時間《3S來焊接;
-
led
+關(guān)注
關(guān)注
242文章
23480瀏覽量
665791 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
94瀏覽量
16386
發(fā)布評論請先 登錄
相關(guān)推薦
對決:正裝芯片與倒裝芯片,哪種更勝一籌?



倒裝芯片應(yīng)用的設(shè)計規(guī)則
倒裝COB顯示屏
倒裝全面取代正裝可能不太現(xiàn)實
正裝、倒裝、垂直LED芯片結(jié)構(gòu)的介紹及LED倒裝芯片的優(yōu)點
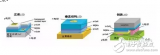
支架式倒裝的定義及其與FEMC之間的關(guān)系介紹
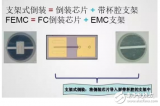
LED倒裝芯片的水基清洗劑工藝介紹
什么是LED倒裝芯片?LED倒裝芯片制備流程
LED芯片封裝大揭秘:正裝、垂直、倒裝,哪種更強?





 led倒裝芯片和正裝芯片差別
led倒裝芯片和正裝芯片差別
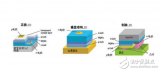
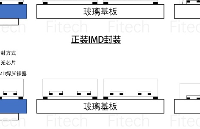











評論