前言
在功率元器件的發(fā)展中,主要半導(dǎo)體材料當(dāng)然還是Si。同樣在以Si為主體的LSI世界里,在“將基本元件晶體管的尺寸縮小到1/k,同時(shí)將電壓也降低到1/k,力爭(zhēng)更低功耗”的指導(dǎo)原理下,隨著微細(xì)加工技術(shù)的發(fā)展,實(shí)現(xiàn)了開(kāi)關(guān)更加高速、大規(guī)模集成化。在功率元器件領(lǐng)域中,微細(xì)加工技術(shù)的導(dǎo)入滯后數(shù)年,需要確保工作電壓的極限(耐壓)并改善模擬性能。但是,通過(guò)微細(xì)化可以改善的性能僅限于100V以下的低耐壓范圍,在需要更高耐壓的領(lǐng)域僅采用微細(xì)加工無(wú)法改善性能,因此,就需要在結(jié)構(gòu)上下工夫。21世紀(jì)初,超級(jí)結(jié)(SJ)-MOSFET注1進(jìn)入實(shí)用階段,實(shí)現(xiàn)了超過(guò)MOSFET性能極限的性能改善。
然而,重要的特性——低導(dǎo)通電阻、柵極電荷量與耐壓在本質(zhì)上存在權(quán)衡取舍的關(guān)系。在功率元器件中有成為單元的晶體管,將多個(gè)單元晶體管并聯(lián)可獲得低導(dǎo)通電阻。但這種做法需要同時(shí)并聯(lián)寄生于晶體管的電容,導(dǎo)致柵極電荷量上升。為了避免柵極電荷上升而進(jìn)行微細(xì)化即將1個(gè)單元變小的話,耐壓能力又會(huì)下降。
作為解決這個(gè)問(wèn)題的手法,除了像SJ-MOSFET一樣通過(guò)結(jié)構(gòu)改善來(lái)提高性能,還通過(guò)變更材料來(lái)提高性能,就是使用了碳化硅(SiC) 注2和GaN注3這類(lèi)寬禁帶(WBG)半導(dǎo)體注4的功率元器件。WBG材料的最大特點(diǎn)如表1所示,其絕緣擊穿電場(chǎng)強(qiáng)度較高。只要利用這個(gè)性質(zhì),就可提高與Si元件相同結(jié)構(gòu)時(shí)的耐壓性能。只要實(shí)現(xiàn)有耐壓余量的結(jié)構(gòu),將這部分單元縮小、提高集成度,就可降低導(dǎo)通電阻。
本稿中將具體解說(shuō)羅姆在“SiC”與“GaN”功率元器件領(lǐng)域的探索與發(fā)展。
羅姆在“SiC”功率元器件領(lǐng)域的飛躍發(fā)展
SiC(碳化硅)功率元器件是以碳和硅的化合物——碳化硅作為原材料制作而成。與以往的硅材料功率元器件相比,具有低導(dǎo)通電阻、高速開(kāi)關(guān)、高溫作業(yè)的特點(diǎn),所以許多研究機(jī)構(gòu)和廠商將其視為新一代功率元器件,一直致力于對(duì)它的研發(fā)。由于其出色的性能,一直以“理想器件”備受期待的SiC功率器件近年來(lái)已得以問(wèn)世。羅姆已批量生產(chǎn)SiC二極管和SiC-MOSFET,并于2012年3月開(kāi)始批量生產(chǎn)內(nèi)置上述兩種元器件的功率模塊。
①SiC-SBD(碳化硅肖特基勢(shì)壘二極管):性能提升的第二代產(chǎn)品陸續(xù)登場(chǎng)
SiC‐SBD于2001年首次在世界上批量生產(chǎn)以來(lái),已經(jīng)過(guò)去10多年。羅姆從2010年開(kāi)始在日本國(guó)內(nèi)廠商中首次批量生產(chǎn)SiC-SBD,并且已經(jīng)在各種機(jī)器中得到采用。與以往的Si-FRD(快速恢復(fù)二極管)相比,SiC-SBD可以大幅縮短反向恢復(fù)時(shí)間,因此恢復(fù)損耗可以降低至原來(lái)的三分之一。充分利用這些特性,在各種電源的PFC電路(連續(xù)模式PFC)和太陽(yáng)能發(fā)電的功率調(diào)節(jié)器中不斷得到應(yīng)用。
另外,羅姆備有耐壓600V、1200V的SiC-SBD產(chǎn)品線。并且將相繼銷(xiāo)售性能升級(jí)的第二代SiC-SBD。第二代SiC-SBD與以往產(chǎn)品相比,具有原來(lái)的短反向恢復(fù)時(shí)間的同時(shí),降低了正向電壓。通常降低正向電壓,則反向漏電流也隨之增加。羅姆通過(guò)改善工藝和元器件結(jié)構(gòu),保持低漏電流的同時(shí),成功降低了正向電壓。正向上升電壓也降低了0.1~0.15V,因此尤其在低負(fù)載狀態(tài)下長(zhǎng)時(shí)間工作的機(jī)器中效率有望得到提高。
②SiC-MOSFET:有助于機(jī)器節(jié)能化、周邊零部件小型化發(fā)展
相對(duì)于不斷搭載到各種機(jī)器上的SiC-SBD,SiC-MOSFET的量產(chǎn)化,在各種技術(shù)方面顯得有些滯后。2010年12月,羅姆在世界上首次以定制品形式量產(chǎn)SiC-MOSFET。而且,從7月份開(kāi)始,相繼開(kāi)始量產(chǎn)1200V耐壓的第二代SiC-MOSFET “SCH系列”、“SCT系列”。
以往SiC-MOSFET由于體二極管通電引起特性劣化(MOSFET的導(dǎo)通電阻、體二極管的正向電壓上升),成為量產(chǎn)化的障礙。然而,羅姆改善了與結(jié)晶缺陷有關(guān)的工藝和器件結(jié)構(gòu),并在2010年量產(chǎn)時(shí)克服了SiC-MOSFET在可靠性方面的難題。
1200V級(jí)的逆變器和轉(zhuǎn)換器中一般使用Si材質(zhì)IGBT。SiC-MOSFET由于不產(chǎn)生Si材質(zhì)IGBT上出現(xiàn)的尾電流(關(guān)斷時(shí)流過(guò)的過(guò)渡電流),所以關(guān)斷時(shí)開(kāi)關(guān)損耗可以減少90%,而且可實(shí)現(xiàn)50kHz以上的驅(qū)動(dòng)開(kāi)關(guān)頻率。
因此,可實(shí)現(xiàn)機(jī)器的節(jié)能化及散熱片、電抗器和電容等周邊元器件的小型化、輕量化。特別對(duì)于以往的Si材質(zhì)IGBT,開(kāi)關(guān)損耗比導(dǎo)通損耗高,在這種應(yīng)用中進(jìn)行替換,將具有良好效果。
③“全SiC”功率模塊:100kHz以上高頻驅(qū)動(dòng)、開(kāi)關(guān)損耗降低
現(xiàn)在,1200V級(jí)的功率模塊中,Si材質(zhì)IGBT和FRD組成的IGBT模塊被廣泛應(yīng)用。羅姆開(kāi)發(fā)了搭載SiC-MOSFET和SiC-SBD的功率模塊(1200V/100A半橋結(jié)構(gòu),定制品)以替換以往的硅材質(zhì)器件,并從3月下旬開(kāi)始量產(chǎn)、出貨。通用品(1200V/120A半橋結(jié)構(gòu))也將很快量產(chǎn)。
作為替換硅材質(zhì)器件,搭載SiC-MOSFET和SiC-SBD的模塊,可實(shí)現(xiàn)100kHz以上的高頻驅(qū)動(dòng)。可大幅降低IGBT注5尾電流和FRD注6恢復(fù)電流引起的開(kāi)關(guān)損耗。因此,通過(guò)模塊的冷卻結(jié)構(gòu)簡(jiǎn)化(散熱片的小型化,水冷卻、強(qiáng)制空氣冷卻的自然空氣冷卻)和工作頻率高頻化,可實(shí)現(xiàn)電抗器和電容等的小型化。
另外,由于開(kāi)關(guān)損耗低,所以適于20kHz及更高開(kāi)關(guān)頻率的驅(qū)動(dòng),在此情況下,也可以用額定電流120A的SiC模塊替換額定電流200-400A的IGBT模塊。
今后:羅姆將全面推動(dòng)SiC元器件的普及
相對(duì)于已經(jīng)具有大量采用實(shí)績(jī)的SiC-SBD而言,SiC-MOSFET和全SiC功率模塊的真正采用現(xiàn)在才開(kāi)始。相對(duì)以往硅材質(zhì)器件的性能差別和成本差別的平衡將成為SiC器件真正普及的關(guān)鍵。羅姆在兩個(gè)方面進(jìn)行著技術(shù)開(kāi)發(fā):①基于SiC電路板大口徑化,降低SiC器件成本 ②相對(duì)硅材質(zhì)器件,開(kāi)發(fā)在性能上具有絕對(duì)優(yōu)勢(shì)的新一代SiC器件。今后,羅姆將通過(guò)擴(kuò)大普及SiC器件 ,助力于全球范圍內(nèi)實(shí)現(xiàn)節(jié)能和減少CO2的排放。
羅姆在“GaN”功率元器件領(lǐng)域的前沿探索
GaN功率元器件是指電流流通路徑為GaN的元器件。“GaN”曾被作為發(fā)光材料進(jìn)行過(guò)研究,現(xiàn)在仍然作為已普及的發(fā)光二極管(LED)照明的核心部件藍(lán)色LED用材料廣為使用。同時(shí),還有一種稱(chēng)為“WBG”的材料,與發(fā)光元件應(yīng)用幾乎同一時(shí)期開(kāi)始研究在功率元器件上的應(yīng)用,現(xiàn)已作為高頻功率放大器進(jìn)入實(shí)用階段。
GaN與Si和SiC元件的不同之處在于元件的基本“形狀”。圖1為使用GaN的電子元器件的一般構(gòu)造。晶體管有源極、柵極、漏極3個(gè)電極,Si和SiC功率元器件稱(chēng)為“縱向型”,一般結(jié)構(gòu)是源極和柵極在同一面,漏極電極在基板側(cè)。GaN為源極、柵極、漏極所有電極都在同一面的“橫向型”結(jié)構(gòu)。在以產(chǎn)業(yè)化為目的的研究中,幾乎都采用這種橫向型結(jié)構(gòu)。
之所以采用橫向型結(jié)構(gòu),是因?yàn)橄M麑⒋嬖谟贏lGaN/GaN界面的二維電子氣(2DEG)作為電流路徑使用。GaN既是具有自發(fā)電介質(zhì)極化(自發(fā)極化)的晶體,也是給晶體施加壓力即會(huì)重新產(chǎn)生壓電極化(極化失真)的壓電材料。AlGaN與GaN在自發(fā)極化存在差別,由于晶格常數(shù)不同,如果形成如圖1中的AlGaN/GaN異質(zhì)結(jié),為了匹配晶格常數(shù),晶體畸變,還會(huì)發(fā)生極化失真。因這種無(wú)意中產(chǎn)生的電介質(zhì)極化之差,如圖2所示,GaN的禁帶向AlGaN下方自然彎曲。因此,其彎曲部分產(chǎn)生2DEG。由于這種2DEG具有較高的電子遷移率(1500 cm2/Vs左右),因此可進(jìn)行非常快的開(kāi)關(guān)動(dòng)作。但是,其另外一面,相反,由于電子流動(dòng)的路徑常時(shí)存在,因此成為柵極電壓即使為0V電流也會(huì)流過(guò)的稱(chēng)為“常開(kāi)型(normally-on)”的元件。
正如之前所提及的,對(duì)WBG材料的最大期待是提高耐壓性能。由于SiC基本可以實(shí)現(xiàn)與Si相同的縱向型結(jié)構(gòu),因此發(fā)揮材料特性的耐壓性能得以提升。但是,GaN則情況不同。圖1所示的橫向型結(jié)構(gòu)較難提升耐壓性能,這一點(diǎn)通過(guò)Si元件既已明了,只要GaN也采用圖1的結(jié)構(gòu),物理特性上本應(yīng)實(shí)現(xiàn)的耐壓性能就很難發(fā)揮出來(lái)。但是,本來(lái)對(duì)WBG材料的期待就是耐壓特性,因此,發(fā)布的GaN元器件多為耐壓提升產(chǎn)品。但是,提升耐壓性能的方法基本上只能通過(guò)增加?xùn)艠O/漏極間的距離,而這樣芯片就會(huì)增大,芯片增大就意味著成本上升。
只要采用圖1的結(jié)構(gòu),GaN功率元器件的特點(diǎn)不僅是耐壓性能,還有使用2DEG的高速電子遷移率而來(lái)的高頻動(dòng)作性能。因而,GaN晶體管常被稱(chēng)為GaN-HEMT注7。
GaN”功率元器件的特性:確保高頻特性并實(shí)現(xiàn)高速動(dòng)作
羅姆開(kāi)發(fā)的“常開(kāi)型(normally-on)”型元器件的特性見(jiàn)表2,是柵極寬度為9.6cm的元器件,命名為“HEMT”,可查到的其高頻特性的文獻(xiàn)非常少。起初羅姆以盡量確保高頻特性為目標(biāo)進(jìn)行了開(kāi)發(fā),結(jié)果表明,羅姆的“常開(kāi)型(normally-on)”元器件的動(dòng)態(tài)特性非常優(yōu)異。表中的td(on)、tr、td(off)、tf等特性指標(biāo)表示高速性能。由于是“常開(kāi)型(normally-on)”元器件,因此柵極進(jìn)入負(fù)電壓瞬間,元器件關(guān)斷,0V時(shí)元器件導(dǎo)通。符號(hào)表示方法是:柵極電壓信號(hào)關(guān)斷時(shí)(元器件開(kāi)始向ON移行時(shí))為t = 0,源極/漏極間電壓Vds減少到施加電壓的90%之前的時(shí)間為td(on),從90%減少到10%的時(shí)間為tr,另外,柵極電壓信號(hào)導(dǎo)通時(shí)(元器件開(kāi)始向OFF移行時(shí))為t = 0,Vds增加到施加電壓的10%之間的時(shí)間為td(off),從10%增加到90%的時(shí)間為tf。
在現(xiàn)有的Si功率元器件中,td(on)、tr、td(off)、tf多為幾十 ns~100 ns左右,而在GaN-HEMT中,全部為數(shù)ns左右。假設(shè)進(jìn)行10 MHz、duty50%的脈沖動(dòng)作,ON/OFF時(shí)間僅為50ns,上升下降僅10ns,脈沖的實(shí)質(zhì)寬度已達(dá)30ns,無(wú)法確保矩形的波形。而使用這種元器件則無(wú)此問(wèn)題,10 MHz亦可動(dòng)作。
對(duì)于GaN-HEMT來(lái)說(shuō),棘手的問(wèn)題是電流崩塌。這是根據(jù)漏極電壓的施加狀態(tài)導(dǎo)通電阻發(fā)生變動(dòng)的現(xiàn)象。可以觀測(cè)到使開(kāi)關(guān)頻率變化時(shí)導(dǎo)通電阻變動(dòng)、在Vds導(dǎo)通(ON)時(shí)無(wú)法完全為0V、關(guān)斷(OFF)時(shí)無(wú)法返回到施加電壓的現(xiàn)象。
羅姆的“常開(kāi)型(normally-on)”元器件使柵極電壓的開(kāi)關(guān)頻率變化時(shí)的Vds表現(xiàn)如圖3所示。由于沒(méi)有優(yōu)化柵極驅(qū)動(dòng)器,在10MHz存在duty沒(méi)有達(dá)到50%的問(wèn)題,但在這個(gè)頻率范圍內(nèi),沒(méi)有發(fā)現(xiàn)引起電流崩塌的趨勢(shì)。因此,可以認(rèn)為,只要解決“常開(kāi)(normally-on)”這一點(diǎn),即可證明GaN卓越的高速動(dòng)作性能。
今后:羅姆將積極推進(jìn)常關(guān)型元器件的特性改善并進(jìn)行應(yīng)用探索
面向GaN元器件的發(fā)展,正因?yàn)閹缀跛械膽?yīng)用都是以“常關(guān)”為前提設(shè)計(jì)的,因此“常關(guān)化”的推進(jìn)成為了時(shí)下的當(dāng)務(wù)之急。如今羅姆正致力于推進(jìn)高頻特性卓越的常關(guān)型元器件的特性改善,同時(shí)也在進(jìn)行應(yīng)用探索。為呈現(xiàn)出GaN最閃耀的應(yīng)用和只有GaN才能實(shí)現(xiàn)的應(yīng)用而加大開(kāi)發(fā)力度,將不斷帶來(lái)全新的技術(shù)體驗(yàn)。
<術(shù)語(yǔ)解說(shuō)>
注1:SJ-MOSFET
超級(jí)結(jié)MOSFET的縮寫(xiě)。即超級(jí)結(jié)金屬氧化物場(chǎng)效應(yīng)三極管。
注2:SiC
Silicon Carbide的縮寫(xiě)。即碳化硅,是用石英砂、石油焦(或煤焦)、木屑為原料通過(guò)電阻爐高溫冶煉而成。
注3:GaN
即氮化鎵,屬第三代半導(dǎo)體材料,六角纖鋅礦結(jié)構(gòu)。
注4:寬禁帶(WBG)半導(dǎo)體
寬禁帶半導(dǎo)體材料(Eg大于或等于3.2ev)被稱(chēng)為第三代半導(dǎo)體材料。主要包括金剛石、SiC、GaN等。
注5:IGBT
IGBT(Insulated Gate Bipolar Transistor),絕緣柵雙極型晶體管,是由BJT(雙極型三極管)和MOS(絕緣柵型場(chǎng)效應(yīng)管)組成的復(fù)合全控型電壓驅(qū)動(dòng)式功率半導(dǎo)體器件, 兼有MOSFET的高輸入阻抗和GTR的低導(dǎo)通壓降兩方面的優(yōu)點(diǎn)。
注6:FRD
快速恢復(fù)二極管(Fast Recovery Diode,縮寫(xiě)成FRD),是一種具有開(kāi)關(guān)特性好、反向恢復(fù)時(shí)間短特點(diǎn)的半導(dǎo)體二極管。
注7:HEMT
高電子遷移率晶體管(High Electron Mobility Transistor),是一種異質(zhì)結(jié)場(chǎng)效應(yīng)晶體管,又稱(chēng)為調(diào)制摻雜場(chǎng)效應(yīng)晶體管(MODFET)、二維電子氣場(chǎng)效應(yīng)晶體管(2-DEGFET)、選擇摻雜異質(zhì)結(jié)晶體管 (SDHT)等。這種器件及其集成電路都能夠工作于超高頻(毫米波)、超高速領(lǐng)域。
市場(chǎng)增長(zhǎng)顯露曙光
使用碳化硅的功率半導(dǎo)體元件在實(shí)現(xiàn)逆變器等電力轉(zhuǎn)換裝置的小型化及減少損失方面比較有效,因此相關(guān)元器件企業(yè)正在積極推進(jìn)產(chǎn)品開(kāi)發(fā)。昭和電工稱(chēng),此次增加產(chǎn)能的原因在于,“在家電產(chǎn)品等低電壓低電流應(yīng)用領(lǐng)域,已開(kāi)始逐漸產(chǎn)生實(shí)際需求,而且在鐵路車(chē)輛及工業(yè)設(shè)備等高電壓、大電流領(lǐng)域,開(kāi)發(fā)項(xiàng)目也在增多”。碳化硅元件與作為競(jìng)爭(zhēng)對(duì)手的硅元件相比,價(jià)格較高,這已經(jīng)成為實(shí)現(xiàn)普及的瓶頸,但如果優(yōu)質(zhì)外延晶圓的供應(yīng)量增加,便有望降低元件成本(圖1)。
圖1 昭和電工4英寸碳化硅外延晶圓
通過(guò)在存在結(jié)晶缺陷的碳化硅晶圓上形成均質(zhì)的外延層,可提高以此為基礎(chǔ)制造的元器件的性能及成品率。
實(shí)際上,推進(jìn)碳化硅元件開(kāi)發(fā)的企業(yè)活動(dòng)正日趨活躍。開(kāi)拓該領(lǐng)域市場(chǎng)最為積極的羅姆公司于2012年3月舉行了媒體說(shuō)明會(huì),公布了關(guān)于碳化硅相關(guān)業(yè)務(wù)的展望。該公司稱(chēng),雖然2010年的銷(xiāo)售額僅為17億日元,但2011年達(dá)到35億日元,實(shí)現(xiàn)了倍增,預(yù)計(jì)2012年將增長(zhǎng)到50億日元。并宣布2014年力爭(zhēng)實(shí)現(xiàn)160億日元的銷(xiāo)售額。
開(kāi)展碳化硅元件業(yè)務(wù)的企業(yè)還有三菱電機(jī)公司和富士電機(jī)公司等多家企業(yè),但各家企業(yè)在銷(xiāo)售預(yù)測(cè)方面均持慎重態(tài)度,大多未具體公布幾年后的目標(biāo)。從羅姆此次公布相關(guān)信息可以看出,碳化硅元件用戶(hù)企業(yè)正從開(kāi)發(fā)階段穩(wěn)步進(jìn)入實(shí)際需求階段。
應(yīng)用范圍逐步拓寬
逆變器是應(yīng)用功率半導(dǎo)體的代表性產(chǎn)品。這是一種將直流電轉(zhuǎn)變?yōu)榻涣麟姷碾娏D(zhuǎn)換裝置,如果用于驅(qū)動(dòng)交流馬達(dá),可根據(jù)負(fù)荷控制轉(zhuǎn)數(shù),因此可大幅實(shí)現(xiàn)節(jié)能。在日本,早就開(kāi)始將之應(yīng)用于空調(diào)及洗衣機(jī)等領(lǐng)域。今后,如果能進(jìn)一步應(yīng)用于產(chǎn)業(yè)馬達(dá)等領(lǐng)域,從整體來(lái)看,將有望實(shí)現(xiàn)非常大的節(jié)能效果。這是因?yàn)椋毡灸壳凹s60%的電力消費(fèi)在于馬達(dá),但其中逆變器的利用率僅為10%左右(圖2)。
圖2 馬達(dá)耗電量占整體耗電量的60%
據(jù)稱(chēng)其中逆變器利用率僅為10%。
不僅限于驅(qū)動(dòng)馬達(dá),逆變器及轉(zhuǎn)換器(將交流轉(zhuǎn)換為直流)等電力轉(zhuǎn)換裝置被廣泛應(yīng)用于各種用途。在大量使用太陽(yáng)能電池和定置式蓄電池等直流裝置的智能電網(wǎng)等領(lǐng)域,今后尤其需要用到這些裝置。而且在提高充電電池直流電壓,以驅(qū)動(dòng)馬達(dá)的混合動(dòng)力車(chē)(HEV)及純電動(dòng)汽車(chē)(EV)領(lǐng)域,也是關(guān)鍵裝置。大量使用直流設(shè)備的數(shù)據(jù)中心等對(duì)小型高效電力轉(zhuǎn)換裝置的需求也非常大(圖3)。
圖3 功率半導(dǎo)體應(yīng)用領(lǐng)域
電力轉(zhuǎn)換器用于多種領(lǐng)域,可提高馬達(dá)及電源電路的能源利用效率。
功率半導(dǎo)體市場(chǎng)發(fā)展?jié)摿薮?/strong>
再來(lái)看看電力轉(zhuǎn)換裝置所使用的普通硅功率半導(dǎo)體市場(chǎng)。2010年全球半導(dǎo)體市場(chǎng)規(guī)模約為25萬(wàn)億日元(按1美元80日元換算,以下同),而其中作為功率半導(dǎo)體代表的功率MOSFET約為5000億日元,絕緣柵雙極型晶體管(IGBT)為2500億日元左右。雖然從金額來(lái)看,規(guī)模比較小,但增長(zhǎng)潛力較大,調(diào)查公司IHSiSuppli Japan預(yù)測(cè),到2015年,功率MOSFET將增長(zhǎng)到約1萬(wàn)億日元,絕緣柵雙極型晶體管將達(dá)到4000億日元左右,兩者合在一起,或許能在5年時(shí)間內(nèi)實(shí)現(xiàn)倍增。
這一發(fā)展趨勢(shì)的背景原因,不僅是發(fā)達(dá)國(guó)家出現(xiàn)節(jié)能熱,還有新興市場(chǎng)國(guó)家快速的經(jīng)濟(jì)發(fā)展。電力轉(zhuǎn)換裝置有望出現(xiàn)在社會(huì)各個(gè)領(lǐng)域,成為一種“生活必需品”,隨著人口較多的新興市場(chǎng)國(guó)家現(xiàn)代化的發(fā)展,將會(huì)產(chǎn)生大量需求。
硅半導(dǎo)體的設(shè)計(jì)技術(shù)及制造技術(shù)均已成熟,能夠以低成本進(jìn)行大量生產(chǎn)。但另一方面,由于材料特性的原因,其性能存在極限,無(wú)法用于某些用途。碳化硅和氮化鎵將通過(guò)突破硅的性能極限來(lái)開(kāi)拓新市場(chǎng)(圖4)。
圖4 新一代功率半導(dǎo)體可超越硅的性能極限
碳化硅主要適合用于大電力領(lǐng)域,氮化鎵適合用于低電力、轉(zhuǎn)換速度較快的領(lǐng)域。并且,由于可實(shí)現(xiàn)低損耗及小型化,因此還可替代現(xiàn)有的硅元件。
新產(chǎn)品新技術(shù)相繼問(wèn)世
帶隙是半導(dǎo)體的基本特性,碳化硅和氮化鎵的帶隙比硅大3倍左右,絕緣破壞電場(chǎng)也高一位數(shù)。在高溫下也能工作,流經(jīng)電流時(shí)的阻力(導(dǎo)通電阻)較小,也就是能夠制造能量損失較小的元器件(圖5)。
圖5 碳化硅與氮化鎵的材料物性(a)與做成元件后的優(yōu)點(diǎn)(b)
在日本,京都大學(xué)和產(chǎn)業(yè)技術(shù)綜合研究所等很早就開(kāi)始關(guān)注上述新材料,一直在推進(jìn)基礎(chǔ)研究及元器件研究。并且,官方研究機(jī)構(gòu)和民營(yíng)企業(yè)之間也合作實(shí)施了多個(gè)研究項(xiàng)目。2010年,經(jīng)濟(jì)產(chǎn)業(yè)省、內(nèi)閣府、產(chǎn)綜研及新能源產(chǎn)業(yè)技術(shù)綜合開(kāi)發(fā)機(jī)構(gòu)等啟動(dòng)了更注重實(shí)用化的新研究項(xiàng)目,也有多家民營(yíng)企業(yè)參加。由于這些項(xiàng)目涉及晶圓制造技術(shù)、元器件技術(shù)、系統(tǒng)技術(shù)及生產(chǎn)技術(shù)等多方面,因此經(jīng)濟(jì)產(chǎn)業(yè)省于2010年建立了旨在推動(dòng)項(xiàng)目間合作的組織“碳化硅聯(lián)盟”,目前正在提高運(yùn)營(yíng)效率。
上述研究項(xiàng)目已開(kāi)始逐漸取得成果,近年來(lái),有多家企業(yè)相繼公布了與新一代功率半導(dǎo)體相關(guān)的新產(chǎn)品及新技術(shù)。
 電子發(fā)燒友App
電子發(fā)燒友App









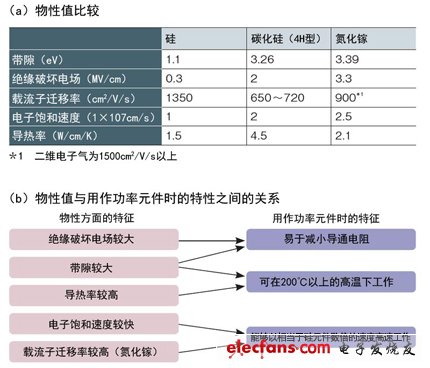








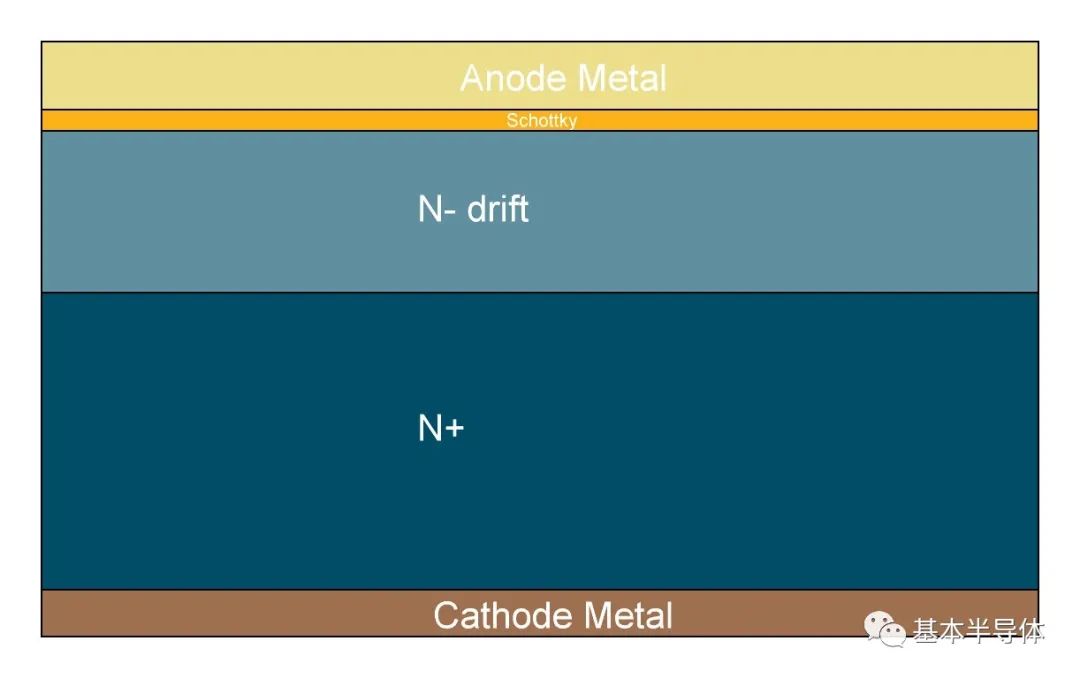
















評(píng)論