半導(dǎo)體封裝測(cè)試構(gòu)成了晶圓制造流程的后階段,緊隨芯片制造步驟之后。此階段涉及將制造完成的晶圓進(jìn)行封裝與測(cè)試,進(jìn)而根據(jù)實(shí)際需求與功能特性,將通過測(cè)試的晶圓加工成芯片。封裝的主要四大目標(biāo)包括:保護(hù)芯片免受損害、為芯片提供必要的支撐與外觀成型、確保芯片電極與外部電路的有效連接、以及提高導(dǎo)熱性能。針對(duì)下游電子產(chǎn)品小型化、輕量化、高性能的需求封裝朝小型化、多引腳、高集成目標(biāo)持續(xù)演進(jìn)。在此過程中,先進(jìn)封裝材料作為先進(jìn)封裝產(chǎn)業(yè)鏈的核心上游組成部分,扮演著至關(guān)重要的角色,是推動(dòng)先進(jìn)封裝技術(shù)持續(xù)進(jìn)步與發(fā)展的堅(jiān)實(shí)基石。
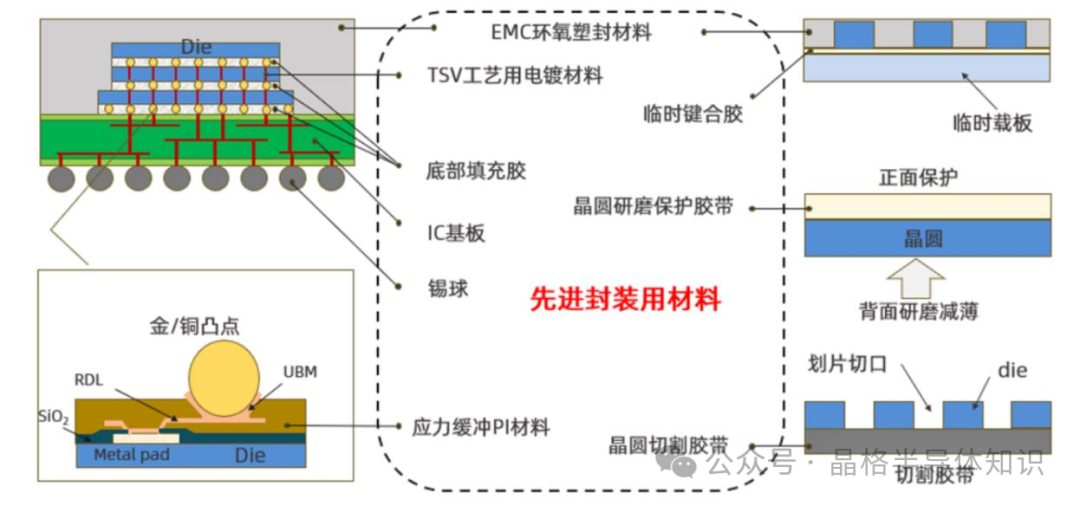
玻璃基板 由于玻璃在介電損耗、熱膨脹系數(shù)等方面具備一定性能優(yōu)勢(shì),故玻璃基板具備成為下一代先進(jìn)封裝基板新材料的潛力,有望成為替代傳統(tǒng)ABF載板、硅中介層的新材料。預(yù)計(jì)全球玻璃基板市場(chǎng)在預(yù)測(cè)期內(nèi)將以超過4%的復(fù)合年增長(zhǎng)率增長(zhǎng)。 環(huán)氧塑封料 這是目前應(yīng)用最廣泛的包封材料,核心作用是為芯片提供防護(hù)、導(dǎo)熱、支撐等。先封封裝尤其是2.5D/3D封裝,對(duì)環(huán)氧塑封料的流動(dòng)性、均勻性和散熱性提出了更高的要求。目前全球集成電路(IC)封裝材料的97%采用環(huán)氧塑封料(EMC)全球市場(chǎng)規(guī)模達(dá)157億元。
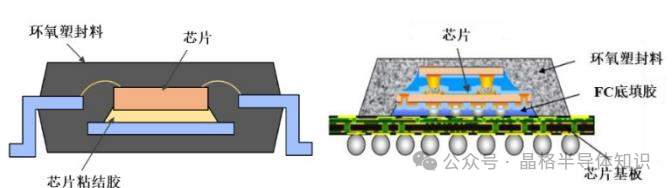
PSPI光刻膠 PSPI是先進(jìn)封裝核心耗材之一,主要應(yīng)用于再布線(RDL)工藝,不僅為封裝提供必要的電氣、機(jī)械和熱性能,還能實(shí)現(xiàn)高分辨率的圖案化,大幅減少了光刻工藝流程,2021年全球市場(chǎng)1.3億美元,未來可能全面替代傳統(tǒng)光刻膠。 電鍍液 電鍍工藝廣泛應(yīng)用于先進(jìn)封裝,電鍍液是核心原材料,TSV、RDL、Bumping、混合鍵合都需要進(jìn)行金屬化薄膜沉積。QYResearch調(diào)研顯示,2023年全球半導(dǎo)體電鍍化學(xué)品市場(chǎng)規(guī)模達(dá)6.89億美元,預(yù)計(jì)2030年將達(dá)到10.48億美元,2024-2030期間年復(fù)合增長(zhǎng)率(CAGR)為5.6%。
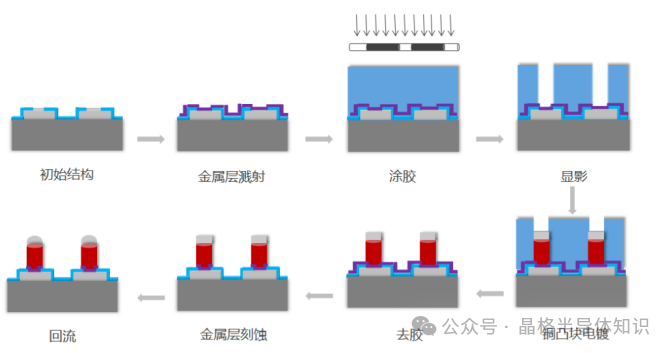
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28342瀏覽量
230015 -
玻璃基板
+關(guān)注
關(guān)注
1文章
96瀏覽量
10642 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
445瀏覽量
467
原文標(biāo)題:先進(jìn)封裝材料有哪些?
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦

#硬聲創(chuàng)作季 【科普向】傳統(tǒng)封裝與先進(jìn)封裝有何差異?——為什么需要先進(jìn)封裝
電子封裝是什么?電子封裝的材料有什么?
先進(jìn)陶瓷材料應(yīng)用——氧化鋁陶瓷基板
ad693ad和ad693aq的封裝有什么區(qū)別?
延續(xù)摩爾定律,先進(jìn)封裝和新材料賽道開啟
SiP與先進(jìn)封裝有什么區(qū)別

什么是先進(jìn)封裝?和傳統(tǒng)封裝有什么區(qū)別?

傳統(tǒng)封測(cè)廠的先進(jìn)封裝有哪些
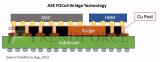
仁懋電子&amp;深圳先進(jìn)材料研究院孫院長(zhǎng)就芯片封裝行業(yè)友好交流

QFN封裝和DFN封裝有何區(qū)別?
投資筆記:17000字詳解14種先進(jìn)封裝核心材料投資邏輯



















評(píng)論