晶圓表面潔凈度會極大的影響后續(xù)半導體工藝及產(chǎn)品的合格率。在所有產(chǎn)額損失中,高達50%是源自于晶圓表面污染。
能夠?qū)е缕骷?a target="_blank">電氣性能或器件制造過程發(fā)生不受控制的變化的物體統(tǒng)稱為污染物。污染物可能來自晶圓本身、潔凈室、工藝工具、工藝化學品或水。晶圓污染一般可以通過肉眼觀察、過程檢查、或是最終器件測試中使用復雜的分析設備檢測到。
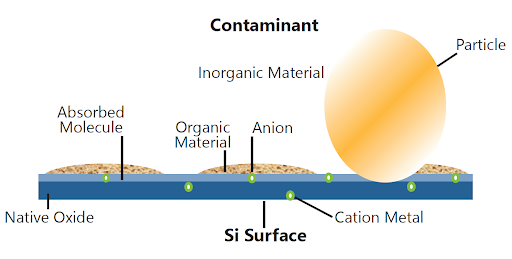
▲硅晶圓表面的污染物| 圖源網(wǎng)絡
污染分析的結(jié)果可用于反映晶圓在某一工藝步驟、特定機臺或是整體工藝中所遭遇的污染程度與種類。根據(jù)檢測方法分類,可將晶圓表面污染分為以下幾種。
金屬污染
由金屬造成的污染,可導致不同程度的半導體器件缺陷。
堿金屬或堿土金屬(Li、Na、K、Ca、Mg、Ba等)會造成p-n結(jié)構中的漏電流,進而導致氧化物的擊穿電壓;過渡金屬與重金屬(Fe、Cr、Ni、Cu、Au、Mn、Pb等)污染可使載流子生命周期的減少,降低元件使用壽命或使元件工作時暗電流增大。
檢測金屬污染的常用方法是全反射X射線熒光、原子吸收光譜法和電感耦合等離子體質(zhì)譜法 (ICP-MS)。

▲晶圓表面污染| ResearchGate
金屬污染可能來自于清潔、刻蝕、光刻、沉積等過程中所使用的試劑,或是工藝中所使用的機臺,如烘箱、反應器、離子注入等,亦有可能是對晶圓處理方式不慎所導致。
顆粒污染
實際的材料沉積物,通常通過檢測從表面缺陷散射的光來觀察到的污染,因此顆粒污染更準確的學名是亮點缺陷 (light-point defect)。顆粒污染可能導致在蝕刻及微影工藝中,產(chǎn)生阻塞(blocking) 或遮蔽(masking) 的效應。
在薄膜成長或沉積過程中,產(chǎn)生針孔(pinholes) 和微孔(microvoids),若粒子顆粒較大且具有導電性,甚至會導致線路短路。
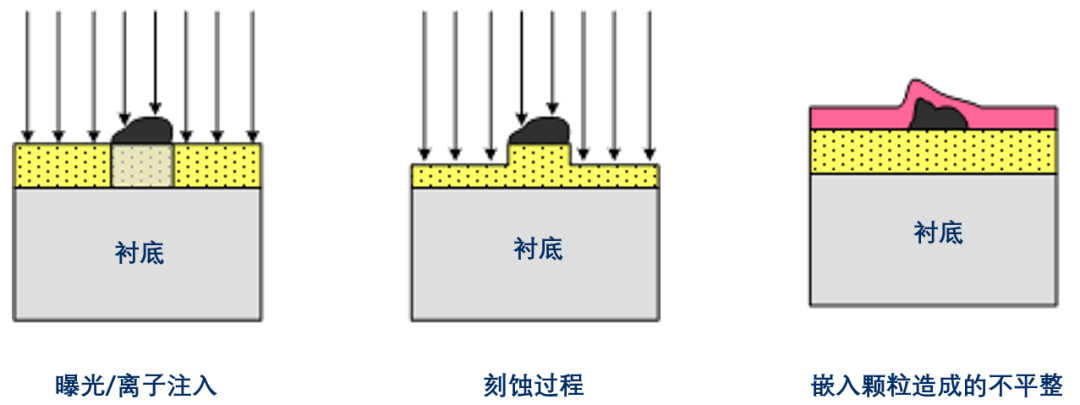
▲顆粒污染的形成| 圖源網(wǎng)絡
微小的顆粒污染會導致表面出現(xiàn)陰影,例如在光刻過程中。如果大顆粒位于光掩模和光刻膠層之間,則它們會降低接觸曝光的分辨率。
此外,它們還可以在離子注入或干蝕期間阻擋加速離子。顆粒也可能被薄膜封閉,這樣就有凹凸不平。隨后沉積的層可能會在這些位置開裂或抵抗積累,從而在暴露過程中引起問題。
有機污染
含有碳的污染物,以及與C相關的鍵合結(jié)構,稱為有機污染。有機污染物可能會導致晶圓表面產(chǎn)生非預期的疏水性質(zhì)、增加表面的粗糙度、產(chǎn)生霧化表面、破壞外延層的生長,且在未先移除污染物的情況下,也會影響金屬污染的清洗效果。
一般用熱脫附MS、X射線光電子能譜和俄歇電子能譜等儀器檢測此類表面污染。
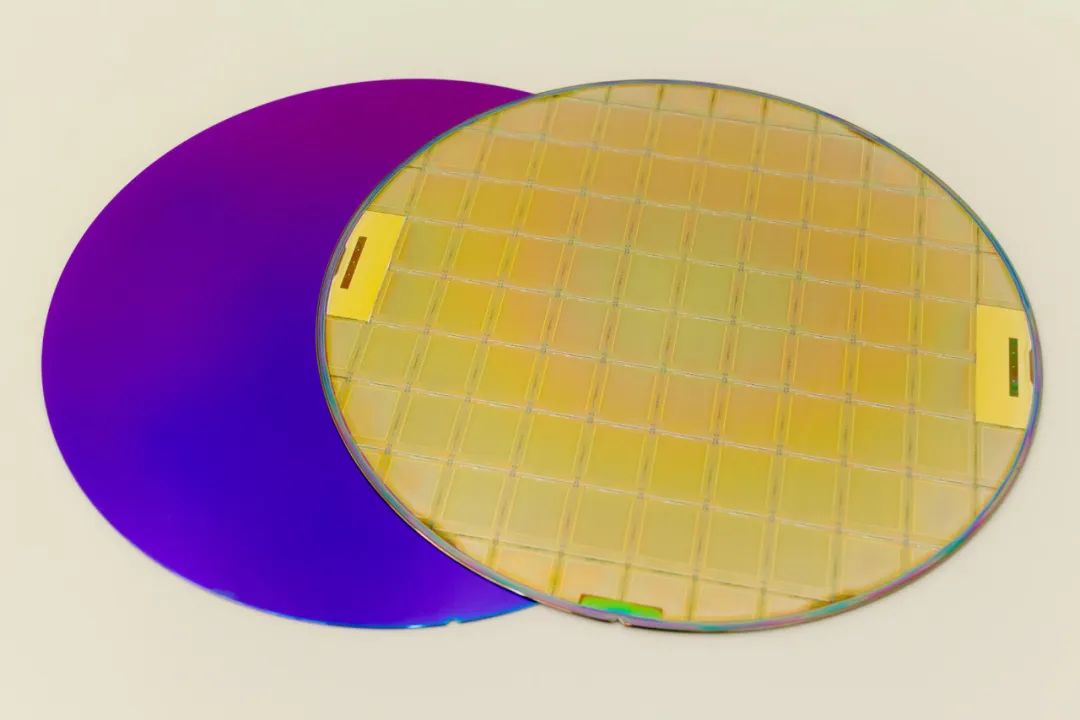
▲圖源網(wǎng)絡
氣態(tài)污染和水分污染
具有分子尺寸的大氣分子和水分污染,通常無法使用普通高效顆粒空氣(HEPA) 或超低滲透空氣過濾器(ULPA) 去除。此類污染通常通過離子質(zhì)譜和毛細管電泳進行監(jiān)測。
有些污染物可能屬于多個類別,例如顆粒可能由有機或金屬材料組成,或者同時包含兩者,因此這類污染也可能被歸類為其它類型。
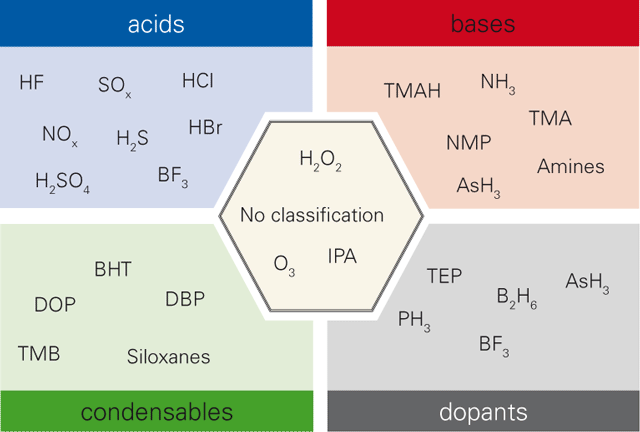
▲氣態(tài)分子污染物|IONICON
此外,按照污染源尺寸,也可以將晶圓污染分類為分子污染、顆粒污染和工藝衍生碎片污染。污染顆粒尺寸越小,去除難度越高。在當今電子元器件的制造中,晶圓清潔程序占到整個生產(chǎn)過程步驟的30% - 40%。
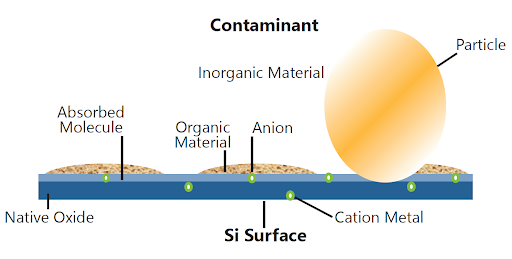
▲硅晶圓表面的污染物| 圖源網(wǎng)絡
-
晶圓
+關注
關注
52文章
5076瀏覽量
128980 -
檢測
+關注
關注
5文章
4575瀏覽量
92376
原文標題:科普 | 晶圓表面污染及其檢測方法
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關推薦
晶圓表面形貌及臺階高度測量方法

史上最全晶圓專業(yè)術語
三維壓電偏擺臺在晶圓表面檢測中的應用分析

多通道晶圓缺陷檢測方法
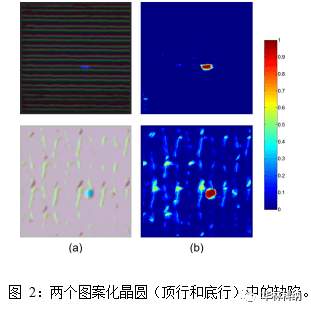
晶圓表面的潔凈度對半導體工藝的影響 如何確保晶圓表面無污染殘留
晶圓表面污染該如何處理
抓出半導體工藝中的魔鬼-晶圓表面金屬污染
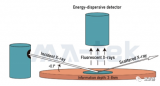
WD4000無圖晶圓檢測機:助力半導體行業(yè)高效生產(chǎn)的利器
晶圓表面形貌及臺階高度測量方法
晶圓表面金屬污染:半導體工藝中的隱形威脅
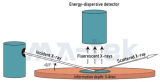
晶圓表面特性和質(zhì)量測量的幾個重要特性



















評論