高溫柵偏(High Temperature Gate Bias,HTGB)、高溫反偏(High Temperature Reverse Bias,HTRB)、高溫高濕反偏(High Humidity High Temperature Reverse Bias,H3TRB)等環(huán)境可靠性測試是進行功率器件壽命評估所必備的試驗。由于不同標準下的試驗條件并不相同,因而理解上述環(huán)境可靠性測試采用的加速老化物理模型是十分必要的。
溫度場、濕度場和電場是老化測試的加速因子。溫度場的作用是為了增大電子或空穴遷移率,增大碰撞電離或暴露污染離子,進而加速柵氧化層或鈍化層老化;電場的作用是為了增大電子遷移速率或積聚污染離子,進而加速柵氧化層或鈍化層老化。濕度場的作用是為了增大金屬離子電化學遷移現(xiàn)象的速率,加快電樹枝的形成,進而加速鈍化層老化。一般情況下是上述電場、溫度場和濕度場對功率期間進行共同作用。
本文基于JEDEC標準簡要介紹了HTGB、HTRB、H3TRB試驗所采用的加速老化模型與其適用范圍。
HTGB加速老化模型
HTGB試驗對應器件柵氧化層失效的加速老化物理模型為時間相關介質(zhì)擊穿(Time-Dependent Dielectric Breakdown,TDDB),涉及到電場與溫度場共同作用。在TDDB模型中,基于F-N隧穿效應的1/E模型與基于電偶極子交互作用的E模型以其良好的物理機理及擬合結(jié)果被廣泛應用。

HTRB加速老化模型
HTRB試驗通過在高溫下對器件施加阻斷電壓進而考核器件的終端和鈍化層,同樣涉及到電場與溫度場的共同作用,其對應失效的加速老化物理模型為含電壓加速因子的擴充Eyring模型與逆冪律模型。

H3TRB加速老化模型
H3TRB考核功率半導體器件漏極在電應力以及高溫高濕條件下的可靠性,同樣涉及到溫度場、濕度場與電場的共同作用,相對應的加速老化物理模型為Peck模型與HV-H3TRB模型。
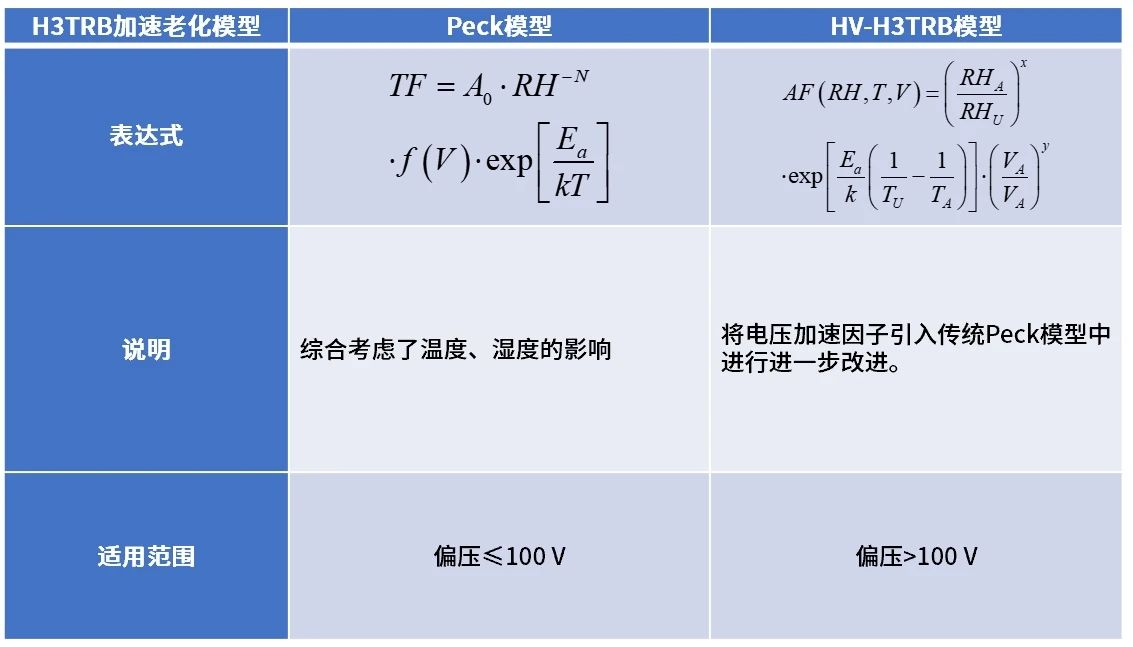
廣電計量半導體服務優(yōu)勢
工業(yè)和信息化部“面向集成電路、芯片產(chǎn)業(yè)的公共服務平臺”
工業(yè)和信息化部“面向制造業(yè)的傳感器等關鍵元器件創(chuàng)新成果產(chǎn)業(yè)化公共服務平臺”
國家發(fā)展和改革委員會“導航產(chǎn)品板級組件質(zhì)量檢測公共服務平臺”
廣東省工業(yè)和信息化廳“汽車芯片檢測公共服務平臺”
江蘇省發(fā)展和改革委員會“第三代半導體器件性能測試與材料分析工程研究中心”
上海市科學技術(shù)委員會“大規(guī)模集成電路分析測試平臺”
在集成電路及SiC領域是技術(shù)能力最全面、知名度最高的第三方檢測機構(gòu)之一,已完成MCU、AI芯片、安全芯片等上百個型號的芯片驗證,并支持完成多款型號芯片的工程化和量產(chǎn)。
在車規(guī)領域擁有AEC-Q及AQG324全套服務能力,獲得了近50家車廠的認可,出具近400份AEC-Q及AQG324報告,助力100多款車規(guī)元器件量產(chǎn)。
-
功率器件
+關注
關注
42文章
1849瀏覽量
91473 -
可靠性測試
+關注
關注
1文章
99瀏覽量
14370
發(fā)布評論請先 登錄
相關推薦
可靠性檢技術(shù)及可靠性檢驗職業(yè)資格取證
大功率白光LED的應用及其可靠性研究
汽車電子產(chǎn)品環(huán)境可靠性測試
電子元器件的可靠性篩選
可靠性與失效分析
GaN HEMT可靠性測試:為什么業(yè)界無法就一種測試標準達成共識
碳化硅功率器件可靠性之芯片研發(fā)及封裝篇
軍用電子元器件二篩,進口元器件可靠性篩選試驗
老化測試提高了 SiC 和 GaN 的可靠性

半導體器件在高溫環(huán)境下的可靠性




















評論