光掩模上的曲線形狀(curvilinear shapes)的轉(zhuǎn)變多年來一直被認為是提高良率、降低缺陷率和減少芯片上浪費空間的一種方式,現(xiàn)在正在獲得越來越多的支持——所有這些對于半導(dǎo)體的持續(xù)微縮和提高可靠性都至關(guān)重要。
在今年的 SPIE 光掩模技術(shù) + EUV 光刻會議上,人們對這種方法表現(xiàn)出了濃厚的興趣。簡而言之,曲線形狀(curvilinear shapes)是對特征的更準確表示,這些特征將被印刷在掩模上并最終蝕刻到晶圓上,從而使這些特征之間的間距更緊密。如果整個行業(yè)都支持這種做法,影響可能會很大。但這種規(guī)模的任何舉措都會帶來挑戰(zhàn),特別是當(dāng)它適用于大批量制造時,而且這種轉(zhuǎn)變并非易事。此外,即使有廣泛的支持,也需要數(shù)年時間才能完全實現(xiàn)其好處。
西門子 EDA的 Calibre 半導(dǎo)體解決方案副總裁 Steffen Schulze 表示:“Curvilinear 已經(jīng)存在很長一段時間了。” “該技術(shù)已經(jīng)有一些演示,例如內(nèi)存公司在高重復(fù)率的高密度陣列中使用它,但它始終受到制造框架的約束。現(xiàn)在,采用曲線幾乎就像大壩已經(jīng)決堤一樣。”
人們對其潛力肯定更加樂觀。“幾十年來,人們一直在談?wù)撉€光罩,”Fractilia 首席執(zhí)行官 Chris Mack 說道。“但這種成本效益比一直存在,而且成本大于收益。現(xiàn)在,幾個關(guān)鍵推動因素已經(jīng)改變了成本效益比,曲線掩模實際上可能是實用的。”
這些推動因素之一是采用多光束掩模寫入器(multi-beam mask writers)。從歷史上看,掩模寫入依賴于單束電子束光刻,這對于創(chuàng)建復(fù)雜圖案來說非常耗時且效率較低。然而,隨著對復(fù)雜設(shè)計和更小節(jié)點的需求不斷增長,對更快、更精確的掩模寫入的需求變得越來越明顯。這些工具于 2010 年代初推出,允許同時寫入多個圖案,大大減少寫入時間并能夠創(chuàng)建更復(fù)雜的設(shè)計,從而徹底改變了掩模生產(chǎn)。
“多光束掩模寫入器已經(jīng)存在好幾年了,” D2S董事長兼首席執(zhí)行官 Aki Fujimura 說道。“現(xiàn)在,尤其是對于 EUV,掩模幾乎總是 100% 由多光束掩模寫入器寫入。曲線形狀不會帶來額外的損失,因為曲線掩模不需要額外的時間來生產(chǎn)。”
這使得曲線采用的情況變得更加簡單。“該行業(yè)已經(jīng)轉(zhuǎn)向曲線,” Synopsys高級產(chǎn)品營銷經(jīng)理 Travis Brist 表示。“數(shù)據(jù)量一直是一個障礙,這有點‘正在進行中’,而掩碼寫入器也是一個障礙。但多光束掩模寫入器開始出現(xiàn),并且您開始看到它們的更多用途。”
該設(shè)備的性能得到了顯著提高。“在老式的掩模寫入中,我們一次寫入一個像素,”Mack補充道。“對于曲線掩模,你必須有更小的像素尺寸和更小的地址尺寸,這將大大增加寫入時間,從而增加掩模的成本。但在過去的十年中,我們看到多光束掩模寫入器變得可用并流行。現(xiàn)在,他們可以以與寫入曼哈頓幾何掩模相同的速度寫入曲線掩模,而且精度也很高。”

圖 1:英特爾的 Frank Abboud 在 SPIE 上討論曲線掩模挑戰(zhàn)
曲線掩膜的另一個關(guān)鍵推動因素是用于表示曲線特征的“多邊形”(multigon)格式。多邊形(單一幾何圖形中的多邊形集合)專門為表示曲線特征而設(shè)計,可確保數(shù)據(jù)量保持可管理性,盡管這些設(shè)計具有復(fù)雜性。
IMEC 高級圖案化項目主任 Kurt Ronse 表示:“逆向光刻技術(shù)或曲線光刻技術(shù)已于 10 多年前誕生。” “問題是它們是光罩上的隨機圖案,有時是非常小的圖案和更大的圖案以及各種方向,所以沒有人能夠制作這樣的面具。另外,沒有方法可以存儲您以標準數(shù)據(jù)格式計算的圖像。數(shù)據(jù)變得太大,面具店無法將其加載到寫入器中。”
這是曲線形狀的挑戰(zhàn)之一。直線可以由兩個點定義,但曲線需要沿著曲線的許多點才能獲得準確的表示,如果有很多起伏,則需要很多點。這種設(shè)計的數(shù)據(jù)量將是巨大的。
這就是多邊形格式發(fā)揮作用的地方。多邊形格式不是僅僅依賴分段線性表示,而是引入了表示曲線多邊形的方法,例如二次貝塞爾曲線擬合或樣條擬合。這些方法可以用更少的數(shù)據(jù)點捕獲曲線形狀的本質(zhì),從而可能減少文件大小并提高數(shù)據(jù)處理效率。
“三次樣條(Cubic splines)是人們最常見的多邊形,因為它們非常靈活,”Mack說。“將一些三次樣條放在一起,您就可以用更少的數(shù)字來描述一個相當(dāng)復(fù)雜的形狀。但這是一項標準化工作,需要整個行業(yè)合作才能實現(xiàn)這一目標。這項工作正在進行中。完成后將會非常有幫助。”
即使過渡到這種格式也很復(fù)雜。“除了這些曲線特征之外,曲線還帶來了更多的數(shù)據(jù)量和復(fù)雜性,”Synopsys 的 Brist 說。“因此,我們將多邊形格式視為一種不同的方式來表示 GDS 文件中的數(shù)據(jù),以減少體積,并使用人工智能和機器學(xué)習(xí)等技術(shù)來處理數(shù)據(jù)的復(fù)雜性并加快部署速度。”
針對曼哈頓結(jié)構(gòu)優(yōu)化的現(xiàn)有工具和流程可能會產(chǎn)生不準確的曲線形狀結(jié)果。這就需要開發(fā)新的工具、算法和檢查來有效處理復(fù)雜的曲線設(shè)計。
“你可以想象,現(xiàn)在有了這些彎曲特征,用于觀察曼哈頓結(jié)構(gòu)并在曼哈頓特征之間進行測量的東西不再適用于彎曲特征,”Brist補充道。“因此,您確實必須創(chuàng)建新類型的檢查,以便識別這些功能,而不會識別誤報或遺漏的內(nèi)容。這成為一個新的挑戰(zhàn)。”
檢查缺陷
掩模規(guī)則檢查 (MRC) 長期以來一直是半導(dǎo)體設(shè)計和制造的基石。這些規(guī)則確保光掩模圖案是可制造的,并且它們忠實地再現(xiàn)硅晶片上的預(yù)期特征而沒有缺陷。從歷史上看,MRC 是為曼哈頓(直線)結(jié)構(gòu)量身定制的,其特點是直角和簡單的設(shè)計。然而,隨著行業(yè)轉(zhuǎn)向曲線或非曼哈頓特征,傳統(tǒng) MRC 的局限性變得明顯。這些傳統(tǒng)檢查難以有效處理彎曲特征的細微差別,從而導(dǎo)致潛在的不準確、誤報或被忽視的細節(jié)。
“曼哈頓世界中的掩模規(guī)則檢查已經(jīng)有了相當(dāng)明確的定義,但我們正在與客戶合作,以確定與曲線數(shù)據(jù)表示相關(guān)的新掩模規(guī)則,”西門子 EDA 掩模和平臺解決方案總監(jiān) Stephen Kim 說道。“我不認為這些規(guī)則已經(jīng)解決,但隨著它們的出現(xiàn),它們將鞏固約定,希望很多人都可以使用。”
這種方法的好處早已為人所知。“使用曼哈頓蒙版,您實際上會受到 MRC 約束,無法將事物添加到一起,”Brist 補充道。“當(dāng)你有四個 90° 邊緣時,你很快就會遇到這些限制,并且你可以看到那里的印刷觸點是如何受到損害的。” (見圖2)。“如果你可以進入曲線狀態(tài),那么現(xiàn)在你仍然滿足 MRC 約束。但因為它是彎曲的,所以實際上你可以在那里獲得更多的覆蓋范圍,并且你可以打印更接近目標的東西。我們看到更嚴格的 CD 控制、更少的 CD 變異性、更低的 MEEF——所有這些優(yōu)點。” (掩模誤差增強因子,或 MEEF,是晶圓上圖案化光刻膠的 CD 相對于掩模臨界尺寸的比率。)

圖 2:曼哈頓掩模比曲線掩模更受 MRC 約束的限制。
高數(shù)值孔徑 EUV 的可能拼接解決方案
采用曲線掩模的另一個挑戰(zhàn)是需要將兩個掩模縫合在一起以在晶圓上形成完整的圖像。對于高數(shù)值孔徑 EUV,半場掩模的拼接誤差是一個主要問題。
想象一下,在田野上畫一條線,無意中留下了微小的碎片或“碎片”。然后,這些微小的特征需要在后續(xù)掩模上表現(xiàn)出來。與其直接穿過田地,稍微調(diào)整線以將這些條帶包含在主多邊形內(nèi)可能更具策略性。這種方法簡化了任務(wù),使拼圖的各個部分更加協(xié)調(diào),但需要人工智能/機器學(xué)習(xí)來處理計算。
“高數(shù)值孔徑的拼接挑戰(zhàn)是眾所周知的,”imec 的 Ronse 說。“高數(shù)值孔徑的全新特點之一是鏡頭的變形特性,它限制了晶圓上打印區(qū)域的尺寸。該設(shè)計掩模上的放大倍數(shù)在一個方向上是 8 倍,而不是兩倍 4 倍。另一個方向仍然是4X。使用六英寸掩模,您只能曝光晶圓上一半的區(qū)域尺寸。如果您的芯片類似于典型的 33 x 26,則只能掃描 15 或 16 毫米,然后您需要另一個掩模來對芯片的另一面進行成像。當(dāng)然,它們必須配合在一起。這是一個大問題。從來沒有人這樣做過。”
幾家主要芯片制造公司最近提出了一種非正統(tǒng)的解決方案來解決高數(shù)值孔徑的拼接問題。基本思想是將典型的 6 x 6 英寸掩模版尺寸加倍為 6 x 12 英寸掩模,這樣可以在高數(shù)值孔徑掃描儀上一次性對整個芯片進行成像,并避免拼接的挑戰(zhàn)。但光掩模的嘎吱聲如何發(fā)生如此重大的改變并不容易。
“掩膜制造商基本上需要對更大的Blank進行書寫、清潔和編碼,而且它們必須更厚,以避免任何下垂,”Ronse 說。“它們會重得多。”
光罩公司是否會采取這種做法仍不得而知。西門子的舒爾茨表示:“人們對此持懷疑態(tài)度,也不知道該行業(yè)是否已準備好應(yīng)對這一問題。” “但共識似乎是,這更多的是一個工程問題,而不是一個科學(xué)問題。如果人們決定走這條路,那么需要幾年的時間才能到達那里。”
這就是當(dāng)今行業(yè)的現(xiàn)狀。“基本上,他們所說的是,如果整個行業(yè)在今年年底前協(xié)調(diào)一致,他們將開始開發(fā)它,”imec 的 Ronse 說。“如果行業(yè)不協(xié)調(diào),那么他們當(dāng)然不會這樣做,因為這將是一項昂貴的工作。但最重要的是你可以避免縫合。其次,吞吐量至少會提高 50%,這樣基本上就降低了成本。”
但也存在抵消因素。西門子的 Kim 補充道:“肯定會考慮到這種新光罩尺寸的重量。”他指出,這需要一些標準化規(guī)格。“這為行業(yè)提供了一些需要考慮的東西,以及可以預(yù)見的問題,以便一旦我們有了這樣的規(guī)格,就可以進行討論。”
即使大家都同意,實施起來也需要時間。“[開發(fā)]使用一組新基板處理更大掩模所需的新設(shè)備可能需要五年的開發(fā)時間,”舒爾茨補充道。“這意味著我們必須同時集中精力解決拼接問題。”
較小節(jié)點處的曲線掩模
與最初為前沿設(shè)計的其他技術(shù)一樣,最終會滲透到流程中的其他區(qū)域,曲線掩模寫入也可能會遷移到較舊的工藝。隨著技術(shù)的成熟以及晶圓廠獲得更好的曲線模型和工藝配方,曲線沒有理由不用于較舊的工藝節(jié)點。
“這取決于收益是否值得額外成本,”Fractilia 的 Mack 說。“如果有人希望在 EUV 中使用曲線掩模,那可能是因為 EUV 層證明支付更高的成本是合理的。可能有 193 層也證明支付成本是合理的,并且成本可能會隨著使用而下降 - 在這種情況下,超過 193 層可能值得使用曲線掩模。也就是說,沒有人會返回并更改已經(jīng)運行的流程,但每個新節(jié)點仍然包含大量 193 層。”
規(guī)模經(jīng)濟在某個時候就會發(fā)揮作用。“一旦曲線變得更加可用,也許隨著生成這些掩模的成本下降,您將看到曲線不僅在 EUV 和高數(shù)值孔徑中使用,”Brist 說。“它將運行在以前僅限于曼哈頓風(fēng)格功能的舊技術(shù)上。公司可以通過利用這些曲線掩模來延長現(xiàn)有工具的使用壽命,而不是在舊節(jié)點上運行多重圖案,或者甚至嘗試獲得新工具。”
這反過來又為儲蓄創(chuàng)造了更長的尾巴。“隨著行業(yè)的成熟,隨著這項技術(shù)的成熟,由于電壓和電流方面的優(yōu)勢、通孔數(shù)量的減少和成本的降低,它似乎可能會激增。” 舒爾茨補充道。
曲線的剩余挑戰(zhàn)
在曲線進入主流制造之前,還有另外兩個重大挑戰(zhàn)需要克服。一是缺乏現(xiàn)有的模型和歷史來進行精確計算。
“經(jīng)驗對我們的行業(yè)非常重要,”麥克說。“我們正在用極其復(fù)雜的工藝制造極其復(fù)雜的設(shè)備,我們依靠我們的歷史來了解什么有效、什么無效。增量變化更容易處理,因為我們可以利用我們的制造歷史來了解要注意什么和要忽略什么。但使用曲線掩模是一個足夠大的改變,需要大量學(xué)習(xí)來克服我們?nèi)狈?jīng)驗的問題。”
這種轉(zhuǎn)變需要時間、努力和廣泛的行業(yè)承諾。“通過曼哈頓設(shè)計,我們擁有了豐富的數(shù)據(jù)庫,可以利用豐富的經(jīng)驗和知識,”D2S 的 Fujimura 說道。“部落知識隨著時間的推移而積累,但我們不知道曲線的知識。對于 CD 來說,業(yè)界已經(jīng)確立了這一點:都是一樣的。因此,當(dāng)你有這些數(shù)字可供比較時,人們就會知道這是一個有意義的比較。雖然這對曲線造成了技術(shù)障礙,但它并不是“你能做到嗎?” 更多的是,‘慣例是什么?’”
曲線掩模的另一大挑戰(zhàn)是檢查。傳統(tǒng)的檢查工具針對曼哈頓設(shè)計進行了優(yōu)化,其特點是簡單的直角結(jié)構(gòu)。使用曲線掩模,復(fù)雜性呈指數(shù)級增加。這些掩模上復(fù)雜多樣的圖案使得傳統(tǒng)工具難以快速準確地識別缺陷。此外,與曲線設(shè)計相關(guān)的大量數(shù)據(jù)可能會壓垮這些工具,導(dǎo)致檢查時間更長和潛在的疏忽。隨著行業(yè)傾向于曲線掩模,迫切需要開發(fā)先進的檢測方法,以有效處理這些設(shè)計的細微差別,同時確保最高水平的準確性和精確度。
“目前,障礙是檢查,”imec 的 Ronse 說。“如果你有一個曲線掩膜,你必須檢查它,看看一切是否正確或是否存在缺陷。但檢測工具無法檢測整個板材,因為數(shù)據(jù)太多。現(xiàn)在,檢查工具正在準備接受這種新的曲線數(shù)據(jù)格式,但這可能仍然是當(dāng)今最大的問題。”
曲線掩模檢測
本質(zhì)上有兩種檢測范例。一種是芯片與芯片之間的比較。典型的掩模上有多個芯片,檢查它們的一種非常簡單的方法是將一個芯片與下一個芯片進行比較。高分辨率相機查看一個區(qū)域的圖片,查看不同芯片上同一區(qū)域的圖片并比較差異。任何差異都可能代表缺陷,因為所有圖像都應(yīng)該相同。
總是存在重復(fù)缺陷的可能性,因為每個芯片都可能具有相同的缺陷。這可能是由設(shè)計數(shù)據(jù)中的缺陷引起的。盡管如此,這些案例還是不尋常的。通常,它是隨機缺陷或源于在掩模上制作特定特征的能力的缺陷。大多數(shù)時候,所有缺陷都可以通過芯片間檢查來識別。
然而,在某些情況下,每個掩模只有一個芯片,或者在曲線設(shè)計的情況下,每個掩模有半個芯片。十個芯片之間的比較是不可能的。相反,您使用芯片到數(shù)據(jù)庫檢查,其中您擁有設(shè)計數(shù)據(jù)應(yīng)該是什么樣子的數(shù)據(jù)庫,并且您擁有實際的掩模,然后工程師進行比較。與芯片到芯片的比較相比,芯片到數(shù)據(jù)庫的比較要復(fù)雜得多,而且計算量很大。
“目前,存在三種潛在的檢查解決方案,有傳統(tǒng)的芯片對芯片檢查。然后是光化,它使用與光刻過程中使用的相同波長的光進行檢查。然后是電子束檢查,可以有兩種形式。一是他們對口罩進行電子束檢查。或者他們可以對印有掩模的晶圓進行電子束檢查。在某些方面,潛在技術(shù)太多,行業(yè)的焦點和資金可能會被稀釋。”
結(jié)論
曲線掩膜的時代已經(jīng)到來。下一步是將其引入 HVM,但這帶來了整個行業(yè)必須積極應(yīng)對的許多挑戰(zhàn)。從多光束掩模寫入器到多邊形方程以及更大掩模版的可能性,制造、計算以及改變光掩模的創(chuàng)建和使用方式的過程正在發(fā)生變化。
在最近的一次演講中,英特爾掩模操作和晶圓廠計量技術(shù)開發(fā)副總裁 Frank Abboud 稱曲線“美麗”。“它有價值。它對波形有價值。它對 OPC 引擎有價值。它具有很大的價值,我們需要讓它成為現(xiàn)實。”
編輯:黃飛
-
芯片
+關(guān)注
關(guān)注
459文章
51812瀏覽量
431888 -
人工智能
+關(guān)注
關(guān)注
1801文章
48309瀏覽量
243832 -
EUV
+關(guān)注
關(guān)注
8文章
609瀏覽量
86607
原文標題:光罩,將發(fā)生巨變
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
VirtualLab Fusion應(yīng)用:具有高數(shù)值孔徑的反射顯微鏡系統(tǒng)
光纖數(shù)值孔徑測量實驗

顯微鏡物鏡上的數(shù)值孔徑是什么意思
ASML研發(fā)更先進光刻機 高數(shù)值孔徑極紫外光刻設(shè)計基本完成
淺談高數(shù)值孔徑EUV系統(tǒng)的好處

高數(shù)值孔徑EUV的技術(shù)要求是什么

關(guān)于高數(shù)值孔徑EUV和曲線光掩模等燈具的討論
高數(shù)值孔徑 EUV技術(shù)路線圖

什么是光纖的數(shù)值孔徑,其物理意義是什么
單模光纖數(shù)值孔徑一般是多少
阿斯麥(ASML)公司首臺高數(shù)值孔徑EUV光刻機實現(xiàn)突破性成果








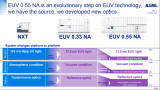











評論