在 PCT 期間,當(dāng) DUT 開啟時(shí),由于電流從漏極流向源極,DUT 溫度會(huì)升高(圖 1a)。當(dāng) DUT 關(guān)閉時(shí),通過從源極到漏極的感測(cè)電流測(cè)量體二極管壓降。通過應(yīng)用圖 1b 中所示的 V SD -T 校準(zhǔn)曲線,可以在知道體二極管壓降的情況下估算結(jié)溫 T J 。
(a) PCT 程序 - (b) VSD-T 校準(zhǔn)曲線。

圖 1:(a) PCT 程序 – (b) V SD -T 校準(zhǔn)曲線
根據(jù)文獻(xiàn) [5],在測(cè)量階段應(yīng)使用負(fù)柵極電壓。通常情況下,感測(cè)電流小于 200 mA,這可以防止在溫度測(cè)量階段自熱,也可以擺脫封裝相關(guān)劣化的影響。
調(diào)查中使用的設(shè)備
為了完成對(duì) PCT 相關(guān)體二極管可靠性的比較研究,選擇了不同的商用 SiC MOSFET(見表 I)。將進(jìn)行靜態(tài)和動(dòng)態(tài)表征以查詢體二極管特性。 DUT 的關(guān)鍵參數(shù)。

表 I:DUT 的關(guān)鍵參數(shù)
在靜態(tài)表征階段,體二極管正向電壓 V SD與 T J特性的關(guān)系是通過曲線跟蹤器和帶有氣壓熱流的氣候室確定的,施加負(fù)柵極電壓 V GS = -5V。
對(duì)于靜態(tài) I D -V SD測(cè)量,將溫度傳感器放置在與 DUT 接觸的位置以測(cè)量確切的外殼溫度,該溫度以 15°C 的間隔從 25°C 逐漸變化到 130°C。由于 MOSFET 的 V SD的反向壓降與溫度有關(guān),并且在低電流 (200mA) 和高電流 (800mA) 下都表現(xiàn)出很強(qiáng)的線性,圖 2 和圖 3 表明該壓降是TJ測(cè)量的良好候選者。 所有供應(yīng)商在 200 mA 時(shí)的 VSD-T 曲線。
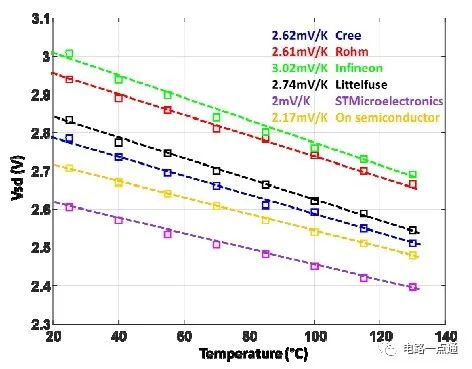
圖 2:所有供應(yīng)商在 200 mA 時(shí)的V SD -T 曲線 所有供應(yīng)商的 VSD-T 曲線均為 800 mA。
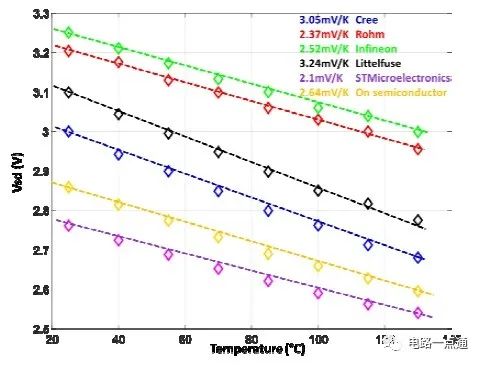
圖 3:所有供應(yīng)商在 800 mA 時(shí)的V SD -T 曲線
為了測(cè)量開關(guān)參數(shù)和評(píng)估DUT的動(dòng)態(tài)行為,使用了雙脈沖測(cè)試方法。設(shè)置如圖 4 所示。三個(gè) IsoVu 探頭用于使用平面分布式分流方法測(cè)量 V GS、V DS和 I DS 。 雙脈沖測(cè)試裝置。
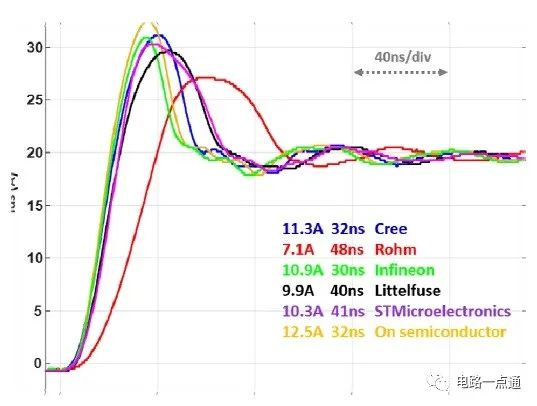
圖 4:雙脈沖測(cè)試設(shè)置
通過該測(cè)試,可以測(cè)量反向恢復(fù)時(shí)間 (trr) 和峰值反向恢復(fù)電流 (Irrm) 等動(dòng)態(tài)特性。這些參數(shù)是在限制帶寬 200 MHz 時(shí)測(cè)得的,如圖 5 所示。 開啟時(shí)的 ID 波形。
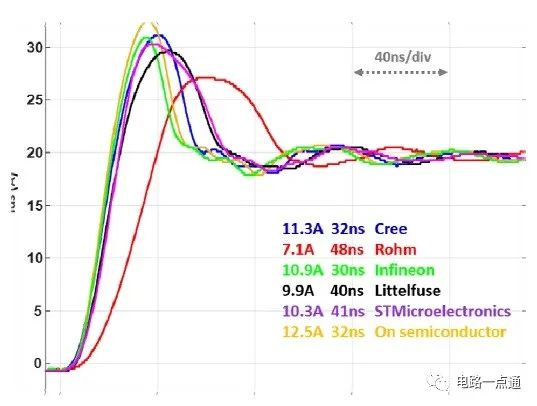
圖 5:開啟時(shí)的I D波形
測(cè)試條件
為了檢驗(yàn) SiC MOSFET 在功率循環(huán)測(cè)試下的可靠性,對(duì)每個(gè) DUT 的體二極管進(jìn)行了壓力測(cè)試。為防止亞閾值效應(yīng),保證MOS通道完全夾斷,測(cè)試時(shí)采用了-5V的柵源電壓。每個(gè)制造商的總共三個(gè) DUT 在以下測(cè)試條件下測(cè)試約 50 小時(shí):
I SD1 =200mA,外殼溫度=130°C
I SD2 =800mA,外殼溫度=130°C I SD3 =2A,外殼溫度=130°C
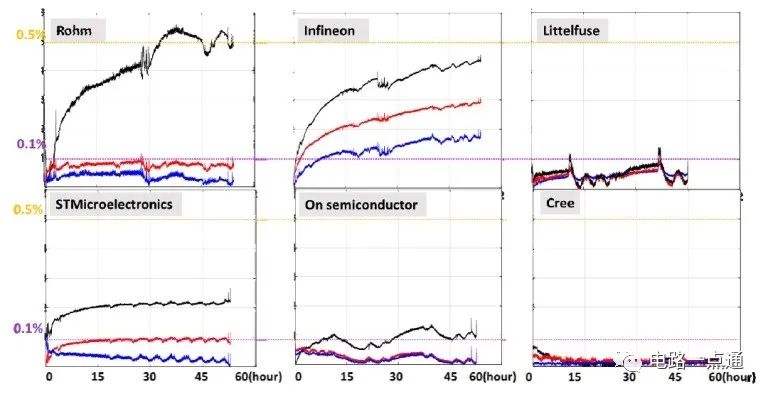
圖 6 顯示了每次測(cè)試的結(jié)果。如圖所示,來自不同制造商的 DUT 表現(xiàn)出不同的行為。正向壓降 V SD在壓力測(cè)試后有所增加,同時(shí)振蕩也表現(xiàn)出輕微的偏移。
不同負(fù)載電流下的壓力測(cè)試結(jié)果。
圖6:不同負(fù)載電流下的壓力測(cè)試結(jié)果
以上結(jié)果表明,在相同的測(cè)試條件下,平面SiC MOSFET體二極管的浪涌可靠性優(yōu)于溝槽SiC MOSFET體二極管。
圖7和圖8分別為Rohm和Infineon DUT測(cè)試前后的V SD -T校準(zhǔn)曲線。對(duì)于英飛凌的 DUT,在 2A 應(yīng)力和 800mA 感應(yīng)電流的情況下,Tj 差異可高達(dá)約 18°C,而在 200mA 應(yīng)力和 200mA 感應(yīng)電流的情況下,Tj 差異可低至約 3°C。對(duì)于 Rohm 的 DUT,只有 DUT3 的 V SD -T 曲線顯示出明顯的偏移,Tj 差異約為 10°C。由于這種影響,溫度估計(jì)會(huì)產(chǎn)生錯(cuò)誤的結(jié)果,從而提供不準(zhǔn)確的壽命估計(jì)。 Rohm 的 DUT 在壓力測(cè)試前后的 VSD-T 曲線。

圖 7:Rohm 的 DUT 在壓力測(cè)試前后的V SD -T 曲線 壓力測(cè)試前后英飛凌 DUT 的 VSD-T 曲線。

圖 8:壓力測(cè)試前后英飛凌 DUT 的V SD -T 曲線
對(duì) Rohm、Infineon 和 STMicroelectronics 的 DUT 進(jìn)行了 2A 應(yīng)力的雙脈沖測(cè)試。根據(jù)圖 6,這三個(gè) DUT 在 2A 應(yīng)力的情況下顯示 VSD 顯著增加。對(duì)于所有 DUT,反向恢復(fù)峰值和總反向恢復(fù)電荷在 2A 應(yīng)力后顯著降低。
低側(cè)開關(guān)的導(dǎo)通電流波形如圖 9 所示。很明顯,在 2A 的壓力下,所有 DUT 的反向恢復(fù)峰值和總體反向恢復(fù)電荷都低得多。 2A 壓力測(cè)試前后體二極管的反向恢復(fù)。
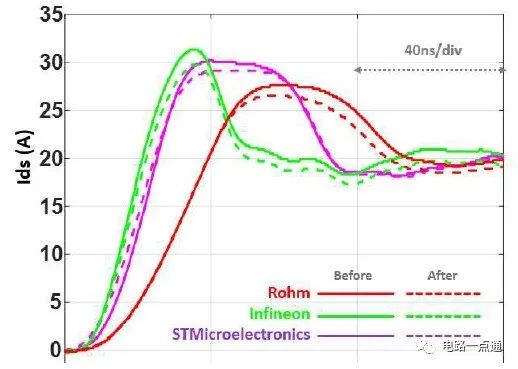
圖 9:2A 壓力測(cè)試前后體二極管的反向恢復(fù)
結(jié)論
當(dāng) DUT 的體二極管開始退化時(shí),電壓降 V SD總是可以被認(rèn)為是退化指示,因?yàn)樗@示上升趨勢(shì)。
但是,長(zhǎng)期的壓力和高溫可能會(huì)導(dǎo)致 V SD -T 校準(zhǔn)曲線上升。在體二極管正向應(yīng)力測(cè)試下,對(duì)來自六家不同制造商的商用 1200 V SiC MOSFET(其中兩家采用溝槽柵極結(jié)構(gòu),四種采用平面柵極結(jié)構(gòu))進(jìn)行了檢查。實(shí)驗(yàn)結(jié)果表明,隨著 V SD的增加和反向恢復(fù)電流峰值的降低,雙極退化。當(dāng)應(yīng)用于具有柵極溝槽結(jié)構(gòu)的 DUT 時(shí),效果似乎更明顯。在相同的測(cè)試條件下,V SD -T 技術(shù)中平面 SiC MOSFET 的體二極管比溝槽 SiC MOSFET 更可靠。
審核編輯:湯梓紅
-
二極管
+關(guān)注
關(guān)注
148文章
9947瀏覽量
169237 -
MOSFET
+關(guān)注
關(guān)注
148文章
7729瀏覽量
216615 -
PCT
+關(guān)注
關(guān)注
0文章
35瀏覽量
18810 -
DUT
+關(guān)注
關(guān)注
0文章
190瀏覽量
12665
原文標(biāo)題:1200 V SiC MOSFET 的二極管可靠性研究
文章出處:【微信號(hào):電路一點(diǎn)通,微信公眾號(hào):電路一點(diǎn)通】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
美高森美推出碳化硅(SiC)材料和技術(shù)的全新1200V肖特基二極管
SiC-MOSFET體二極管特性
SiC-SBD的特征以及與Si二極管的比較
SiC-MOSFET的可靠性
羅姆成功實(shí)現(xiàn)SiC-SBD與SiC-MOSFET的一體化封裝
600V碳化硅二極管SIC SBD選型
650V/1200V碳化硅肖特基二極管如何選型
碳化硅SiC MOSFET:低導(dǎo)通電阻和高可靠性的肖特基勢(shì)壘二極管
GeneSiC的1200V SiC肖特基二極管可實(shí)現(xiàn)更快的開關(guān)瞬變
具有溫度不變勢(shì)壘高度和理想因數(shù)的GeneSiC 1200V SiC肖特基二極管
Fairchild針對(duì)高速光伏逆變器和苛刻工業(yè)應(yīng)用發(fā)布1200V SiC二極管
探究快速開關(guān)應(yīng)用中SiC MOSFET體二極管的關(guān)斷特性

派恩杰半導(dǎo)體1200V 400A系列半橋62mm封裝模塊 內(nèi)置二極管提升高頻應(yīng)用可靠性
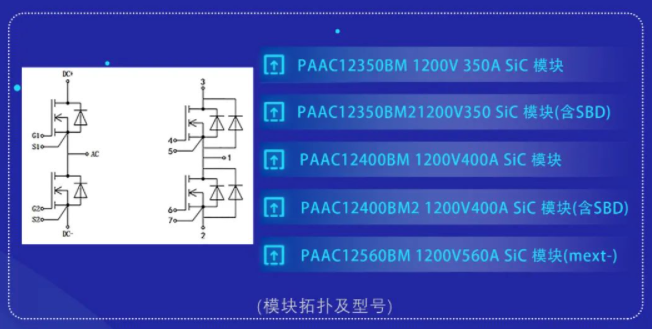




















評(píng)論