完善資料讓更多小伙伴認識你,還能領(lǐng)取20積分哦,立即完善>
電子發(fā)燒友網(wǎng)技術(shù)文庫為您提供最新技術(shù)文章,最實用的電子技術(shù)文章,是您了解電子技術(shù)動態(tài)的最佳平臺。
高溫焊接回流導(dǎo)致內(nèi)部積聚的濕氣蒸發(fā)并對不穩(wěn)固?的表面造成分層 如果內(nèi)部蒸汽壓力超過塑料能承受的強度,就會出現(xiàn)- -個破裂。...

先進封裝技術(shù)以SiP、WLP、2.5D/3D為三大發(fā)展重點。先進封裝核心技術(shù)包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術(shù)的組合各廠商發(fā)展出了滿足多樣化需求的封裝解決方案,SiP系統(tǒng)級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發(fā)展重點。...

本文著重分析智能制造系統(tǒng)中的人機協(xié)同需求與人機交互鴻溝,從行為、意圖、認知三個層次闡述人因工程在縮小人機交互鴻溝、實現(xiàn)人機協(xié)作中的重要性,并在此基礎(chǔ)上結(jié)合數(shù)字孿生、混合現(xiàn)實等先進技術(shù)的發(fā)展與應(yīng)用,提出面向智能制造的人機交互的人因工程發(fā)展建議。...

Chiplet也稱芯粒,通俗來說Chiplet模式是在摩爾定律趨緩下的半導(dǎo)體工藝發(fā)展方向之一,是將不同功能芯片裸片的拼搭...
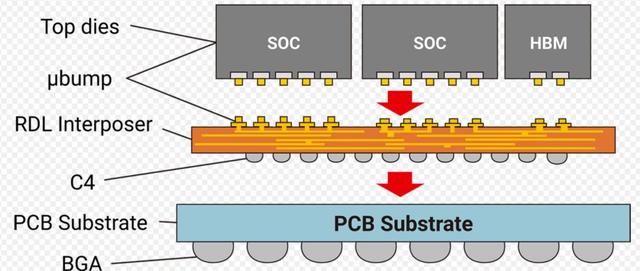
有機基板的材料主要由類似 PCB 的材料和編織玻璃層壓板制成,允許通過芯片路由相當多的信號,包括基本的小芯片設(shè)計,例如英特爾的移動處理器(具有單獨的 PCH 和 CPU 芯片)以及 AMD 基于小芯片的 Zen 處理器。...

統(tǒng)一的工作流程,包括分區(qū)、樓層規(guī)劃、系統(tǒng)級設(shè)計。 互連線、路徑探索及可行性分析。有能力 從多個來源創(chuàng)建抽象包模型和虛擬模具模型...

表面組裝元器件的外貌,從廣。義上來講基本_上都是片狀形式的,包括薄片矩形、正方形、圓柱形、扁平異形等。所以業(yè)內(nèi)常把它們稱之為片狀元器件、貼片元器件。表面組裝元器件和傳統(tǒng)的插裝元器件樣,可以從功能上將它們分為表面組裝元件(SMC)、表面組裝器件(SMD)。...

集成電路封裝是指將制備合格芯片、元件等裝配到載體上,采用適當連接技術(shù)形成電氣連接,安裝外殼,構(gòu)成有效組件的整個過程,封裝主要起著安放、固定、密封、保護芯片,以及確保電路性能和熱性能等作用。...


其實三種集成名字不同,但都是同一一個目的,那就是把無源器件和有源器件集成在同一個芯片.上。因為硅是間接帶隙材料不能發(fā)光,所以不可避免的需要三五族材料作為光 源,但硅基材料由于晶格失配又很難與三五族材料集成在一一個芯片上,所以衍生了以上幾種概念。...
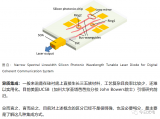
Chiplet技術(shù)背景下,可將大型單片芯片劃分為多個相同或者不同小芯片,這些小芯片可以使用相同或者不同工藝節(jié)點制造,再通過跨芯片互聯(lián)及封裝技術(shù)進行封裝級別集成,降低成本的同時獲得更高的集成度。...

為了證明該技術(shù)的有效性,英特爾發(fā)布了一款全功能測試芯片,該芯片采用 75um TGV,長寬比為 20:1,核心厚度為 1 毫米。雖然測試芯片是客戶端設(shè)備,但該技術(shù)最初將用于構(gòu)建面向數(shù)據(jù)中心的處理器...

前提是都需要一定的空間,如你開始描述的裝配方式,一般僅僅調(diào)試時臨時搭接,而且硅橡膠粘接和灌封效果幾乎一樣,震動量級大了沒用,而且加上熱膨脹應(yīng)力存在,你們這種‘垂直貼焊’不可靠,斷裂不出意外也是斷在芯吸終點位置。...

歐洲極紫外光刻(EUVL)技術(shù)利用波長為13.5納米的光子來制造集成電路。產(chǎn)生這種光的主要來源是使用強大激光器產(chǎn)生的熱錫等離子體。激光參數(shù)被調(diào)整以產(chǎn)生大多數(shù)在13.5納米附近發(fā)射的錫離子(例如Sn10+-Sn15+)。...

扇出型晶圓級封裝技術(shù)采取在芯片尺寸以外的區(qū)域做I/O接點的布線設(shè)計,提高I/O接點數(shù)量。采用RDL工藝讓芯片可以使用的布線區(qū)域增加,充分利用到芯片的有效面積,達到降低成本的目的。扇出型封裝技術(shù)完成芯片錫球連接后,不需要使用封裝載板便可直接焊接在印刷線路板上,這樣可以縮短信號傳輸距離,提高電學(xué)性能。...

一些半導(dǎo)體器件集成了專用的熱二極管,根據(jù)校準后的正向電壓與溫度曲線精確測量結(jié)溫。由于大多數(shù)器件沒有這種設(shè)計,結(jié)溫的估計取決于外部參考點溫度和封裝的熱阻參數(shù)。常用的封裝熱指標是熱阻和熱表征參數(shù)。...

在半導(dǎo)體制程工藝中,有很多不同名稱的用于移除多余材料的工藝,如“清洗”、“刻蝕”等。如果說“清洗”工藝是把整張晶圓上多余的不純物去除掉,“刻蝕”工藝則是在光刻膠的幫助下有選擇性地移除不需要的材料,從而創(chuàng)建所需的微細圖案。半導(dǎo)體“刻蝕”工藝所采用的氣體和設(shè)備,在其他類似工藝中也很常見。...
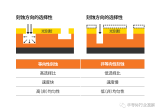
碳化硅(silicon carbide,SiC)功率器件作為一種寬禁帶器件,具有耐高壓、高溫,導(dǎo)通電阻低,開關(guān)速度快等優(yōu)點。如何充分發(fā)揮碳化硅器件的這些優(yōu)勢性能則給封裝技術(shù)帶來了新的挑戰(zhàn):傳統(tǒng)封裝雜散電感參數(shù)較大,難以匹配器件的快速開關(guān)特性;器件高溫工作時,封裝可靠性降低;以及模塊的多功能集成封裝與...

SSMB就產(chǎn)生了和FEL類似的“微聚束”,但是關(guān)鍵還加上了“穩(wěn)態(tài)”。FEL不是穩(wěn)態(tài),電子團在波蕩器里自由互相作用,最后發(fā)出強光完事。SSMB是讓電子束在存儲環(huán)里繞圈,這樣就有可能是“穩(wěn)態(tài)”的,對于重復(fù)發(fā)光很重要。也就是兩個特性結(jié)合:微聚束的相干輻射發(fā)強光 + 存儲環(huán)高重頻。...
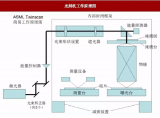
先進封裝增速高于整體封裝,將成為全球封裝市場主要增量。根據(jù)Yole的數(shù)據(jù),全球封裝市場規(guī)模穩(wěn)步增長,2021 年全球封裝 市場規(guī)模 約達 777 億美元。其中,先進封裝全球市場規(guī)模約 350 億美元,占比約 45%, 2025 年,先進封裝在全部封裝市場的 占比將增長至 49.4%。...
