根據(jù)產(chǎn)業(yè)研究機(jī)構(gòu)Yole Développement(Yole)的研究指出,像HBM和CIS這樣的硬件創(chuàng)造了TSV的大部分收入。2023年整體堆疊技術(shù)市場(chǎng)將超過(guò)57億美元,年復(fù)合成長(zhǎng)率(CAGR)為27%,2.5D/3D TSV和晶圓級(jí)封裝技術(shù)中,消費(fèi)市場(chǎng)是最大的貢獻(xiàn)者,市場(chǎng)比重超過(guò)65%。高效能運(yùn)算(HPC)是立體構(gòu)裝技術(shù)的真正驅(qū)動(dòng)力,并且將呈現(xiàn)高度成長(zhǎng)到2023年,市場(chǎng)占有率從2018年的20%增加到2023年的40%。汽車(chē)、醫(yī)療和工業(yè)等領(lǐng)域的應(yīng)用將是主力。

而消費(fèi)性、高效能運(yùn)算與網(wǎng)絡(luò)(HPC & Network)、汽車(chē)、工業(yè)與醫(yī)療則是最主要的應(yīng)用領(lǐng)域,其中消費(fèi)性應(yīng)用還是占據(jù)最大的規(guī)模,市場(chǎng)將從2018年的11億7600萬(wàn)美元,成長(zhǎng)至27億2200萬(wàn)美元,CAGR 18%,而高效能運(yùn)算則將從3億5000萬(wàn)美元成長(zhǎng)至23億3200萬(wàn)美元,CAGR高達(dá)46%,是成長(zhǎng)率最高的應(yīng)用,車(chē)用市場(chǎng)8100萬(wàn)美元成長(zhǎng)至2億5200萬(wàn)美元,CAGR 25%,工業(yè)與醫(yī)療應(yīng)用合計(jì)將從2018年的1億5000萬(wàn)美元,成長(zhǎng)至2023年的4億5200萬(wàn)美元,CAGR也是25%
-
立體堆疊技術(shù)
+關(guān)注
關(guān)注
0文章
2瀏覽量
8404
原文標(biāo)題:2023年2.5D/3D封裝產(chǎn)業(yè)規(guī)模達(dá)57.49億美元
文章出處:【微信號(hào):SEMI2025,微信公眾號(hào):半導(dǎo)體前沿】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
2.5D/3D封裝技術(shù)升級(jí),拉高AI芯片性能天花板
未來(lái)十年3D打印無(wú)人機(jī)市場(chǎng)規(guī)模及預(yù)測(cè)

3D打印技術(shù),推動(dòng)手板打樣從概念到成品的高效轉(zhuǎn)化
最全對(duì)比!2.5D vs 3D封裝技術(shù)
預(yù)計(jì)汽車(chē)半導(dǎo)體市場(chǎng)規(guī)模2029年將增至1000億美元

技術(shù)資訊 | 2.5D 與 3D 封裝

一文理解2.5D和3D封裝技術(shù)

SoC芯片市場(chǎng)前景廣闊,2029年規(guī)模將超2000億美元
扇出型 (Fan-Out)封裝市場(chǎng)規(guī)模到2028 年將達(dá)到38 億美元
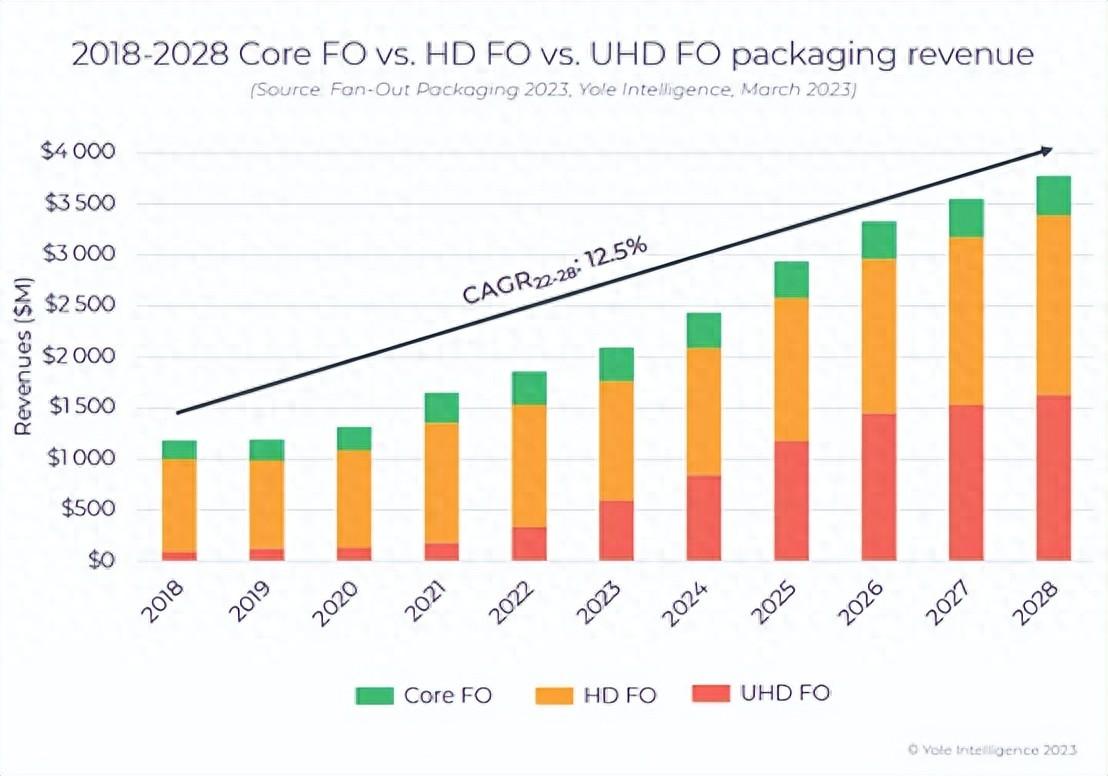
2030年GaN功率元件市場(chǎng)規(guī)模將超43億美元
探秘2.5D與3D封裝技術(shù):未來(lái)電子系統(tǒng)的新篇章
AI應(yīng)用致復(fù)雜SoC需求暴漲,2.5D/Chiplet等先進(jìn)封裝技術(shù)的機(jī)遇和挑戰(zhàn)





 2.5D/3D封裝產(chǎn)業(yè)規(guī)模2023年整體堆疊技術(shù)市場(chǎng)將超過(guò)57億美元,年復(fù)合成長(zhǎng)率(CAGR)為27%
2.5D/3D封裝產(chǎn)業(yè)規(guī)模2023年整體堆疊技術(shù)市場(chǎng)將超過(guò)57億美元,年復(fù)合成長(zhǎng)率(CAGR)為27%












評(píng)論