來源:大米的老爹
芯片封裝是半導體制造的關鍵環節,承擔著為芯片提供物理保護、電氣互連和散熱的功能,這其中的鍵合技術(Bonding)就是將晶圓芯片固定于基板上。
目前主要有四種鍵合技術:傳統而可靠的引線鍵合(Wire Bonding)、性能優異的倒裝芯片鍵合(Flip Chip Bonding)、可靠性更高的熱壓鍵合(TCB,Thermal Compression Bonding),以及代表未來趨勢的混合鍵合(Hybrid Bonding)技術。

01 引線鍵合(Wire Bonding)
引線鍵合是應用最廣泛的鍵合技術,它利用熱、壓力或超聲波,通過細金屬引線(金、鋁、銅)將芯片的焊盤與基板(一般是引線框架或PCB)的焊盤連接起來。
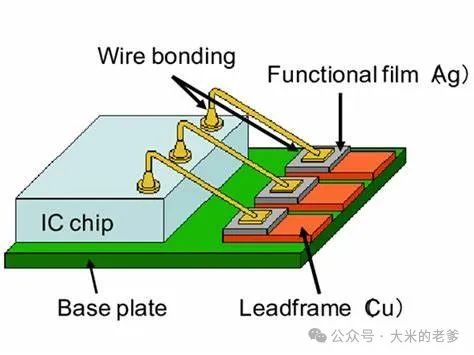
引線鍵合工藝要求鍵合焊區的凸點電極沿芯片四周邊緣分布,引線的存在也需要塑封體提供保護,從而增加了體積,阻礙了芯片工作時熱量的散發。隨著器件小型化和復雜化,傳統封裝使用的引線鍵合工藝逐漸難以滿足行業需求。
02 倒裝鍵合(Flip Chip Bonding)
倒裝鍵合起源于20世紀60年代,由IBM率先研發出來,是將芯片功能區朝下以倒扣的方式背對著基板,通過焊料凸點(簡稱Bump)與基板進行互聯。
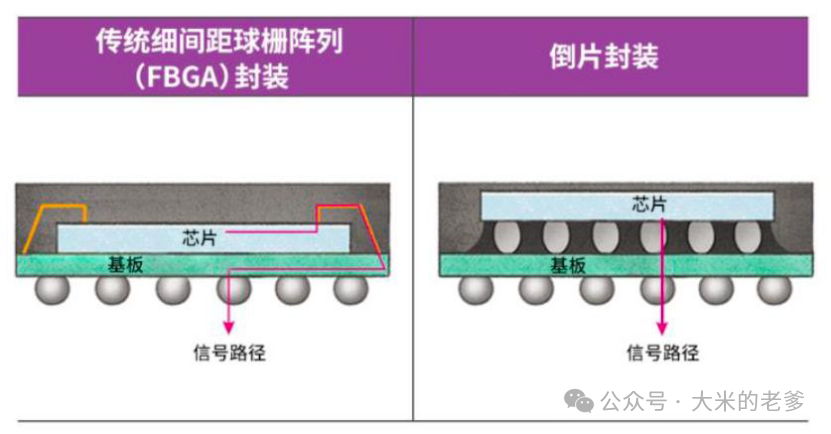
與傳統的引線鍵合技術相比,倒裝芯片鍵合的優勢有:
① 通過再布線(RDL)實現面陣分布,單位面積內的I/O密度更高;
② 互聯通路變短,信號完整性、頻率特性更好;
③ 倒裝芯片沒有塑封體,芯片背面可用散熱片等進行有效的冷卻,散熱能力提高。
基礎的倒裝芯片常采用回流焊作為鍵合方案(回流溫度的峰值一般控制在240oC到260oC),一個回流焊爐同時可以容納很多加工產品,所以整體的吞吐量還是非常高的。
但是由于整個芯片封裝都放入回流爐中,芯片、基板、焊球以不同的速率膨脹,從而發生翹曲導致芯片不能很好的被粘合,而且熔融焊料會擴散到其指定區域之外,相鄰焊盤之間出現不必要的電連接造成短路,芯片良率降低。
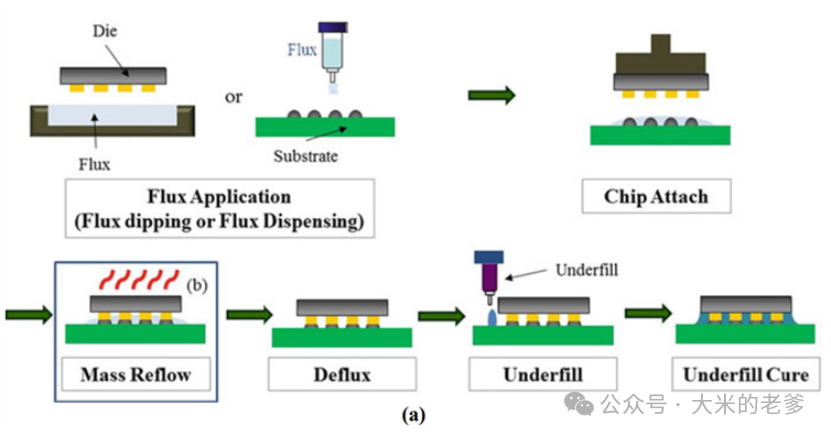
(常見的回流焊芯片鍵合流程)

(常見的回流焊溫度控制)
03 熱壓鍵合(Thermal Compression Bonding)
區別于回流焊,熱壓鍵合(TCB)僅從芯片側對Bump升溫加壓,使其與基板實現物理連接。
TCB典型的工藝溫度范圍在150oC-300oC之間,壓力水平在10-200MPa之間。這種鍵合方式確保均勻粘合,沒有間隙變化或傾斜,減少了基板翹曲問題(因為事先將噴涂了助焊劑的基板牢牢固定在真空板上且整體溫度不高),可以允許I/O間距縮小到更小的尺寸(10μm 左右)。英特爾公司最早選擇了基于基板(Substrate)的熱壓鍵合工藝以替代傳統的回流焊, 由英特爾和ASMPT公司聯合開發,并于2014年導入量產。
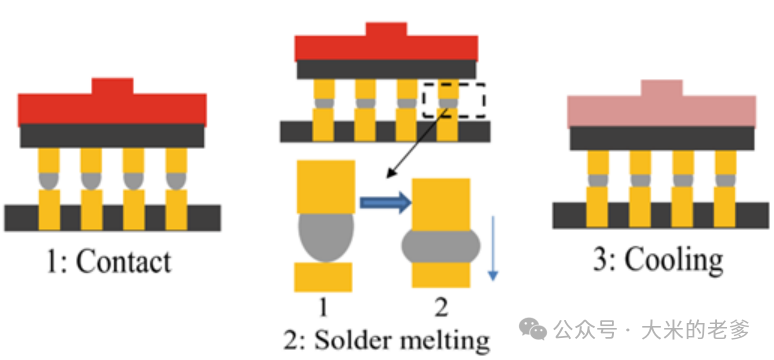
標準的 TCB 工藝還需要使用可去除銅氧化物的涂層助焊劑來降低鍵合互連故障。但當互連間距縮小到 10μm 以下時,助焊劑會變得更難清除,并會留下粘性殘留物,這會導致互連發生微小變形,從而造成腐蝕和短路。所以,庫力法索于2023年推出無助焊劑鍵合技術(Fluxless Bonding),在真空或惰性氣體環境(如氮氣或氬氣)中運行,以防止鍵合過程中發生氧化。
04 混合鍵合(Hybrid Bonding)
倒裝鍵合和熱壓鍵合都使用某種帶焊料的凸塊作為硅與封裝基板之間的互連,但Bump間距受到物理上的限制,無法滿足3D內存堆棧和異構集成需要極高的互連密度,因此混合鍵技術被開發出來。
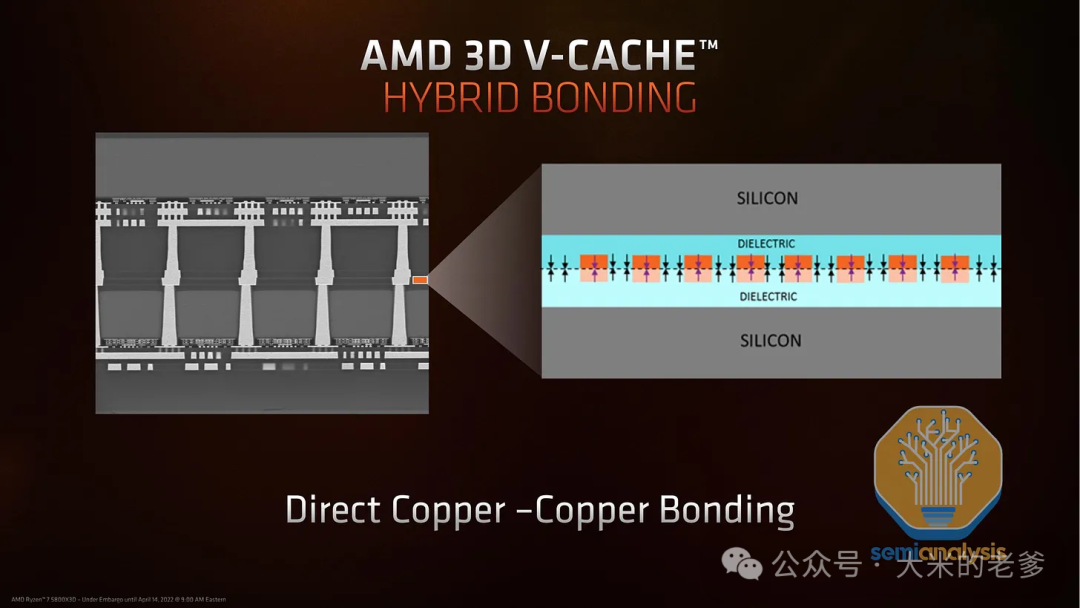
混合鍵合是一種新型的三維集成封裝技術,通過同時實現金屬鍵合(Cu-Cu)和介質鍵合(氧化物-氧化物),在晶圓或芯片級別直接進行物理和電氣連接。通俗來說就是可以將兩片晶圓(Wafer)直接連接起來,也可以把晶粒(Die)直接封裝到晶圓上。這種技術無需傳統的銅柱或錫球等Bump結構,可實現實現超細互連間距(<1μm)的連接,互連密度極高。且鍵合界面平整度好,可實現更薄的晶圓堆疊,有利于3D集成。目前,HBM3普遍使用熱壓鍵合技術,韓系大廠預計從HBM4開始導入混合鍵合。
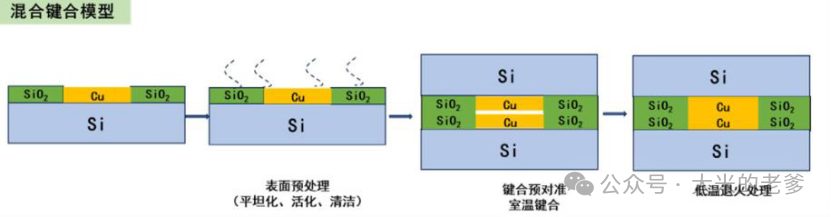
典型的Cu/SiO2 混合鍵合主要包括三個關鍵工藝步驟。
(1)鍵合前預處理:晶圓需經過化學機械拋光/ 平坦化(CMP)和表面活化及清洗處理,實現平整潔凈且親水性表面;
(2)兩片晶圓預對準鍵合:兩片晶圓鍵合前進行預對準,并在室溫下緊密貼合后介質SiO2 上的懸掛鍵在晶圓間實現橋連,形成SiO2 -SiO2 間的熔融鍵合,此時,金屬Cu 觸點間存在物理接觸或凹陷縫隙(dishing),未實現完全的金屬間鍵合;
(3)鍵合后熱退火處理:通過后續熱退火處理促進了晶圓間介質SiO2 反應和金屬Cu 的互擴散從而形成永久鍵合。
混合鍵合的工藝難點主要在于光滑度、清潔度和對準精度。
-
半導體
+關注
關注
335文章
28315瀏覽量
229876 -
晶圓
+關注
關注
52文章
5076瀏覽量
128989 -
芯片封裝
+關注
關注
11文章
561瀏覽量
31136 -
鍵合
+關注
關注
0文章
75瀏覽量
8034
原文標題:芯片封裝涉及到的四種鍵合方式
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
PADS封裝中的四種庫
優化封裝之鍵合線封裝中的兩個主要不連續區
混合鍵合技術:開啟3D芯片封裝新篇章




























評論