來源:版圖設計LayoutArt,作者:JK_LayoutArt
在之前文章如何計算芯片(Die)尺寸?中,討論了Die尺寸的計算方法,在本文中,將討論如何預估一個晶圓中有多少Die,也就是DPW(Die per Wafer)。
在具體討論如何預估一個晶圓中有多少Die之前,需要問一個問題:為什么要預估一個晶圓中有多少Die?
這又是一個關于成本考慮的問題。一般來說,在一個項目立項時,除了評估這個芯片需要具備哪些功能,需要達到什么性能,還需要評估做這個項目的收益如何。根據估算的DPW,晶圓價格,類似功能芯片等信息,去評估這個項目值不值得做。
需要注意的是,這里計算DPW用的是預估,因為除了我們畫好的版圖尺寸是確定的,決定DPW的還有其他很多參數,比如工藝監測結構PCM大小,放Wafer信息的面積,圈邊的尺寸等等。
在不同的Fab廠商,即使是相同規格的晶圓,版圖尺寸一樣的(比如相同工藝節點,不同工藝廠家的工藝Porting),DPW也會不一樣。
用一個簡單的公式,看一下決定DPW大致有哪些參數;

d:晶圓的直徑
WEdge :晶圓邊緣去除的寬度
W:Die的長度
H:Die的寬度。
有些計算DPW的網站,是基于以下公式計算:

從上面公式中,可以很直觀的看到,決定一個晶圓上有多少Die,與晶圓的直徑,芯片的面積,晶圓邊緣去除的尺寸有關。
晶圓面積
晶圓面積和晶圓的規格有關,比如常用的晶圓尺寸200mm,300mm的,也就是我們常說的8英寸、12英寸晶圓。根據該尺寸,可以得到晶圓的面積。
芯片面積
芯片面積,和我們設計的芯片大小有關。這里面需要注意劃片槽的尺寸(即切割道寬度),在如何計算芯片(Die)尺寸?中提到,根據劃片能力,以及Fab廠的要求來看,這是個可變的參數。此處的芯片面積不需要去除之前文章中提到的切割損耗的尺寸。
邊緣損失
在晶圓生產中,晶圓邊緣的厚度不均,機械應力等,導致邊緣區域有缺陷,一般會去除3mm到5mm,。比如200mm晶圓(8寸),去除5mm,晶圓的有效直徑就只有190mm,損失大概9.75%;300mm晶圓(12寸),去除5mm,晶圓的有效直徑就只有290mm,損失大概6.56%的面積;從上面兩個規格晶圓,去除相同尺寸的邊緣后,300mm比200mm的晶圓損失的少,可利用率更高。
DPW計算器
大部分情況,我們只需知道大概怎么計算就可以。在工作中,通常可以找DPW計算器計算。比如以下幾個計算DPW的網址:
1. https://www.innotronix.com.cn/?page_id=1766
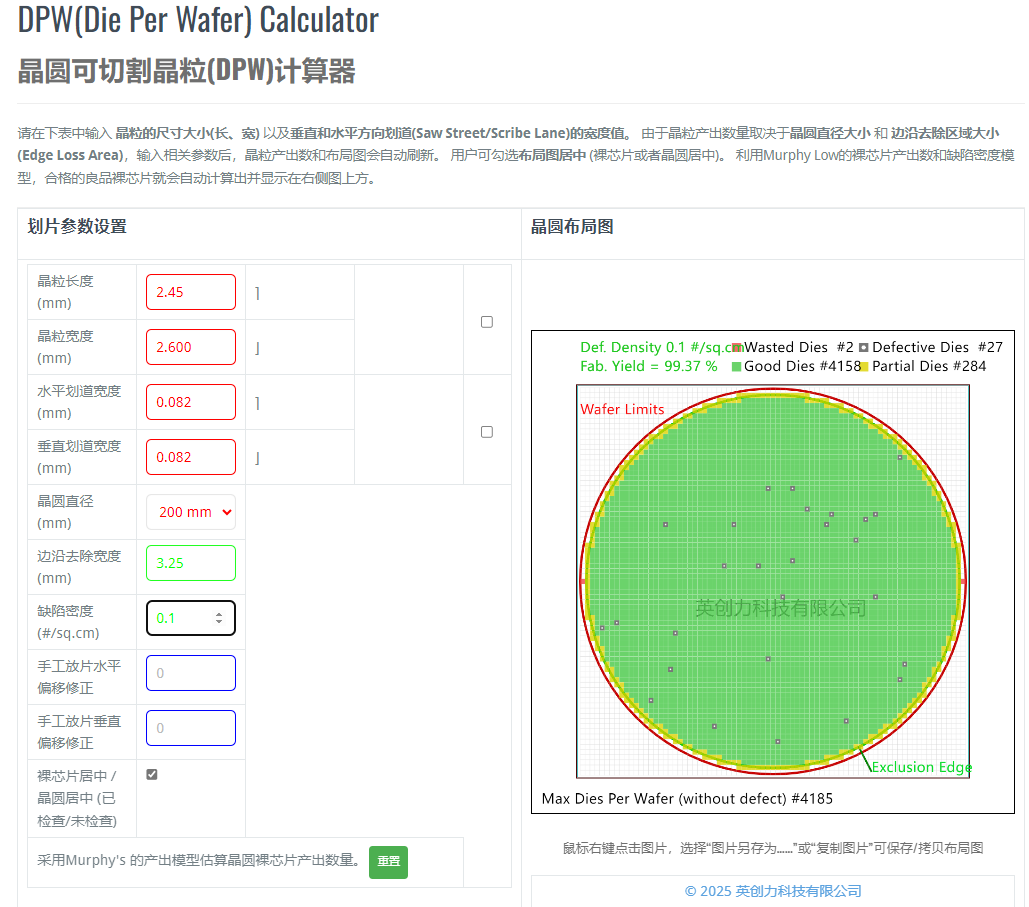
2. http://silicon-edge.co.uk/j/index.php/resources/die-per-wafer

3. https://anysilicon.com/die-per-wafer-formula-free-calculators/

4. Fab廠提供的DPW計算器。
大家也可以在網上找其他的DPW計算器,然后和Fab廠反饋回來的Wafer信息比對,挑選一個計算比較接近的計算器。
-
芯片
+關注
關注
459文章
51891瀏覽量
433215 -
晶圓
+關注
關注
52文章
5076瀏覽量
128972 -
工藝
+關注
關注
4文章
654瀏覽量
29146
原文標題:如何預估一個晶圓中有多少Die?
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦




















評論