概述
HMC264LM3是一款集成LO放大器的20 - 30 GHz表貼次諧波(x2) MMIC混頻器,采用SMT無引腳芯片載體封裝。 在25至35 dB時,2LO至RF隔離性能出色,無需額外濾波。 LO放大器采用單偏置(+3V至+4V)雙級設計,僅需-4 dBm的驅動。 所有數據均通過安裝在50 ?測試夾具中的非密封型、環氧樹脂密封LM3封裝器件獲取。 采用HMC264LM3即無需線焊,從而為客戶提供一致的接口。
數據表:*附件:HMC264LM3次諧波混頻器,采用SMT封裝技術手冊.pdf
應用
特性
- 集成LO放大器: -4 dBm輸入
- 次諧波(x2) LO
- 高2LO/RF隔離: 35 dB
- LM3 SMT封裝
框圖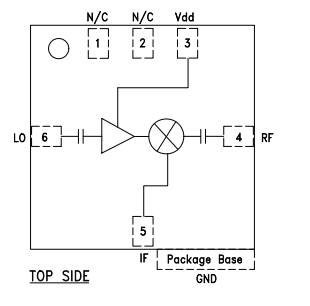
電氣規格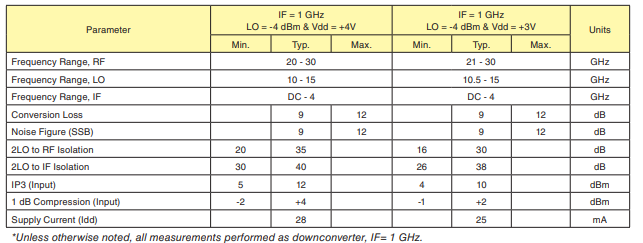
外形圖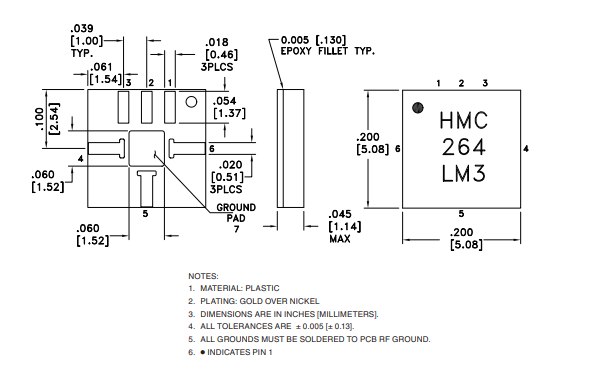
引腳描述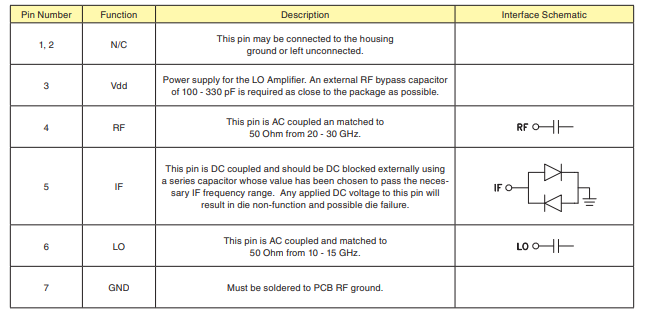
評估PCB
HMC264LM3推薦的表面貼裝技術
用于表面貼裝的LM3毫米波封裝的準備與操作
HMC LM3封裝設計為與大批量表面貼裝印刷電路板(PCB)組裝工藝兼容。LM3封裝需要特定的安裝圖案,以實現機械連接,并優化毫米波頻率下的電氣性能。此PCB布局圖案可在每個LM3產品數據手冊中找到。也可應Hittite銷售與應用工程部門的要求,以電子圖紙形式提供。
遵循以下預防措施,以免造成永久性損壞:
- 清潔度 :遵守正確的操作程序,確保PCB和LM3器件保持清潔。在元件放置之前,LM3器件應一直置于原始包裝中,以防止射頻、直流和接地接觸受到污染或損壞。
- 靜電敏感度 :遵循靜電防護措施,防止靜電沖擊。
- 一般操作 :使用真空吸筆從頂部抓取LM3封裝,或使用鋒利的彎頭鑷子沿邊緣操作。避免損壞封裝底部的射頻、直流和接地接觸點。請勿對蓋子施加過大壓力。
焊料材料和溫度曲線
遵循應用說明中的相關信息。不建議手工焊接,也不建議使用導電環氧連接。
焊膏
應根據用戶經驗選擇焊膏,且焊膏需與所用的金屬化系統兼容。有關引腳和接地接觸點金屬化方案,請參見LM3數據手冊中的外形圖。
焊膏涂覆
通常使用模板印刷機或點涂方式將焊膏涂覆到PCB上。焊膏的用量取決于PCB和元件的布局,應加以控制,以確保穩定的機械和電氣性能。過多的焊料可能會在高頻下產生不必要的電氣寄生效應。
回流焊接
焊接過程通常通過回流爐完成,也可采用汽相焊接工藝。建議的回流焊接溫度曲線如上圖所示。
在進行熱模擬之前,應使用與實際組件相同的質量來測量溫度曲線。熱電偶應放置在電路板的不同位置,以考慮邊緣和角落效應以及元件質量的差異。最終的溫度曲線應通過將熱電偶安裝在器件位置來確定。
遵循焊膏供應商的建議,制定標準回流焊接溫度曲線。溫度應從室溫平穩上升到預熱溫度,以避免熱沖擊造成的損壞。達到預熱溫度后,應留出足夠時間使焊膏中的溶劑蒸發并激活助焊劑。回流前,熱電偶應完全驅動關閉。回流峰值溫度的持續時間不應超過15秒。封裝需經過測試,以確保能承受235°C的峰值溫度15秒。驗證該曲線不會使暴露的接地層溫度超過235°C。
-
諧波
+關注
關注
7文章
852瀏覽量
42263 -
混頻器
+關注
關注
10文章
838瀏覽量
46289 -
MMIC
+關注
關注
3文章
629瀏覽量
24779
發布評論請先 登錄
相關推薦
HMC264LC3B 次諧波混頻器,采用SMT封裝,21 - 31 GHz

HMC264LM3 次諧波混頻器,采用SMT封裝,20 - 30 GHz
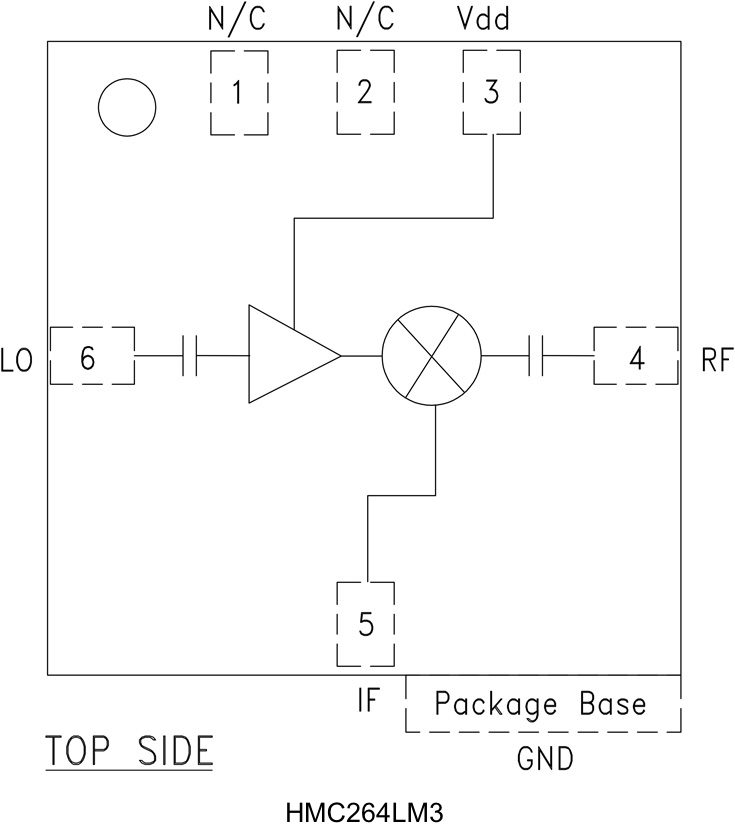
HMC265LM3 次諧波混頻器,采用SMT封裝,20 - 31 GHz

HMC338LC3B:GaAs MMIC次諧波SMT混頻器,24-34 GHz數據表









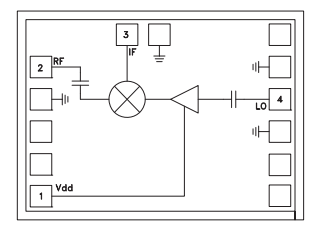

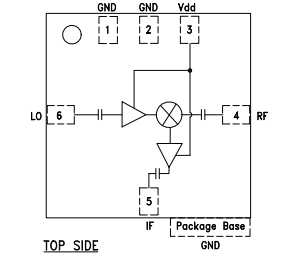
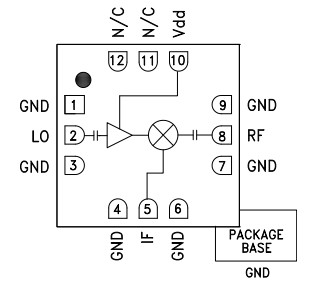











評論