聚焦離子束(Focused Ion Beam,簡稱 FIB)技術是一種在微觀尺度上對材料進行加工、分析和成像的先進技術。它在材料科學、半導體制造、納米技術等領域發揮著不可或缺的作用。
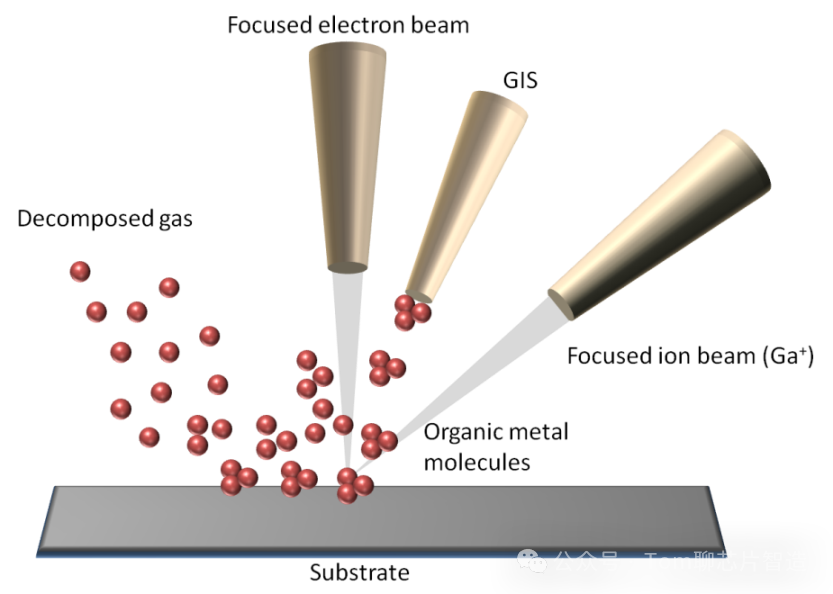
FIB 的基本原理
聚焦離子束技術的核心在于利用高能離子束對樣品進行加工和分析。
其基本原理是將鎵(Ga)等元素在強電場的作用下加速,形成高能離子束。通過精確控制電場和磁場,離子束能夠聚焦到樣品表面,并按照設定的路徑進行掃描。當高能離子束轟擊樣品表面時,會產生兩種重要的現象:一是樣品表面的原子被濺射出來,從而實現對樣品的加工;二是會產生二次電子,這些二次電子被檢測器捕獲后,可以用于成像和分析。FIB 的這種工作原理使其具有極高的精度和靈活性。它可以對樣品進行納米級的加工和分析,能夠清晰地觀察到微觀結構的細節。與掃描電子顯微鏡(SEM)類似,FIB 也利用聚焦束對樣品進行掃描,但 FIB 使用的是離子束,而 SEM 使用的是電子束。離子束的能量更高,因此 FIB 在加工能力上具有獨特的優勢。
FIB 的重要作用
1.芯片截面分析
在半導體制造領域,FIB 最重要的應用之一是對芯片進行截面分析。芯片的內部結構復雜,傳統的方法難以直接觀察到其內部的缺陷和結構。
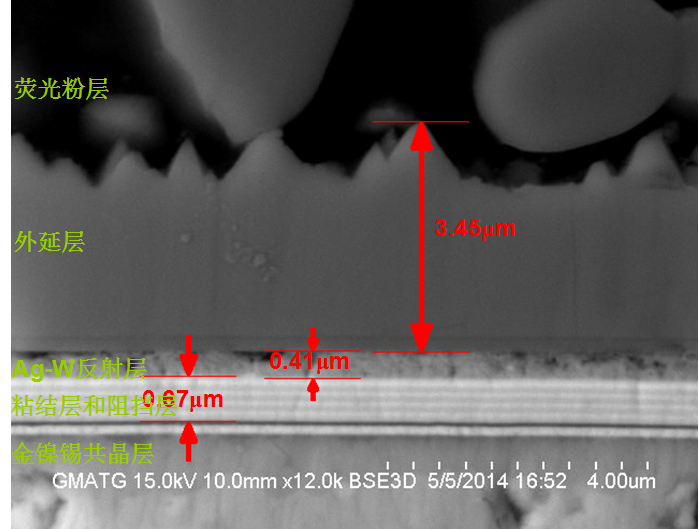
此外,FIB 通常集成了二次離子質譜(SIMS)、能量色散光譜(EDS)或能量色散X射線光譜(EDX)等分析設備。這些設備可以對樣品不同層次的元素分布和濃度進行分析,從而幫助工程師發現芯片內部的結構缺陷和材料問題。這種能力對于芯片制造過程中的質量控制和故障排查至關重要,能夠有效提高芯片的性能和可靠性。
2.芯片電路的修改
除了分析功能,FIB 還具有強大的加工能力,能夠對芯片電路進行修改。
通過離子束誘導沉積,FIB 可以在芯片表面沉積特定的材料,用于修復芯片上的缺陷或添加新的電路結構。
此外,利用高能鎵離子撞擊樣品,FIB 還可以實現對材料的刻蝕,從而去除不需要的部分。這種能力使得 FIB 在芯片的修復、掩模版的修復以及電路的微調中發揮著重要作用。例如,在芯片制造過程中,如果發現某個區域的電路存在缺陷,FIB 可以通過沉積材料來修復該區域,或者通過刻蝕去除多余的材料。這種微觀加工能力不僅能夠延長芯片的使用壽命,還能夠提高芯片的性能和功能。
3.TEM 制樣
透射電子顯微鏡(TEM)是一種能夠觀察到原子級別的微觀結構的強大工具。然而,TEM 對樣品的要求極高,需要樣品非常薄,通常約為 100 納米或更薄。在芯片制造過程中,如果數百萬個晶體管中有一個出現故障,如何制備該單個晶體管的電子顯微鏡樣本是一個巨大的挑戰。而 FIB 是唯一能夠勝任這項任務的工具。這一過程需要極高的精度和控制能力,而 FIB 的納米級加工精度使其能夠完美地完成這一任務。通過 FIB 制備的樣品,科學家和工程師可以在 TEM 下清晰地觀察到晶體管的內部結構和缺陷,從而為芯片的設計和制造提供重要的參考依據。
結語
聚焦離子束技術作為一種強大的微觀加工和分析工具,在現代科技中發揮著重要的作用。它不僅能夠幫助我們深入探索微觀世界的奧秘,還為半導體制造、材料科學等領域提供了有力的技術支持。隨著技術的不斷發展和創新,FIB 技術將在更多的領域展現其獨特的魅力,為人類的科技進步做出更大的貢獻。
-
材料
+關注
關注
3文章
1291瀏覽量
27640 -
fib
+關注
關注
1文章
85瀏覽量
11285 -
離子束
+關注
關注
0文章
76瀏覽量
7669
發布評論請先 登錄
相關推薦
FIB聚焦離子束電路修改服務
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束應用介紹
聚焦離子束系統的結構、工作原理及聚焦離子束雙束系統
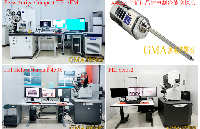









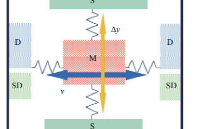


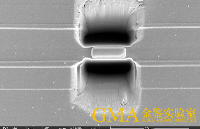
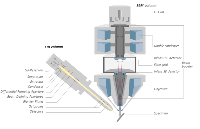

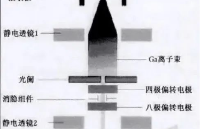











評論