文章來源:睞芯科技LightSense
原文作者:LIG
1、化學研磨拋光CMP技術
CMP 設備通過化學腐蝕與機械研磨的協同配合作用,實現晶圓表面多余材料的高效去除與全局納米級平坦化。目前集成電路組件普遍采用多層立體布線,集成電路制造的工藝環節要進行多次循環,每完成一層布線都需要對晶圓表面進行全局平坦化和除雜,從而進行下一層布線。CMP 設備在晶圓完成每層布線后實現全局納米級平坦化與表面多余材料的高效去除,保證光刻工藝套刻精度和多層金屬互聯的高質量實現。
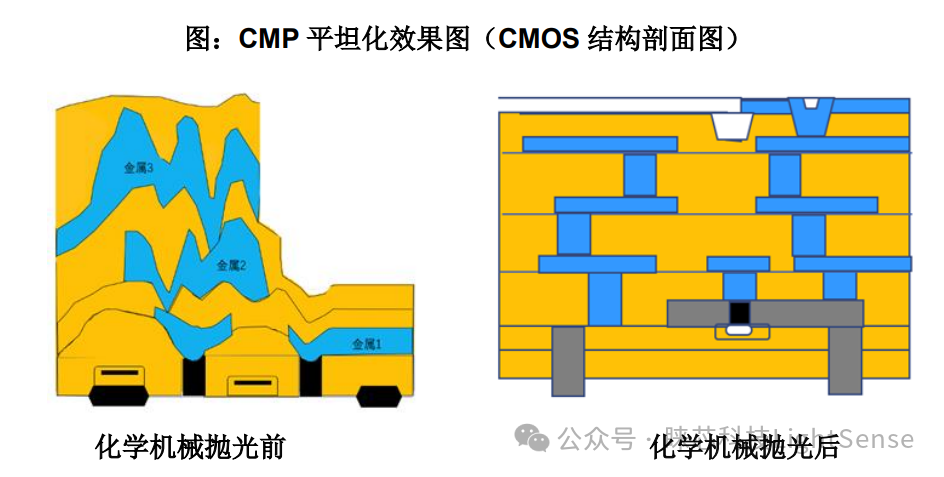
隨著線寬越來越小、層數越來越多,對 CMP 的技術要求越來越高,CMP設備的使用頻率也越來越高,在先進制程集成電路的生產過程中每一片晶圓都會經歷幾十道的 CMP 工藝步驟。
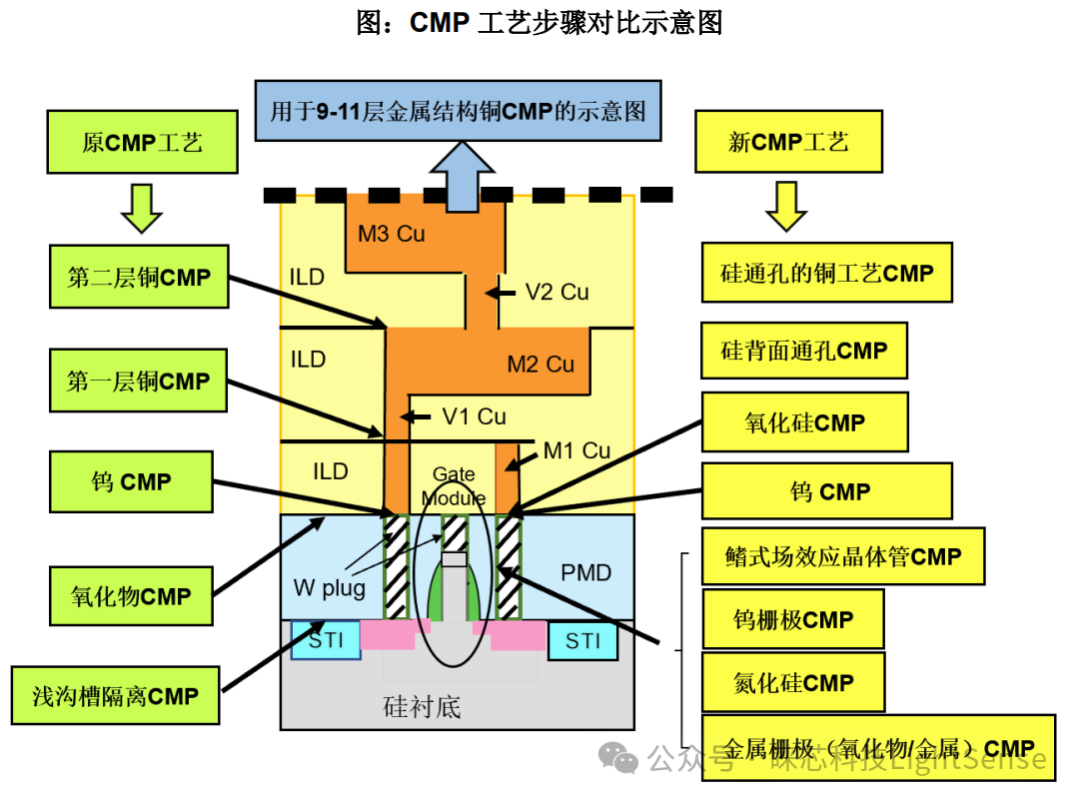
2、CMP 設備的工作原理
CMP 設備主要由晶圓傳輸單元、拋光單元和清洗單元三大主要模塊組成。
A)晶圓傳輸單元要由前端模組、晶圓傳輸手等部件組成。其中,前端模組負責與工廠的晶圓搬運系統對接,將晶圓搬運至機臺內進行加工。晶圓傳輸手負責晶圓在拋光單元、清洗單元內部及不同加工工位之間的傳輸。
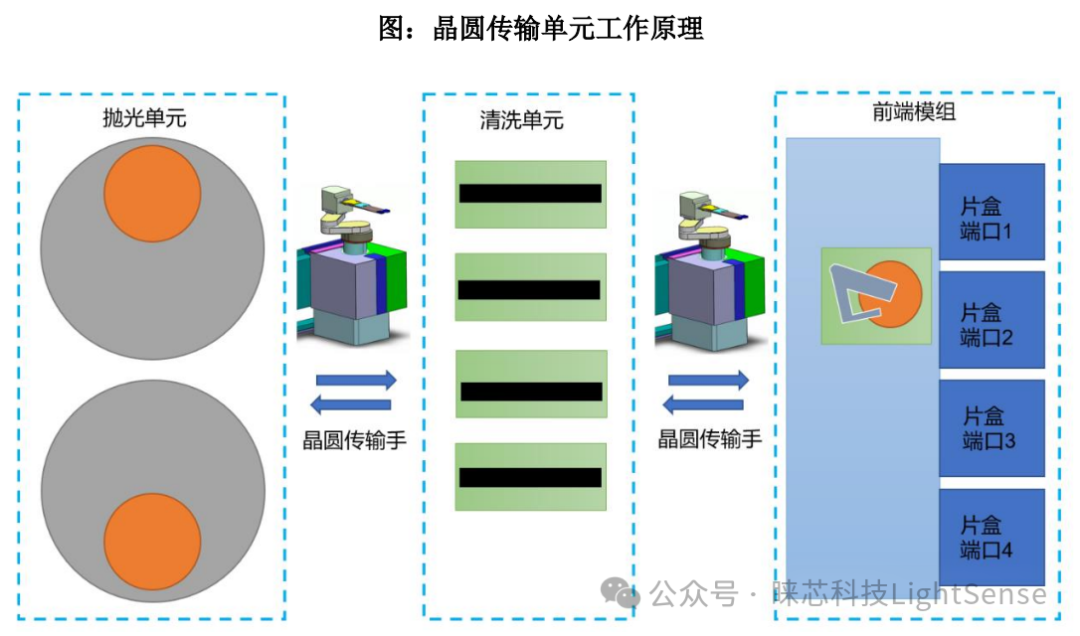
B)光單元在拋光單元中,利用化學腐蝕與機械研磨的協同配合,通過夾持晶圓的研磨頭和研磨墊之間的相對運動來實現晶圓表面平坦化。在研磨墊和晶圓之間滴入一定流量的研磨液,利用研磨液中的化學成分產生的腐蝕作用,以及研磨液顆粒產生的機械摩擦力去除晶圓表面的多余材料,實現晶圓全局平坦化。
拋光過程中通過研磨頭的不同區域同時施加不同壓力來調整區域研磨速率,從而優化晶圓表面的全局平坦化程度。同時,運用終點檢測技術,實時檢測晶圓表面的材料厚度,在達到預定厚度后停止拋光。
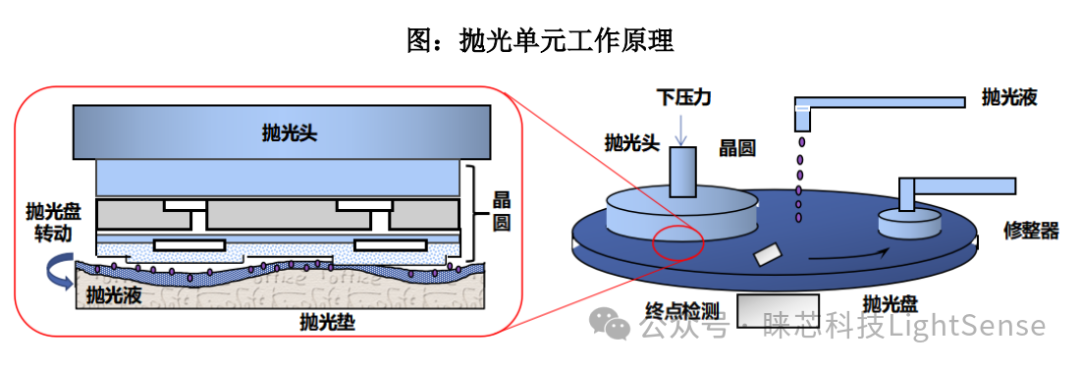
C)清洗單元在完成化學機械拋光后,通過清洗單元有效去除晶圓表面的顆粒污染物,并干燥晶圓。清洗單元一般包含兆聲清洗模組、刷洗模組及干燥模組等。兆聲清洗模組利用兆聲波能量及化學液的腐蝕作用實現大顆粒的去除。刷洗模組利用清洗化學品的腐蝕和機械刷洗雙重作用去除晶圓表面的強附著力顆粒,并用超純水沖洗殘留的沾污。干燥模組通過高速旋轉產生的離心力,異丙醇溶劑產生的馬蘭戈尼效應去除晶圓表面的水漬,實現晶圓干燥。

審核編輯:湯梓紅
-
集成電路
+關注
關注
5415文章
11865瀏覽量
366234 -
半導體
+關注
關注
335文章
28342瀏覽量
230020 -
CMP
+關注
關注
6文章
152瀏覽量
26395
原文標題:半導體的化學機械研磨拋光CMP技術
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
新型銅互連方法—電化學機械拋光技術研究進展
化學機械拋光技術的研究進展
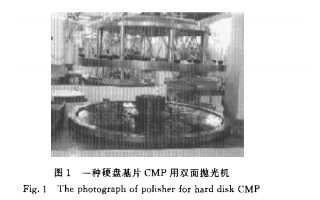
化學機械拋光CMP技術的發展應用及存在問題
化學機械拋光(CMP)技術的發展、應用及存在問題
采用化學機械拋光(CMP)工藝去除機理
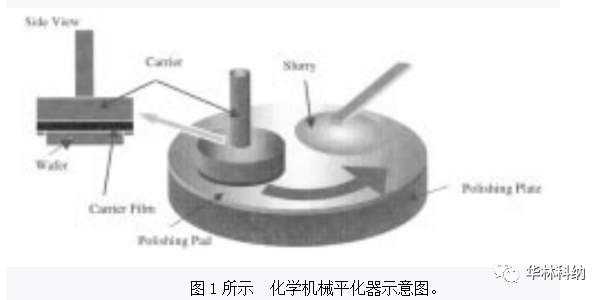
化學機械拋光工藝(Chemical Mechanical Polishing,CMP)
半導體行業中的化學機械拋光(CMP)技術詳解
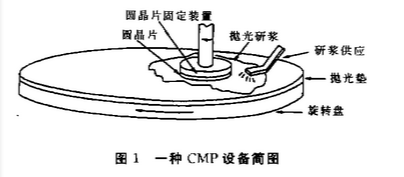








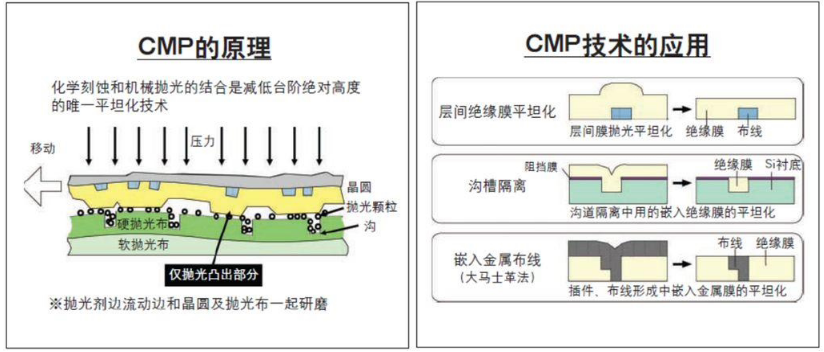











評論