電動汽車近幾年的蓬勃發(fā)展帶動了功率模塊封裝技術(shù)的更新迭代。各種各樣的封裝技術(shù)追求的目標(biāo)是更高的功率密度,更高的散熱效率,更高的可靠性及其更低的成本。本文梳理一下主流的封裝結(jié)構(gòu),供同行參考。
一 散熱器概念
1 散熱器pinfin概念
pinfin概念是2010年日本H公司提出的,后來在HPD以及SSC的散熱器都用到了該結(jié)構(gòu)。
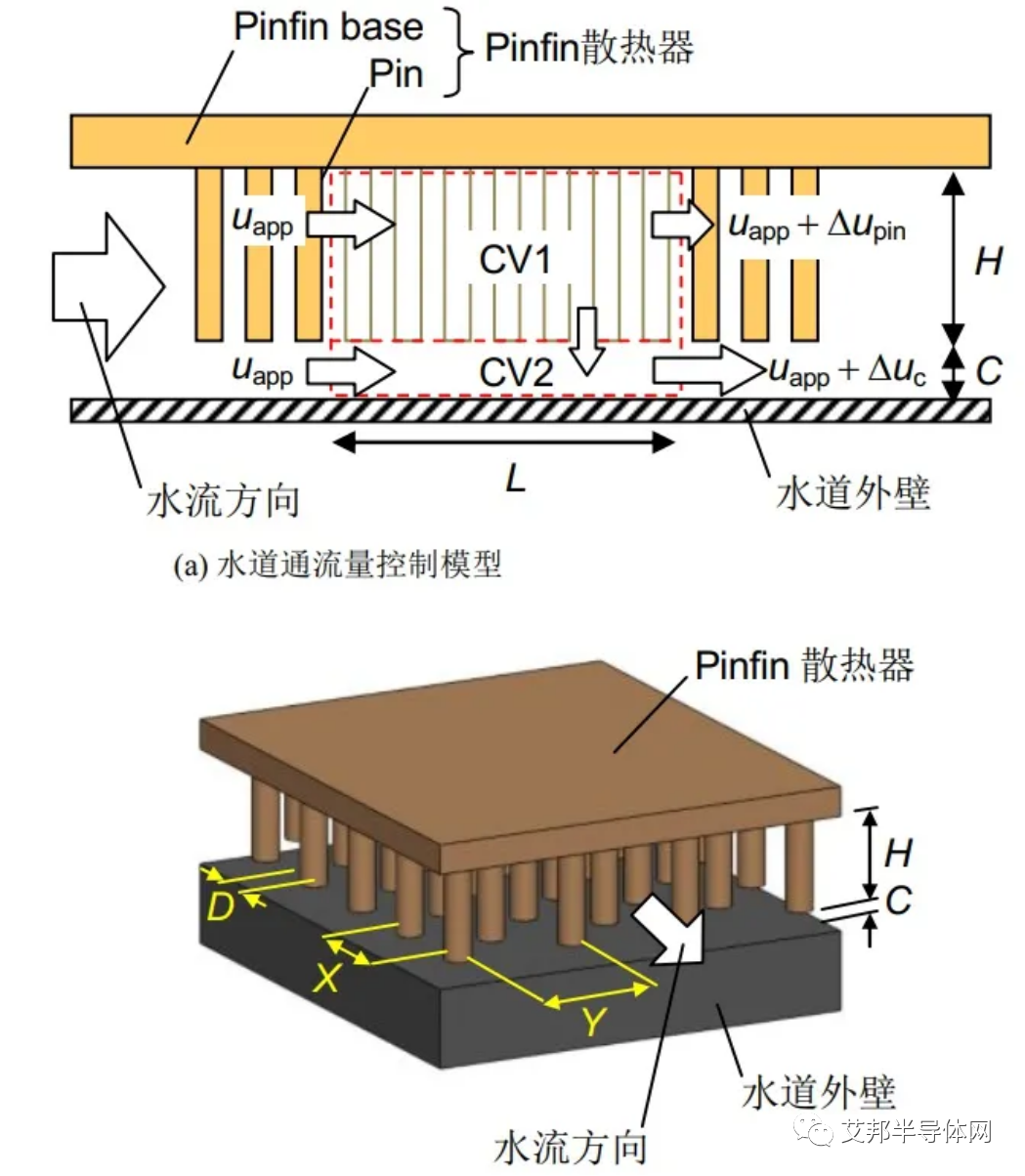
上面圖中這些參數(shù)用軟件一頓計算,可知道什么樣的PIN結(jié)構(gòu)效率更高。有時因為生產(chǎn)工藝的限制,結(jié)構(gòu)再漂亮,不一定生產(chǎn)得出來。
后來市面對pin的結(jié)構(gòu)優(yōu)化也隨著制造工藝能力的提升,玩出花來,形狀各異不說,還有根據(jù)冷卻水流向云圖來定制的PIN。也有用鍵合鋁帶的思路來實現(xiàn)的,好像只有IFX 曾經(jīng)玩過。
帶pinfin產(chǎn)品能力提升大約30%-40%比例,這個成本比芯片面積減小的收益,結(jié)果是讓人開心的。
2 DSC概念
DSC概念是在2005年左右由H還是D先提出來的。國內(nèi)2010年左右也論文爆發(fā),但是落地項目,大家還是相當(dāng)謹(jǐn)慎,市面上能看到的產(chǎn)品也不多,ON..HW..IFX..DENSO.也有衍生出其他產(chǎn)品。DSC在散熱上,上下比例大概也是8-2開,另外一個收益就是雜感有機會降低。
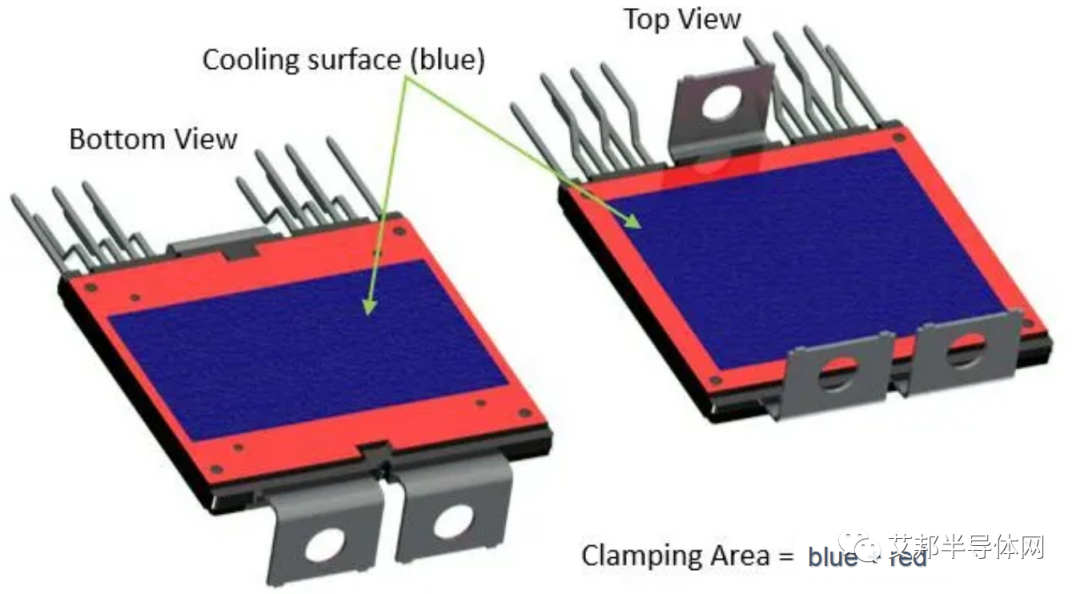 (網(wǎng)圖ON DSC)
(網(wǎng)圖ON DSC)
在這條線上的Delphi也混的不錯,器件尺寸能縮到很小,在OBC系統(tǒng)中,體積優(yōu)勢尤其突出。
(Delphi的概念) 關(guān)于DSC,也有一些證偽的驗證,始終無法落地,當(dāng)他是2.45代吧。如下:芯片上面焊接連接采用預(yù)沉積30um厚的銅柱再研磨拋光再做焊接,這對上層互聯(lián)用的DBC的平面度要求更高,warpage大了,就導(dǎo)致個別凸臺無法接觸,Vfd的數(shù)值比較大,手工件如此,可靠性的測試就沒啥人做,數(shù)據(jù)更少了。其中一個優(yōu)勢——免除所有鍵合線;晶圓工藝的成本不知道能不能抵得過封裝流程簡化的成本。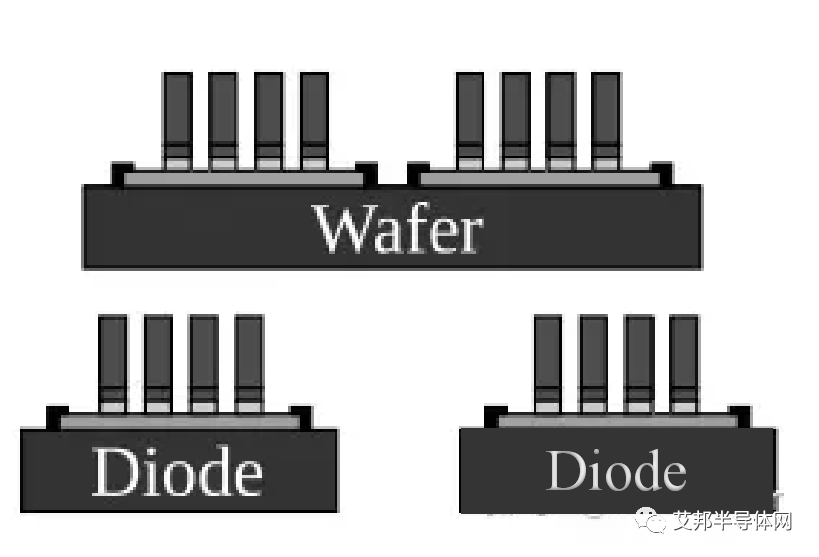
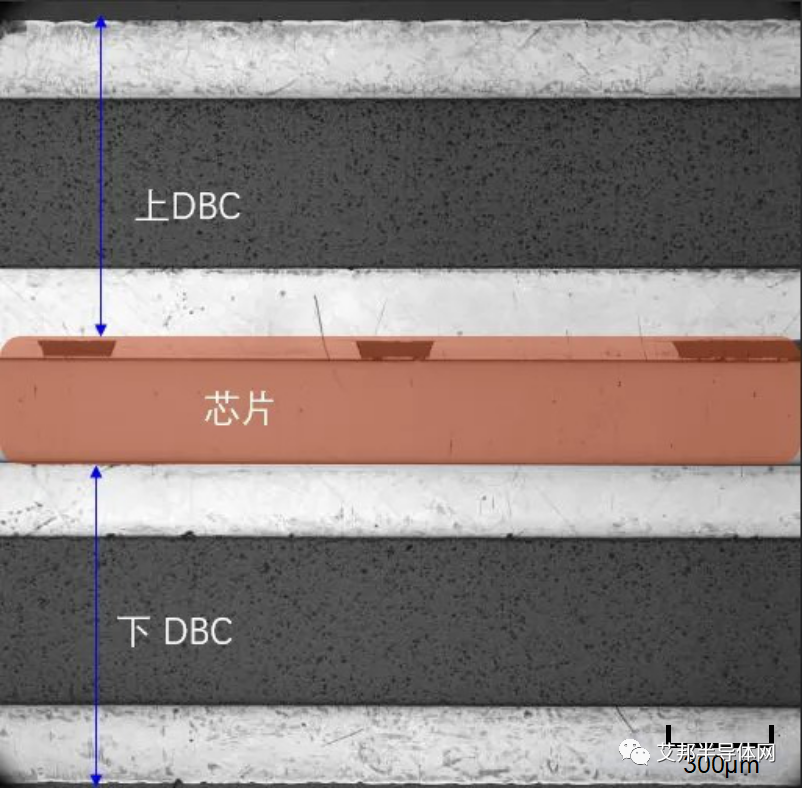
3 DLB 或clip互聯(lián)
在芯片表面鍍層能可靠焊接之后,大家的想法也更加豐富了;直接將芯片表面與外部電氣接口,通過一個clip整體,直接連在一起,gate也有機會如此。這對焊接技術(shù)要求很高,良率上不去,成本下不來。
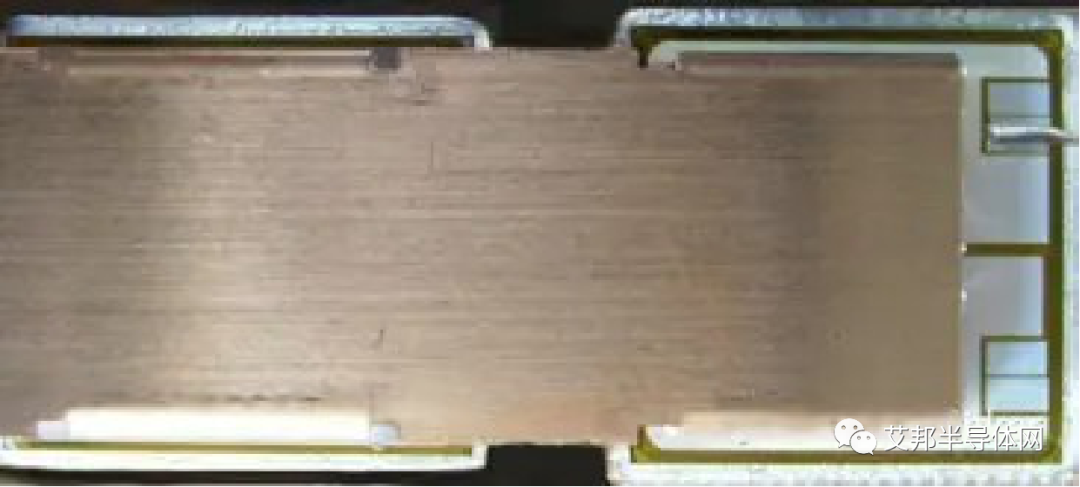
塞米控的SKiN概念,應(yīng)該是有產(chǎn)品落地,但沒機會見過實物。
這類正面連接的技術(shù)路線,不再使用粗銅鋁線進(jìn)行互聯(lián),鍵合設(shè)備的需求會降低,貼片設(shè)備需求增高。
4 水道直冷焊接技術(shù)
隨著功率密度不斷提高,散熱要求越來越高。硅膠、硅脂、碳膜等TIM技術(shù)也提升了很多,但還是不夠牛逼。接著就開始探索直接焊接或者燒結(jié),大面積銀燒結(jié)技術(shù)走的更快,但銀膏貴,在成本上控制不住,收益不明顯,有條件不如加大芯片面積。
大家又繼續(xù)折騰soldering焊接技術(shù),用賣材料的兄弟的話說,碰到做IGBT的都在做直焊這個事,也不見誰能突破,多元合金材料也送出去不少,還沒見誰有采購的意思。既然難,就不瞎說太多。
還有其他概念的,如ABB的壓接技術(shù),冷焊,激光焊技術(shù)。
二 模塊封裝概念
目前汽車廠商主流的幾種模塊應(yīng)用解決方案,大概分為以下幾種: 分立器件 ;1 in 1;2in1 ;6in1;All in 1
分立器件:
典型案例:Tesla Model X等 設(shè)計非常經(jīng)典巧妙,IGBT單管夾在散熱水道兩邊,立體式設(shè)計節(jié)省空間;并且方便疊層母排布局,減小雜散電感; 優(yōu)點:成本低,集成度高,通用產(chǎn)品; 缺點:設(shè)計復(fù)雜,熱阻較大,散熱效率不高
1 in 1
典型案例一 :Tesla Model 3 比較新穎的封裝形式,1 in 1這個名字很奇怪,為什么這種封裝看起來像分立器件卻被稱為模塊,直接叫分立器件不就完了。其實這種說法的原因是其采用了模塊的封裝技術(shù) Model 3 單個小模塊包含一個開關(guān),內(nèi)部兩個SiC芯片并聯(lián),使用時多個小模塊并聯(lián) 優(yōu)點:散熱效率高,設(shè)計布局靈活 缺點:量產(chǎn)工藝要求很高

典型案例二 :德爾福Viper 雙面水冷散熱Viper讓德爾福在小型化上嘗到了不少甜頭,除了雙面水冷之外,這款模塊還取消了綁定線設(shè)計,提升了循環(huán)可靠性。
使用時,采用雙面水冷典型的夾心餅干散熱模式,非常誘人。
2in1 模塊
包含兩種: 一種是灌膠模塊封裝,早期應(yīng)用較多,例如下邊這種,工業(yè)上也比較常見。
第二種是塑封,也是國際上有經(jīng)驗的廠商傾向于選擇的形式,一方面功率密度較大,便于小型化設(shè)計;另一方面具有一定的成本優(yōu)勢。 早期使用單面間接水冷的半橋模塊,博世產(chǎn)品上可以看到,后續(xù)主要的發(fā)展方向是雙面水冷和單面直接水冷。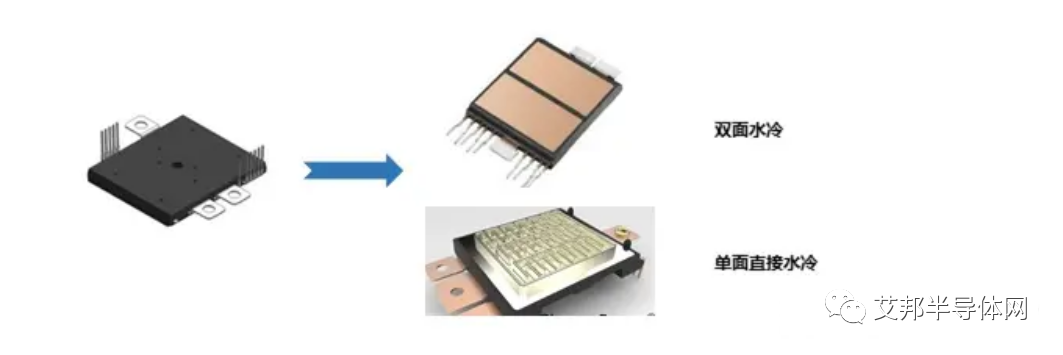
以豐田普銳斯4代PCU為例,摒棄之前的All-in-1結(jié)構(gòu),采用雙面水冷半橋模塊“插卡”式結(jié)構(gòu),設(shè)計巧妙的同時,極大提升散熱效率,由此提升系統(tǒng)功率密度。

雙面水冷內(nèi)部結(jié)構(gòu):
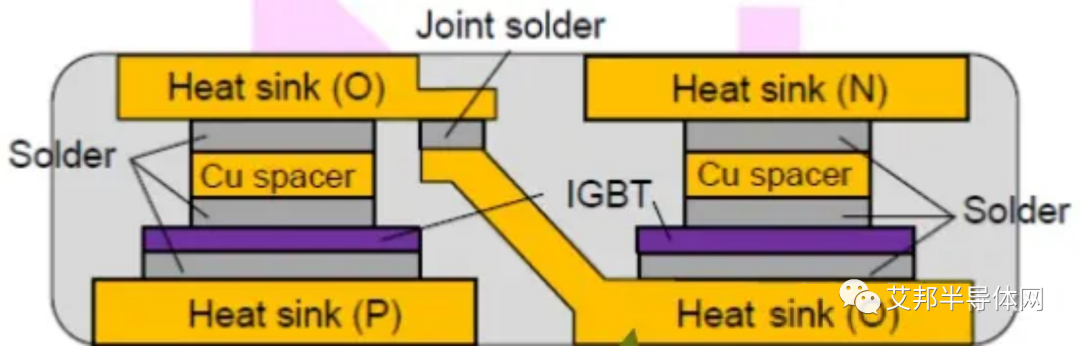
優(yōu)點: 結(jié)構(gòu)緊湊,散熱效率高,塑封的可靠性高
缺點:沒有集成散熱絕緣陶瓷,設(shè)計時跟散熱器之前需要加隔離墊片
6 in 1
目前應(yīng)用最廣泛的模塊,尤其是國內(nèi)汽車廠商,設(shè)計相對簡單。說到這,不能不提英飛凌的明星產(chǎn)品:HP Drive Pin-Fin設(shè)計直接散熱底板,顯著提高功率模塊散熱效率,提高模塊的功率密度,再加上模塊化設(shè)計簡單,很快在汽車領(lǐng)域風(fēng)靡開來。
優(yōu)點:設(shè)計簡單,功率密度高,應(yīng)用門檻低
缺點:成本高
針對Pin-Fin針翅成本高的問題,模塊廠商正在開發(fā)低成本的直接水冷板,例如英飛凌的wave散熱底板,在成本和散熱性能之間做了折中。
All in 1
典型應(yīng)用:豐田普銳斯系列 以普銳斯第三代PCU為例,這款電裝為豐田定制的功率系統(tǒng),所有的IGBT和Diode被集成到一個AlN陶瓷板上,外觀上看像一個大的功率模塊。
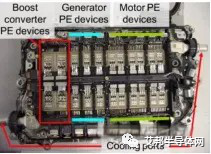
三 發(fā)展趨勢
1)6 in 1模塊
雖然6In1模塊對汽車來說并不是最優(yōu)設(shè)計,但由于其設(shè)計應(yīng)用的方便性,在短期內(nèi)還將占據(jù)主流,技術(shù)上主要會在散熱技術(shù)和可靠性尚下功夫 改進(jìn)點:
高導(dǎo)熱陶瓷材料的應(yīng)用,例如主流的Al2O3陶瓷更新Si3N4陶瓷
高可靠材料底板的應(yīng)用,例如高機械性能鋁硅碳底板代替銅底板
銀燒結(jié)技術(shù)的使用(Die與DBC、DBC與散熱板)
銅綁定線乃至銅帶綁定技術(shù)
2) 雙面水冷封裝
雙面水冷封裝技術(shù)的優(yōu)點一方面提升散熱效率,另一方面夾心式的散熱系統(tǒng)設(shè)計易于拓展,同時,相對于硅膠灌封模塊,塑封的半橋模塊又具有一定的量產(chǎn)成本優(yōu)勢,相信未來一段時間會成為一個主流方向。
3) 單面直接水冷封裝
丹佛斯在PCIM Europe 2017上展示的Shower Power 3D技術(shù),據(jù)稱比Pin-Fin的散熱能力還要優(yōu)秀。
4) 雙面直接水冷封裝
如日立的插式雙面水冷散熱,已在奧迪e-tron量產(chǎn),理論上,這種形式的封裝散熱效果相對于單面直接水冷是顯而易見的
四 小結(jié)
汽車對功率模塊可靠性、功率密度的高要求,催生車規(guī)級模塊封裝技術(shù)的不斷進(jìn)步并量產(chǎn)落地,相信到碳化硅時代,適應(yīng)于碳化硅的新型封裝技術(shù)會成為一個新的方向。
審核編輯:劉清
-
電動汽車
+關(guān)注
關(guān)注
156文章
12328瀏覽量
233722 -
散熱器
+關(guān)注
關(guān)注
2文章
1072瀏覽量
38193 -
IGBT模塊
+關(guān)注
關(guān)注
8文章
114瀏覽量
16665 -
PIN管
+關(guān)注
關(guān)注
0文章
36瀏覽量
6502 -
OBC
+關(guān)注
關(guān)注
10文章
169瀏覽量
18144
原文標(biāo)題:車規(guī)級 IGBT 模塊封裝趨勢
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
國產(chǎn)新突破!江波龍車規(guī)級 LPDDR4x與車規(guī)級eMMC重磅發(fā)布,定義存儲新標(biāo)桿

車規(guī)級NTC熱敏電阻在雷達(dá)模塊熱崩潰中的安全斷連設(shè)計
英飛凌車規(guī)級IGBT功率模塊FF300R08W2P2_B11A產(chǎn)品概述

下一代主流SiC IGBT模塊封裝技術(shù)研發(fā)趨勢——環(huán)氧灌封技術(shù)

芯動能第100萬只車規(guī)級電驅(qū)雙面散熱塑封模塊成功下線
中恒微發(fā)布Mini Z3功率模塊:750V新技術(shù)車規(guī)級芯片引領(lǐng)新能源變革
車規(guī)電阻和普通電阻有什么不一樣

深入剖析車規(guī)級IGBT模組的成本要素

如何辨別符合車規(guī)級標(biāo)準(zhǔn)的電子元器件?

車規(guī)級IGBT模組:成本背后的復(fù)雜系統(tǒng)解析

車規(guī)級芯片車身空調(diào)控制方案Demo
長電科技首座大規(guī)模生產(chǎn)車規(guī)級芯片成品的先進(jìn)封裝基地即將落地
TMC2024丨車規(guī)級功率半導(dǎo)體論壇劇透一丨SiC模塊特色封裝與半導(dǎo)體制造技術(shù)創(chuàng)新




















評論