封裝載板與ABF
Chiplet先進(jìn)封裝需要高密度互連,封裝本身不再只是封裝單個芯片,必須綜合考慮布局、芯片和封裝的互聯(lián)等問題,其會采用2.5D封裝、3D封裝、SIP等多種形式對芯片進(jìn)行先進(jìn)封裝。如英特爾推出的EMIB嵌入式多芯片互連橋和Foveros有源板載技術(shù)。
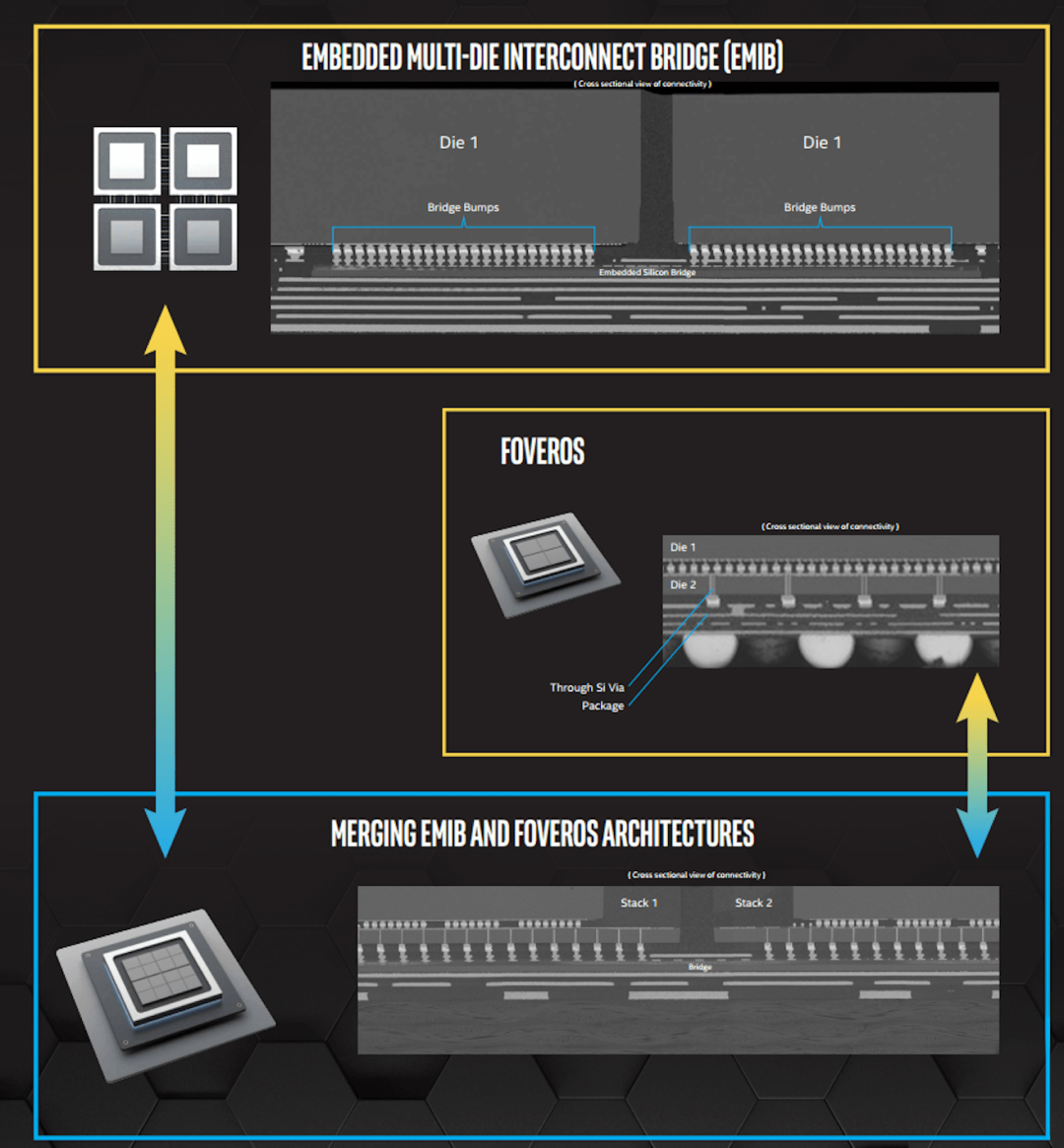
圖4:Intel的EMIB橋接和
Foveros技術(shù)的2.5D和3D技術(shù)
在EMIB中,針對芯片密度比較大、連接比較密集的地方,嵌一塊硅片,嵌到基板里(像橋連接一樣),然后在硅上進(jìn)行互連,由此來提高互連密度;Foveros,又被稱為三維面對面異構(gòu)集成芯片堆疊,屬于3D堆疊封裝技術(shù),更適用于小尺寸產(chǎn)品或?qū)?nèi)存帶寬要求更高的產(chǎn)品。在該技術(shù)中,底下是芯片,在芯片上打孔,芯片上面再堆積芯片,通過TSV實現(xiàn)芯片之間的互連以及芯片和基板之間的互連。
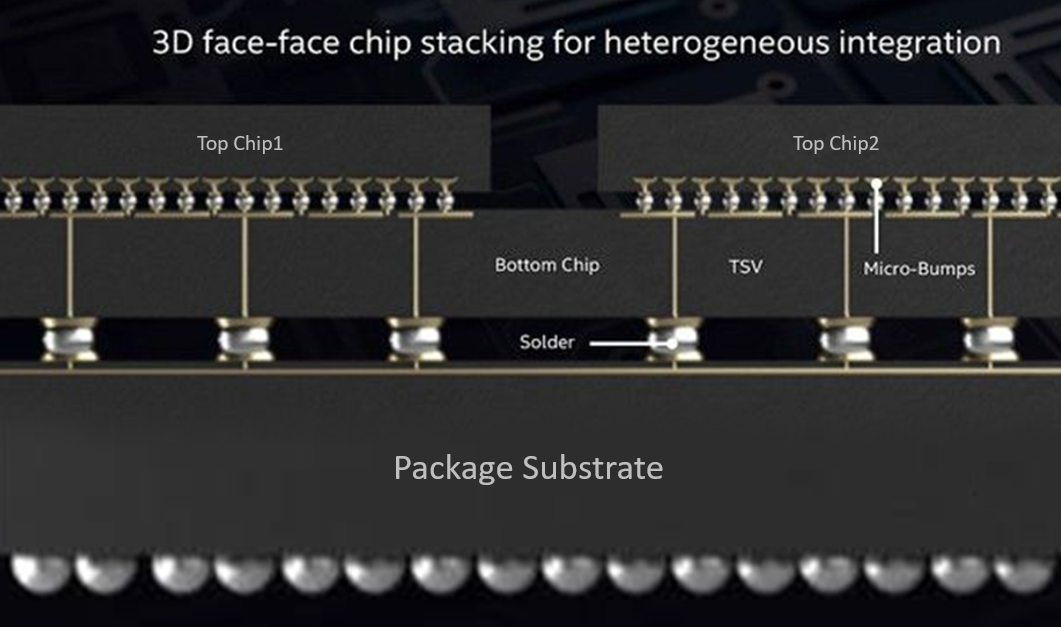
圖5:Foveros技術(shù)圖
(來源:網(wǎng)絡(luò))
先進(jìn)封裝的應(yīng)用會增加封裝載板層數(shù),具體層數(shù)與技術(shù)指標(biāo)要求取決于芯片的設(shè)計方案,由此對載板的需求將日益升高,尤其是主要用于CPU、GPU和芯片組等高端產(chǎn)品的FC-BGA載板。
FC-BGA(flip chip ball grid array)載板具有層數(shù)多、面積大、線路密度高、線寬線距小以及通孔、盲孔孔徑小等特點,build-up(積層)基板技術(shù)是FC-BGA載板的核心技術(shù)。FC-BGA載板通常以日本味之素生產(chǎn)的味之素積層介質(zhì)薄膜(Ajinomoto build-up film,ABF)作為積層絕緣介質(zhì)材料,采用半加成法(利用圖形電鍍增加精細(xì)線路的厚度,而未電鍍加厚非線路區(qū)域在差分蝕刻過程中全部蝕刻,剩下的部分保留下來形成線路)制造。
在制造過程中,以玻纖布預(yù)浸BT樹酯做為核心層(又稱芯板,Core Substrate),然后在每層用build-up(積層)的方式增加上下層的層數(shù)。上下的增層結(jié)構(gòu)舍去了原用的預(yù)浸玻纖布壓合銅箔的銅箔基板,進(jìn)而通過在ABF上電鍍銅來取代。此方法可以減少載板總體的厚度、避免以往BT樹酯載板雷射鉆孔所遇到問題,同時也能增加線路與介質(zhì)層的結(jié)合力。此外,隨著一些薄型化、柔性產(chǎn)品的發(fā)展,在業(yè)界也出現(xiàn)了無芯載板,即除去了芯板,僅由積層板構(gòu)成。
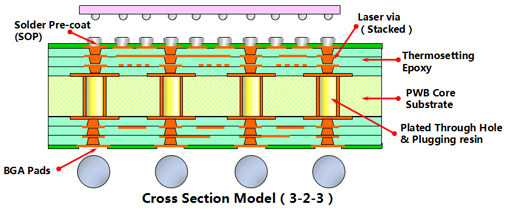
圖6:京瓷FC-BGA載板截面示意圖
(來源:京瓷官網(wǎng))
ABF是一種低熱膨脹系數(shù)、低介電損耗的熱固性薄膜,其易于加工精細(xì)線路、機(jī)械性能良好、耐用性好的特性,也叫積層絕緣電介質(zhì)材料、積層絕緣膜。該款材料源自于日本一家味精廠:味之素。1970年,該公司工作人員在研究制作味精副產(chǎn)物時,發(fā)現(xiàn)一種樹脂,經(jīng)過加工后可以得到擁有極高絕緣性的薄膜材料。1990年代,味之素正式推出“ABF薄膜”。而當(dāng)時業(yè)界利用油墨當(dāng)作絕緣增層材料,但油墨會產(chǎn)生氣泡、表面平整度差、環(huán)境等問題。
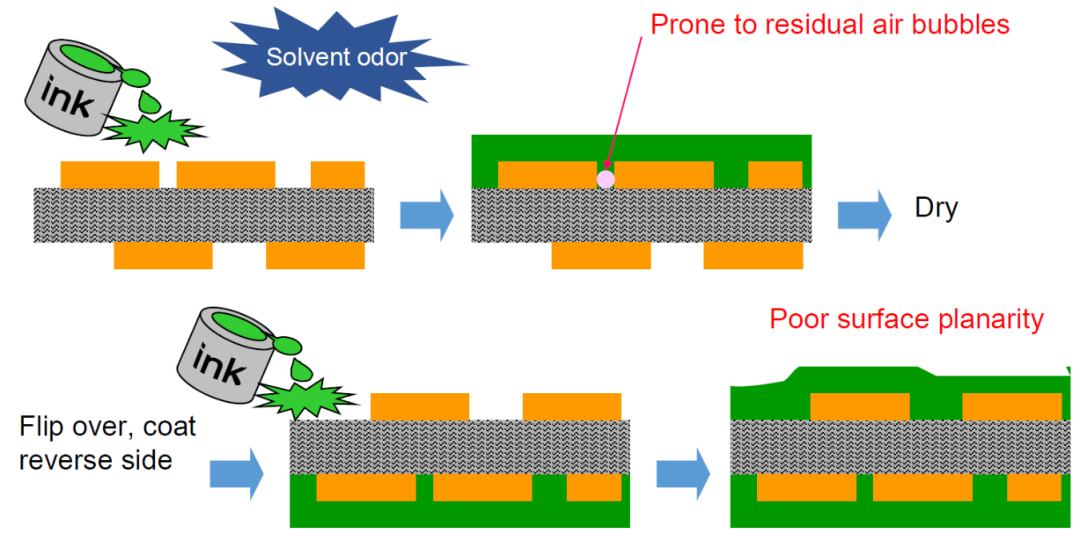
圖7:油墨用于增層材料
(來源:味之素官網(wǎng))
到2000年左右,個人計算機(jī)爆發(fā)式增長,用于計算機(jī)上的CPU大規(guī)模集成電路隨著摩爾定律越來越復(fù)雜,對IC封裝載板的需求也迅速增長。復(fù)雜的芯片布線圖案對載板的絕緣材料提出更嚴(yán)格的要求。由英特爾主導(dǎo),首次在其CPU載板上運用ABF絕緣膜,并在未來幾年內(nèi)大規(guī)模使用,一直延續(xù)至今,成為標(biāo)配,用于導(dǎo)入Flip Chip等載板的生產(chǎn)。目前幾乎所有的高性能CPU、GPU等高端芯片均使用ABF載板。而味之素也占據(jù)了全球積層絕緣電介質(zhì)材料市場份額的90%以上。
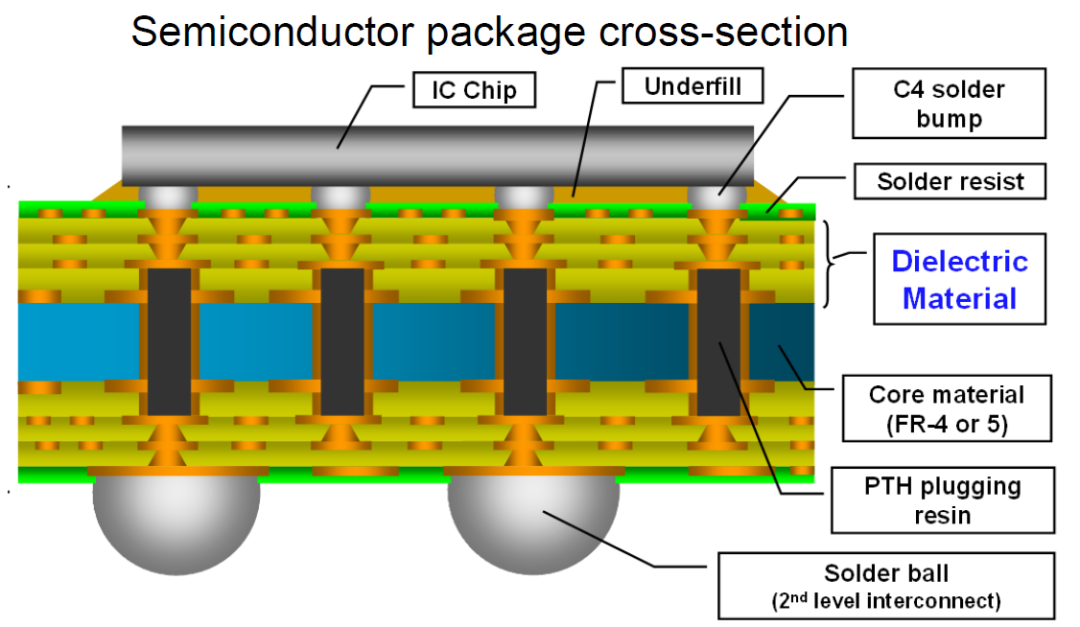
圖8:ABF在載板中的應(yīng)用
(來源:味之素官網(wǎng))
ABF絕緣膜一般由支撐薄膜(PET)、ABF涂層以及保護(hù)膜組成。其中,ABF涂層的配方以及涂布工藝是該款材料的核心技術(shù)。從配方上看,需要對溶劑、樹脂、填料以及相關(guān)添加劑等組份進(jìn)行調(diào)控,以滿足ABF絕緣膜熱膨脹系數(shù)、介電常數(shù)、介電損耗、玻璃轉(zhuǎn)化溫度、粘合力等性能參數(shù);從涂布工藝上來看,形成厚度可控、無氣泡、光滑平整的薄膜是關(guān)鍵的技術(shù)。
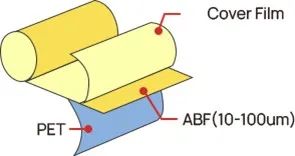
圖9:ABF材料結(jié)構(gòu)
(來源:味之素官網(wǎng))
雖然ABF材料的關(guān)鍵核心技術(shù)依然被味之素掌握,但近年來國內(nèi)廠商也開始積極布局相關(guān)技術(shù)的研發(fā),例如,生益科技、華正新材等;我國臺灣地區(qū)的晶化科技也可以小規(guī)模出貨。
未來,隨著CPU、GPU、FPGA、ASIC 等高性能運算芯片需求增長,Chiplet技術(shù)(增大了單顆芯片的封裝面積與載板用量)成熟與廣泛應(yīng)用,將進(jìn)一步增加ABF絕緣膜需求。相信國內(nèi)廠商能夠在此背景下,能夠抓住時間“窗口期”,加快核心技術(shù)研發(fā),在ABF絕緣膜市場占據(jù)一席。
ABF載板交流紀(jì)要
IC 載板行業(yè)概況?
1)載板行業(yè)概述:
載板行業(yè)是半導(dǎo)體產(chǎn)業(yè)鏈的一個環(huán)節(jié),二級供應(yīng)的部分。上游是晶圓制作,覆銅箔,原材料(包括ABF 中的原材料),載板和 PCB 一樣,是產(chǎn)業(yè)鏈的第二個環(huán)節(jié),下游是封測廠、組裝廠,進(jìn)而是消費電子或 server。
2)載板分類(按原材料劃分)
第一類:BT 載板,對應(yīng)消費電子中處理器、內(nèi)存卡、藍(lán)牙耳機(jī),小型的消費電子所用的原材料;
第二類:ABF 載板,用于高速通信領(lǐng)域,層數(shù)相對較高,利于制作細(xì)微線路的特性。封裝方式是FCBGA。
第三類:搭配晶圓級封裝,在晶圓背面將引線框架直接結(jié)合晶圓連接PCB 的方式。這種方式可以不用載板。
BT 載板和ABF 載板最常見,是主流的供應(yīng)方式。
3)產(chǎn)業(yè)供應(yīng)鏈:
IC 載板行業(yè)90%供應(yīng)商都在海外,比如日韓地區(qū),BT 載板45%在韓國,例如三星作為內(nèi)存大頭,最主要用的是BT 載板。ABF 載板主要供應(yīng)在臺灣,占比40%,韓國和日本共占50%左右,另有一些德系、歐洲的供應(yīng)商。
國內(nèi)目前已經(jīng)在量產(chǎn)的如深南、興森、越亞,基本上是BT 載板。為了打破ABF 載板壟斷,國內(nèi)做BT 載板的供應(yīng)商陸續(xù)在2021、2022 年新增投資,新增 ABF 載板的產(chǎn)能。
ABF 載板的技術(shù)要求和BT 載板的差異?
技術(shù)方面:
1)匹配多層板。ABF 主要用在高速通訊領(lǐng)域?qū)?yīng)的芯片,比如電腦 cpu、服務(wù)器中的計算模塊。需要承載的通訊速度更快,功耗、散熱能力更強。在有限芯片產(chǎn)品面積情況下,意味著載板層數(shù)要比BT 載板高很多,常見的 ABF 載板都在6-22 層板較常見,傳統(tǒng)的BT 載板在2-4 層,無法滿足層數(shù)需求。
2)匹配細(xì)線路。有限面積中需要更多更細(xì)的線承接信號的通訊,意味著線路寬度更低,常規(guī)PCB 線路在35 微米以上,BT 載板線路在12 微米以上,無法滿足更細(xì)線路。通常 12 微米以下都是搭配ABF 薄膜,結(jié)合SAP 的中層工藝,將線路通過化銅電鍍出來。目前最細(xì)的線路可做到6 微米。
3)尺寸大。相對于BT 展板尺寸較大。常規(guī)BT 載板尺寸基本是幾毫米,指甲蓋的大小。ABF 載板常見的有35mm*35mm,以及大尺寸的200*200 的整合性芯片。比如1 臺服務(wù)器有8 個CPU,16 個AI 芯片組合在一起。尺寸越大,良率越低,制作能力要求越高。
目前國內(nèi)擴(kuò)產(chǎn)ABF,需要解決的問題?
第一,設(shè)備方面。制作細(xì)線路的指定設(shè)備高解析的曝光機(jī)基本被日本壟斷,如日本的ORC、ADTEC 均為壟斷性企業(yè)。由于近期日韓、國內(nèi)廠商都在擴(kuò)產(chǎn),這類設(shè)備的交期會延長到1-2 年。此外,像電鍍線、專用的 ABF 壓膜機(jī)均為海外進(jìn)口,交期很長。阻礙了國內(nèi)供應(yīng)商向ABF 轉(zhuǎn)移的進(jìn)程。
第二,制作環(huán)境。由于層數(shù)多、線路細(xì),對整個車間的要求區(qū)別于PCB 和BT 載板,80%的區(qū)域都需在無塵室制作。所以現(xiàn)有工廠只能做樣品,但無法量產(chǎn)。因此國內(nèi)廠商向 ABF 轉(zhuǎn)移通常都是新建工廠。在規(guī)劃時,由于整個車間環(huán)境要求高,工廠投資非常大。
第三,生產(chǎn)技術(shù)人才大部分集中在日韓臺地區(qū),目前這些地區(qū)對 ABF 載板人才封鎖很強。像臺灣如欣興、南亞、本身 ABF 產(chǎn)能就在擴(kuò)產(chǎn),對人才限制上,包括競業(yè)協(xié)議、股權(quán)激勵以及其他的特殊限制,使得人才基本綁定。
ABF 主流的尺寸及大概的價格?
不同的產(chǎn)品類型定價差異非常大。
1)普通ABF 載板尺寸如最常見的電腦 CPU 有35*35、40*40、50*50。以40*40 為例,價格經(jīng)過了較大波動。2017 年之前價格較平穩(wěn),每顆大概35-40 元。2019 年之后隨著電腦出貨量上升、疫情影響以及材料運輸?shù)臓顩r,2020-2021 年價格大幅上升,最高上升到 90 元/顆。自2021 年4 季度開始有緩解,2022 年一二季度價格有所回落,從90 降到80,直到2022 年三四季度,消費電子需求回落,供給面出現(xiàn)緩和,價格回落到60 元/顆。目前從2022 年Q4 到2023 年 Q1,整體上從低端的電腦來看,還沒有明顯的好轉(zhuǎn)跡象。存在價格波動,目前價格在50 元/顆。
2)高端的產(chǎn)品。尺寸大、層數(shù)高的產(chǎn)品供應(yīng)商少,資源有限且良率低,20 層的200*200的大尺寸基板一流梯隊良率只有 50%左右,同時對應(yīng)商用服務(wù)器又結(jié)合了一些先進(jìn)封裝,所以價格維持在高位,比較平穩(wěn),個別高端載板價格在20000 元/顆左右。
綜合上,普通低端產(chǎn)品價格相對于2021、2022 年有一些回落,但整體價格比17 年略高。高端產(chǎn)品一直維持在高位。供給端沒有特別快把高端產(chǎn)品拉起來,先進(jìn)技術(shù)搭配的先進(jìn)封裝以及尺寸、層數(shù)都有同步增加,因此高端產(chǎn)品價格相對穩(wěn)定。
載板原材料以及占比?
1)BT 載板:制作簡單,主要原材料——基板本身指定如三菱瓦斯、國內(nèi)如生益科技的基板,占成本的20%;銅箔,三井的銅箔目前是壟斷的地位,占成本 10%左右;Pt,占成本5%。表面處理,不同的表面處理價格不同,大部分使用貴金屬,如鍍金、鎳鈀金、沉金,成本占比15-20%;油墨,業(yè)內(nèi)載板使用日本的太陽油墨,占 BT 載板的成本8-10%。其他過程中的耗材,例如干膜、鉆針、電鍍藥水以及其他輔材占成本35%左右。
2)ABF 成本占比差異比較大:以常見 8 層板來看,制作工藝中最內(nèi)層是BT 載板, BT 覆銅箔的載板做內(nèi)存材料,后續(xù)每一層用ABF 薄膜做增層,共6 層ABF 薄膜,ABF 薄膜成本占載板成本30%;BT 的耗材加銅箔大約占 10%;表面處理部分,對應(yīng) FCBGA,在基板背面做直錫球的加工工藝,正面做一些貴金屬的表面處理,成本占比10%;油墨,做高級芯片的油墨使用干膜類型,相對比BT 載板油墨更高階,成本占比大概5%。由于流程長,其他的工序(200 個工序)綜合成本加起來在40%左右。
針對銅箔應(yīng)用工藝?
1) 傳統(tǒng)的工藝,PCB 或傳統(tǒng)的載板,如果線路等級在35 微米以上,基本上使用叫剪工發(fā)的工藝,即線路是蝕刻出來的,使用的是最常規(guī)的銅箔,TTHH12 微米或18 微米的銅箔就可以。制作工藝相對簡單,售價和良率也相對穩(wěn)定。
2)低于35 的對應(yīng)線路制作工藝為 mSAP,即半加成法,使用超薄銅箔,最主要的技術(shù)就是銅牙,在銅箔和PPER 結(jié)合的銅的粗糙度的狀況,相對比較均勻,深度比較小,利于做超細(xì)線路,業(yè)內(nèi)常用的是3 微米、5 微米的超薄銅箔。因為本身制作難度大,所以價格相對高。目前國內(nèi)工廠還不具備超薄銅箔的制作工藝,像江銅之類,在 PCB 有應(yīng)用,但載板上還沒有實際案例,供應(yīng)商也在搭配載板廠共同研發(fā)替代的產(chǎn)品。
3)銅箔在ABF 的應(yīng)用相對較少,只有在 ABF 剛開始發(fā)量內(nèi)層時,發(fā)的 BT 板上有對應(yīng)的兩張銅箔,后續(xù)增層壓ABF 薄膜而不會再壓銅箔,直接在 ABF 銅箔上沉積一層化學(xué)銅,在化學(xué)銅上電鍍出線路。ABF 載板使用的是 SAP 工藝,不使用超薄銅箔,直接在化銅上把線路鍍出來,所以整個ABF 載板對銅箔的使用量相對較少。
原材料認(rèn)證的認(rèn)證周期?
原材料的認(rèn)證會分不同材料。銅箔的認(rèn)證決定權(quán)在載板廠,因為銅箔不影響芯片廠、封裝廠的特性,銅箔主要是對線路制作良率的影響。認(rèn)證周期上,新供應(yīng)商認(rèn)證周期相對長,需要認(rèn)證幾款不同型號,從開始發(fā)料制作到最終的線路,通常需要首批驗證、三批認(rèn)證、十批認(rèn)證三個階段來判定是否具有能力,周期最少要 3 個月以上;如果是三井的新銅箔認(rèn)證,比如換產(chǎn)地的認(rèn)證會相對較短,大概一到兩個月即可。
板材認(rèn)證周期相對長,板材最大的決定權(quán)在設(shè)計公司。設(shè)計公司在設(shè)計芯片時會考量到對應(yīng)晶圓的漲縮、特性、需求的組織、熱膨脹系數(shù)、體積。所以生產(chǎn)載板使用哪一款基材由設(shè)計公司決定。較低端的芯片決定權(quán)在封裝廠,比如用相對成本低的原材料。但認(rèn)證周期相對較長,如終端客戶指定的新材料做認(rèn)證,在載板廠制作后要搭配封裝廠完成整芯片的封裝及驗證,需要近一年的周期才能完成新材料認(rèn)證。
線路制作工藝:
不同線路等級對制作工藝要求不同,通常35 微米以上是傳統(tǒng)剪頭法的制作工藝,12 微米到35 微米對應(yīng)mSAP;12 微米以下,通常是SAP 工藝,即在 ABF 薄膜上沉積化學(xué)銅。
后續(xù)的發(fā)展?fàn)顩r,晶圓的部分,結(jié)合整個市場的需求看,對通訊、功耗及散熱的要求越來越高。從晶圓制作角度看已經(jīng)無法滿足摩爾定律的發(fā)展了。晶圓的制作從7nm 到 5、3 納米,目前制作成本和良率已達(dá)到物理極限,很難再突破。
第二種方式,加大晶圓面積,但隨著晶圓面積加大,消費電子整個尺寸面積會變大,不符合消費電子的需求。同時晶圓面積越大,良率越低。將晶圓尺寸加大雖然可以提高芯片性能,但制作良率以及產(chǎn)品外形的要求非常嚴(yán)格。
后續(xù)的發(fā)展是圍繞先進(jìn)封裝做突破,涉及到幾個方向:第一種比較成熟的mcm 和 SIP, mcm 即多芯片組合,SIP 即system in package(系統(tǒng)級封裝),目前業(yè)內(nèi)已經(jīng)成熟應(yīng)用了。第一種mcm,比如蘋果將M1 芯片加大到M1 Max,以及 M1 Ultra 將兩個M1 Max 芯片組合在一起,做整體封裝,這是一種快速提高整個芯片性能的趨勢。
第二種System in package ,比如藍(lán)牙耳機(jī),將處理器、音源控制及電源管理芯片集中在一塊小芯片上做控制,包含一些元器件、電阻電容都整體封裝在一個芯片里,做到輕小化,線路的集成度越來越高,功耗、散熱都能得到改良,在市面上已經(jīng)批量應(yīng)用。
第三種SOC,系統(tǒng)級封裝,在前二者的基礎(chǔ)上,將不同的控制芯片直接刻畫在一個晶圓上,前面兩種是不同晶圓封裝在一塊載板上。SOC 是將不同控制單元和不同功能區(qū)域在一塊晶圓上刻畫并封裝在一起。目前在市面上處于研究、打樣的階段,
此外,目前在測試中的2.5D 封裝和先進(jìn)封裝。2.5D 封裝應(yīng)用較廣的是 Chiplet 觀念,目前在市面上已經(jīng)大量應(yīng)用。比如海思芯片,由于無法獲得高端晶圓,為了保持運算效能,特別是服務(wù)器,采用了這種概念。華為鯤鵬920 就是組合了 7nm 和16nm 芯片,一個服務(wù)器兩個架構(gòu),然后疊加AI 芯片,替代intel 的X86,多個芯片組合加上 AI 的邏輯運算,就可以將性能大幅提升。普通的服務(wù)器和通過2.5D 封裝的服務(wù)器對應(yīng)的載板,不論尺寸、乘數(shù)、線路等級都有一定差距,整個售價就相差很多。普通芯片載板大概20 美元,但異質(zhì)整合搭配先進(jìn)封裝的載板,有些超過了100 美元。
異質(zhì)整合搭配先進(jìn)封裝的載板價格高的原因?
第一,整個尺寸,根據(jù)搭配不同芯片的封裝類型,差異很多。以英特爾為例,采用 Chiplet芯片,平均面積大出16-25%之間,華為甚至更多,一些產(chǎn)品已經(jīng)超出了兩倍的面積,原先普通的是45*45,多芯片組合封裝就會達(dá)到200*200。
第二,層數(shù),先進(jìn)封裝搭配的通訊速度越來越高,對載板線路制作的程度也越來越高,線路等級也會越來越高,原先普通 CPU 封裝6、8 層可以匹配。先進(jìn)封裝的領(lǐng)域?qū)?yīng)的層數(shù)有些達(dá)到了12 到16 層以上。線路等級由 15 到目前 8 微米的線路等級。先進(jìn)封裝是未來比較可行的提升芯片性能的可行方式。先進(jìn)封裝對載板的層數(shù)、面積、線路等級的要求越來越高,也會拉動載板的需求。同時等級越高,制作良率也會越低,對供應(yīng)是一個正向影響。
第三,3D 封裝,在2.5D 基礎(chǔ)上,在垂直結(jié)構(gòu)上將晶圓和晶圓中間的通道用硅通孔技術(shù)打通,在晶圓和晶圓之間打一些硅的通孔,再做電鍍、電性的材料導(dǎo)通,從而在平面的基礎(chǔ)上又在垂直的方向做了芯片的結(jié)合。所以運算性能和功耗會進(jìn)一步得到改善,但目前仍處于研發(fā)階段。傳統(tǒng)產(chǎn)品封裝,在市面上大量應(yīng)用,就用疊die 的方式。比如晶圓上疊晶圓,像存儲產(chǎn)品,原先單層 die,最多疊到了100 多層die。不同晶圓一直疊,再通過打印的方式搞到載板上去。這對載板的要求也會越來越高,對載板的平坦度、以及層數(shù)有更高要求,這是未來發(fā)展的方向。
對國產(chǎn)替代、對整個行業(yè)發(fā)展的中長期看法?
(1)從短期看,目前沒有看到明朗的需求。
BT 載板的需求回落很明顯,臺資及韓系工廠的稼動率都相對較低,只有50-60%的稼動
率。越低端產(chǎn)品稼動率越低,供給較為充裕。欣興2020 年開始轉(zhuǎn)型,將大部分產(chǎn)能擴(kuò)充到高階產(chǎn)品。ABF 工廠,分不同產(chǎn)品類型,普通電腦CPU 目前是需要去庫存的階段,稼動率相對不高,只有70%左右。一些高階產(chǎn)品處在供不應(yīng)求狀況,因為只有頭部幾家能做。隨著AI、智能化、物聯(lián)網(wǎng)的需求,對通信的要求越來越高,高端載板需求比較穩(wěn)定,甚至有進(jìn)一步增長。包含車載芯片在內(nèi),還會有進(jìn)一步的增長。業(yè)內(nèi)調(diào)查在2023 年的 Q1、Q2是維持2022 年Q4 的狀況,稼動率不高。隨著經(jīng)濟(jì)的復(fù)蘇,消費電子端,今年年中會有手機(jī)、電腦、服務(wù)器新的處理器發(fā)布,包含去年生產(chǎn)的庫存,2023 年Q1 就可消除掉。消費端的復(fù)蘇和整個行業(yè)景氣度的提升,有機(jī)會在Q3 有所回升。
(2)從中長期看,受地緣政治、國內(nèi)自主推進(jìn)的影響,在國產(chǎn)替代部分中長期看好。
第一個明顯指標(biāo)——晶圓制作國內(nèi)的工廠都在低調(diào)購買設(shè)備,擴(kuò)大晶圓制作產(chǎn)能,目前封測廠大幅產(chǎn)能向中國內(nèi)陸轉(zhuǎn)移,比如長電、華天近幾年大幅擴(kuò)產(chǎn)。國內(nèi)大基金重點扶持。目前先進(jìn)封裝發(fā)展的并不慢。國內(nèi)對內(nèi)存的需求受政策影響,比如國內(nèi)推進(jìn)的東數(shù)西算,包括內(nèi)存,比如長江存儲,在國內(nèi)實現(xiàn)了從0 到1 的突破,大部分內(nèi)存從設(shè)計生產(chǎn)走向國內(nèi)的自主化生產(chǎn)。
第二,從政治角度看,國家從政治上重點扶持國內(nèi)產(chǎn)業(yè)鏈各個環(huán)節(jié)都能自主生產(chǎn)。從原材料看,像BT 板材,生益科技、華正新材、南亞新材都開始逐步研發(fā)替代性BT 板材,如海思推動生益科技認(rèn)證自己的板材。目前國內(nèi)有一些供應(yīng)商,像生益、華正都在研發(fā)自己的堆積薄膜,搭配國內(nèi)設(shè)計公司共同研發(fā)。從設(shè)備看,制作板廠的設(shè)備,大部分高端設(shè)備都是日本、德國、歐洲的設(shè)備,目前對應(yīng)的設(shè)備在國內(nèi)也開始轉(zhuǎn)移。
高端的曝光機(jī),國內(nèi)比較好的,像芯碁微裝、源卓,已經(jīng)在 PCB 領(lǐng)域大幅應(yīng)用,載板方面,先進(jìn)的工廠也已經(jīng)在評估。所以中長期看,從國產(chǎn)替代角度看,這是發(fā)展的必然趨勢。國內(nèi)的公司開始投資擴(kuò)產(chǎn)自己的產(chǎn)能,是符合發(fā)展趨勢的。
國內(nèi)想要進(jìn)入該領(lǐng)域,開始只能拼成本價格,但相對 PCB 來說凈利潤比較好,普通、傳統(tǒng)的載板利潤在30%左右,高級的產(chǎn)品可以做到 80%左右,比 PCB 的利潤率高很多,國內(nèi)工廠擴(kuò)建的產(chǎn)能,即使比傳統(tǒng)工廠售價低 10-20%進(jìn)入市場,在良率穩(wěn)定的基礎(chǔ)上,仍會有一定利率去爭取,綜合利潤率好于 PC。所以目前國內(nèi)的發(fā)展?fàn)顩r比較正向。
國內(nèi)做BT/ABF 覆銅板的廠商有嗎?那些廠商做的更好更成熟?
國內(nèi)只能做BT 板材,生益科技的 BT 板材和華為海思共同研發(fā)的,做的比較好。在臺灣的欣興電子已經(jīng)在應(yīng)用。南亞新材、臺光的材料,目前都是在實驗階段,沒有批量生產(chǎn)。生益科技已經(jīng)有小批量的生產(chǎn)在認(rèn)證。
ABF,97%都是Ajinomoto 的,剩下的在業(yè)內(nèi)基本都沒有批量生產(chǎn)。唯一比較好的是日本太陽的tbf,國內(nèi)華正新材的cbf,實際上都是在搭配研發(fā),還沒有真正的產(chǎn)品型號面世。
現(xiàn)在新增的ABF 載板的覆銅板也是從海外采購的?
覆銅板中間的BT,50%以上都是三菱瓦斯, BT 載板是三菱瓦斯的專利,應(yīng)用最成熟,因為興森在做BT 出給三星,大部分是從韓國的斗山、LG 采購,只有不到10%是國內(nèi)生益代工的。
很多ABF 廠商和英特爾、英偉達(dá)簽訂包產(chǎn)線的條約,其訂單情況?
這些工廠的部分廠區(qū)是和英偉達(dá)、英特爾簽訂的,如欣興的桃園廠區(qū)。但英特爾雖然是中長期協(xié)議,但目前處于最低稼動率。此外欣興在大陸擴(kuò)展的新廠大部分是為了非英特爾客戶,這部分客戶存在砍單現(xiàn)象。
目前的狀況看,覆銅板或PCB 價格還有下降空間嗎?
取決于不同產(chǎn)品。低端的產(chǎn)品毛利不到10%,很難有下降空間,部分廠商為了開工資可能下降2 個點。部分載板產(chǎn)品毛利率高,在35%以上,隨著進(jìn)一步釋放產(chǎn)能,新玩家想要進(jìn)入,產(chǎn)品報價存在一定降價的空間,因此仍會有價格波動。覆銅板近期價格沒有上升。
Chiplet技術(shù)
Chiplet,又稱芯粒或小芯片,它是將一類滿足特定功能的die(裸片),通過die-to-die內(nèi)部互聯(lián)技術(shù)實現(xiàn)多個模塊芯片與底層基礎(chǔ)芯片封裝在一起,形成一個系統(tǒng)芯片,以實現(xiàn)一種新形式的IP復(fù)用。
SOC與Chiplet
在傳統(tǒng)大規(guī)模集成電路設(shè)計中,異構(gòu)多核的SoC成為主流趨勢,設(shè)計者把整個電子系統(tǒng)集成在一個芯片中,微處理器、模擬IP核、數(shù)字IP核,存儲器或片外存儲控制接口,都被集成在單一芯片上,形成一顆SoC,并使用同一種工藝制造。以此來縮小芯片體積,增加功能,提高性能和可靠性。
SoC 設(shè)計的關(guān)鍵技術(shù)主要包括IP可復(fù)用技術(shù)、總線架構(gòu)技術(shù)、軟硬件協(xié)同設(shè)計、SoC驗證、可靠性可測性設(shè)計、低功耗設(shè)計、超深亞微米電路實現(xiàn)技術(shù)等。隨著工藝節(jié)點的不斷向前推進(jìn),除了芯片設(shè)計技術(shù)上的難度、復(fù)雜度進(jìn)一步增加,其成本也在不斷升高,據(jù)了解,28nm 節(jié)點上開發(fā)芯片需要5130萬美元投入;16nm 節(jié)點需要1億美元;在7nm 工藝節(jié)點上的成本超過2.5億美元。此外,隨著芯片面積增大,芯片的良率會下降,將進(jìn)一步提高芯片制造的成本。
而基于裸芯片的Chiplet模式或許是解決以上問題的一種方法。將傳統(tǒng)的系統(tǒng)級芯片劃分為多個單功能或多功能組合的“芯粒”,然后在一個封裝內(nèi)通過基板互連成為一個完整的復(fù)雜功能芯片。有專家曾指出:可以將Chiplet看成是一種硬核形式的IP,其以芯片裸片的形式提供,而不是像SoC以軟件形式提供,如下圖所示。
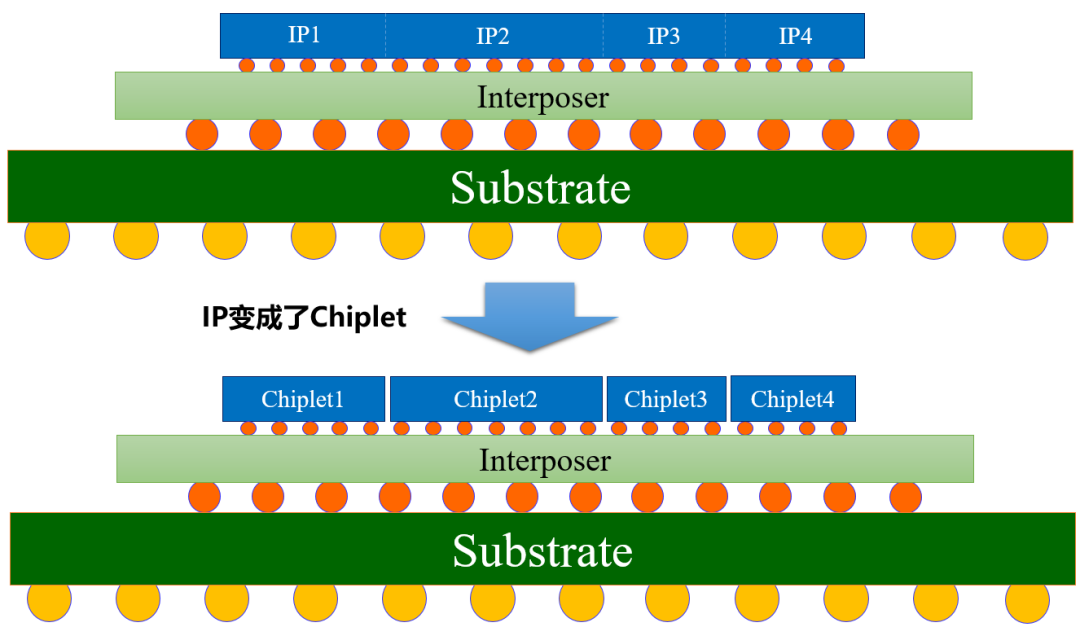
圖1:Chiplet技術(shù)示意圖
(來源:SIP與先進(jìn)封裝技術(shù))
由于Chiplet 面積較小,其良率和成本相對于SOC有較大的改善,此外,Chiplet芯片可以使用不同的工藝節(jié)點制造,甚至可以由不同的供應(yīng)商提供。將這些針對特定應(yīng)用設(shè)計專用的高性能芯粒和其他通用芯粒(例如內(nèi)存,高速串行接口等)通過先進(jìn)封裝技術(shù)集成在一起,從而實現(xiàn)異構(gòu)計算和集成以提升系統(tǒng)性能。
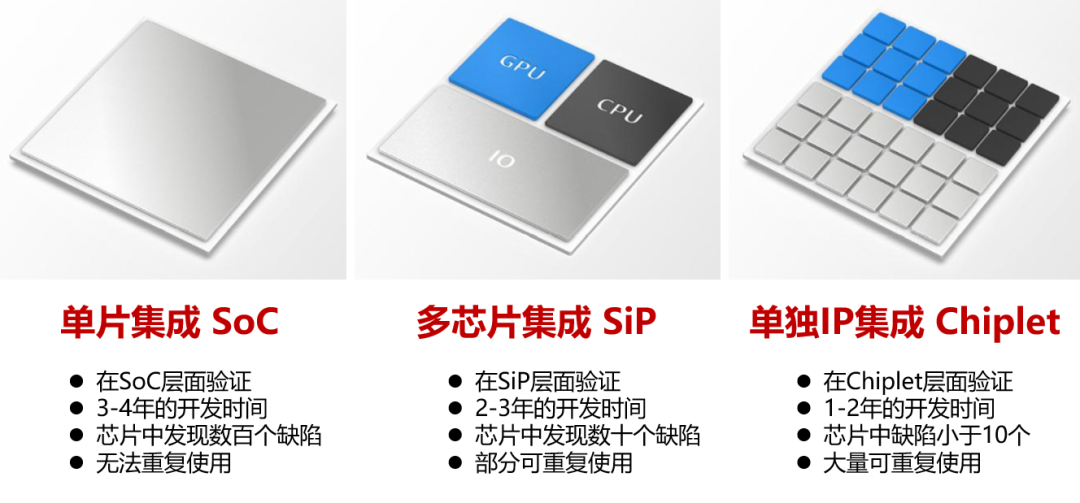
圖2:SOC、SiP與Chiplet的區(qū)別
(來源:網(wǎng)絡(luò))
此外,Chiplet還有以下主要優(yōu)勢:
(1)存儲器、數(shù)字邏輯、模擬、射頻、硅光等芯片的工藝不同,工藝尺寸縮小的速度也存在差異,Chiplet集成技術(shù)可以滿足這些器件在不同工藝下的異構(gòu)集成(異構(gòu)集成和異質(zhì)集成)需求。以AMD為例,AMD第二代EPYC 服務(wù)器處理器Ryzen采用小芯片設(shè)計,將先進(jìn)的臺積電7nm工藝制造的CPU模塊與更成熟的格羅方德12/14nm工藝制造的I/O 模塊組合,7nm可滿足高算力的需求;
(2)Chiplet可以在不同產(chǎn)品中實現(xiàn)重用,降低產(chǎn)品的上市時間;
(3)通過測試,對不同Chiplet的性能進(jìn)行分類和篩選,實現(xiàn)更優(yōu)的Chiplet集成組合和產(chǎn)品性價比控制。以下是Chiplet與SoC比較。

華為CHIPLET專家會議紀(jì)要
專家信息:華為負(fù)責(zé)先進(jìn)封測核心技術(shù)的某部門研發(fā)總監(jiān)
Q:從中國半導(dǎo)體產(chǎn)業(yè)來看,Chiplet技術(shù)是否是短期內(nèi)破局先進(jìn)制程限制的唯一路線?還有沒有其他可能的突破點?
A:目前來看是最有機(jī)會的,但是唯一的說法有點太過絕對。Chiplet只是把SOC轉(zhuǎn)換過來,拆分成一個個功能單元再封裝起來,其實用package也可以做到,但是會損失尺寸和功率,總體來說Chiplet在PPA上面會更有優(yōu)勢。
Q:中國企業(yè)Chiplet技術(shù)發(fā)展現(xiàn)狀,哪些方面領(lǐng)先或者夠用了,哪些方面還有不足,是否有部分環(huán)節(jié)還是有卡脖子問題?
A:要從Chiplet的全產(chǎn)業(yè)鏈來看,Chiplet雖然現(xiàn)在是屬于先進(jìn)封裝這一塊,但是實際上要涉及到全產(chǎn)業(yè)鏈的聯(lián)動,包括芯片的設(shè)計,EDA,IP,Interposer,材料和設(shè)備等,相當(dāng)于換了一個賽道有更多的機(jī)會,但是整體上也和先進(jìn)制程維持著一樣的水平,在芯片制造的后道,設(shè)備環(huán)節(jié)機(jī)會好一點,封裝這一塊是最有機(jī)會的。
Q:封測廠方面,和哪家合作比較多?
A:和長電合作比較多,和通富停留在打樣試制的程度
Q:目前產(chǎn)品做到什么程度,涉及到的環(huán)節(jié)比如EDA,IP與制造有哪些是國產(chǎn)的?
A:國內(nèi)也有一些EDA公司,國外的EDA軟件也能用。已經(jīng)發(fā)布了14nm堆疊得到7nm的服務(wù)器的云計算的處理器。EDA部分還是用的原來的國外的EDA,還有部分的國內(nèi)EDA,華大九天的EDA在試用,IP還是用的國外的,制造就是中芯國際。
Q:Die測試量的增加是否能明顯帶動測試設(shè)備商的業(yè)績提升?國內(nèi)主要是和哪家測試機(jī)廠商在合作?
A:測試方面在國外的限制之前還是能測的,國內(nèi)在扶植華峰和長川,兩家給的機(jī)會基本是均等的,兩家各有側(cè)重點,長川測試的分選會更好一點,測試機(jī)更國外差距還比較大。華峰測試機(jī)這一塊可能稍微更好。
Q:測試方面跟長川的綁定是不是更深一些?
A:長川跟華為的合作意愿更強,希望借助大公司平臺把經(jīng)營方面做好,華峰出于自身考慮,不想綁定在某一家公司或者Chiplet身上,想多元化發(fā)展去更好適應(yīng)市場。
Q:測試增量定量增量有多少?
A:比較難定量測算,舉例來說5個功能集成到同一個SOC上,測一次,但是測試比較復(fù)雜,耗時比較長,Chiplet需要測五次,但是時間不是簡單1:5,由于單個小芯片測試簡單了,時間可能變成1:4。另一方面,集成SOC有可能只測關(guān)鍵參數(shù),測一個結(jié)果即可,但是Chiplet需要每個小芯片都測清楚,參數(shù)不同,需要的時間有可能又會更多,時間比又或許會成為1:6,因此要看具體的產(chǎn)品來定。
Q:Chiplet產(chǎn)品策略怎樣?面向鯤鵬的Chiplet,基站Chiplet,還是手機(jī)的Chiplet?
A:產(chǎn)品研發(fā)從簡單到復(fù)雜,一般先做大數(shù)據(jù)處理,云計算方面的需求,就是服務(wù)器芯片,成熟以后,再轉(zhuǎn)向消費電子,手機(jī)處理器上面去做,什么時候去做要根據(jù)具體情況。服務(wù)器對體積和散熱需求不如手機(jī)那么高,手機(jī)對尺寸和散熱容忍程度是需要解決的難點。
Q:通信基站是不是不需要用Chiplet技術(shù)做的14nm?
A:基站要求沒有那么高,不一定要用到5nm或者3nm,暫時不需要用到Chiplet,未來也不排除在基站方向用Chiplet,目前來看是沒有這方面的推進(jìn)。
Q:Chiplet技術(shù)路線上還有哪些環(huán)節(jié)可以被美國卡脖子?
A:從產(chǎn)業(yè)鏈來看還是會有卡脖子的地方,單從Chiplet去看,可以自己組合各種功能,但是從芯片制造方向來看還是會有卡脖子的地方,比如14nm芯片制造,還有EDA軟件等。此外,雖然封裝差距比較小,但是也有關(guān)鍵部件也是能夠被卡的。最大的問題是材料這一塊,材料的國內(nèi)外差距也很大,跟設(shè)備的差距差不多,現(xiàn)在都是日韓等國,如果美國提升限制,很多材料也沒法用,尤其是一些高端基板,低端基板滿足不了Chiplet需求,美國卡了基本的話就用不了。先進(jìn)的基板材料都是被日本壟斷,線寬間距和掩膜(ABF膜)也是日本獨家壟斷,國內(nèi)自己基板和國外差異還是很大。
Q:興森科技也在擴(kuò)ABF的基板?興森和深南擴(kuò)出來的ABF基板能達(dá)到要求嗎?
A:掩膜是覆蓋在ABF上面的材料,這塊也有比較大的受限的風(fēng)險。興森和深南擴(kuò)產(chǎn)做ABF基板,但是ABF材料一旦不供應(yīng),ABF基本就做不了,線寬線間距也就做不小了。
Q:Interposer的作用,市場空間,分類,單價,用量等?
A:基板占大頭30%,接下來就是Interrposer20%,合起來在50%以上,價值量有幾十到幾百塊錢,這是不算芯片的價錢,是除了芯片之外所有材料的價值量。轉(zhuǎn)接板大都是用的硅基的轉(zhuǎn)接板,就是只有晶圓廠能做。
Q:大港股份收購的蘇州科陽能做TSV,是不是也能做Chiplet?
A:大港目前不做Chiplet,做一些Bumping,但是要看尺寸的。要做到像Chiplet的需求的話應(yīng)該還做不了,Bumping和rdl是有能力的,但是尺寸達(dá)不到chiplet要求,也沒有對應(yīng)的晶圓的后處理的設(shè)備。總體來說是能做跟Chiplet相關(guān)的一些Bumping,TSV一定需要晶圓廠的設(shè)備。
Q:TSV每平米的單價?
A:屬于晶圓廠定價,單應(yīng)該不是按尺寸大小,應(yīng)該是按加工難度,深寬比來收費。
Q:海外的康寧、肖特,國內(nèi)的沃格光電,發(fā)布的玻璃基TGV技術(shù),也可以用于interposer,如何評價該技術(shù)路線?
A:TGV適用于特殊環(huán)境特殊需求,一種是基底做金屬化圖形,另外一種是做轉(zhuǎn)接板用但是比chiplet要求要簡單,間距等比較粗,用非批量性的產(chǎn)品,主要是對熱應(yīng)力變形要求高的特殊領(lǐng)域。起源不是為了用于chiplet,現(xiàn)在要開始改進(jìn)原有技術(shù)路線,適應(yīng)chiplet的需求,多層、高密度等。
Q:TGV技術(shù)過去沒有發(fā)展起來的主要瓶頸是什么?未來是否有望放量?市場空間多大?
A:玻璃基有難點是通孔定向蝕刻,硅基很成熟,深寬比、保護(hù)側(cè)壁等。TSV先刻蝕一個深度,然后長鈍化層保護(hù)起來,然后底部打開保護(hù)繼續(xù)向下蝕刻,玻璃基還做不到。如果這個問題能解決,TGV是有優(yōu)勢能替代TSV的,性能更好,電性能抗磁電感都要好于硅,硅的晶體結(jié)構(gòu)決定了一些缺陷。玻璃更適合短距離快速傳遞。然后要看TGV和TSV的成本,如果成本一致的話TGV性能有優(yōu)勢,可以替代TSV的市場。
Q:如何評價沃格光電在TGV、玻璃基封裝載板方面的技術(shù)實力?
A:沃格最初研發(fā)是為了解決光領(lǐng)域的光通信需求有合作,然后看到了chiplet的需求,就想來拓展這塊。目前還是光器件領(lǐng)域的TGV能力。另外他還有玻璃基封裝產(chǎn)品,目前還滿足不了chiplet的需求,和芯片接觸面還達(dá)不到10+nm級別水平。和華為有技術(shù)合作。
Q:Chiplet是否能帶動IP廠商(如芯原股份)的產(chǎn)品虛擬轉(zhuǎn)向?qū)嶓w,IP廠商在Chiplet方向上的彈性有多大?還是說純IP廠商會失去原有優(yōu)勢?
A:通過IP去找市場,有明確的需求后才會去做,庫存不是很大的問題,產(chǎn)品由虛擬轉(zhuǎn)向?qū)嶓w也會帶來價值量的提升,此外未來Chiplet的硬IP的組合會更靈活有更多的選擇性,因此總體上來說IP廠商可以獲取更多的機(jī)會?
Q:傳統(tǒng)EDA在Chiplet項目設(shè)計上有諸多問題待解決,對多芯片堆疊的2.5D/3D異構(gòu)封裝顯得很低效,芯片和封裝相互之間的影響變得更顯著,還有芯片可測性設(shè)計如何實現(xiàn)均要求DFT工具能夠用高度自動化流程實現(xiàn),國產(chǎn)EDA在Chiplet領(lǐng)域能否追趕上國際龍頭的步伐?
A:在Chiplet設(shè)計上的EDA相當(dāng)于換了賽道,的確是對國內(nèi)EDA廠商追趕國外龍頭企業(yè)有些幫助,但是海外的龍頭發(fā)展這么多年還是在細(xì)節(jié)上優(yōu)勢明顯。國內(nèi)的華大九天有整體架構(gòu)能力,但是細(xì)節(jié)還是要解決問題。
Q、Chiplet相關(guān)的很多先進(jìn)技術(shù)依然由臺積電等把持,因為Chiplet涉及的很多先進(jìn)封裝技術(shù)和晶圓級的處理緊密相關(guān),TSV會不會被卡脖子?
A:雖然TSV也是涉及到納米級別的工藝,但是和SOC芯片制造工藝也不完全一樣,要求要等很多,因此可以繞過,不太容易在這個環(huán)節(jié)被卡脖子。
Q:Chiplet從產(chǎn)業(yè)上來講未來的發(fā)展趨勢是否真正是高端芯片產(chǎn)品繞不過的技術(shù)路線?
A:是目前來說最有優(yōu)勢的一種技術(shù)路徑,不能說是完全繞不過,未來也許會有更新的顛覆性的技術(shù)出現(xiàn),但是當(dāng)下來說Chiplet確實具有很多價值。
Q:國內(nèi)《小芯片接口總線技術(shù)要求》標(biāo)準(zhǔn)和國際UCIe聯(lián)盟的協(xié)議標(biāo)準(zhǔn)在技術(shù)層面有什么本質(zhì)區(qū)別,如果未來UCIe聯(lián)盟最中國企業(yè)進(jìn)行制裁,是否會造成國內(nèi)Chiplet技術(shù)與國際脫節(jié)。
A:國際標(biāo)準(zhǔn)即使封鎖了也可以拿過來用,這是不影響的。最差情況只是不帶中國廠商制定標(biāo)準(zhǔn)。目前兩套標(biāo)準(zhǔn)不會脫節(jié),國內(nèi)的Chiplet標(biāo)準(zhǔn)發(fā)布更多出于是一種制衡的策略。
審核編輯 :李倩
-
封裝
+關(guān)注
關(guān)注
127文章
8128瀏覽量
143818 -
ABF
+關(guān)注
關(guān)注
1文章
21瀏覽量
9214 -
chiplet
+關(guān)注
關(guān)注
6文章
437瀏覽量
12673
原文標(biāo)題:ABF載板交流紀(jì)要
文章出處:【微信號:AIOT大數(shù)據(jù),微信公眾號:AIOT大數(shù)據(jù)】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
奧特斯將投資10億歐元在重慶新建一座高端半導(dǎo)體封裝載板工廠
產(chǎn)能緊缺的ABF載板,國內(nèi)企業(yè)取得突破
什么是ABF (Adaptive BeamForming)
南電預(yù)期雖然PCB需求因步入淡季而下滑,但在ABF載板需求續(xù)強
PCB與半導(dǎo)體封裝載板市場概況:規(guī)模近500億美元!
未來三年 PCB和半導(dǎo)體封裝載板市場的年復(fù)合增長率將為3.7%
奧特斯宣布將在重慶擴(kuò)產(chǎn)其戰(zhàn)略支柱型業(yè)務(wù)半導(dǎo)體封裝載板
行業(yè) | 興森積極擴(kuò)產(chǎn)IC封裝載板,有望實現(xiàn)國內(nèi)產(chǎn)能第一
奧特斯持續(xù)成長,ABF載板需求激增

ABF載板的制造難度在哪里
IC載板族群面臨2022年經(jīng)濟(jì)下修,ABF明年仍供不應(yīng)求
IC載板行業(yè)現(xiàn)狀及市場前景可期
大摩:ABF載板產(chǎn)能利用率Q3僅50% 下調(diào)廠商預(yù)期
TDA3x SoC15mm封裝(ABF)器件版本2.0數(shù)據(jù)表

DM505 SoC 15mm封裝(ABF)器件版本2.0數(shù)據(jù)表


















評論