根據(jù)產(chǎn)業(yè)研究機(jī)構(gòu)Yole Développement(Yole)的最新研究指出,在AI、資料中心和HPC發(fā)展的推動(dòng)下,F(xiàn)CBGA封裝的營(yíng)收預(yù)期將從2020年的100億美元成長(zhǎng)至2025年的120億美元。FCBGA封裝未來(lái)五年的產(chǎn)業(yè)規(guī)模年平均復(fù)合成長(zhǎng)率(CAGR)達(dá)3%。截至2025年,F(xiàn)CBGA營(yíng)收預(yù)期將超過(guò)100億美元。晶圓需求主要來(lái)自3D堆疊元件,與2020年相較,晶圓總體成長(zhǎng)為CAGA 8.5%。
其中包含F(xiàn)CBGA、扇出型、WLCSP和3D堆疊封裝,3D堆疊IC的目標(biāo)是在未來(lái)五年中以24.8%的CAGR成長(zhǎng),其中HBM占48%、3D占27%,而3D NAND占82%。臺(tái)積電仍保持領(lǐng)先地位,其2019年占扇出型封裝市場(chǎng)69%市占率。WLCSP封裝在智慧手機(jī)相關(guān)應(yīng)用中已經(jīng)成為不可或缺的一環(huán)。另外,日月光半導(dǎo)體、江蘇長(zhǎng)電科技、安靠科技和矽品是WLCSP晶圓市場(chǎng)的領(lǐng)導(dǎo)廠商。
從臺(tái)積電布局看3D IC的未來(lái)
中介層、EMIB、Foveros、die對(duì)die的堆疊、ODI、AIB和TSV。所有這些單詞和首字母縮寫(xiě)詞都具有一個(gè)重要的功能,它們都涉及硅的兩個(gè)位之間如何物理連接。簡(jiǎn)單來(lái)說(shuō),可以通過(guò)印刷電路板連接兩個(gè)芯片。這種方案很便宜,但沒(méi)有太大的帶寬。在這個(gè)簡(jiǎn)單的實(shí)現(xiàn)之上,還有多種方法可以將多個(gè)小芯片連接在一起,而臺(tái)積電擁有許多這樣的技術(shù)。為了統(tǒng)一其2.5D和3D封裝變體的所有不同名稱,TSMC在早前的技術(shù)大會(huì)上推出了其新的首要品牌:3DFabric。
3DFabric作為一個(gè)品牌具有一定的意義,可以將臺(tái)積電提供的數(shù)十種封裝技術(shù)結(jié)合在一起。從廣義上講,3DFabric分為兩個(gè)部分:一方面是所有“前端”芯片堆疊技術(shù),例如晶圓上芯片,而另一方面是“后端”封裝技術(shù),例如InFO(Integrated Fan-Out))和CoWoS(Chip-On-Wafer-On-Substrate)。
在我們之前的文章 里,我們對(duì)這方面有了初步的說(shuō)明,來(lái)到本文,我們來(lái)深入了解一下這家晶圓代工廠的先進(jìn)封裝技術(shù)。并將其與其他工廠的相似競(jìng)爭(zhēng)技術(shù)進(jìn)行對(duì)比。
臺(tái)積電為什么聚焦先進(jìn)封裝
在大家一貫的理解中,臺(tái)積電所從事的其實(shí)是晶圓代工的業(yè)務(wù)。 但進(jìn)入新世紀(jì),無(wú)論是臺(tái)積電,還是三星甚至 Intel,都把先進(jìn)封裝當(dāng)做公司的一大工作重點(diǎn),這主要是在日益增長(zhǎng)的性能需求與摩爾定律的逐漸失效的矛盾影響下所演進(jìn)出來(lái)的折中結(jié)果。
如semiwiki報(bào)道所說(shuō),對(duì)于許多其他應(yīng)用,摩爾定律不再具有成本效益,尤其是對(duì)于集成異構(gòu)功能而言,多芯片模塊(Multi-chip modules :MCM)和系統(tǒng)級(jí)封裝(System in PackageSiP)等“Moore than Moore”技術(shù)已成為將大量邏輯和存儲(chǔ)器,模擬,MEMS等集成到(子系統(tǒng))解決方案中的替代方案。但是,這些方法仍然是非常特定于客戶的,并且會(huì)花費(fèi)大量的開(kāi)發(fā)時(shí)間和成本。
翻看芯片發(fā)展的歷史,其實(shí)先進(jìn)封裝這個(gè)概念已經(jīng)存在了數(shù)十年。折中通過(guò)在封裝中組裝不同且先進(jìn)的芯片是推進(jìn)芯片設(shè)計(jì)的方法之一。今天,這個(gè)概念有時(shí)被稱為異構(gòu)集成。盡管如此,由于成本的原因,高級(jí)封裝主要用于高端,面向利基市場(chǎng)的應(yīng)用。
但這那可能很快就會(huì)改變。因?yàn)镮C縮放是推進(jìn)設(shè)計(jì)的傳統(tǒng)方式,它縮小了每個(gè)節(jié)點(diǎn)上的不同芯片功能,并將它們封裝到單片式芯片上。但是,IC縮放對(duì)許多人來(lái)說(shuō)變得太昂貴了,并且每個(gè)節(jié)點(diǎn)的收益都在減少。
雖然縮放仍然是新設(shè)計(jì)的一種選擇,但業(yè)界正在尋找替代方案,包括高級(jí)封裝。而變化的是,該行業(yè)正在開(kāi)發(fā)新的高級(jí)封裝類型或擴(kuò)展現(xiàn)有技術(shù)。
高級(jí)封裝背后的動(dòng)機(jī)仍然是相同的。與其將所有芯片功能塞在同一個(gè)芯片上,不如將它們分解并將它們集成到一個(gè)封裝中。據(jù)說(shuō)這可以降低成本并提供更好的產(chǎn)量。另一個(gè)目標(biāo)是使芯片彼此靠近。許多先進(jìn)分裝使內(nèi)存更接近處理器,從而以較低的延遲更快地訪問(wèn)數(shù)據(jù)。
這聽(tīng)起來(lái)很簡(jiǎn)單,但是這里有幾個(gè)挑戰(zhàn)。另外,沒(méi)有一種可以滿足所有需求的封裝類型。實(shí)際上,芯片客戶面臨著各種各樣的選擇。其中:扇出(晶圓級(jí)封裝中的集成die和組件)、2.5D / 3D(芯片在封裝中并排放置或彼此疊放)和3D-IC:(在內(nèi)存上堆疊內(nèi)存,在邏輯上堆疊或者在邏輯上堆疊邏輯)就成了三種常見(jiàn)的選擇。
此外,業(yè)界也正在追求一種稱為Chiplets的概念,該概念支持2.5D / 3D技術(shù)。這個(gè)想法是您在庫(kù)中有一個(gè)模塊化芯片或小芯片的選擇。然后,將它們集成到一個(gè)封裝中,并使用die到die的互連方案將它們連接起來(lái)。
在臺(tái)積電方面,為了滿足市場(chǎng)對(duì)新型多芯片IC封裝解決方案的需求,他們也與其OIP合作伙伴合作開(kāi)發(fā)了先進(jìn)的IC封裝技術(shù),以提供經(jīng)濟(jì)的解決方案,以實(shí)現(xiàn)摩爾定律以外的集成。
2012年,TSMC與Xilinx一起推出了當(dāng)時(shí)最大的FPGA,它由四個(gè)相同的28 nm FPGA芯片并排安裝在硅中介層上。他們還開(kāi)發(fā)了硅通孔(TSV),微凸點(diǎn)和再分布層(re-distribution-layer:RDL),以將這些構(gòu)件相互連接。臺(tái)積電基于其構(gòu)造,將該集成電路封裝解決方案命名為CoWoS(Chip-on-Wafer-on-Substrate)。這種基于積木和EDA支持的封裝技術(shù)已成為高性能和高功率設(shè)計(jì)的實(shí)際行業(yè)標(biāo)準(zhǔn)。
臺(tái)積電于2017年宣布了InFO(Integrated FanOut technology)技術(shù)。它使用polyamide film代替CoWoS中的硅中介層,從而降低了單位成本和封裝高度,這兩項(xiàng)都是移動(dòng)應(yīng)用成功的重要標(biāo)準(zhǔn)。臺(tái)積電已經(jīng)出貨了海量用于智能手機(jī)的InFO設(shè)計(jì)。
臺(tái)積電于2019年又推出了集成芯片系統(tǒng)(SoIC)技術(shù)。借助前端(晶圓廠)設(shè)備,TSMC可以非常精確地對(duì)準(zhǔn),然后使用許多窄間距的銅焊盤(pán)進(jìn)行壓焊(compression-bond)設(shè)計(jì),以進(jìn)一步最小化形狀因數(shù),互連電容和功率。
這兩種技術(shù)就逐漸演進(jìn)成了今天的3D Fabric。
TSMC-SoIC:前端芯片堆疊
按照臺(tái)積電方面的定義,諸如CoW(chip-on-wafer)和WoW(wafer-on-wafer)等前 端芯片堆疊技術(shù)統(tǒng)稱為“ SoIC”,即集成芯片系統(tǒng)(System of Integrated Chips)。 這些技術(shù)的目標(biāo)是在不使用后端集成選項(xiàng)上看到的“bumps”的情況下,將硅片堆疊在一起。 在這里,SoIC設(shè)計(jì)實(shí)際上是在創(chuàng)建鍵合接口,以便硅可以放在硅的頂部,就好像它是一整塊硅一樣。
根據(jù)臺(tái)積電官方介紹,公司的SoIC服務(wù)平臺(tái)提供創(chuàng)新的前段3D芯片間堆疊技術(shù),用于重新集成從片上系統(tǒng)(SoC)劃分的小芯片。最終的集成芯片在系統(tǒng)性能方面優(yōu)于原始SoC。它還提供了集成其他系統(tǒng)功能的靈活性。臺(tái)積電指出,SoIC服務(wù)平臺(tái)可滿足云,網(wǎng)絡(luò)和邊緣應(yīng)用中不斷增長(zhǎng)的計(jì)算,帶寬和延遲要求。它支持CoW和WoW方案,而這兩種方案在混合和匹配不同的芯片功能、尺寸和技術(shù)節(jié)點(diǎn)時(shí)提供了出色的設(shè)計(jì)靈活性。
具體而言,臺(tái)積電的SoIC技術(shù)是將多個(gè)die堆疊到“ 3D構(gòu)造塊”(又稱為“ 3D Chiplet”)中的一種非常強(qiáng)大的方法。
如今,SoIC在垂直堆疊的芯片之間的每平方毫米空間能夠?qū)崿F(xiàn)約10,000個(gè)互連。但看法這正在進(jìn)行向每平方毫米100萬(wàn)個(gè)互連的開(kāi)發(fā)工作。3D-IC愛(ài)好者一直在尋找一種能夠?qū)崿F(xiàn)這種細(xì)微互連,進(jìn)一步減小外形尺寸,消除帶寬限制,簡(jiǎn)化die堆疊中的熱量管理以及將大型、高度并行系統(tǒng)集成到其中的IC封裝方法。
SoIC的好處之一體現(xiàn)在在其熱性能:
面對(duì)面SoIC鍵合的熱阻比微凸點(diǎn)連接降低35%,并且隨著我們進(jìn)入具有多個(gè)封裝芯片的計(jì)算的未來(lái),管理這些接口以進(jìn)行散熱要更加難。但是,這些SoIC技術(shù)的不利之處在于,堆疊設(shè)計(jì)必須彼此協(xié)同設(shè)計(jì)。
諸如EMIB之類的微凸點(diǎn)技術(shù)以一種技術(shù)上可以將一系列芯片連接在一起的方式進(jìn)行。使用類似COW和WOWO的SoIC技術(shù),則從一開(kāi)始就固定了設(shè)計(jì)。
盡管如此,臺(tái)積電仍熱衷于提高其SoIC芯片堆疊能力,他們還展示了12層的堆疊。
根據(jù)臺(tái)積電的規(guī)劃,這是他們面向未來(lái)集成的一項(xiàng)關(guān)鍵技術(shù),它超越了過(guò)去的中介層或芯片堆疊的實(shí)現(xiàn)方式,因?yàn)樗试S在不使用任何微凸點(diǎn)的情況下堆疊硅芯片,而直接將硅的金屬層對(duì)準(zhǔn)并鍵合到硅芯片上。
如上圖所示,TSMC當(dāng)前正在探索SoIC的12-Hi配置。12-Hi堆疊中的每個(gè)die都有一系列的硅通孔(TSV),以使每一層與其余層通信,其中心思想是每一層可以是邏輯的不同組件 :如SRAM的IO,或者可以是無(wú)源的,這樣他們可以充當(dāng)其他主動(dòng)層之間的絕熱層。
按照TSMC的說(shuō)法,這種設(shè)計(jì)的最大厚度為600微米,這就意味著每一層的厚度均在50微米以下。請(qǐng)注意,標(biāo)準(zhǔn)的傳統(tǒng)die堆疊解決方案上的凸點(diǎn)間距可以約為50微米。對(duì)于SoIC,N7 / N6芯片的混合鍵合間距為9μm,N5芯片的混合鍵合間距為6μm。它表明,臺(tái)積電擁有一些令人印象深刻的線性制造和晶圓減薄技術(shù),以實(shí)現(xiàn)這種水平的一致性和die對(duì)準(zhǔn)。該公司甚至展示了將其減小到0.9μm的能力,該規(guī)模將使其能夠擴(kuò)展硅芯片的后端互連。
自然地,人們擔(dān)心沒(méi)有微凸點(diǎn)的兩個(gè)硅如何聯(lián)結(jié),此外還有密度和可靠性的問(wèn)題。臺(tái)積電表示,他們可以以非常可靠的格式展示出可靠的0.9微米鍵距。如果我們將其與英特爾路線圖上最佳的凸點(diǎn)間距堆疊進(jìn)行比較,該公司的目標(biāo)是10微米的凸點(diǎn)間距,那就意味著這要高出一個(gè)數(shù)量級(jí)。在這種情況下,對(duì)于有意義的芯片,SoIC可提供更好的連接密度和更低的每位能量。
臺(tái)積電計(jì)劃在其N7,N5和N3工藝節(jié)點(diǎn)上提供SoIC選項(xiàng),屆時(shí)TSV的間距將從9微米減小到4.5微米。臺(tái)積電期望這個(gè)技術(shù)能有規(guī)劃地發(fā)布,在每個(gè)節(jié)點(diǎn)進(jìn)入大批量生產(chǎn)后大約6-12個(gè)月就會(huì)出現(xiàn)新的選項(xiàng)。
臺(tái)積電后端先進(jìn)封裝:與Intel競(jìng)爭(zhēng)
封裝中的另一個(gè)相對(duì)簡(jiǎn)單的方案就是在一個(gè)封裝中連接兩個(gè)硅芯片。通常,這是通過(guò)兩塊硅片并排進(jìn)行的,并采用多種連接方式。大多數(shù)人最熟悉的是中介層方法,該方法將一大塊硅片置于所有互連的die下面,并且比簡(jiǎn)單地通過(guò)PCB封裝鋪設(shè)走線,它的布線方法更快捷。
類似地,另一種方法是將中介層嵌入在PCB中,僅用于將一個(gè)特定的die連接到另一個(gè)die(這就是Intel稱為其嵌入式多管芯互連橋或EMIB)。
英特爾等效的EMIB解決方案
第三個(gè)是die對(duì)die的直接垂直堆疊,但是,由于在兩塊硅片之間使用了微凸塊,因此這與上面提到的SoIC實(shí)現(xiàn)不同——SoIC使用了鍵合。實(shí)際上,臺(tái)積電下半年產(chǎn)品中的所有實(shí)現(xiàn)都是基于微凸塊的,因?yàn)檫@允許在制造完每個(gè)芯片之后更好地混合和匹配不同芯片之間的場(chǎng)景,但是并沒(méi)有獲得SoIC提供的密度或功耗優(yōu)勢(shì)。
這就是為什么它被稱為“后段”高級(jí)封裝的原因。舉個(gè)例子,具有HBM功能的GPU就是通過(guò)這樣實(shí)現(xiàn)的。
許多支持HBM的GPU具有一個(gè)GPU裸片,幾個(gè)HBM裸片,所有這些裸片都放置在中介層的頂部。GPU和HBM由不同公司制造(甚至可以使用不同的HBM),而硅中介層也可以在其他地方制造。該硅中介層可以是無(wú)源的(不包含邏輯,僅僅是die到die間的路由),也可以是有源的,并且如果需要,可以設(shè)計(jì)為在芯片之間實(shí)現(xiàn)更好的網(wǎng)絡(luò)互連,盡管這意味著中介層會(huì)消耗電源。
臺(tái)積電類似GPU中介層的策略在過(guò)去一直被稱為CoWoS(chip-on-wafer-on-substrate)。作為3DFabric的一部分,從實(shí)現(xiàn)方式上劃分,CoWoS現(xiàn)在具有三個(gè)變體:
每個(gè)人都熟悉的標(biāo)準(zhǔn)稱為CoWoS-S,其中S代表Silicon Interposer。CoWoS-S的局限性在于中介層的尺寸,該終結(jié)通常基于65nm制造工藝或類似工藝制造。由于中介層是單片硅片,因此必須類似地制造,并且隨著我們進(jìn)入小芯片時(shí)代,客戶要求越來(lái)越大的中介層,這意味著臺(tái)積電必須能夠制造它們(并提供高產(chǎn)量) 。
傳統(tǒng)芯片受標(biāo)線(reticle)的大小限制,這是機(jī)器內(nèi)部的基本限制,即在單個(gè)實(shí)例上可以“打印”一層的大小。為了使芯片尺寸為標(biāo)片大小的產(chǎn)品成為可能,TSMC一直在開(kāi)發(fā)多標(biāo)線大小的插入器技術(shù),以使這些產(chǎn)品更大。基于臺(tái)積電自己的路線圖,我們預(yù)計(jì)2023年的CoWoS實(shí)施將是標(biāo)線的四倍左右,每個(gè)產(chǎn)品將允許超過(guò)3000 平方毫米的有源邏輯硅。
由于CoWoS-S是以ASIC + HBM的組合實(shí)現(xiàn),因此臺(tái)積電也正在為標(biāo)準(zhǔn)架構(gòu)實(shí)施一個(gè)稱為CoWoS-S STAR的技術(shù)路線。這將使客戶能夠在針對(duì)2/4/6 HBM堆棧的特定設(shè)計(jì)協(xié)議內(nèi)工作,最小化中介層的尺寸,還可以加快產(chǎn)品上市時(shí)間并提高良率。
CoWoS-L則是另一種變體,使用局部硅互連和重新分布層。這里的關(guān)鍵詞是“本地”,這意味著它將兩個(gè)硅芯片本地連接在一起。這是一項(xiàng)與英特爾EMIB相同的方法。英特爾的EMIB已經(jīng)用于多種產(chǎn)品(Kaby-G,Stratix 10,Agilex FPGA),但臺(tái)積電目前僅在預(yù)認(rèn)證階段。臺(tái)積電似乎實(shí)現(xiàn)CoWoS-L的方式是將所有橋接互連一次放置在一個(gè)封裝上,因此該技術(shù)受到與每個(gè)互連的最大距離的限制。如下圖所示,TSMC的目標(biāo)是在2021年第二季度為CoWoS-L提供3.0倍標(biāo)線。
InFO封裝使芯片可以“扇出”,以在 SoC標(biāo)準(zhǔn)平面圖之外增加其他連接。這意味著,雖然芯片邏輯區(qū)域可以很小,但芯片要比邏輯電路更大以容納所有必需的引腳輸出連接。臺(tái)積電提供InFO已經(jīng)有很多年了,但是在3DFabric的支持下,它現(xiàn)在將提供與封裝內(nèi)連接有關(guān)的不同類型的InFO。
InFO-R(也稱為InFO_oS)允許在芯片和微凸塊之間添加重新分布層,以將多個(gè)芯片統(tǒng)一為一個(gè)封裝。這是另一種技術(shù),其限制因素是該技術(shù)的x / y尺寸(以標(biāo)線片尺寸衡量)。自2018年以來(lái),目前臺(tái)積電以1.5倍標(biāo)線支持InFO-R,并將在2020年第四季度升級(jí)到1.7倍標(biāo)線,到2021年第一季度將達(dá)到2.5倍標(biāo)線。
InFO-L與CoWoS-L相似之處在于,它使用局部硅互連將多個(gè)InFO die連接在一起。這項(xiàng)技術(shù)仍在開(kāi)發(fā)中,預(yù)計(jì)將于2021年第一季度完成認(rèn)證。
TMSC的封裝技術(shù)也可以結(jié)合在同一產(chǎn)品中。通過(guò)同時(shí)實(shí)現(xiàn)前端(SoIC)和后端(InFO)封裝,可以制造出新的產(chǎn)品類別。該公司制作了一個(gè)這樣的模型:
從表面上看,臺(tái)積電將在未來(lái)幾年為客戶提供更多的封裝選擇。他們?cè)谶@方面的主要競(jìng)爭(zhēng)者似乎是英特爾,后者已經(jīng)能夠在一些當(dāng)前產(chǎn)品和某些即將發(fā)布的產(chǎn)品中實(shí)現(xiàn)其EMIB和Foveros技術(shù)。臺(tái)積電將受益于與更多項(xiàng)目和客戶合作。
之前臺(tái)積電董事會(huì)通過(guò)了建設(shè)竹南先進(jìn)封測(cè)廠的決定。據(jù)報(bào)道,該廠選址為苗栗縣竹南科學(xué)園區(qū)。該封測(cè)廠預(yù)計(jì)總投資額約合人民幣716.2億元,計(jì)劃明年年中第一期產(chǎn)區(qū)運(yùn)轉(zhuǎn)。這對(duì)于臺(tái)積電來(lái)說(shuō)必然是一件好事,但對(duì)于傳統(tǒng)OSAT來(lái)說(shuō),這并不是什么好消息。
責(zé)任編輯:tzh
-
IC
+關(guān)注
關(guān)注
36文章
5978瀏覽量
176169 -
臺(tái)積電
+關(guān)注
關(guān)注
44文章
5685瀏覽量
166972 -
晶圓
+關(guān)注
關(guān)注
52文章
4973瀏覽量
128285 -
封裝
+關(guān)注
關(guān)注
127文章
7990瀏覽量
143365
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
臺(tái)積電2025年起調(diào)整工藝定價(jià)策略
臺(tái)積電熊本工廠正式量產(chǎn)
臺(tái)積電CoWoS封裝A1技術(shù)介紹

TechWiz LCD 3D應(yīng)用:撓曲電效用仿真
西門(mén)子擴(kuò)大與臺(tái)積電合作推動(dòng)IC和系統(tǒng)設(shè)計(jì)
臺(tái)積電擬在歐洲增設(shè)多座工廠,重點(diǎn)布局AI芯片市場(chǎng)
臺(tái)積電3nm制程需求激增,全年?duì)I收預(yù)期上調(diào)
臺(tái)積電封裝,新規(guī)劃
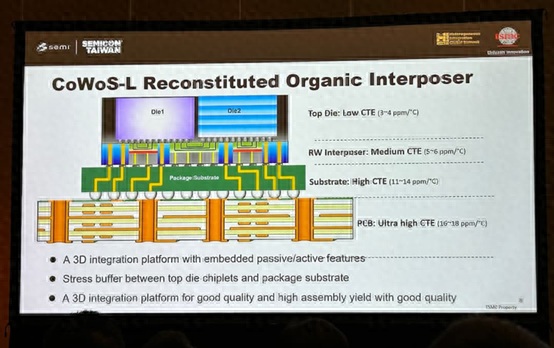
臺(tái)積電批準(zhǔn)近300億美元資本預(yù)算
臺(tái)積電布局FOPLP技術(shù),推動(dòng)芯片封裝新變革
臺(tái)積電增資日本、美國(guó)設(shè)廠,百億投資彰顯全球布局決心
西門(mén)子推出Calibre 3DThermal軟件,持續(xù)布局3D IC熱分析
Cadence與臺(tái)積電深化合作創(chuàng)新,以推動(dòng)系統(tǒng)和半導(dǎo)體設(shè)計(jì)轉(zhuǎn)型
AMD與臺(tái)積電聯(lián)手推動(dòng)先進(jìn)工藝發(fā)展
臺(tái)積電它有哪些前沿的2.5/3D IC封裝技術(shù)呢?





 從臺(tái)積電布局看3D IC的未來(lái)
從臺(tái)積電布局看3D IC的未來(lái)










評(píng)論