高頻驅動,有利于外圍元器件的小型化
在PWM逆變器驅動時的損耗仿真中,與同等額定電流的IGBT模塊相比,相同開關頻率的損耗在5kHz時減少30%、20kHz時減少55%,總體損耗顯著降低。在20kHz時,散熱器所需尺寸可比預期小88%。另外,通過高頻驅動,可使用更小體積的外圍無源器件,可進步一實現設備的小型化。
4、SiC肖特基勢壘二極管Bare Die
SBD可降低開關損耗,可高速開關。主要用于高速開關電源的PFC電路。肖特基二極管是通過金屬與N型半導體之間形成的接觸勢壘具有整流特性而制成的一種屬-半導體器件。肖特基二極管的基本結構是重摻雜的N型4H-SiC片、4H-SiC外延層、肖基觸層和歐姆接觸層。
SBD 在導通過程中沒有額外載流子的注入和儲存,因而反向恢復電流小,關斷過程很快,開關損耗小。傳統的硅肖特基二極管,由于所有金屬與硅的功函數差都不很大,硅的肖特基勢壘較低,硅 SBD 的反向漏電流偏大,阻斷電壓較低,只能用于一二百伏的低電壓場合且不適合在 150 ℃以上工作。然而,碳化硅 SBD彌補了硅 SBD 的不足,許多金屬,例如鎳、金、鈀、鈦、鈷等,都可以與碳化硅形成肖特基勢壘高度 1 eV 以上的肖特基接觸。據報道,Au/4H-SiC 接觸的勢壘高度可達到 1.73 eV,Ti/4H-SiC 接觸的勢壘比較低,但最高也可以達到 1.1 eV。6H-SiC與各種金屬接觸之間的肖特基勢壘高度變化比較寬,最低只有 0.5 eV,最高可達1.7 eV。于是,SBD 成為人們開發碳化硅電力電子器件首先關注的對象。它是高壓快速與低功率損耗、耐高溫相結合的理想器件。目前國際上相繼研制成功水平較高的多種類的碳化硅器件。
肖特基勢壘中載流子的輸運機理
金屬與半導體接觸時,載流子流經肖特基勢壘形成的電流主要有四種輸運途徑。這四種輸運方式為:
N 型 4H-SiC 半導體導帶中的載流子電子越過勢壘頂部熱發射到金屬;
N 型 4H-SiC 半導體導帶中的載流子電子以量子力學隧穿效應進入金屬;
空間電荷區中空穴和電子的復合;
4H-SiC 半導體與金屬由于空穴注入效應導致的的中性區復合。
5、SiC MOSFET Bare Die
從原理上而言,不存在開關工作時的拖尾電流,因此,可高速工作,降低開關損耗。芯片尺寸小,導通電阻低,因此實現了低容量、低柵極電壓。
N-channel SiC 功率MOSFET bare die_S4108
S4108是SiC(碳化硅)功率MOSFET。其特征是高耐壓、低導通電阻、高速開關。
審核編輯黃宇
-
二極管
+關注
關注
147文章
9700瀏覽量
167461 -
MOSFET
+關注
關注
147文章
7234瀏覽量
214158 -
PWM
+關注
關注
114文章
5197瀏覽量
214753 -
功率器件
+關注
關注
41文章
1794瀏覽量
90602 -
SiC
+關注
關注
29文章
2881瀏覽量
62897
發布評論請先 登錄
相關推薦
羅姆、臺積電就車載氮化鎵 GaN 功率器件達成戰略合作伙伴關系

羅姆與臺積公司攜手合作開發車載氮化鎵功率器件
芯動半導體與羅姆簽署SiC車載功率模塊合作協議
羅姆宣布全面委托臺積電代工GaN產品
全新SiC塑封模塊,羅姆革新了哪些?
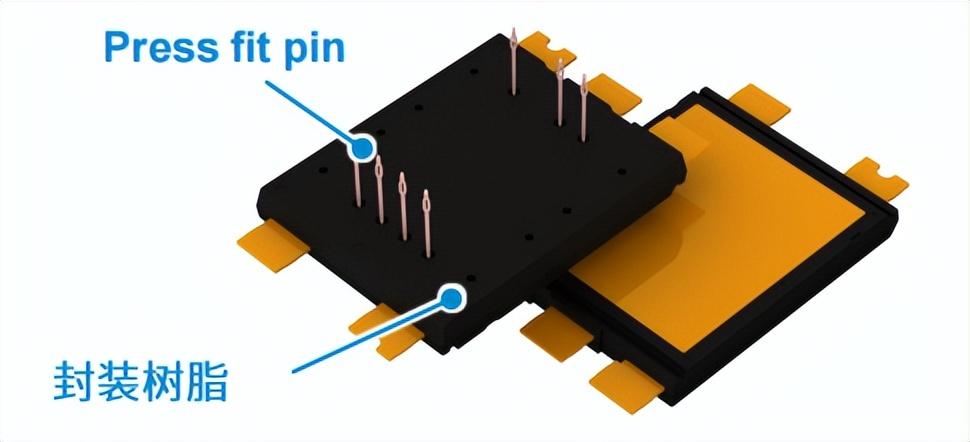
羅姆與聯合汽車電子簽署SiC功率元器件長期供貨協議
引領電動汽車革新,羅姆PCIM展重磅展出二合一SiC模塊
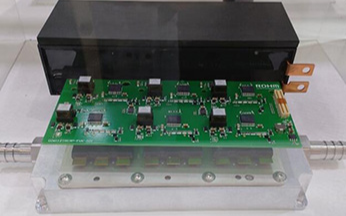
羅姆SiC技術賦能極氪電動車核心部件
羅姆半導體推動SiC MOSFET技術進步,與吉利汽車展開深度合作

羅姆子公司SiCrystal在德國擴產,SiC產能將擴大三倍
羅姆即將參展PCIM Europe 2024:賦能增長,推動創新





 5種羅姆常用的SiC功率器件介紹(下)
5種羅姆常用的SiC功率器件介紹(下)










評論