毫米波長范圍(30-300GHz)內(nèi)除了其較低端外,還沒有很好地被利用。而在成像,安全,醫(yī)療,和短距離無線傳輸以及數(shù)據(jù)速率不斷提高的光纖傳輸中的新應(yīng)用可能會(huì)迅速地改變這種狀態(tài)[1],[2]。在過去的三十年里,III-V 技術(shù)(GaAs 和InP)已經(jīng)逐漸擴(kuò)大到這個(gè)毫米波范圍中。新近以來,由于工藝尺寸持續(xù)不斷地減小,硅技術(shù)已經(jīng)加入了這個(gè)“游戲”。
在本文中,按照半導(dǎo)體特性和器件要求,對(duì)可用于100-GHz 和100-Gb/s 應(yīng)用的半導(dǎo)體有源器件進(jìn)行了綜述。隨后介紹了使用最廣泛的技術(shù),接著是兩個(gè)不同方面具有競(jìng)爭(zhēng)性的技術(shù)現(xiàn)狀:分頻器,來說明該技術(shù)適宜用在高速數(shù)字電路中,以及振蕩器,用來說明其在模擬電路應(yīng)用中的性能。
材料和工藝的基本特性
半導(dǎo)體材料的特性
運(yùn)行在很高頻率下的電子器件所表現(xiàn)的性能主要與:1)組成半導(dǎo)體的材料特性和2)器件的結(jié)構(gòu)有關(guān)[3]。Si,GaAs 和InP 是目前具有截止頻率在300GHz 及以上的器件所選擇的材料。在表1,人們給出了一些相關(guān)的表征能隙,載流子輸運(yùn)特性和導(dǎo)熱性的參數(shù)。同樣也報(bào)道了與InP,GaN 和InAs 晶格相匹配的InGaAs 的特性。
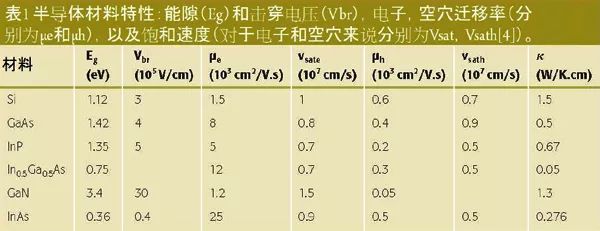
擁有一個(gè)足夠大能隙(Eg>1eV )是很有利的,這是因?yàn)樗梢蕴峁┖玫膿舸┨匦浴i,GaAs 和InP 在100nm 實(shí)際上可以承受幾伏的電壓水平;此外,p-n 結(jié)顯示出很明晰的整流行為,室溫下的泄漏電流可以忽略不計(jì)。采用GaN 可以獲得更高的擊穿電壓,InAs 因?yàn)槠淠芟逗艿投荒苡糜陔妷汉艿偷钠骷?/p>
III-V 材料中的電子遷移率比硅的要大,這意味著在給定的摻雜濃度下,n-型接觸區(qū)具有較低的串聯(lián)電阻,而對(duì)于p-型 區(qū)來說,由于III-V 材料較低的空穴遷移率,情況則恰恰相反。然而,在器件的高場(chǎng)強(qiáng)區(qū)控制跨導(dǎo)和渡越時(shí)間的載流子速度與取決于載流子類型的飽和漂移速度相接近(Vsat?或Vsath′取決于載流子的類型;接近于10nm/ps)。由于暫態(tài)效應(yīng)(電子從導(dǎo)帶中的低能級(jí),高遷移率能谷到達(dá)較高能級(jí),較低遷移率能谷的轉(zhuǎn)換不是瞬間發(fā)生的),電子的傳輸通常會(huì)受益于一些過沖量;例如,根據(jù)具有薄集電極的InP異質(zhì)結(jié)雙極性晶體管(HBT)的基極到集電極的渡越時(shí)間所推導(dǎo)出的有效速度大于3×107cm/s,大約是飽和速度的5 倍[5]。
甚高頻率性能意味著較短的渡越時(shí)間和較低的RC寄生量;對(duì)于場(chǎng)效應(yīng)管(FET)和雙極性晶體管來說,這通常可以通過減小電子器件的尺寸和提高電流密度來實(shí)現(xiàn)(例如,見[6])。對(duì)于極高頻器件和電路來說,熱導(dǎo)率則成為一個(gè)重要的參數(shù),硅在與其III-V 技術(shù)的對(duì)手相比時(shí),其所具有的良好的導(dǎo)熱性便成為一個(gè)真正的優(yōu)勢(shì),因?yàn)檫@有可能達(dá)到更高的器件密度。
基于III-V 技術(shù)的早期單片微波集成電路(MMIC)的主要優(yōu)點(diǎn)之一要?dú)w因于未摻雜(或補(bǔ)償)基片的半絕緣特性,這是與其大的半導(dǎo)體能隙直接相關(guān)的(基片的電阻率為108Ω.cm 的數(shù)量級(jí),而硅的電阻率為104Ω.cm)。這使得可以實(shí)現(xiàn)具有低關(guān)聯(lián)寄生效應(yīng)的電阻,電感和傳輸線。隨著近來巨大的微波應(yīng)用市場(chǎng)的開發(fā)(例如,移動(dòng)電話網(wǎng)絡(luò)),在硅基技術(shù)上引入無源器件這方面已經(jīng)取得了很大的進(jìn)展。此外,絕緣體加載硅基片技術(shù)(SOI)已經(jīng)展示出其降低寄生效應(yīng)的潛力(然而,這是以較低的基片導(dǎo)熱率為代價(jià)的)。
服務(wù)于高頻應(yīng)用的FET?和雙極性晶體管
今天,適用于高頻應(yīng)用的雙極性晶體管和FET 是基于異質(zhì)結(jié)結(jié)構(gòu)的(除了是硅基MOSFET 以外)。對(duì)異質(zhì)結(jié)的開發(fā)已經(jīng)有40 多年了,并且在材料和晶格應(yīng)力方面還在不斷地發(fā)展著。兩種不同材料(具有同樣的晶體結(jié)構(gòu)和同樣的晶格參數(shù))之間的異質(zhì)結(jié)主要是由它們的能隙差異,以及由這種差異所區(qū)分的導(dǎo)帶和價(jià)帶的階躍方式來表征的(表2)。在晶體管的有源區(qū),異質(zhì)結(jié)被用來達(dá)到兩個(gè)不同的目的:

? 不論它們各自的摻雜濃度如何,保證雙極性晶體管中從發(fā)射極向基極注入的是電子占主導(dǎo)地位的載流子
? 在高電子遷移率晶體管(HEMT)中將電子局限在未摻雜的量子肼中。
雖然最初是針對(duì)晶格匹配異質(zhì)結(jié)來實(shí)施的,但很快就顯示出用在失配異質(zhì)結(jié)中也可以增強(qiáng)性能,條件是應(yīng)力結(jié)晶層是在假晶厚度的極限內(nèi)(如果生長層足夠薄,其晶格常數(shù)會(huì)調(diào)整到基片的晶格常數(shù))。這種特性被用在HBT 中(例如漸變組分的方法,graded-composition)來生成具有短的渡越時(shí)間的基極層,以及高遷移率HEMT 的溝道層。在臨界厚度以上,(失配程度越高,層厚就越薄),生長層松弛下來,在晶體結(jié)構(gòu)中便會(huì)出現(xiàn)晶格脫位。這種現(xiàn)象仍然可以被用來在基片的頂部生成具有不同晶格參數(shù)的高質(zhì)量晶體層,在中間有一個(gè)過渡層(緩沖層)來俘獲大多數(shù)的脫位。例如,這種結(jié)構(gòu)可以在被稱為改性(metamorphic)HEMT 中找到,在松弛緩沖層之上又生長了一層高質(zhì)量的活性異質(zhì)結(jié)構(gòu)。特別是,變性結(jié)構(gòu)允許采用極高遷移率的InAs 溝道[7],[8]。
目前,可以預(yù)見幾種服務(wù)于100-GHz 和100-Gb/s應(yīng)用的技術(shù):GaAs 和InP HEMT;InP 和SiGe HBT,這些技術(shù)在過去的十年中已經(jīng)在使用之中了;以及硅CMOS 技術(shù),從最近的一些情況來看,它似乎要發(fā)揮作用了。很有前景的技術(shù)如GaN HEMT 以及那些采用小能隙材料的技術(shù)同樣可以進(jìn)入這個(gè)“游戲”。到目前為止,由于GaN HEMT 非凡的微波和毫米波功率容量,人們已對(duì)其進(jìn)行了開發(fā)[9]。此外,與晶體結(jié)構(gòu)相關(guān)的壓電效應(yīng)所帶來的高界面電子密度(大約1013cm-2)可以用來補(bǔ)償相對(duì)較低的載流子遷移率,如果特定的結(jié)構(gòu)設(shè)計(jì)可以產(chǎn)生低接觸電阻的話,那么使其具有甚高頻率性能似乎也是可行的[10]。
HBT?與FET?的差別
除了FET 是單極性器件以外(只有一種類型的載流子參與晶體管的運(yùn)行,而一個(gè)雙極性器件則意味著兩種類型的載流子都參與運(yùn)行),在雙極性和FET 技術(shù)之間還可以觀察到幾種差別,特別是:
? HBT 器件具有指數(shù)性的驅(qū)動(dòng)特性[就是說,集電極電流與輸入電壓之間的依賴關(guān)系是指數(shù)性的:icαexp(Vbe/kT)],而FET 器件的則是平方的關(guān)系[漏極電流隨著電壓的平方而變化的:idsαk(Vgs2)]。對(duì)于HEMT 來說,這種關(guān)系轉(zhuǎn)化為具有較大分散性的門限電壓。這便是為什么高速數(shù)字或混合信號(hào)集成電路(IC)通常采用HBT 技術(shù)進(jìn)行設(shè)計(jì)的原因(但請(qǐng)記住CMOS 在數(shù)字集成電路芯片中的成功)。另一方面,HEMT 呈現(xiàn)出比雙極晶體管較低的微波噪聲(金屬柵極電阻比半導(dǎo)體基極電阻要低)。
? HBT 晶體管是一個(gè)工作在很高電流密度下的垂直溝道器件(>100KA/m2,具有最高截止頻率的HBT 的電流密度甚至>1MA/cm2)。由于其所具有的高相關(guān)熱阻,HBT 的高功耗會(huì)削弱其固有的低門限電壓分散性這個(gè)優(yōu)點(diǎn)。
? 雖然截止頻率可以是類似的(直到500GHz),微波雙極晶體管通常是具有較低阻抗的器件,這是由較高的跨導(dǎo)和輸入電容來表征的。這會(huì)產(chǎn)生一些后果,包括雙極晶體管較低的負(fù)載靈敏度。
現(xiàn)有工藝
雖然一個(gè)設(shè)計(jì)人員可能不容易接觸到不同的工藝,但還是存在一些為數(shù)不多的具有下列工藝的制造廠家:
? 45-,65-和90-nm CMOS
? 130- nm HBT SiGe
? 100- nm HEMT
? 500- nm HBT InP。
對(duì)GaAs HEMT 的開發(fā)已經(jīng)很長時(shí)間了,其柵極長度遠(yuǎn)遠(yuǎn)小于1μm;就較早的MESFET 技術(shù)而言,主要的技術(shù)變化是與更加復(fù)雜的異質(zhì)外延結(jié)構(gòu)相關(guān)的。類似地,III-V HBT 技術(shù)通過將低頻GaAs 功率放大器用于手機(jī)之中而取得了商業(yè)上的成功。只需通過轉(zhuǎn)換到InP 基的材料系統(tǒng),這個(gè)技術(shù)便可踏入甚高頻領(lǐng)域。
新近,由于晶體管尺寸持續(xù)不斷地下降,硅工藝也同樣登上了毫米波舞臺(tái)。當(dāng)SiGe HBT 技術(shù)被開發(fā)后,這種技術(shù)通過深亞毫米工藝被引入到Bi-CMOS 圓晶廠,很快便呈現(xiàn)出具有與它們所對(duì)應(yīng)的III-V 技術(shù)相近的截止頻率。今天,這兩個(gè)技術(shù)主要的不同之處是:1)SiGe HBT 技術(shù)具有更成熟的工業(yè)環(huán)境(較高的電路復(fù)雜程度和擴(kuò)展了CMOS 的環(huán)境),以及2)該工藝較低的集電極擊穿電壓。
當(dāng)談到應(yīng)用時(shí),決定哪種工藝最適合的主要因素可能是下面幾點(diǎn),各自的分量取決于應(yīng)用情況。
1) 性能。這是一個(gè)關(guān)鍵因素,特別是對(duì)于那些要求具有最佳性能的應(yīng)用來說。
2) 目標(biāo)規(guī)范。應(yīng)用的規(guī)范要求可能會(huì)改變(隨著標(biāo)準(zhǔn)的演變),對(duì)于新應(yīng)用來說,具有一定程度的靈活性也許是必要的。
3) 直流功耗。為了減少設(shè)備的尺寸以及移動(dòng)終端的重量和功耗,低功耗是一個(gè)重要的因素。
4) 門數(shù)。這是另一個(gè)重要方面,因?yàn)?a target="_blank">數(shù)字信號(hào)處理正在提高其在應(yīng)用中的分量。
5) 成本。很顯然這是一個(gè)很重要的問題,并且適用于整個(gè)系統(tǒng)。而成本反過來則取決于所需的器件數(shù)量(市場(chǎng)容量):對(duì)于小的或中等數(shù)量(幾千到幾萬件)來說,III-V 工藝可能比SiGe的成本要低;對(duì)于更大的數(shù)量,情況則可能相反。
成熟工藝的介紹及現(xiàn)狀
基于GaAs?和InP?的P-HEMT和M-HEMT
最初,GaAs 晶體管是具有n- 型溝道的肖特基柵FET(MESFET),因?yàn)镮II-V 材料中電子的遷移率比空穴的遷移率大得多。會(huì)妨礙實(shí)現(xiàn)MOS 結(jié)構(gòu)的表面很強(qiáng)的費(fèi)米能級(jí)釘扎效應(yīng)卻有利于開發(fā)肖特基柵極。MESFET的性能通過提高溝道的摻雜濃度而逐漸改善;這是以電子遷移率(當(dāng)摻雜濃度提高時(shí),遷移率下降)和柵極泄漏電流為代價(jià)的。在1980 年所引入的HEMT 結(jié)構(gòu)(見圖1) 可以同時(shí)實(shí)現(xiàn)兩種改善:1) 通過一個(gè)高遷移率溝道來提高溝道電流(產(chǎn)生一個(gè)高跨導(dǎo)),以及2)由于寬能隙勢(shì)壘而改善了柵極泄漏。

圖1、HEMT 異質(zhì)結(jié)構(gòu)的能帶圖展示了夾在半-絕緣(SI)基片和勢(shì)壘層之間的窄能隙溝道。
在這個(gè)圖中,勢(shì)壘層是δ 摻雜,這意味著將施主雜質(zhì)引入到一個(gè)極薄層內(nèi)。溝道中的電子在界面的量子肼中積累,界面導(dǎo)帶偏移量(ΔEc)控制著表面密度ns。
自從HEMT 技術(shù)問世以來,人們已經(jīng)引入了許多旨在改善性能(ns?和Vsate)的改進(jìn)方案。兩種主要的途徑是:1)提高導(dǎo)帶偏移,從而使得在界面量子肼內(nèi)積累更多的電子,以及2)提高溝道的遷移率,實(shí)際上這意味著提高InGaAs 溝道中In 成分的含量(從常規(guī)的GaAsHEMT 的Xin=0%到最高速InP HEMT 中的Xin=80%)。
目前,正在GaAs 基片上開發(fā)兩種類型的HEMT:
1) 具有一層AlGaAs 障礙層和一個(gè)應(yīng)力InGaAs 溝道的主流GaAs P-HEMT(假晶HEMT)主要是用在20-70GHz 頻率范圍的低噪聲或功率應(yīng)用中[11]。
2) 采用GaAs M-HEMT(改性HEMT)可以獲得更高的速度,它基本上是一個(gè)在GaAs 基片的松弛緩沖層上生長一個(gè)晶格匹配的InP 結(jié)構(gòu)(具有一個(gè)ALInAs/InGaAs 異質(zhì)結(jié)結(jié)構(gòu))。這個(gè)結(jié)構(gòu)得益于InP 基結(jié)構(gòu)較高的速度和與較大,較脆GaAs 基片相關(guān)的低成本。雖然緩沖層的熱導(dǎo)性相當(dāng)差,但這個(gè)技術(shù)在100GHz 下仍然顯示出出色的功率和噪聲性能。
就最高運(yùn)行速度和較高的輸出功率而言,這些性能紀(jì)錄還是由InP PM-HEMT 來創(chuàng)造的,它在90GHz 時(shí)超過400mW,并且在300GHz 超過2mW[14]。
InP HBT
連同采用與InP 基片晶格匹配的材料系統(tǒng)成功制成了器件的首篇報(bào)道一起,在90 年代后期,有關(guān)InP 異質(zhì)結(jié)雙極性晶體管(HBT)的工作正式邁入了軌道[15]。這個(gè)材料系統(tǒng)具有若干超出SiGe 和GaAs 的優(yōu)勢(shì),包括:
1) InGaAs(晶格與InP 相匹配)材料中的遷移率和電子速度比GaAs 或SiGe 的更高。
2) 與GaAs 相比具有較低的表面復(fù)合速率,從而具有較高的電流增益,導(dǎo)致其具有按比例縮小到較小尺寸的能力。
3) 由于在基極中使用了窄能隙InGaAs,則具有比GaAs 較低的基極-發(fā)射極開啟電壓。
4) 當(dāng)InP 被用作集電極材料時(shí),具有比SiGe 更高的擊穿電場(chǎng)強(qiáng)度。
5) 產(chǎn)品具有比其它任何Si 或III-V 材料更高的擊穿電場(chǎng)/截止頻率的乘積。
6) 在InGaAs 基極和InGaAs 發(fā)射極覆蓋層(Cap)的最大摻雜濃度較高,從而產(chǎn)生較低的寄生接觸電阻值。
7) 由于許多三價(jià)半導(dǎo)體材料的晶格與InP 的相匹配,從而具有一種增強(qiáng)的“用能隙來操縱”HBT 的能力。
這些年來,InP HBT 已經(jīng)擔(dān)負(fù)起最快速基準(zhǔn)晶體管和電路性能的重任。近來,在Santa Barbara 和illinois 的研究小組已經(jīng)報(bào)道了Ft?超過700GHz 的器件,以及Ft/Fmax?超過500GHz 的平衡器件[16],[17]。
SiGe HBT-BiCMOS;CMOS 和NMOS
在80 年代后期所開發(fā)的SiGe HBT 是采用成熟的硅技術(shù)來生產(chǎn)的。通過各種開發(fā),包括在基極使用碳摻雜和基極自對(duì)準(zhǔn)生長技術(shù),器件已達(dá)到了出色的性能- 特別是,在Bi-CMOS 配置中的HBT 顯示了高的Ft,F(xiàn)max(>300GHz)[19]。此外,由于具有很好的鈍化結(jié)而獲得了在混頻器和振蕩器中極為有用的出色的1/f 噪聲性能。所有這些特性被用來制成了許多可以運(yùn)行的芯片,例如在43GHz 光纖傳輸系統(tǒng)中的多用復(fù)用器(MUX)和多路分離器(DEMUX),高速模-數(shù)轉(zhuǎn)換器[20],以及77GHz 頻率的車用雷達(dá)芯片組,甚至可用于工作在100GHz 以上的收發(fā)機(jī)中[21]。
在過去的幾年中,隨著極短?hào)艠O工藝過程的采納(現(xiàn)在是在45-90nm 的范圍),人們已經(jīng)報(bào)道了具有極高截止頻率的n-溝道MOS 晶體管(ft>200GHz)[22]。這種與半導(dǎo)體國際技術(shù)發(fā)展藍(lán)圖相一致的結(jié)果,實(shí)際上是從前僅限于III-V HEMT(昂貴)的電子束加工工藝過程和許多正在發(fā)生的MOS 結(jié)構(gòu)演變所產(chǎn)生的柵極長度減小的結(jié)果。正像HEMT 結(jié)構(gòu)一樣,通過較高的遷移率溝道(例如所獲取的應(yīng)變硅溝道)以及由所謂的高-K 電介質(zhì)柵極所產(chǎn)生的具有合適的氧化層厚度與溝道的長度比值,使得性能得到了加強(qiáng)(由于SiO2?可以提供無與倫比的Si 鈍化作用,它的相對(duì)介電常數(shù)-只有4 -在柵極長度,柵極厚度按比例減小時(shí),就變得太低了)。

圖2、在互連之前,發(fā)射極寬度為0.6μm 的InP DHBT 的顯微照片。HBT 是采用三層臺(tái)面(Triple-Mesa)自對(duì)準(zhǔn)工藝制作的[18]。
受益于這種擴(kuò)展的頻率性能,在過去幾年,人們已經(jīng)在毫米波領(lǐng)域?qū)OS 技術(shù)的潛力進(jìn)行了初步的評(píng)估[23]。高集成度和低成本(對(duì)于大量芯片)是我們對(duì)硅工藝感興趣的主要原因。
III-V 器件:與CMOS的共同集成
為了同時(shí)獲得兩種技術(shù)領(lǐng)域的最佳優(yōu)勢(shì),異質(zhì)集成工藝是一個(gè)頗有前途的解決方案。為了將III-V 晶體管(實(shí)際上是InP 晶體管)和硅基CMOS 進(jìn)行相近的集成,人們已經(jīng)探索了不同的途徑,特別是在DARPA 資助的COSMOS 項(xiàng)目中[24]。人們已經(jīng)探索了若干種方法,從超級(jí)自對(duì)準(zhǔn)(小于5μm)倒裝芯片集成到一個(gè)完全徹底的單片失配外延技術(shù)。早期的結(jié)果非常鼓舞人心,在將InP 器件集成到CMOS 圓晶片之后,InP 器件的性能劣化并不明顯,并且已經(jīng)演示了一類具有大輸出擺幅和小功耗的大增益-帶寬的差分放大器(>100GHz)[25]。雖然沒有直接的聯(lián)系,但人們應(yīng)當(dāng)注意到,通過MOSFET技術(shù)中的高遷移率III -V 溝道層的研究而在沿著半導(dǎo)體國際技術(shù)路線發(fā)展藍(lán)圖道路上所取得的進(jìn)展[26]。
從晶體管到電路
我們?cè)谏弦还?jié)介紹了現(xiàn)有的用于有源器件的不同工藝的特性。這些器件是開啟100-GHz 以上頻率大門的關(guān)鍵,但這還不夠。同樣需要合適的方式將它們變?yōu)榭蛇\(yùn)行的電路,這意味著傳輸線,無源器件和接地等特定領(lǐng)域的開發(fā)。由于這些因素,在將器件特性轉(zhuǎn)換到應(yīng)用領(lǐng)域時(shí),某一種工藝可能比其它的都要好。
目前,人們已可以明確不同技術(shù)在特定方面的勝出,見表3。

這個(gè)表繪制了一幅演變現(xiàn)狀的畫面。在接下來的討論中,將用兩種不同類型的演示電路來對(duì)畫面進(jìn)行具體的說明。T.Swan,Y.Baeyens,和M.Meghelli 在文章中對(duì)特定的100-Gb/s 光波電路在該方面的進(jìn)展進(jìn)行了討論[53]。
用靜態(tài)分頻器作為技術(shù)的衡量基準(zhǔn)
用于數(shù)字電路的半導(dǎo)體工藝通常是用靜態(tài)分頻器的性能來作為衡量基準(zhǔn)的。由于一個(gè)靜態(tài)分頻器使用的是可以在更復(fù)雜的時(shí)序電路中找到的觸發(fā)器單元元件[36],因此這樣一個(gè)電路的性能可以作為公認(rèn)的數(shù)字集成電路工藝的質(zhì)量因數(shù)。相同的觸發(fā)器被用作分頻器,判斷電路,10/100-Gb/s 系統(tǒng)復(fù)用器的基本單元[37]。在使用類似基礎(chǔ)元件的不同電路中,選擇靜態(tài)分頻器的原因是因?yàn)樗『檬遣捎煤?jiǎn)單的測(cè)量設(shè)備最容易進(jìn)行明確評(píng)估的電路,并且它可以給出這個(gè)技術(shù)所能達(dá)到的明確的性能上限。
圖3 示出了從90 年代初期直到現(xiàn)在所報(bào)道的靜態(tài)分頻器的速度。數(shù)據(jù)顯示出在過去幾年中,即使在2000年高速光纖的市場(chǎng)崩潰之后,速度也是在穩(wěn)定上升的。最近的進(jìn)展中大部分是由DARPA 通過頻率捷變數(shù)字合成發(fā)射機(jī)技術(shù)這個(gè)計(jì)劃(TFAST)所資助的。注意,在InP HBT 技術(shù)上正持續(xù)不斷獲得最好的結(jié)果,SiGe HBT 緊隨其后[38]。HEMT 或CMOS器件技術(shù)在最高頻率方面沒有那么強(qiáng)的競(jìng)爭(zhēng)力,因?yàn)樵贔ET 為基的器件中,需要大的器件尺寸才能達(dá)到必要的跨導(dǎo)要求。至今為止,所發(fā)表的靜態(tài)分頻器的最好結(jié)果是采用250-nm InP HBT 技術(shù)所達(dá)到的150GHz,最近的進(jìn)展已經(jīng)集中到降低功耗這方面了[39]。這個(gè)性能與全速率判斷電路的性能是一致的,并且在多路復(fù)用器/多路分離器(MUX/DEMUX)電路中的性能還有很大的發(fā)展余地。
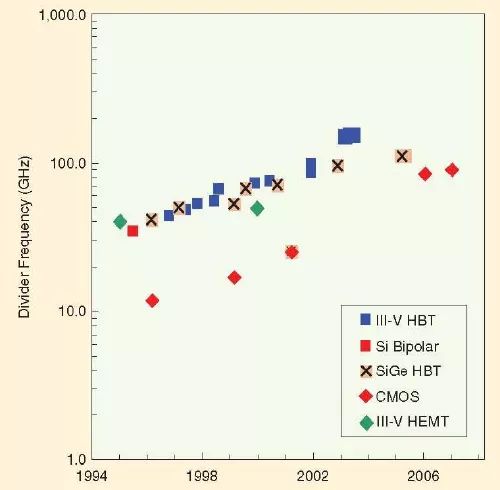
圖3、靜態(tài)頻分器的最高頻率隨著報(bào)道年代而發(fā)生的變化。所示數(shù)據(jù)僅僅了包含了當(dāng)時(shí)特定技術(shù)的最好結(jié)果。
在最高工作速度下,功耗是特別重要的,此時(shí)單個(gè)門電路會(huì)有幾百毫瓦的功耗。雖然功耗隨著分頻器切換率的提高而迅速增長(例如,在87GHz時(shí)是23mW[41]),但CMOS 由于其出色的結(jié)果(輸入頻率范圍是90-100GHz[40])而加入了競(jìng)爭(zhēng)行列。所報(bào)道的最好的功耗是采用InP HBT 技術(shù),在150GHz 時(shí)為42mW/每個(gè)鎖存器[39]。
用振蕩器(VCO)作為技術(shù)衡量基準(zhǔn)
壓控振蕩器(VCO)是100Gb/s 串行應(yīng)答器以及下毫米波通信,高分辨率雷達(dá)和成像系統(tǒng)所必不可少的構(gòu)建模塊。這樣的振蕩器要求將低相位噪聲,高輸出功率和好的直流-到-射頻轉(zhuǎn)換效率相結(jié)合,特別是在最高頻率下。這便轉(zhuǎn)換為許多重要的技術(shù)要求。
? 最高振蕩頻率(fmax)對(duì)于亞毫米波操作來說是很關(guān)鍵的;最高頻率基頻振蕩器是基于納米級(jí)別的InP 基HEMT。所報(bào)道的最高基頻振蕩器是已有十年歷史的213-GHz InP HEMT 振蕩器[42]。近來,采用35-nm柵極InP HEMT 技術(shù)具有Fmax?為600-GHz 的器件的fmax?的進(jìn)一步改善使得基頻振蕩器可以達(dá)到346GHz[43]?。InPDHBT 最近也同樣展示了在亞毫米波頻率的基頻振蕩[44]。
? 為了獲得振蕩器好的近載波相位噪聲性能,重要的是使用具有低閃爍噪聲的技術(shù)。雙極技術(shù),如SiGe 或InP HBT 通常可以提供比諸如HEMT或CMOS 這類FET 更低的1/f 拐角頻率,這要?dú)w功于表面狀態(tài)影響的減少。在觀察較大頻率偏離處的相位噪聲時(shí)(例如,距離載波1MHz-見圖4),毫米波CMOS 振蕩器所展示的相位噪聲與它們所對(duì)應(yīng)的SiGe 和InP HBT 器件的相接近。這個(gè)比較并未將調(diào)諧范圍的影響考慮在內(nèi),而且還會(huì)受到曲解,即如文獻(xiàn)[45]中所提到的,在沒有輸出緩沖時(shí),振蕩器毫米波頻率相位噪聲會(huì)更好一些。

圖4、所報(bào)道的采用不同技術(shù)所實(shí)施的毫米波振蕩器相位噪聲概觀(在偏離載波1-MHz 處)。
? 最后,振蕩器在最高頻率下可實(shí)現(xiàn)的輸出功率便成了一個(gè)重要的設(shè)計(jì)參數(shù),特別是當(dāng)器件工作在接近其fmax?時(shí),這是因?yàn)椋藭r(shí)要進(jìn)一步放大輸出信號(hào)會(huì)變得格外困難。為了讓輸出功率達(dá)到最大,振蕩器內(nèi)部電壓的擺幅需要達(dá)到最大。大多數(shù)III-V 器件,如InP HBT 就擊穿電壓而言具有不折不扣的優(yōu)勢(shì),尤其是當(dāng)其與CMOS 相比較時(shí)。這樣便可以產(chǎn)生所報(bào)道的較高的輸出功率。
100GHz?以上的高效率高功率源推-推振蕩器
為了在100GHz 以上達(dá)到較高的振蕩器輸出功率,設(shè)計(jì)者們更傾向于推-推振蕩器拓?fù)浣Y(jié)構(gòu),在這個(gè)結(jié)構(gòu)中,兩個(gè)以相反相位相耦合的振蕩器的輸出合成到一起來產(chǎn)生一個(gè)具有強(qiáng)二階諧波的輸出信號(hào)。這個(gè)拓?fù)浣Y(jié)構(gòu)使得可以在現(xiàn)有有源器件技術(shù)上實(shí)現(xiàn)高于fmax?的信號(hào)源,并且可以將現(xiàn)有高-Q 值諧振器技術(shù)的頻率范圍擴(kuò)展[46]。此外,采用推-推拓?fù)浣Y(jié)構(gòu),可以使用工作在基頻而不是二階諧波輸出頻率的靜態(tài)或動(dòng)態(tài)分頻器來將相位鎖相環(huán)(PLL)的振蕩器鎖定,以實(shí)現(xiàn)頻率鎖定信號(hào)源,從而將分頻器的速度要求降低了一半。
毫米波頻率的推-推振蕩器的潛力已經(jīng)得到了充分的展示。用不同的化合物半導(dǎo)體技術(shù)所實(shí)現(xiàn)的推-推振蕩器已經(jīng)在文獻(xiàn)中有所報(bào)道:在[47]中報(bào)道了直到140GHz 的0.13μmGaAs PHEMT 振蕩器,和在[48]中所報(bào)道的可以直到278GHz 的SiGe HBT 振蕩器。即使是采用CMOS 技術(shù)也成功地實(shí)現(xiàn)了100GHz以上的信號(hào)源:人們已經(jīng)報(bào)道了一個(gè)采用130-nmCMOS 技術(shù)的192GHz 推-推振蕩器[49]。最近,采用45-nm CMOS 技術(shù)構(gòu)建了一臺(tái)工作在410GHz 的信號(hào)源[50]。然而,即使是采用推-推拓?fù)浣Y(jié)構(gòu),由于硅基高速技術(shù)降低了的擊穿電壓以及納米級(jí)CMOS 需要在低偏置電壓下工作,在100GHz 以上可以觀察到CMOS 推-推振蕩器明顯降低了的輸出功率。例如,410-GHzCMOS 信號(hào)源具有20nW的輸出功率,這可能不足以用在發(fā)射機(jī)應(yīng)用中或驅(qū)動(dòng)接收機(jī)的混頻器中。正如在下列段落中所說明的,具有如此高功率的推-推振蕩器的理想選擇是InP 雙-異質(zhì)結(jié)HBT(D-HBT)技術(shù),它將高的fmax?和高的擊穿電壓結(jié)合在一起。
振蕩頻率在220 和355GHz 的集成推-推振蕩器是由Alcatel-Lucent/Bell- 實(shí)驗(yàn)室的0.5μm 發(fā)射極InGaAs/InP HBT D-HBT 技術(shù)來實(shí)現(xiàn)的,具有的最大振蕩頻率為335GHz 和4V 的擊穿電壓(Vbceo)[51]。
這些振蕩器是基于一種平衡Colpitts 振蕩器拓?fù)浣Y(jié)構(gòu)的。通過將相位相反的輸出進(jìn)行合成,并且使用短路截線(short stub)通過電抗部分在二階諧波頻率上來調(diào)節(jié)振蕩器輸出阻抗使其產(chǎn)生一個(gè)很強(qiáng)的二階諧波信號(hào)[52],如圖5 所示。人們已經(jīng)采用這個(gè)技術(shù)實(shí)現(xiàn)了不同的諧振器。圖5 展示一個(gè)287GHz 的電路布局圖。傳輸線諧振器LE,LB?和LC?是在7-μm 低-K 層間介電材料(εr=2.6)之上采用一個(gè)2-μm 厚的金板接地面通過薄膜微帶線來實(shí)現(xiàn)的。
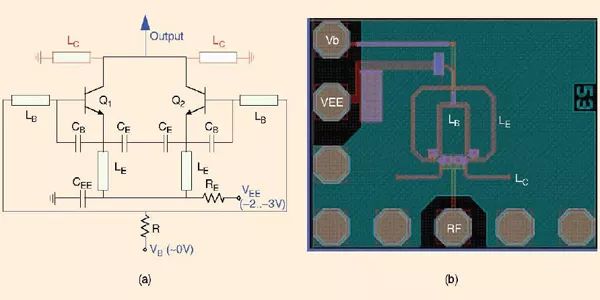
圖5、一臺(tái)InP D-HBT 推-推振蕩器的(a)電路圖和(b)電路布局圖[52]。
不同振蕩器的輸出信號(hào)是采用一個(gè)WR03 波導(dǎo)探頭來探測(cè)的,并且使用WR03 次諧波混頻器進(jìn)行下變頻的。在210GHz 和235GHz 所測(cè)得的輸出功率可達(dá)1mW,直流-到-射頻的效率為2-3%。工作在280 和297GHz 的振蕩器可以獲得-5dBm 的輸出功率。圖6 展示了所實(shí)現(xiàn)的最高頻率振蕩器所測(cè)得的輸出頻譜。雖然輸出超過了WR03 波導(dǎo)(LO)在片探頭和下變頻混頻器的頻段范圍,在將振蕩器信號(hào)與321.6GHz 的有效本振頻率相混頻時(shí),仍然會(huì)探測(cè)到很強(qiáng)的IF 信號(hào)。通過對(duì)探頭和混頻器損耗進(jìn)行校正,損耗值估計(jì)在23dB 與30dB 之間,在355GHz 上可以獲得高于-13dBm的輸出功率。

圖6、一個(gè)工作在355GHz 的InP D-HBT 推-推VCO 的下變頻頻譜(LO=321.6GHz,上邊帶)(未對(duì)混頻器的損耗進(jìn)行任何修正)。
這些振蕩器的輸出功率與振蕩頻率的關(guān)系展示在圖7 中,并且將其與不同的半導(dǎo)體技術(shù)所制作的振蕩器進(jìn)行了比較。多虧了InP D-HBT 的高擊穿電壓,以及可以將輸出功率改善5dB 的二階諧波調(diào)諧技術(shù),截止目前為止,InP D-HBT 推-推振蕩器可以在該頻段范圍內(nèi)具有比所報(bào)道的其它晶體管信號(hào)源更高的輸出功率和效率。

圖7、所報(bào)道的采用不同技術(shù)所實(shí)施的振蕩器的輸出功率和工作頻率的概觀。采用基頻和推-推振蕩器的結(jié)果分別用空心和實(shí)心符號(hào)來表示。
結(jié)論
若干種半導(dǎo)體材料和技術(shù)都適合用來解決100GHz 和100-Gb/s 的應(yīng)用問題。這些技術(shù)有時(shí)候會(huì)相互競(jìng)爭(zhēng),正如我們所預(yù)期的,這是一個(gè)新的應(yīng)用領(lǐng)域,人們?nèi)匀辉趯?duì)這些技術(shù)各自的優(yōu)點(diǎn)和缺點(diǎn)進(jìn)行著討論。本文旨在說明隨著頻率性能的不斷提高,這些演進(jìn)技術(shù)的多樣性和其潛在的影響。盡管長期以來,器件性能的改善僅僅依賴于光刻技術(shù)進(jìn)步所允許的尺寸的減小,然而異質(zhì)結(jié)構(gòu)和應(yīng)力工程技術(shù)現(xiàn)在已成為強(qiáng)有力的手段,通過它們可以增強(qiáng)速度和功率性能,使之達(dá)到能夠打開100-GHz 和100-Gb/s 應(yīng)用領(lǐng)域之門的水平。
作者:André Scavennec,Marko Sokolich,Yves Baeyens
參考文獻(xiàn)
[1] P. H. Siegel, “Terahertz technology,” IEEE Trans. Microwave Theory Tech., vol. 50, pp. 910–928, Mar. 2002.
[2] A. Tessmann, I. Kallfass, A. Leuther, H. Massler, M. Kuri, M. Riessle, M. Zink, R. Sommer, A. Wahlen, H. Essen, V. Hurm, M. Schlechtweg, and O. Ambacher, “Metamorphic HEMT MMICs and modules for use in a high-bandwidth 210 GHz radar,” IEEE J. Solid-State Circuits, vol. 43, no. 10, pp. 2194–2205, Oct. 2008.
[3] R. J. Trew, “High frequency solid-state electronic devices,” IEEE Trans. Electron. Devices, vol. 52, pp. 638–649, May 2005.
[4] R. Quay, C. Moglestue, V. Palankovski, and S. Selberherr, “A temperature dependent model for the saturation velocity in semiconductor materials,” Mater. Sci. Semicond. Process., vol. 3, no. 1-2, pp. 149–155, 2000.
[5] Z. Griffith, Y. Dong, D. Scott, Y. Wei, N. Parthasarathy, M. Dahlstr?m, C. Kadow, V. Paidi, M. J. W. Rodwell, M. Urteaga, R. Pierson, P. Rowell, B. Brar, S. Lee, N. X. Nguyen, and C. Nguyen, “Transistor and circuit design for 100–200-GHz ICs,” IEEE J. Solid-State Circuits, vol. 40, no. 10, pp. 2061–2069, Oct. 2005.
[6] M. J. W. Rodwell, M. Urteaga, T. Mathew, D. Scott, D. Mensa, Q. Lee, J. Guthrie, Y. Betser, S. C. Martin, R. P. Smith, S. Jaganathan, S. Krishnan, S. I. Long, R. Pullela, B. Agarwal, U. Battacharya, L. Samoska, and M. Dahlstr?m, “Submicron scaling of HBTs,” IEEE Trans. Electron. Devices, vol. 48, no. 11, pp. 2606–2624, Nov. 2001.
[7] B. Y. Ma, J. Bergman, P. S. Chen, J. B. Hacker, G. Sullivan, B. Brar, “Ultrawideband ultra-low-dc-power high gain differentialinput low noise amplifier MMIC using InAs/AlSb HEMT,” in Proc. Compound Semiconductors ICs Symp., Portland, OR, Oct. 2007, pp. 213–216.
[8] D.-H. Kim and J. A. del Alamo, “30-nm InAs pseudomorphic HEMTs on an InP substrate with a current-gain cutoff frequency of 628 GHz,” IEEE Trans Electron. Device Lett., vol. 29, no. 8, pp. 830–833, Aug. 2008.
[9] M. Micovic, A. Kurdoghlian, H. P. Moyer, P. Hashimoto, M. Hu, M. Antcliffe, P. J. Willadsen, W. S. Wong, R. Bowen, I. Milosavljevic, Y. Yoon, A. Schmitz, W. Wetzel, C. McGuire, B. Hughes, and D. H. Chow, “GaN MMIC for E-band (71 GHz – 95 GHz) radio,” in Proc. Compound Semiconductors ICs Symp., Oct. 2008, pp. 10–13.
[10] M. Higashiwaki, T. Mimura, and T. Matsui, “Enhancementmode AlN/GaN HFETs using Cat-CVD SiN,” IEEE Trans. Electron. Devices, vol. 54, no. 6, pp. 1566–1570, June 2007.
[11] H. Amasuga, A. Inoue, S. Goto, T. Kunii, Y. Yamamoto, T. Oku, and T. Ishikawa, “A high power and high breakdown voltage millimeter- wave GaAs pHEMT,” in IEEE MTT-S Dig. Int. Microwave Symp., 2007, pp. 821–824.
[12] K.J. Herrick, K.W. Brown, F.A. Rose, C.S. Whelan, J. Kotce, J.R. Laroche, Y. Zhang “W-band Metamorphic HEMT with 267 mW Output Power”, in Microwave Symp. Dig., 12–17 June 2005, pp. 843–846.
[13] D. L. Ingram, Y. C. Chen, J. Kraus, B. Brunner, B. Allen, H. C. Yen, and K. F. Lau, “A 427 mW, 20% compact W-band InP HEMT MMIC power amplifier,” in Proc. IEEE Radio Frequency ICs Symp., 1999, pp. 95–98.
[14] W. R. Deal,X.B. Mei, V. Radisic, M.D. Lange, W. Yoshida, P-H. Liu, J. Uyeda, M.E. Barsky, A. Fung, T. Gaier, and R. Lai, “Development of sub-millimeter-wave power amplifiers,” IEEE Trans. Microwave Theory Tech., vol. 55, no. 12, pp. 2719– 2726, Dec. 2007.
[15] B. Jalali, R. N. Nottenburg, Y. K. Chen, A. F. J. Levi, A. Y. Cho, and M. B. Panish, “Scaled AlInAs/InGaAs and InP/InGaAs heterostructure bipolar transistors,” IEEE Trans. Electron. Devices, vol.36, no. 11, p. 2602, Nov. 1989.
[16] Z. Griffith, E. Lind, M. J. W. Rodwell, Xiao-Ming Fang, D. Loubychev, Ying Wu, J. M. Fastenau, and A. W. K. Liu, “Sub-300 nm InGaAs/InP Type-I DHBTs with a 150 nm collector, 30 nm base demonstrating 755 GHz fmax and 416 GHz ft,” in Proc. Indium Phosphide and Related Materials, 2007 (IPRM ‘07), May 14–18, 2007, pp. 403–406.
[17] W. Snodgrass, Bing-Ruey Wu; K. Y. Cheng, and M. Feng, “Type-II GaAsSb/InP DHBTs with Record fT = 670 GHz and Simultaneous fT, fMAX . 400 GHz,” in Proc. IEEE Electronic Devices Meeting, Dec.10–12, 2007, pp. 663–666.
[18] J. Godin, V. Nodjiadjim, M. Riet, P. Berdaguer, O. Drisse, E. Derouin, A. Konczykowska, J. Moulu, J.-Y. Dupuy, F. Jorge, J.-L. Gentner, A. Scavennec, T. Johansen, and V. Krozer, “Submicron InP DHBT technology for high-speed, highswing mixed signal ICs,” in Proc. Compound Semiconductors IC Symp., Monterey, Oct. 12–15, 2008, pp. 109–112.
[19] B. A. Orner, M. Dahlstrom, A. Pothiawala, R. M. Rassel, Q. Liu, H. Ding, M. Khater, D. Ahlgren, A. Joseph, and J. Dunn, “A BiCMOS technology featuring a 300/330 GHz (fT/fmax) SiGe HBT for millimeter wave applications,” in Proc. BCTM, 2006, pp. 49–52.
[20] J. Lee, “High-speed analog-to-digital converters in SiGe technologies,” in Dig. IEEE Compound Semiconductors IC Symp., Portland, Oct. 14–17, 2007, pp. 93–96. [21] E. Laskin, P. Chevallier, A. Chantre, B. Sautreuil, and S. Voinigescu, “165-GHz transceiver in SiGe technology,” IEEE J. Solid-State Circuits, vol. 43, no. 5, pp. 1087–1100, May 2008.
[22] S. Lee, B. Jagannathan, S. Narashimha, A. Chou, N. Zamdmer, J. Johnson, R. Williams, L. Wagner, J. Kim, J.-O. Plouchart, J. Pekarik, S. Springer, and G. Freeman, “Record RF performance of 45-nm SOI CMOS technology,” in Proc. IEDM, 2007, pp. 255–258.
[23] K. K. O, C. Cao, E.-Y. Seok, and S. Sankaran, “100–200 GHz CMOS signal sources and detectors,” in Dig. IEEE Compound Semiconductors IC Symp., Portland, Oct. 14–17, 2007, pp. 11–14.
[24] M. J. Rosker, V. Greanya, and T.-H. Chang, “The DARPA Compound Semiconductor Materials On Silicon (COSMOS) Program,” in Proc. Compound Semiconductors ICs Symp., Oct. 12–15, 2008, pp. 6–9.
[25] J. C. Li, K. R. Eliott, D. S. Matthews, D. A. Hitko, D. M. Zehnder, Y. Royter, P. R. Patterson, T. Hussain, and J. F. Jensen, “100GHz+ gain-bandwidth differential amplifiers in a wafer scale heterogeneously integrated technology using 250nm InP DHBTs and 130 nm CMOS,” in Proc. Compound Semiconductors IC Symp., Monterey, Oct. 12–15, 2008, pp. 227–230.
[26] G. Dewey, M. K. Hudait, K. Lee, R. Pillarisetty, W. Rachmady, M. Radosavljevic, T. Rakshit, and R. Chau, “Carrier transport in high-mobility III-V quantum-well transistors and performance impact for high-speed low-power logic applications,” IEEE Trans. Electron. Device Lett., vol. 29, no. 10, pp. 1094–1097, Oct. 2008.
[27] L. Wang, S. Glisic, J. Borngraeber, W. Winkler, and J.-C. Scheytt, “A singleended fully integrated SiGe 77/79 GHz receiver for automotive radar,” IEEE J. Solid-State Circuits, vol. 43, no. 9, pp. 1897–1908, Sept. 2008.
[28] J. Hallin, T. Kjellberg, and T. Swahn, “A 165-Gb/s 4:1 multiplexor in InP DHBT technology,” IEEE J. Solid-State Circuits, vol. 41, no. 10, pp. 2209–2214, Oct. 2006.
[29] M. Meghelli, “A 132-Gb/s 4:1 multiplexor in 0.13-μm SiGebipolar technology,” IEEE J. Solid-State Circuits, vol. 39, no. 12, pp. 2403–2407, Dec. 2004.
[30] P. Schvan, J. Bach, C. Fait, P. Flemke, R. Gibbins, Y. Greshishchev, N. Ben- Hamida, D. Pollex, J. Sitch, S.-C. Wang, and J. Wolczanski, “A 24GS/s 6b ADC in 90 nm CMOS,” in Dig. Tech. Papers, 2008 Solid-State Circuits Conf. (ISSCC), Feb. 3–7, 2008,pp. 544–638.
[31] B. Chan, B. Oyama, C. Monier, and A. Gutierrez-Aitkin, “An ultra-wideband 7- bit 5-Gsps ADC implemented in submicron InP HBT technology,” IEEE J. Solid- State Circuits, vol. 43, no. 10,pp. 2187–2193, Oct. 2008.
[32] E. Laskin, M. Khanpour, R. Aroca, K. W. Tang, P. Garcia, and S. P. Voinigescu, “A 95 GHz receiver with fundamental-frequency VCO and static frequency divider in 65nm digital CMOS,” in IEEE ISSCC Dig. Tech. Papers, Feb. 2008, p. 180.
[33] T. Suzuki, Y. Nakasha, T. Takahashi, K. Makiyama, T. Hirose, and M. Takikawa, “144-Gbit/s selector and 100-Gbit/s 4:1 multiplexer using InP HEMTs,” in Proc. 2004 IEEE MTT-S Int. Microwave Symp. Dig., June 6–11, 2004, vol. 1, pp. 117–120.
[34] K. Kanda, D. Yamazaki, T. Yamamoto, M. Horinaka, J. Ogawa, H. Tamura, and H. Onodera, “40Gb/s 4:1 MUX/1:4 DEMUX in 90 nm standard CMOS,” in IEEE ISSCC Dig. Tech. Papers, 2005, vol. 1, p. 152.
[35] S. Shahramian, A. C. Carusone, P. Schvan, and S. P. Voinigescu, “An 81 gb/s, 1.2v tiala-retimer in standard 65 nm cmos,” in Proc. IEEE Compound Semiconductor Integrated Circuits Symp., 2008, pp. 1–4.
[36] J. F. Jensen, M. Hafizi, W. E. Stanchina, R. A. Metzger, and D. B. Rensch, “39.5- GHz static frequency divider implemented in AlInAs/GaInAs HBT technology,” in GaAs IC Symp. Tech. Dig., 1992, pp. 101–104.
[37] M. Yoneyama, Y. Miyamoto, T. Otsuji, H. Toba, Y. Yamane, T. Ishibashi, and H. Miyazawa, “Fully electrical 40-Gb/s TDM system prototype based on InP HEMT digital IC technologies,” J. Lightwave Technol., vol. 18, pp. 34–43, Jan. 2000.
[38] S. Trotta, H. Knapp, T. F. Meister, K. Aufinger, J. B?ck, W. Simbürger, and A. L. Scholtz, “110-GHz static frequency divider in SiGe bipolar technology,” in CSIC 2005 Dig., 2005, pp. 291–294.
[39] D. A. Hitko, T. Hussain, D. S. Matthews, R. D. Rajavel, I. Milosavljevic, M. Sokolich, “State of the art low power (42 mW per flip-flop) 150 GHz+ CML static divider implemented in scaled 0.2 m emitter-width InP DHBTs,” in Indium Phosphide and Related Materials Conf. Proc., May 7–11, 2006, pp. 85–88.
[40] S. P. Voinigescu, R. Aroca, T. O. Dickson, S. T. Nicolson, T. Chalvatzis, P. Chevalier, P. Garcia, C. Garnier, and B . Sautreuil “Towards a sub-2.5 V, 100-Gb/s serial transceiver,” in Proc. IEEE CICC 2007, pp. 471–478.
[41] D. D. Kim, C. Cho, J. Kim, and J.-O. Plouchart, “Wideband mm- Wave CML static divider in 65nm SOI CMOS technology” in Proc. IEEE CICC 2008, pp. 627– 634.
[42] S.E. Rosenbaum, B.K. Kormanyos, L.M. Jelloian, M. Matloubian,A.S. Brown, L.E. Larson, L.D. Nguyen, M.A. Thompson, L.P.B. Katehi, and G.M. Rebeiz, “155- and 213-GHz AlInAs/GaInAs/InP HEMT MMIC oscillators,” IEEE Trans. MicroIEEE microwave magazine April 2009 86 wave Theory Tech., vol. 43, no. 4, pp. 927–932, Apr. 1995.
[43] V. Radisic, X.B. Mei, W.R. Deal, W. Yoshida, P.H. Liu, J.Uyeda, M. Barsky, L. Samoska, A. Fung, T. Gaier, and R. Lai, “Demonstration of sub-millimeter wave fundamental oscillators using 35-nm InP HEMT technology,” IEEE Microwave Wireless Comp. Lett., vol. 17, no. 3, pp. 223–225, Mar. 2007.
[44] V. Radisic, D. Sawdai, D. Scott, W.R. Deal, L. Dang, D. Li, T. Chen, A. Fung, L. Samoska, T. Gaier, and R. Lai, “Demonstration of a 311-GHz fundamental oscillator using InP HBT technology, IEEE Trans. Microwave Theory Tech., vol. 55, no. 11, pp. 2329–2335, Nov. 2007.
[45] H. Li and H. Rein, “Millimeter-wave VCOs with wide tuning range and low phase noise, fully integrated in a SiGe bipolar production technology,” IEEE J. Solid-State Circuits, vol. 38, no. 2, pp. 184–191, Feb. 2003.
[46] F. Sinnesbichler, “Hybrid millimeter-wave push-push oscillators using silicongermanium HBTs,” IEEE Trans. Microwave Theory Tech., vol. 51, no. 2, pp. 422– 430, Feb. 2003.
[47] S. Kudszus, W.H. Haydl, A. Tessmann, W. Bronner, and M. Schlechtweg, “Pushpush oscillators for 94 and 140 GHz applications using standard pseudomorphic GaAs HEMTs,” in 2001 IEEE MTT-S Int. Microwave Symp. Dig., 2001, vol. 3, pp. 1571–1574.
[48] R. Wanner, R. Lachner, G. Olbrich, and P. Russer, “A SiGe monolithically integrated 278 GHz push-push oscillator,” in Dig. 2007 IEEE/MTT-S Int. Microwave Symp., June 3–8, 2007, pp. 333–336.
[49] C. Cao, E. Seok, and K. K. O, “192 GHz push-push VCO in 0.13 mm CMOS,” Electron. Lett., vol. 42, no. 4, pp. 208–210, Feb. 2006.
[50] E. Seok, K.K.O, “A 410GHz CMOS push-push oscillator with an on-chip patch antenna,” in Dig. Tech. Papers of the 2008 Solid-State Circuits Conf. (ISSCC), Feb. 3–7, 2008, pp. 472–629.
[51] N. Weimann, V. Houtsma, Y. Yang, J. Frackoviak, A. Tate, and Y.K. Chen, “Fully dry-etched Inp double-hetero bipolar transistors with ft > 400 GHz,” in Proc. 2006 IEEE Device Research Conf., State College, PA.
[52] Y. Baeyens, N. Weimann, V. Houtsma, J. Weiner, Y. Yang, J. Frackoviak, P. Roux, A. Tate, and Y.K. Chen, “Highly efficient harmonically tuned InP D-HBT push-push oscillators operating up to 287 GHz,” in Dig. 2007 IEEE/MTT-S Int. Microwave Symp., June 3–8, 2007, pp. 341–344.
[53] T. Swahn, Y. Baeyens, and M. Meghelli, “ICs for 100 Gb/s serial operation,” IEEE Microwave Mag., vol. 10, no. 2, pp. 58–67.
編輯:黃飛
?
 電子發(fā)燒友App
電子發(fā)燒友App




















評(píng)論